林定皓指出,當產(chǎn)品的可用空間受限,但需要提供的功能性卻持續(xù)提升,芯片設(shè)計邏輯走向功能高度整合、芯片合并、芯片與封裝走向薄小、連結(jié)密度大為提升。在上述趨勢下,帶動3D封裝技術(shù)興起,而印刷電路板產(chǎn)業(yè)也必須提升自我的技術(shù)能力,才可以與產(chǎn)品的發(fā)展同步性。
林定皓說,3D封裝可以采用硅穿孔(TSV)互連技術(shù)、覆晶芯片間連結(jié)、芯片堆棧混合打線連結(jié)等,這些技術(shù)交互運用,可以展現(xiàn)3D封裝的多樣性,現(xiàn)在業(yè)界目前比較常見的3D封裝整合類型包括,SIP(System in package)、PIP(package in package)或者SOP(System on package),這一類的技術(shù)都以芯片堆棧為主。
不過,林定皓也認為,3D封裝仍有不同層面的問題必須克服,包括設(shè)計能力的建構(gòu)、是否可以達到最佳效益化、可靠度信賴度提升、成本的控制、測試與檢驗?zāi)芰Α⒄w供應(yīng)鏈接構(gòu)、新材料開發(fā)、細微化連接技術(shù)等都需要突破性的發(fā)展。
3D封裝對于印刷電路板產(chǎn)業(yè)的影響,林定皓以手持式電子產(chǎn)品為例,他指出,手機一年的銷售量高達12億-13億支,尤其以智能型手機成長最為快速,為了達到多元化功能、傳輸速度快以及輕薄短小等特性,更需要3D整合性封裝的技術(shù)搭配,就連軟板、軟硬復合板的需求也會跟著被帶動。
林定皓認為,在3D封裝發(fā)展趨勢下,印刷電路板業(yè)者必須面臨組裝與信賴度的挑戰(zhàn)。在系統(tǒng)加入更多芯片材料后,不論與PCB的熱膨脹系數(shù)、耐溫性差異等,都會影響成品的信賴度。而細微的間距也考驗著材料的絕緣強度與耐候性,細小的接點亦考驗產(chǎn)品的耐沖擊性,因此電路板業(yè)者必須與產(chǎn)品的發(fā)展具有更高的同步性,電路板的設(shè)計可能與產(chǎn)品設(shè)計同時完成,其間的關(guān)聯(lián)性將更趨緊密。
-
pcb
+關(guān)注
關(guān)注
4362文章
23458瀏覽量
408241 -
華強pcb線路板打樣
+關(guān)注
關(guān)注
5文章
14629瀏覽量
43830
發(fā)布評論請先 登錄
3D測量-PCB板(星納微科技)
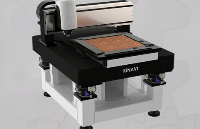
3D封裝與系統(tǒng)級封裝的背景體系解析介紹

如何看待2025年金屬3D打印行業(yè)的趨勢與挑戰(zhàn)?

對于結(jié)構(gòu)光測量、3D視覺的應(yīng)用,使用100%offset的lightcrafter是否能用于點云生成的應(yīng)用?
3D打印中XPR技術(shù)對于打印效果的影響?
芯片3D堆疊封裝:開啟高性能封裝新時代!

英倫科技裸眼3D便攜屏有哪些特點?

有源晶振在3D打印機應(yīng)用方案
技術(shù)資訊 | 2.5D 與 3D 封裝

KiCad發(fā)現(xiàn)之旅(三)PCB 3D查看器
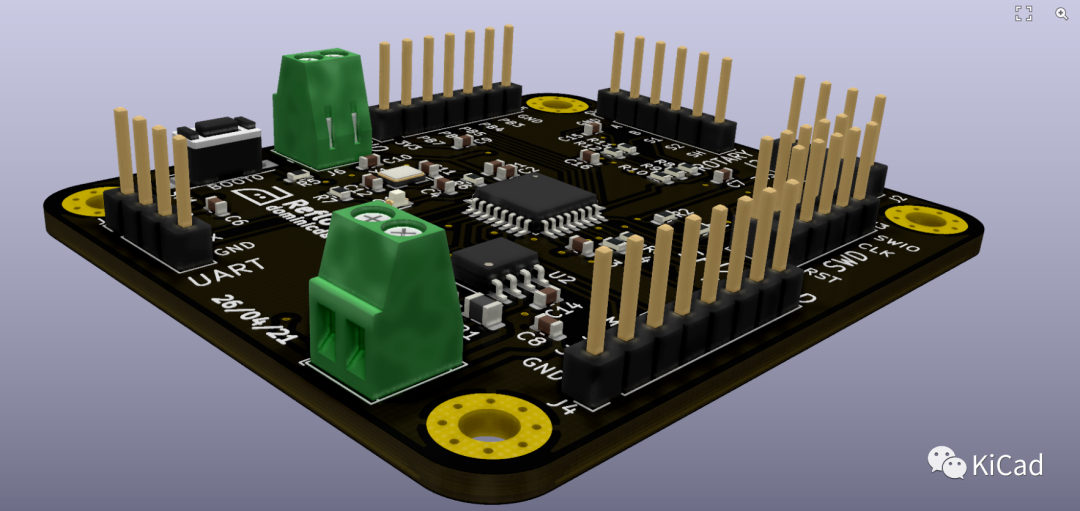
一文理解2.5D和3D封裝技術(shù)

物聯(lián)網(wǎng)行業(yè)中的模具定制方案_3D打印材料選型分享






 3D封裝對于pcb行業(yè)有什么影響
3D封裝對于pcb行業(yè)有什么影響

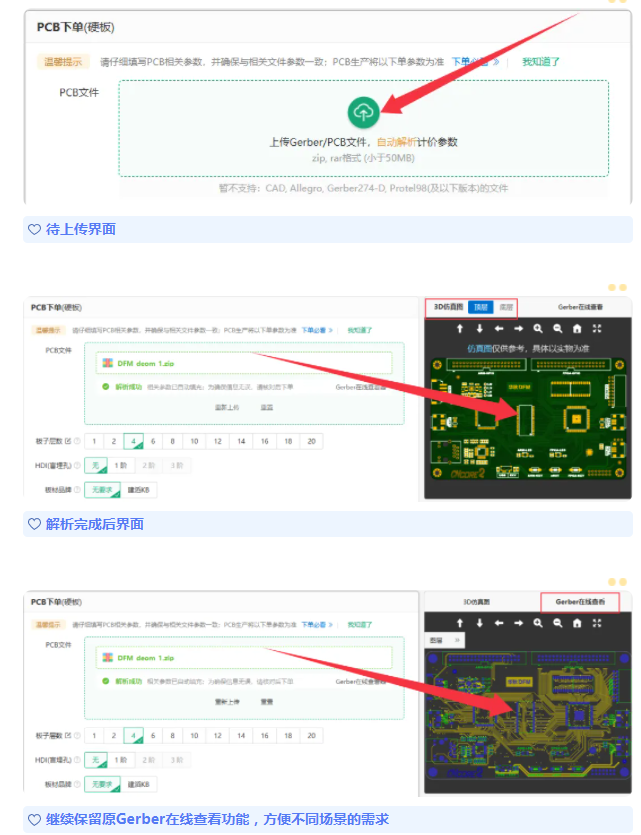












評論