00前言
如何建立準(zhǔn)確的IC封裝模型是電子部件級(jí)、系統(tǒng)級(jí)熱仿真的關(guān)鍵問(wèn)題和挑戰(zhàn)。建立準(zhǔn)確有效的IC封裝模型,對(duì)電子產(chǎn)品的熱設(shè)計(jì)具有重要意義。對(duì)于包含大量IC封裝的板級(jí)或系統(tǒng)級(jí)仿真來(lái)說(shuō),提高IC封裝的建模速度更為重要,需要方便快捷的模型庫(kù),提升任務(wù)的時(shí)效性、節(jié)約計(jì)算資源。接下來(lái)的兩篇文章將簡(jiǎn)單探討工程中常用的IC封裝模型種類,并介紹在Simcenter Flotherm中的IC建模方法。
01IC封裝建模分類
IC封裝建模主要分成詳細(xì)建模(Detailed Thermal Model, DTM)和緊湊式建模(Compact Thermal Model, CTM)兩大類。
1.1
詳細(xì)建模 DTMDTM即利用仿真工具,盡可能具體地模仿和復(fù)制IC封裝的實(shí)際物理結(jié)構(gòu)和材料,通常與IC封裝的CAD模型相結(jié)合。故而從外觀上看,DTM總是與實(shí)際IC封裝相似。但詳細(xì)模型也會(huì)根據(jù)所研究問(wèn)題的要求對(duì)封裝內(nèi)的組件進(jìn)行適當(dāng)簡(jiǎn)化,如用總體尺寸相符的立方體代替BGA的焊球陣列,用給定銅組分含量的基板代替實(shí)際的基板走線等等。將測(cè)量工具和仿真工具相結(jié)合,還可以對(duì)DTM進(jìn)行校準(zhǔn),使DTM結(jié)構(gòu)函數(shù)與實(shí)際封裝結(jié)構(gòu)函數(shù)的誤差降低到3%以內(nèi)。本文第二節(jié)將進(jìn)一步討論Simcenter Flotherm的模型校準(zhǔn)功能。
DTM的精度較高,且與邊界條件無(wú)關(guān),經(jīng)常用于芯片或封裝的設(shè)計(jì)制造,比如典型的封裝參數(shù)表征、封裝設(shè)計(jì)優(yōu)化等等。但是,由于IC封裝內(nèi)部組件尺寸差異很大,DTM會(huì)產(chǎn)生過(guò)大的網(wǎng)格量,降低仿真效率,故而對(duì)于板級(jí)仿真,建議只對(duì)重要的封裝進(jìn)行詳細(xì)建模,而系統(tǒng)級(jí)或以上的仿真由于包含大量的封裝,通常不使用DTM,而使用CTM描述。
1.2
緊湊式建模 CTMCTM是一種行為模型,不對(duì)IC封裝的實(shí)際物理結(jié)構(gòu)或材料進(jìn)行建模,而是模擬IC封裝對(duì)環(huán)境的熱力學(xué)響應(yīng),旨在精確預(yù)測(cè)幾個(gè)關(guān)鍵位置(如結(jié)點(diǎn)、外殼和引線)的溫度,通常以熱阻-熱容網(wǎng)絡(luò)的形式構(gòu)建。
最常用的兩種CTM是雙熱阻(2R)模型和DELPHI模型。2R模型最為簡(jiǎn)單,應(yīng)用也最為廣泛,它的結(jié)構(gòu)如下圖所示,包含了junction,case,board三個(gè)節(jié)點(diǎn),以及從θJC(junction to case)和θJB(junction to board)兩個(gè)熱阻。JEDEC相關(guān)標(biāo)準(zhǔn)對(duì)其測(cè)量方式進(jìn)行了定義,可參考[1]。
2R模型的優(yōu)點(diǎn)在于其結(jié)構(gòu)簡(jiǎn)單明了,且熱阻值可以通過(guò)實(shí)驗(yàn)測(cè)量得到,因此廣泛應(yīng)用于多封裝的板級(jí)或系統(tǒng)級(jí)建模;但其構(gòu)建方式?jīng)Q定了在特定工況下的2R模型的誤差是無(wú)法提前計(jì)算出來(lái)的。有關(guān)2R模型的誤差和使用,需要注意下述問(wèn)題:
1. 2R模型是簡(jiǎn)單的一維模型,當(dāng)封裝的熱量絕大部分都進(jìn)入基板或者散熱器時(shí),2R模型的誤差比較小;但當(dāng)封裝內(nèi)部的熱擴(kuò)散較多時(shí),2R模型的準(zhǔn)確性會(huì)大幅度降低,它與經(jīng)過(guò)校準(zhǔn)的DTM之間的誤差值一般在±30%以內(nèi)。類似地,2R模型所處實(shí)際工況與JEDEC定義的測(cè)量環(huán)境越接近,模型準(zhǔn)確性越高。2. 2R模型用作對(duì)比分析時(shí)(比如說(shuō)使用同一2R模型,預(yù)測(cè)兩種不同冷卻方案的溫度差),準(zhǔn)確性一般優(yōu)于絕對(duì)溫度的預(yù)測(cè)。3. 2R模型預(yù)測(cè)外殼溫度的準(zhǔn)確性通常不如結(jié)溫,尤其是對(duì)于外殼導(dǎo)熱性較差的封裝,比如OMP封裝,單點(diǎn)的Tcase很難準(zhǔn)確刻畫(huà)外殼的溫度梯度。4. 陣列封裝的2R模型會(huì)引入一定的基板熱阻,這是由θJB的測(cè)量方式?jīng)Q定的,具體有多大的影響需要具體分析。引腳封裝則不存在這個(gè)問(wèn)題。
綜合2R模型的優(yōu)缺點(diǎn)考慮,建議在設(shè)計(jì)初期使用2R模型來(lái)粗略地預(yù)測(cè)結(jié)溫,在設(shè)計(jì)后期,2R模型更適合進(jìn)行參數(shù)對(duì)比分析,而非具體的溫度/熱流預(yù)測(cè)。
DELPHI模型相對(duì)2R模型結(jié)構(gòu)復(fù)雜一些,邊界條件無(wú)關(guān)性和預(yù)測(cè)的準(zhǔn)確性也更高,一般情況下DELPHI模型與DTM對(duì)結(jié)溫的預(yù)測(cè)誤差不超過(guò)5%。這使得DELPHI模型廣泛應(yīng)用于從芯片級(jí)到系統(tǒng)級(jí)的熱仿真建模,尤其是對(duì)于需要準(zhǔn)確預(yù)測(cè)溫度/熱流的板級(jí)和系統(tǒng)級(jí)仿真任務(wù),DELPHI模型是首選的CTM。
典型的DELPHI模型結(jié)構(gòu)如下圖所示,由有限個(gè)表面/內(nèi)部節(jié)點(diǎn)以及節(jié)點(diǎn)之間的熱阻構(gòu)成。JEDEC同樣對(duì)DELPHI模型的構(gòu)建和使用發(fā)布了一系列標(biāo)準(zhǔn),詳見(jiàn)[2]。
DELPHI模型的優(yōu)點(diǎn)主要有:
1.DELPHI模型一般將封裝表面分成多個(gè)表面節(jié)點(diǎn),從而能較為準(zhǔn)確地描述封裝的溫度梯度。2.DELPHI模型自身帶有定量的模型誤差值。這是由于DELPHI模型的構(gòu)建過(guò)程定義了量化的目標(biāo)函數(shù),并在數(shù)十個(gè)標(biāo)準(zhǔn)測(cè)量環(huán)境中進(jìn)行預(yù)測(cè)、對(duì)比、誤差分析和優(yōu)化。3.DELPHI模型的邊界條件無(wú)關(guān)性相對(duì)于2R模型更高。
近年來(lái),越來(lái)越多的供應(yīng)商開(kāi)始提供封裝產(chǎn)品的DELPHI模型,方便用戶進(jìn)行熱仿真分析,DELPHI模型的普及程度日益提升。一些電子熱仿真軟件工具如Simcenter Flotherm也提供大量的模板,供用戶方便快捷地建立DELPHI模型以及其他的CTM或DTM。接下來(lái),本文將介紹在Simcenter Flotherm中構(gòu)建各種熱模型的方法。
02Simcenter Flotherm中的IC封裝建模
Flotherm 能夠創(chuàng)建不同精度的CTM和DTM,并且可以結(jié)合西門子Simcenter T3STER瞬態(tài)熱阻量測(cè)系統(tǒng),對(duì)DTM進(jìn)行進(jìn)一步的模型校準(zhǔn)。
Flotherm搭建熱阻模型的主要工具是Flotherm Project Manager中的SmartParts和在線工具Flotherm PACK, 模型校準(zhǔn)需要用到Flotherm Command Center模塊中的Model Calibration功能。
2.1
Cuboids
Cuboid立方體是最簡(jiǎn)單的IC封裝模型,在Flotherm中可以定義材料性質(zhì)、表面性質(zhì)、熱源和熱邊界條件,單個(gè)cuboid一般僅用于概念設(shè)計(jì)階段或系統(tǒng)級(jí)仿真中的元件。
DTM一般根據(jù)封裝的實(shí)際結(jié)構(gòu),由立方體、棱柱、圓柱、熱源、監(jiān)測(cè)點(diǎn)等多種SmartParts構(gòu)成裝配
2.2
PCB Components
PCB Components 是PCB裝配下的子元件,可以建立PCB板上獨(dú)立或陣列的IC封裝模型,封裝存在三種形式:
1)均勻分布于板上的熱源;2)元件大小的平面熱源;3)三維固體Cuboid,可以定義材料性質(zhì)(封裝處理為單一材料)以及Junction-Board、Junction-Case和Junction-sides三個(gè)熱阻,構(gòu)建CTM。
2.3
Compact Components
Compact component能夠創(chuàng)建兩種CTM模型:2R Model和General Model。2R Model顯示為兩層Cuboids,用戶需自定義θJC和θJB。General Model顯示為三層Cuboids,允許用戶自定義最多20個(gè)Junction節(jié)點(diǎn)和2個(gè)Interal節(jié)點(diǎn),可以構(gòu)建更詳細(xì)的CTM,如Area Array Packages, Peripheral Packages, Stacked Die Packages等。
2.4
Network Assembly
使用Network Assembly 構(gòu)建的2R模型
Network assembly是由分級(jí)的cuboids和節(jié)點(diǎn)組成的熱阻-熱容網(wǎng)絡(luò)。用戶可以自由地定義節(jié)點(diǎn)以及節(jié)點(diǎn)之間的熱阻和熱容,用三維Network Cuboid表征封裝的實(shí)際體積,用二維Network Cuboid(Collapsed Cuboid)定義封裝與環(huán)境接觸的表面節(jié)點(diǎn)。
2.5
EDA ComponentsEDA Components在Project Manager中的具體形式取決于在EDA bridge中的源元件:
簡(jiǎn)單的長(zhǎng)方體/圓柱元件轉(zhuǎn)換為Cuboid/Cylinder + 監(jiān)測(cè)點(diǎn) + Volume Region的裝配
2R/DELPHI元件轉(zhuǎn)換為Compact Components / Network Assembly + Volume Region的裝配
詳細(xì)建模的元件轉(zhuǎn)化為DTM,具體構(gòu)成由IC封裝實(shí)際結(jié)構(gòu)決定,一般是Cuboids + 熱源 + 監(jiān)測(cè)點(diǎn)構(gòu)成的裝配。
除了手動(dòng)建模的方法之外,F(xiàn)lotherm還提供更為方便快捷的半自動(dòng)化建模數(shù)據(jù)庫(kù)Flotherm PACK和Package Creator。考慮到實(shí)際IC封裝生產(chǎn)中會(huì)產(chǎn)生的一些不確定因素以及熱瞬態(tài)分析對(duì)模型的高精度要求,F(xiàn)lotherm還提供了熱仿真與熱測(cè)試相結(jié)合的模型校準(zhǔn)技術(shù)。這些內(nèi)容將在下一篇文章中進(jìn)行介紹。
責(zé)任編輯:haq
-
IC
+關(guān)注
關(guān)注
36文章
6105瀏覽量
178670 -
封裝
+關(guān)注
關(guān)注
128文章
8598瀏覽量
144994 -
建模
+關(guān)注
關(guān)注
1文章
316瀏覽量
61481
原文標(biāo)題:【分享】詳解IC封裝建模 - Simcenter Flotherm 的IC封裝解決方案 (上)
文章出處:【微信號(hào):BasiCAE,微信公眾號(hào):貝思科爾】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
如何實(shí)現(xiàn)MC33774IC在Simulink環(huán)境中使用基于模型的設(shè)計(jì)?
IC封裝產(chǎn)線分類詳解:金屬封裝、陶瓷封裝與先進(jìn)封裝

芯片封裝IC載板

新質(zhì)生產(chǎn)力材料 | 芯片封裝IC載板

芯片封裝的核心材料之IC載板
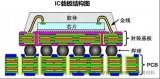
如何提升ASR模型的準(zhǔn)確性
如何使用SIP Layout建立PiP封裝結(jié)構(gòu)

AR如何大幅提升IC封裝廠檢測(cè)效率?






 如何建立準(zhǔn)確的IC封裝模型
如何建立準(zhǔn)確的IC封裝模型










評(píng)論