本文提出了基于濺射Ti/Pt/Cr和Cr/Pt/Cr金屬多層膜在熱王水中濕法腐蝕Pt薄膜的簡單制備方案,鉻(Cr)或鈦(Ti)用作鉑的粘附層,Cr在Pt蝕刻過程中被用作硬掩模層,因為它可以容易且精確地用光致抗蝕劑圖案化,并且能夠承受圖案被轉移到Pt中,然后去除Cr掩模,只需要標準化學品和潔凈室設備/工具,在王水蝕刻之前,鉑上的任何表面鈍化都需要去除,這通常通過在稀氫氟酸(HF)中快速浸泡來實現,HF通常也用于濕法蝕刻鈦粘附層,通過用氬(Ar)等離子體處理代替HF-dip并用基于過氧化氫(H2O2)的蝕刻劑蝕刻Ti層來避免在這兩個步驟中使用HF。
我們華林科納提出了一種更簡單的鉑薄膜圖案化方案,該方案基于Cr硬掩模層的使用,顯示出優異的特征分辨率,由于鉻不易被王水溶解,使用傳統的光刻技術將鉻掩模圖案化,用作鉑蝕刻的掩模,然后去除粘附層(Cr或Ti ),電隔離Pt電極,最后的Cr蝕刻步驟去除掩模層。該方法快速、可重復,并且不需要任何專門的設備。具有Ti或Cr作為永久粘附層、功能性Pt層和Cr作為臨時掩蔽層的多層被濺射到各種晶片襯底上,例如硼浮法玻璃(PlanOptik,德國)、具有天然氧化物的Si和具有200 nm SiO2的Si(SiMat,德國)。
在裝載之前,玻璃晶片在Piranha浴中清洗,硅晶片直接從密封的晶片盒中取出,在沉積之前,在壓力為4×103毫巴的氬(Ar)等離子體中,在200 W的Nordiko RFG 2500平行板RF濺射鍍膜機的室中,對所有晶片進行濺射清洗5分鐘。濺射清洗后,在不破壞真空的情況下,立即在相同的諾德科RFG 2500平行板RF濺射鍍膜機中沉積Cr/Pt/Cr多層膜(見圖1(a)),沉積72納米的鉻粘附層,接著沉積410納米的鉑層和72納米厚的鉻掩蔽層。
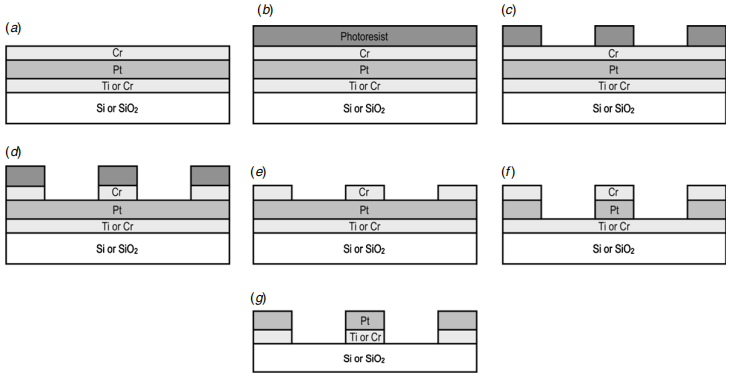
Ti/Pt/Cr層在兩次單獨的運行中沉積,因為該機器僅支持兩種不同的靶材料,首先沉積一層30納米的鈦,然后沉積410納米的鉑,在第二次運行中,在改變靶,再次抽真空至基礎真空,并在先前沉積的Pt層上進行短暫的樣品濺射清洗之后,沉積72 nm的Cr層,一次裝載一個晶片以提高厚度均勻性,如通過膠帶和劃痕試驗所證實的,所得金屬夾層顯示出對基底的優異粘附性,將800納米厚的Shipley S-1813 (Chestech,UK)抗蝕劑層旋涂到晶片上(見圖1(b))并軟烤,將晶片在掩模版中暴露于鉻掩模,然后在未稀釋的micro spot MF-319(Chestech,UK)中顯影,在硬烤抗蝕劑之前,在等離子體RIE中用短時間O2等離子體去渣步驟去除顯影區域中的抗蝕劑殘留物(見圖1(c)),通過將干晶片浸入新制備的CR-14等效蝕刻劑(22%硝酸鈰銨、9%乙酸和69%去離子水,按重量計),對Cr頂層進行濕法蝕刻(見圖1(d)),將晶片在丙酮中浸泡過夜,以剝離抗蝕劑掩模,在O2等離子體中清除任何殘留的抗蝕劑,必須去除由O2等離子體抗蝕劑剝離引起的Pt表面鈍化,這是通過在開始鉑蝕刻之前立即將晶片/鉑表面暴露于純氬等離子體來實現的(見圖1(e))。
為了獲得可重現的結果,應在使用前不久制備王水(HCl和HNO3的3:1混合物),在整個蝕刻過程中,將混合物保持在約60℃的加熱板上,混合后不久,王水開始冒泡并呈現深橙色,閑置時,用蓋子來防止燒杯中的水分蒸發,對于蝕刻,將晶片從Ar等離子體中取出,并立即浸入混合物中。在沒有攪動的情況下,將暴露的Pt層蝕刻185秒(見圖1(f)),最初,與Cr掩模層的較冷的銀金屬色相比,暴露的Pt層將具有較暖的金色,隨著蝕刻的進行,鉑層變得粗糙,而鉻層保持其鏡面光潔度,在使用Ti粘附層的樣品中,蝕刻終點在視覺上是明顯的,因為無光澤的淺灰色Pt在蝕刻區域中消失,并露出較暗的碳灰色Ti粘附層,在使用Cr粘附層的樣品中,當層之間不再有任何視覺對比時,達到終點,這些差異可以通過王水蝕刻溶液觀察到。
重要的是不要過早取出樣品檢查,因為這將導致Pt鈍化,并導致再次浸入蝕刻劑時蝕刻速率嚴重降低。從蝕刻劑中取出后,樣品用去離子水洗滌并用壓縮空氣干燥,最后一步是去除暴露的Ti粘附層和頂部Cr掩蔽層,以便暴露和電隔離Pt圖案,通過在氨(NH4OH)和過氧化氫(H2O2,30%)的1:2溶液中浸泡25秒來移除Ti粘附層,使用先前描述的CR14類似物蝕刻來移除Cr掩蔽層,由于不可能出現底切,因此將樣品放在蝕刻劑中超過2分鐘(見圖1(g)),對于Cr/Pt/Cr膜,Cr粘附層被選擇為與Cr掩模層具有相同的厚度,使得兩者都可以在一個步驟中以最小的底切被蝕刻掉,經過70秒后,終點明顯可見。
Pt層通常需要薄的粘附層,例如Cr、Ti、Ta、Ti/W,對于Cr/Pt/Cr膜,兩個Cr層應該選擇為具有相同的厚度,以在去除Cr掩蔽層期間最小化Cr粘附層的任何欠蝕刻,選擇相同的Cr厚度還有一個額外的優點,即當頂部Cr掩蔽層被去除時,更容易檢測,如果襯底是玻璃晶片,這是特別容易的,因為薄Cr層和純玻璃晶片之間的對比是容易檢測的,如果在隨后的深硅蝕刻中需要的話,Cr粘附層也可以承受KOH蝕刻,用Ti粘附層代替Cr粘附層具有其他優點,Ti是高溫應用(高達600°C)的更好選擇。
Ti充當擴散阻擋層并防止向例如硅襯底的相互擴散,反之亦然,在最終去除頂部Cr掩蔽層的過程中,Ti粘附層不會受到侵蝕,因此可以獨立于Cr厚度來選擇其厚度,在這種情況下,應該選擇具有大約30 nm的典型粘附層厚度的Ti,這再次導致Ti的較低欠蝕刻,從而允許蝕刻更精細的Pt特征,圖2顯示了Ti/Pt/Cr夾層結構的典型蝕刻結果,具有清晰、明確的結構,EDX圖與SEM相匹配,并確認Cr硬掩模已被完全移除,從而露出了Pt表面,Pt結構具有極好的表面質量,沒有凹坑或針孔,雖然鉻會溶解在稀HCl中,但它適合作為在濃王水中濕法蝕刻鉑的掩蔽材料,因為鉻表面會被強無機酸鈍化,而鉑會被過程中產生的新生氯蝕刻。

無論在樣品上使用多短時間的O2等離子體清洗,都會導致Pt表面鈍化,如果沒有隨后的Ar等離子體步驟,樣品就不能在王水中蝕刻,即使在王水中放置相當長的時間,如果放置很長時間,將導致蝕刻逆轉(在80分鐘或更長時間后觀察到),因為Crmasking層將最終被去除,并且下面的未鈍化Pt將被蝕刻。在這種情況下,鉻蝕刻的開始可能與王水的分解有關,王水的分解導致氯、亞硝酰氯和一氧化氮的釋放,隨著時間的推移有效地稀釋了酸,然而很難去除抵抗殘留獲得一個真正干凈的表面沒有使用O2等離子體步驟,這反過來會鈍化整個樣品,在蝕刻過程中,蝕刻以實現最小的掩模抬升,從而實現最小的欠蝕刻,用于圖案化頂部Cr層的抗蝕劑掩模在鉑蝕刻之前在氧化硅中被去除,人們發現,當被留在硅片上時,硅片通常會很快被熱王水腐蝕并剝離,漂浮的抗蝕劑殘余物會隨機掩蓋區域,并留下不可預測的、不干凈的蝕刻結果,因此最好在鉑蝕刻步驟之前將其完全剝離。
Ti/Pt/Cr夾層方法產生良好的特征清晰度,邊緣清晰,在晶片上可靠蝕刻的最小特征尺寸是5 微米,然而,我們還沒有進一步研究用本工藝可達到的最小特征尺寸。
與較小結構相比,較大結構的欠蝕刻較小,這可能是由于蝕刻劑耗盡,有更多的鉑可用于蝕刻,這也可以解釋在彎曲Pt軌跡的內側和外側邊緣看到的不同蝕刻,更容易在圖2(a)中看到。使用Cr/Pt/Cr成功蝕刻的最小特征明顯更大(大約。25微米),測量了72納米厚的Cr粘附層中高達8微米(任一側)的底切,如前所述,Cr掩模層和Cr粘附層被同時去除,因此,通過完全去除頂部Cr掩模層來確定蝕刻時間,這與鉑和鉻之間的原電池效應相結合,可以解釋觀察到的大的鉻粘附層底切,沒有對協議進行進一步的優化。
所獲得的特征尺寸對于MEMS以及芯片實驗室設備是有用的,尤其是對于原型工作,持續蝕刻較小的特征尺寸將需要更嚴格的工藝控制,從產量角度來看,干法蝕刻較小的特征可能是最好的,為了獲得良好的濕法蝕刻結果,尤其是小特征,晶片上的厚度分布應盡可能小的變化,當一次濺射一個晶片的Pt多層時,獲得了最好的結果,該晶片位于襯底支架的中心,而不是一次濺射多個晶片。
提出了一種用于Pt濕法蝕刻的簡化方法,該方法不需要使用除了基本MEMS實驗室中可用的設備之外的任何設備,該技術僅需要沉積一層額外的鉻層,該鉻層通過光刻形成圖案,并用作氧化鉑蝕刻的硬掩模。
研究了Cr/Pt/Cr和Ti/Pt/Cr多層膜,使用72 nm厚的Cr硬掩模在410 nm Pt中圖案化各種特征尺寸,低至10微米線(掩模尺寸),因此,在較薄的Pt層中也應該能夠蝕刻低至10微米特征(掩模尺寸),各種工藝參數和各種層厚度的優化可進一步提高可實現的最小特征尺寸,72 nm厚的Cr層能夠承受王水約80分鐘,而410 nm的Pt層的蝕刻時間約為3分鐘,因此,這種厚度的Cr硬掩模可能允許較厚的Pt層的圖案化,反之亦然,較薄的Cr掩模層可以成功地用于圖案化高達400nm的Pt層。
-
薄膜
+關注
關注
0文章
309瀏覽量
32058 -
蝕刻
+關注
關注
10文章
424瀏覽量
15990
發布評論請先 登錄
使用n型GaSb襯底優化干法和濕法蝕刻工藝

硅濕法蝕刻中的表面活性劑

濕法蝕刻工藝的原理
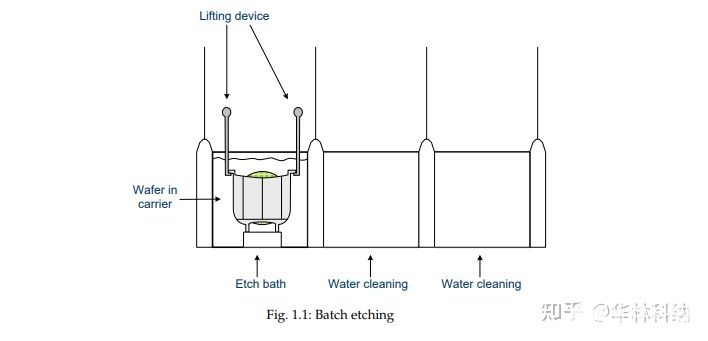
濕法蝕刻工藝
《炬豐科技-半導體工藝》GaN、ZnO和SiC的濕法化學蝕刻
ITO薄膜濕法刻蝕研究






 用于Pt濕法蝕刻的鉑薄膜圖案化方案
用于Pt濕法蝕刻的鉑薄膜圖案化方案
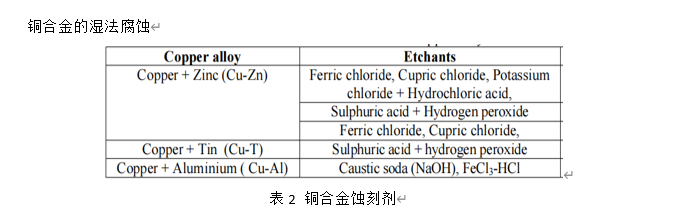












評論