在20nm 工藝節(jié)點(diǎn)之后,傳統(tǒng)的平面浮柵 NAND 閃速存儲器因受到鄰近浮柵 -浮柵的耦合電容干擾而達(dá)到了微縮的極限。為了實(shí)現(xiàn)更高的存儲容量,NAND集成工藝開始向三維堆疊方向發(fā)展。在三維NAND 存儲單元中,電荷的存儲層可以是浮柵或氮化硅電荷俘獲層(Charge-Trapping Layer, CTL)。三維CTL垂直溝道型NAND 閃存(3D NAND 或 V-NAND)基于無結(jié)型 (Junctionless, JL)薄膜場效應(yīng)晶體管(TFT),具有更好的可靠性。
目前,國際上主流的 3D NAND 產(chǎn)品是韓國三星電子研發(fā)出來的,2013 年第一代產(chǎn)品(32~64Gbit)有24層堆疊的存儲單元,2014 年第二代產(chǎn)品 (128Gbit)有 32層,2015 年第三代產(chǎn)品(256Gbit) 有48層,64層產(chǎn)品于 2017 年量產(chǎn),128 層存儲單元的3D NAND 產(chǎn)品目前已研發(fā)完成并量產(chǎn)。
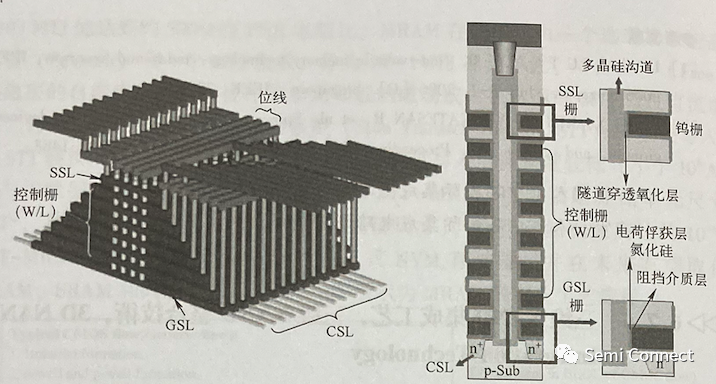
上圖所示為3D NAND 閃存器件結(jié)構(gòu)示意圖。圖中,底層的選通晶體管(CSL/GSI)為反型晶體管,其余每個(gè)存儲單元的晶體管均為無結(jié)型薄膜晶體管(JL-TFT)。在晶體管關(guān)閉時(shí),多晶硅薄膜溝道處于全耗盡狀態(tài),開關(guān)電流比大于10^6。存儲層采用的是基于紙化硅的高陷阱密度材料(電子/空穴在存儲層中的橫向擴(kuò)散會降低 3D NAND 的可靠性)。電荷存儲單元之間的耦合效應(yīng)低。寫入 / 擦除操作分別使用電子和空穴的 FN 隧道穿透,隧道穿透層通常是基于氧化硅和氮氧化硅疊層材料結(jié)構(gòu)的,阻擋層采用氧化硅或氧化鋁等材料 (目的是降低柵反向注入)。3D NAND 存儲單元的存儲性能優(yōu)異,具有寫入 / 擦除快速,存儲窗口大于 6V ,存儲寫入 / 擦除次數(shù)大于 10^4,以及在 85°C 下數(shù)據(jù)保持能力可達(dá)10年等優(yōu)勢。
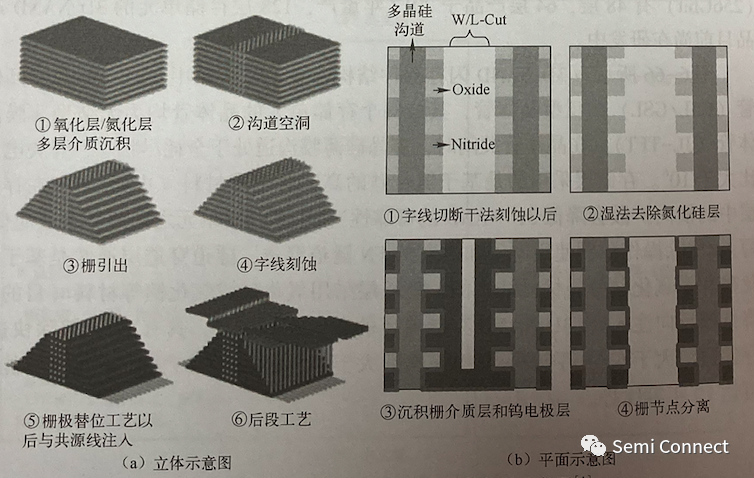
上圖所示為 3D NAND 閃存器件制造工藝流程示意圖。在完成 CMOS的源漏之后,開始重覆沉淀多層氧化硅/氮化硅,然后進(jìn)行光刻和溝道超深孔刻蝕(深寬比大于30:1),沉淀高質(zhì)量的多晶硅薄膜和溝道深孔填充并形成柵襯墊陣列(Gate Pad)。接下來進(jìn)行光刻和字線刻蝕 一 離子注入形成 CSL 線 一 濕法去除氮化硅 一 沉淀柵介質(zhì)和電荷俘獲 ONO 薄膜(其特點(diǎn)是厚度和組分均勻,溝道 - 介質(zhì)界面缺陷密度低) 一 沉積鎢薄膜作為柵極,并刻蝕鎢以分開字線。完成上述工藝后,繼續(xù)進(jìn)行 BEOL 工藝。
審核編輯:湯梓紅
-
NAND
+關(guān)注
關(guān)注
16文章
1719瀏覽量
137894 -
存儲器
+關(guān)注
關(guān)注
38文章
7639瀏覽量
166623 -
工藝
+關(guān)注
關(guān)注
4文章
677瀏覽量
29297 -
晶體管
+關(guān)注
關(guān)注
77文章
9993瀏覽量
140918 -
三維
+關(guān)注
關(guān)注
1文章
517瀏覽量
29386
原文標(biāo)題:三維NAND 集成工藝(3D-NAND Integration Technology)
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
3D NAND良率是NAND Flash市場最大變數(shù)

NAND型三維多層1TXR阻變存儲器設(shè)計(jì)

Allwinner Technology Nand Flash Support List
2017年NAND產(chǎn)能成長有限、價(jià)格走揚(yáng)
美光與英特爾合作伙伴關(guān)系將終止 因3D-NAND不符合目前市場
Sean Kang介紹未來幾年3D-NAND的發(fā)展線路圖,2021年堆疊層數(shù)會超過140層,而且會不斷變薄
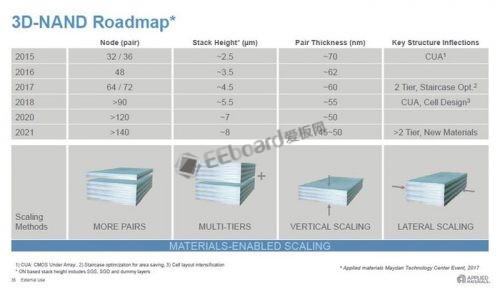
3D工藝的轉(zhuǎn)型步伐較慢,NAND閃存依然處于供給吃緊的狀態(tài)
半導(dǎo)體行業(yè)3D NAND Flash
三星、美光3D-NAND Flash產(chǎn)出比重已逾50%
未來的3D NAND將如何發(fā)展?
未來的3D NAND將如何發(fā)展?如何正確判斷一款3D NAND的總體效率?
什么是3D NAND閃存?
3D-NAND 閃存探索將超過300層
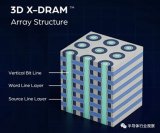
3D-NAND浮柵晶體管的結(jié)構(gòu)解析






 詳解三維NAND集成工藝(3D-NAND Integration Technology)
詳解三維NAND集成工藝(3D-NAND Integration Technology)










評論