三維封裝技術(shù)是指在二維封裝技術(shù)的基礎(chǔ)上,進(jìn)一步向垂直方向發(fā)展的微電子組裝技術(shù)。三維封裝的形式主要分為填埋型三維封裝、有源基板型三維對(duì)裝和疊層型三維封裝。
填埋型三維封裝是將元器件填埋在基板多層布線內(nèi),或者填埋、制作在基板內(nèi)部,以達(dá)到實(shí)現(xiàn)系統(tǒng)集成、功能模塊化的一種新型封裝方式。有源基板型三維封裝采用硅圓片集成技術(shù),在制作基板時(shí),先采用一般半導(dǎo)體集成電路制作方法進(jìn)行一次元器件集成化,形成有源基板;然后再實(shí)施多層布線,并將表面組裝元件與表面組裝器件貼在最上層,從而實(shí)現(xiàn)有源基板型三維封裝。
疊層型三維封裝是將兩個(gè)或多個(gè)裸芯片或已經(jīng)封裝的芯片在垂直方向上、下多層互連,然后再進(jìn)行封裝形成三維結(jié)構(gòu)。三維封裝(引線鍵合與倒裝芯片)如下圖所示。
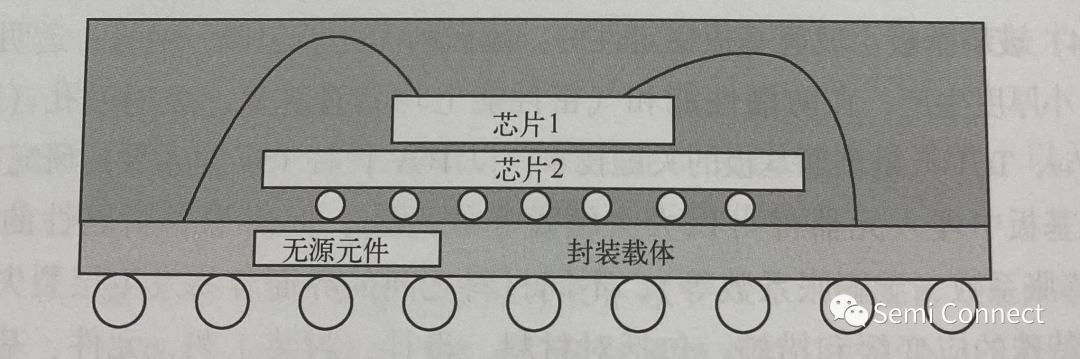
與傳統(tǒng)的二維封裝技術(shù)相比,三維封裝技術(shù)具有提高封裝密度、減小封裝尺寸、提高信號(hào)傳輸速度、降低功耗和噪聲、實(shí)現(xiàn)產(chǎn)品多功能化等特點(diǎn)。
三維互連的方法主要包括引線鍵合、倒裝芯片、硅通孔(TSV)、薄膜導(dǎo)線等。其中,ISV 技術(shù)可實(shí)現(xiàn)芯片與芯片之間垂直方向上的互連,不需要引線鍵合,可以有效縮短互連線長(zhǎng)度,減小信號(hào)傳輸延遲和損失,提高信號(hào)傳輸速度
在三維封裝中,由于封裝密度增加、體積減小,造成熱流密度大幅度提高.因此如何解決散熱問(wèn)題成為重中之重。一般可以通過(guò)使用低熱阻基板和高熱傳性能封裝材料、使用冷卻方法為三維器件降溫,在疊層元件之間使用導(dǎo)熱通孔將內(nèi)部的熱量散至表面的方法來(lái)解決散熱問(wèn)題。
另外,在基板內(nèi)埋人熱膨賬系數(shù)不同的芯片會(huì)產(chǎn)生更為復(fù)雜的應(yīng)力,需要采取特殊的應(yīng)變緩和措施,因此應(yīng)該對(duì)設(shè)計(jì)、封裝工藝、元件、基板的結(jié)構(gòu)變化、封裝設(shè)備、測(cè)量及檢查、返修及元件的三維布置等進(jìn)行綜合研究開發(fā)。
2014 年,三維封裝技術(shù)已經(jīng)應(yīng)用于內(nèi)存芯片封裝(包括大容量?jī)?nèi)存芯片堆疊)和高性能芯片的消費(fèi)電子產(chǎn)品中。到了2015年,三維封裝技術(shù)已經(jīng)開始應(yīng)用于一些高端的 CPU、GPU 及網(wǎng)絡(luò)芯片中。現(xiàn)在,三維扇出 (蘋果處理器)和采用硅通孔的三維集成(包括因像傳感器、指紋傳感器)器件均已實(shí)現(xiàn)量產(chǎn)。
隨著三維封裝技術(shù)的不斷提高,輕薄化、高密度是未來(lái)的重要發(fā)展方向。未來(lái),這一先進(jìn)的封裝技術(shù)將被廣泛應(yīng)用于各個(gè)領(lǐng)城,包括尖端科技產(chǎn)品和眾多消費(fèi)類電子產(chǎn)品等。
審核編輯:劉清
-
傳感器
+關(guān)注
關(guān)注
2560文章
52146瀏覽量
761322 -
gpu
+關(guān)注
關(guān)注
28文章
4880瀏覽量
130342 -
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
565瀏覽量
68331 -
TSV
+關(guān)注
關(guān)注
4文章
119瀏覽量
81781
原文標(biāo)題:三維封裝,三維封裝,3D Package
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
高通和英特爾介紹用在移動(dòng)SOC的TSV三維封裝技術(shù)
光學(xué)三維測(cè)量技術(shù)的各種實(shí)現(xiàn)方法及原理
三維封裝工藝流程與技術(shù)
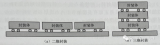
三維逆向工程的成果及應(yīng)用案例
三維觸控技術(shù)突破“二向箔”的束縛
三維快速建模技術(shù)與三維掃描建模的應(yīng)用
廣西掃描服務(wù)三維檢測(cè)三維掃描儀
三維設(shè)計(jì)應(yīng)用案例
三維立體數(shù)字沙盤是是什么?
上海黃浦三維媒體動(dòng)畫技術(shù)
三維人臉建模技術(shù)分析及應(yīng)用
蔡堅(jiān):封裝技術(shù)正在經(jīng)歷系統(tǒng)級(jí)封裝與三維集成的發(fā)展階段
基于三維集成技術(shù)的紅外探測(cè)器
泰來(lái)三維|文物三維掃描,文物三維模型怎樣制作






 三維封裝技術(shù)介紹
三維封裝技術(shù)介紹










評(píng)論