近年來,半導體公司面臨更復雜的高集成度芯片封裝的挑戰,消費者希望他們的電子產品體積更小,性能參數更高,功耗更低,并將更多功能集成到單部設備中。半導體封裝工藝的提升,對于解決這些挑戰具有重要意義。當前和未來的芯片封裝工藝,對于提高系統性能,增加使用功能,降低系統功耗、縮小外形尺寸的要求,需要一種被稱為系統集成的先進封裝方法。
系統集成封裝(System in Package)可將多個集成電路 (IC) 和元器件組合到單個系統或模塊化系統中,以實現更高的性能,功能和處理速度,同時大幅降低電子器件內部的空間要求。
本系列將分為工藝技術、軟件平臺、質量管理、先進封裝等章節,內容會持續更新,謝謝。
SiP概念
SiP的基本定義
SiP封裝(System In Package系統級封裝)是將多種功能芯片,包括處理器、存儲器等功能芯片集成在一個封裝內,從而實現一個基本完整的功能,與SOC(System On Chip系統級芯片)相對應。不同的是SiP是采用不同功能的芯片在基板上進行并排或疊構后組成功能系統后進行封裝。而SOC則是將所需的組件高度集成在一塊芯片上進行封裝。
SiP主流的封裝結構形式
SiP主流的封裝形式有可為多芯片模塊(Multi-chipModule;MCM)的平面式2D封裝,2D封裝中有Stacked Die Module、Substrate Module、FcFBGA/LGA SiP、Hybrid(flip chip+wirebond)SiP-single sided、Hybrid SiP-double sided、eWLB SiP、fcBGA SiP等形式;2.5D封裝中有Antenna-in-Package-SiP Laminate eWLB、eWLB-PoP&2.5D SiP等形式;3D結構是將芯片與芯片直接堆疊,可采用引線鍵合、倒裝芯片或二者混合的組裝工藝,也可采用硅通孔技術進行互連。
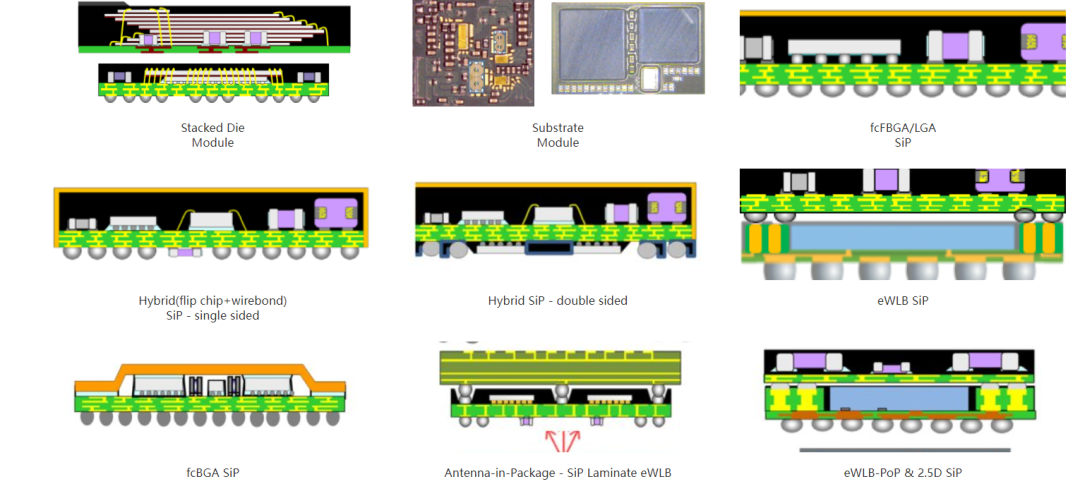
構成SiP技術的要素是封裝載體與組裝工藝。前者包括基板,LTCC,SiliconSubmount(其本身也可以是一塊IC)。后者包括傳統封裝工藝(Wirebond和FlipChip)JI和SMT設備。無源器件是SiP的一個重要組成部分,其中一些可以與載體集成為一體(Embedded,MCM-D等),另一些(精度高、Q值高、數值高的電感、電容等)通過SMT組裝在載體上。
SiP的主流封裝形式是BGA。就目前的技術狀況看,SiP本身沒有特殊的工藝或材料。這并不是說具備傳統先進封裝技術就掌握了SiP技術。由于SiP的產業模式不再是單一的代工,模塊劃分和電路設計是另外的重要因素。模塊劃分是指從電子設備中分離出一塊功能,既便于后續的整機集成又便于SiP封裝。
| 序號 | 類型 | 描述 |
|---|---|---|
| 1 | 2D SiP | 在同一個封裝基板上將芯片一個挨一個的排列以二維的模式封裝在一個封裝體內 |
| 2 | 2.5DSiP | 在一個封裝中采用物理的方法將兩個或多個芯片堆疊整合起來進行封裝。 |
| 3 | 3D SiP | 在2D封裝的基礎上,把多個裸芯、封裝芯片、多芯片甚至圓片進行疊層互聯,構成立體封裝,這種結構也稱作疊層型3D封裝。 |
(表1:SiP的分類)
SiP的應用領域
| 序號 | 應用領域 | 詳細描述 |
|---|---|---|
| 1 | 汽車電子 | 汽車電子里的SiP應用以發動機控制單元(ECU)舉例,ECU由微處理器(CPU)、存儲器(ROM、RAM)、輸入/輸出接口(I/O)、模數轉換器(A/D)以及整形、驅動等大規模集成電路組成。各類型的芯片之間工藝不同,目前較多采用SiP的方式將芯片整合在一起成為完整的控制系統 |
| 2 | 醫療電子 | 該領域的典型應用為可植入式電子醫療器件,比如膠囊式內窺鏡。內窺鏡由光學鏡頭、圖像處理芯片、射頻信號發射器、天線、電池等組成。 |
| 3 | GUP | SiP在計算機領域的應用主要來自于將處理器和存儲器集成在一起。 |
| 4 | 消費類電子 | 包括了ISP(圖像處理芯片)、藍牙芯片等。 |
| 5 | 藍牙系統 | 一般由無線部分、鏈路控制部分、鏈路管理支持部分和主終端接口組成,SiP技術可以使藍牙做得越來越小迎合了市場的需求,從而大力推動了藍牙技術的應用。 |
| 6 | 軍工電子 | SiP技術順應了軍事電子的應用需求涉及了衛星、運載火箭、飛機、導彈、雷達、巨型計算機等軍事裝備,最具典型性的應用產品是各種頻段的收發組件。 |
| 7 | 智能手機 | 手機中的RFPA是最常用SiP形式的。 |
(表2:SiP應用領域分類)
SiP與SoC封裝特性比對
| 定義 | Soc特性 | SiP特性 |
|---|---|---|
| 效率 | 一個芯片就是一個系統 | 系統集成的各功能芯片及無源器件 |
| 工藝 | 受材料、IC不同工藝限制 | 在基板上裝配 |
| 兼容性 | 更高的密度,更高速 | 可集成各種工藝的元件,如射頻器件,RLC等 |
| 難點 | Die尺寸較大 | 測試較復雜 |
| 成本 | 較高的開發成本 | 較低的開發成本 |
| 上市周期 | 開發周期長,良率較低 | 開發周期短,良率較高 |
| 摩爾定律 | 摩爾定律發展方向 | 超越了摩爾定律發展方向 |
(表3:SiP封裝與Soc特性對比)
| 序號 | 優勢 | 描述 |
|---|---|---|
| 1 | 封裝效率高 | SiP封裝技術在同一封裝體內加多個芯片,大大減少了基板中芯片外圍電路的面積,面相更小型化,高密度的基板設計。 |
| 2 | 產品上市周期短 | 由于SiP封裝不同于Soc,無需版圖級布局布線,從而減少了設計、驗證和調試的復雜性,縮短了系統實現的時間。即使需要局部的改動設計也比Soc要簡單容易得多。 |
| 3 | 兼容性佳 | SiP封裝將不同的工藝、材料制作的芯片封成一個系統,可實現嵌入集成化無源元件,無線電和便攜式電子產品中的無源元件至少可被嵌入30-50%,甚至可將Si、GaAs、InP等材料的的芯片組合后進行一體化封裝。 |
| 4 | 系統成本低 | SiP可提供低功耗和低噪聲的系統級設計,在較高的頻率下工作可獲得較寬的帶寬。一個專用的集成電路系統,采用SiP封裝技術可比Soc節省更多的系統設計和生產費用。 |
| 5 | 物理尺寸小 | SiP封裝體的厚度不斷減少,最先進的技術可實現五層堆疊芯片只有1.0mm厚的超薄封裝。 |
| 6 | 電性能高 | SiP封裝技術可以使多個封裝器件在一個SiP系統中整合,可使總的焊點大為減少。也可以顯著減小封裝體積、重量。縮短元件的連接路線,從而使電性能得以提高。 |
| 7 | 低功耗 | SiP封裝可提供低功耗、低噪音的系統級連接,在較高的頻率下工作可獲得幾乎與Soc相等的匯流排寬度。 |
| 8 | 穩定性好 | SiP封裝具有良好的抗摔及抗腐蝕能力,具有高可靠性,借助EMI電磁屏蔽技術,可用于航空航天等復雜電磁場領域。 |
| 9 | 應用廣泛 | 與傳統芯片封裝不同,SiP封裝不僅可以處理數字系統,還可以應用于光通信、傳感器以及微機電MEMS等領域。 |
(表4:SiP封裝的優勢)
SiP工藝技術難點
清洗
定制清洗設備、清洗溶液要求、清洗參數驗證、清洗標準制定;
植球
植球設備選擇、植球球徑大小、球體共面性檢查、BGA測試、助焊劑殘留要求等;
基板
陶瓷基板的設計及驗證難度高,工藝難度高,加工成本高;
有機基板的導熱性差,容易導致IC焊接處電氣鏈接失效。
SiP封裝工藝介紹
SiP封裝技術采取多種裸芯片或模塊進行排列組裝,若就排列方式進行區分可大體分為平面式2D封裝和3D封裝的結構。相對于2D封裝,采用堆疊的3D封裝技術又可以增加使用晶圓或模塊的數量,從而在垂直方向上增加了可放置晶圓的層數,進一步增強SiP技術的功能整合能力。而內部接合技術可以是單純的線鍵合(Wire Bonding),也可使用覆晶接合(Flip Chip),也可二者混用。
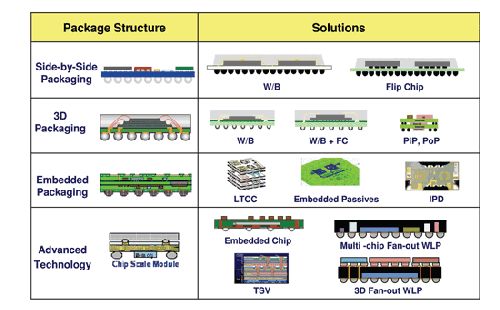
目前世界上最先進的3D SiP 采用 Interposer(硅基中介層)將裸晶通過TSV(硅穿孔工藝)與基板結合。先進封裝篇詳細介紹。
SiP封裝工藝流程
與SiP相關的Wire Bond 、FC、SMT工藝流程如下圖:

**Wire Bond工藝流程圖
**

FC工藝流程圖

SMT工藝流程圖
通常當Wire Bond 封裝中需要對SMT器件進行貼裝時,在置晶前完成四道工序:基板烘烤→錫膏印刷→表面貼裝→回流焊;
通常當FC封裝中需要對SMT器件進行貼裝時,在倒裝芯片鍵合后,進行貼裝,并完成回流焊工序。

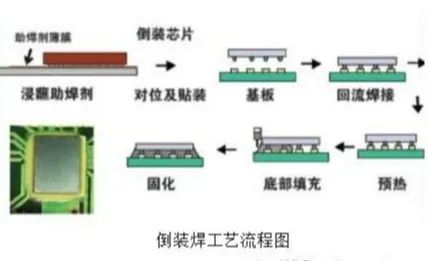
SiP封裝基板
半導體芯片封裝基板是封裝測試環境的關鍵載體,SiP封裝基板具有薄形化、高密度、高精度等技術特點,為芯片提供支撐,散熱和保護,同時提供芯片與基板之間的供電和機械鏈接。
基板的分類
封裝基板的分類有很多種,目前業界比較認可的是從增強材料和結構兩方面進行分類。
結構分類:剛性基板材料和柔性基板材料。
增強材料分類:有有機系(樹脂系)、無機系(陶瓷系、金屬系)和復合系
基板的處理
基板表面處理方式主要有:熱風整平、有機可焊性保護涂層、化學鎳金、電鍍金。
化學鎳金:
化學鎳金是采用金鹽及催化劑在80~100℃的溫度下通過化學反應析出金層的方法進行涂覆的,成本比電鍍低,但是難以控制沉淀的金屬厚度,表面硬并且平整度差,不適合作為采用引線鍵合工藝封裝基板的表面處理方式。
電鍍鎳金:
電鍍是指借助外界直流電的作用,在溶液中進行電解反應,是導電體(例如金屬)的表面趁機金屬或合金層。電鍍分為電鍍硬金和軟金工藝,鍍硬金與軟金的工藝基本相同,槽液組成也基本相同,區別是硬金槽內添加了一些微量金屬鎳或鈷或鐵等元素,由于電鍍工藝中鍍層金屬的厚度和成分容易控制,并且平整度優良,所以在采用鍵合工藝的封裝基板進行表面處理時,一般采用電鍍鎳金工藝,鋁線的鍵合一般采用硬金,金線的鍵合一般都用軟金。
-
處理器
+關注
關注
68文章
19714瀏覽量
232732 -
存儲器
+關注
關注
38文章
7606瀏覽量
165856 -
soc
+關注
關注
38文章
4297瀏覽量
220977 -
sip封裝
+關注
關注
4文章
66瀏覽量
15657 -
功能芯片
+關注
關注
0文章
2瀏覽量
3592
發布評論請先 登錄
相關推薦





 SiP主流的封裝結構形式
SiP主流的封裝結構形式











評論