窄跡晶圓的特性
在晶圓切割環節中,經常遇到的較窄跡道(street)晶圓,要求將每一次切割放在跡道中心幾微米范圍內。雖然目前有激光切割、等離子切割等方式,理論上可以實現窄跡晶圓的切割,但是考慮到技術成熟度不高、適用產品范圍小、設備價格高等方面因素,應用金剛石劃片刀仍是最優的選擇。這就要求切割設備具備更高的精度和更先進的對準運算,以及厚度盡可能薄、剛性更強的刀片。
當切割窄跡道晶圓時,常見的一種推薦是,選擇盡可能最薄的刀片。但是,很薄的刀片是非常脆弱的,更容易過早破裂和磨損,結果,其壽命期望和工藝穩定性都比較厚的刀片差。這對刀片品質以及合適的切割方案有較高的要求。
一般對于50~76μm跡道的晶圓推薦厚度為20~30μm的刀片,40~50μm跡道的晶圓推薦厚度為15~20μm的刀片。
案例實錄
?
測試目的
1、測試切痕寬度
2、測試切割品質

?
材料情況
切割產品 | mos晶圓 |
產品尺寸 | 8寸 |
產品厚度 | 200μm |
膠膜類型 | UV膜 |
?
工藝參數
切割工藝 | 單刀切透 |
設備型號 | DAD322 |
主軸轉速 | 26K rpm |
進刀速度 | 30mm/s |
刀片高度 | CH1:0.055 |
?
樣刀準備
SSTYE SD-4000-R-50-CBA
?
樣刀規格

刀片型號 | 4000-R-50 CBA |
金剛石粒度 | 4000# |
結合劑硬度 | R(硬) |
集中度 | 50 |
刀片厚度 | 0.018mm |
?
測試結果
1、切痕寬度在21~22.3μm之間,切痕
穩定,符合工藝要求。
2、正面無明顯崩邊。


刀痕效果 崩邊效果
西斯特科技
深圳西斯特科技有限公司 (簡稱西斯特SST) ,以“讓一切磨削加工變得容易”為主旨,倡導磨削系統方法論,2015年金秋創立于深圳,根植于技術創新的精神,屹立于創造價值、追求夢想的企業文化。
基于對應用現場的深度解讀、創新性的磨具設計和磨削系統方法論的實際應用,西斯特秉承先進的磨削理念,踐行于半導體、消費電子、汽車零部件等行業,提供高端磨具產品以及“切、磨、鉆、拋”系統解決方案,在晶圓與封裝基板劃切、微晶玻璃和功能陶瓷磨削、汽車零部件精密磨削等領域應用廣泛。
西斯特科技始終以先進的技術、創新的產品、優質服務的理念,引領產業革命,創造無限可能。
-
晶圓
+關注
關注
53文章
5165瀏覽量
129821
發布評論請先 登錄
淺切多道切割工藝對晶圓 TTV 厚度均勻性的提升機制與參數優化






 案例分享第八期:窄跡晶圓切割實例
案例分享第八期:窄跡晶圓切割實例



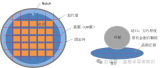











評論