摻雜少量鉑元素的鎳硅化物的穩(wěn)定性也不盡相同,還與物質(zhì)的具體結(jié)構(gòu)有關,舉個例子來說,NiPtSi,比NiSi要穩(wěn)定。
填充了接觸溝槽的鎢被研磨到金屬柵極的同一平面,如下圖e)所示。
由于接觸溝槽只與凸起的源/漏極接觸,所以接觸溝槽深度很淺,這樣使得過刻蝕的控制簡單。
從版圖的角度考慮,代替了圓形和橢圓形接觸孔的溝槽式接觸,簡化了光刻膠圖形化過程。
但是一項技術(shù)的改革往往會帶來一些新的問題,比如說,這會在接觸刻蝕中,過刻蝕到STI氧化層而導致W尖刺問題。
由于鎢栓塞的長度顯著縮短,所以栓塞的電阻大大降低(因為電阻的值與長度為正比關系)。
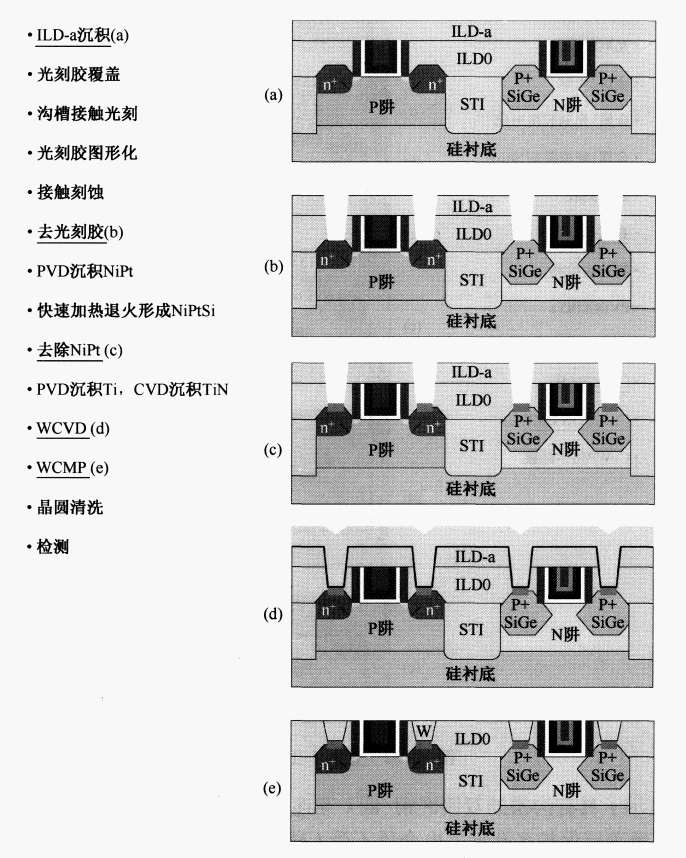
在下面的結(jié)構(gòu)圖中顯示了金屬1(M1)的形成工藝過程。
在這個過程當中,該工藝使用了覆蓋在TEOS上的硬掩膜TiN保護了多孔低h介質(zhì)不受光刻膠去除工藝過程的損傷。
多孔低k電介質(zhì)的化值(2.2?2.5)通常比碳硅酸鹽玻璃的么值(CSG,k為2.7~2.9)低。
多孔低k電介質(zhì)可以通過PECVD摻碳氧化硅電介質(zhì)形成,通過將摻雜的濃度進行相應的精確控制,可以保證其中含有小于2nm的孔和高達40%的孔隙度。這些是在CVD時通過在氣流中加入致孔劑實現(xiàn)的。
CVD預沉積,可以是三甲基硅烷或四甲基硅烷,致孔劑可以是冰片烯或a-松油烯。
鉭阻擋層和銅籽晶層通過具有金屬離化等離子體PVD工藝獲得。
由于銅的沉積量非常大,所以傳統(tǒng)的方法已經(jīng)不再適用了,所以大量的銅沉積利用化學電鍍(ECP)工藝。
在經(jīng)過銅退火工藝后,利用金屬CMP去除不需要的銅、鉭阻擋層和TiN硬掩膜CMP研磨停止于TEOS覆蓋層,這樣可以保護多孔低k電介質(zhì)不受CMP漿料的污染。

下圖顯示了具有溝槽的雙鑲嵌銅/低k互連工藝。
通常金屬硬掩膜TiN、TEOSPECVD氧化物或TEOS覆蓋層保護多孔低k電介質(zhì)不受CMP漿料的污染。
因為這樣相當于在多孔低k電介質(zhì)的外表面加上了幾層的保護膜,今兒產(chǎn)生了一個相對穩(wěn)定的小環(huán)境。
并且在此基礎上,可以利用自對準CoWP化學電鍍的技術(shù)來防止銅的擴散并提高電遷移抵抗能力,通過這種技術(shù)從而提高了IC芯片的可靠性。
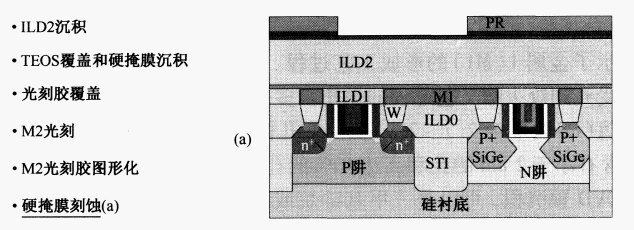

下圖顯示了從M3金屬層(見下圖(a))到M9金屬層(見下圖(c))的銅/低k互連工藝過程。該過程基本上是下圖所示的通孔工藝過程的重復。
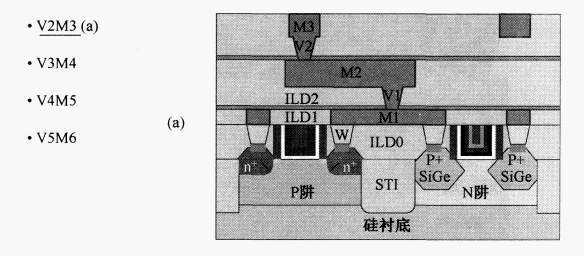
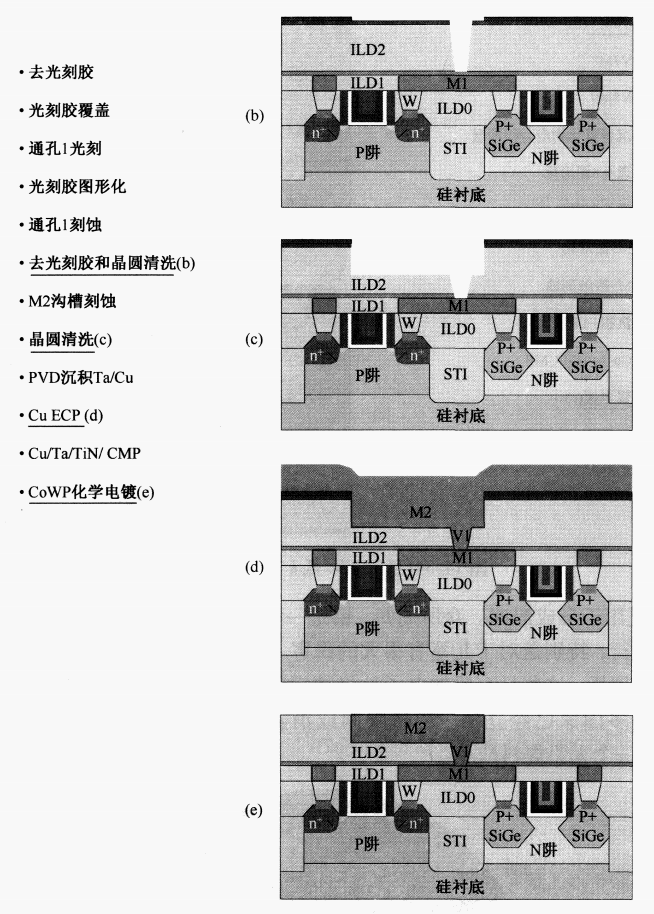
鉛(Pb)廣泛用于形成焊球。眾所周知,鉛是一種污染物,可以影響心臟、骨骼、腸、腎和神經(jīng)系統(tǒng)的正常運行,特別是對于兒童有很大的傷害。
大量使用IC芯片的過時電子儀器形成每年萬噸級的電子垃圾,這些具有鉛的電子垃圾填埋給環(huán)境污染帶來潛在風險,因此,像日本、歐洲和中國等許多國家已經(jīng)立法,嚴格限制或消除鉛在半導體和所有電子行業(yè)中的使用。下圖顯示了一個無鉛焊料凸點。
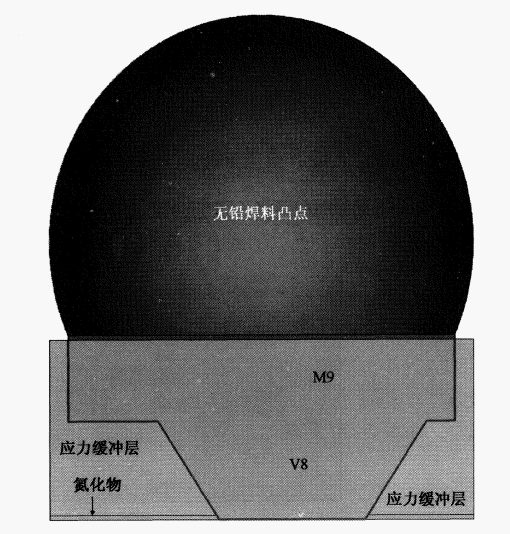
審核編輯:劉清
-
接觸器
+關注
關注
63文章
1212瀏覽量
65923 -
CMP
+關注
關注
6文章
154瀏覽量
26551 -
光刻機
+關注
關注
31文章
1163瀏覽量
48095 -
IC芯片
+關注
關注
8文章
255瀏覽量
26979 -
ICT技術(shù)
+關注
關注
0文章
44瀏覽量
10343
原文標題:半導體行業(yè)(二百)之ICT技術(shù)(十)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
Futurrex高端光刻膠
光刻膠殘留要怎么解決?
Microchem SU-8光刻膠 2000系列
光刻膠
光刻膠在集成電路制造中的應用
光刻膠有什么分類?生產(chǎn)流程是什么?
光刻膠的原理和正負光刻膠的主要組分是什么
光刻膠黏度如何測量?光刻膠需要稀釋嗎?
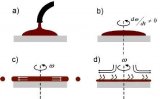
關于光刻膠的關鍵參數(shù)介紹

光刻膠的保存和老化失效
光刻膠剝離液及其制備方法及白光干涉儀在光刻圖形的測量

減少光刻膠剝離工藝對器件性能影響的方法及白光干涉儀在光刻圖形的測量






 如何簡化光刻膠圖形化過程呢?
如何簡化光刻膠圖形化過程呢?

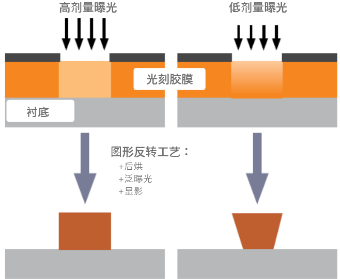










評論