封裝完整晶圓
晶圓級封裝是指晶圓切割前的工藝。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。除此之外,重新分配層(RDL)封裝、倒片(Flip Chip)封裝及硅通孔 ^1^ (TSV)封裝通常也被歸類為晶圓級封裝,盡管這些封裝方法在晶圓切割前僅完成了部分工序。不同封裝方法所使用的金屬及電鍍(Electroplating)^2^繪制圖案也均不相同。不過,在封裝過程中,這幾種方法基本都遵循如下順序。
^1^ 硅通孔(TSV , Through-Silicon Via): 一種可完全穿過硅裸片或晶圓實現硅片堆疊的垂直互連通道。
^2^ 電鍍 (Electroplating): 一項晶圓級封裝工藝,通過在陽極上發生氧化反應來產生電子,并將電子導入到作為陰極的電解質溶液中,使該溶液中的金屬離子在晶圓表面被還原成金屬。
完成晶圓測試后,根據需求在晶圓上制作絕緣層(Dielectric Layer)。初次曝光后,絕緣層通過光刻技術再次對芯片焊盤進行曝光。然后,通過濺射(Sputtering)^3^工藝在晶圓表面涂覆金屬層。此金屬層可增強在后續步驟中形成的電鍍金屬層的黏附力,同時還可作為擴散阻擋層以防止金屬內部發生化學反應。此外,金屬層還可在電鍍過程中充當電子通道。之后涂覆光刻膠(Photoresist)以形成電鍍層,并通過光刻工藝繪制圖案,再利用電鍍形成一層厚的金屬層。電鍍完成后,進行光刻膠去膠工藝,采用刻蝕工藝去除剩余的薄金屬層。最后,電鍍金屬層就在晶圓表面制作完成了所需圖案。這些圖案可充當扇入型WLCSP的引線、重新分配層封裝中的焊盤再分布,以及倒片封裝中的凸點。下文將對每道工序進行詳細介紹。
^3^ 濺射 (Sputtering): 一項利用等離子體束對靶材進行物理碰擊,使靶材粒子脫落并沉積在晶圓上的工藝。

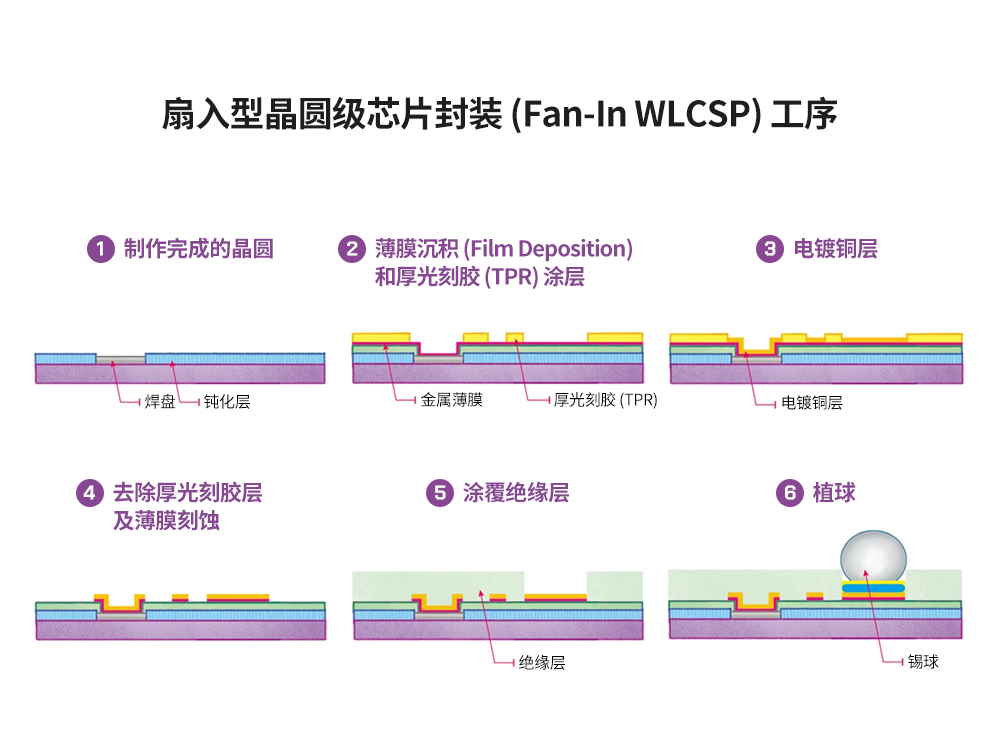
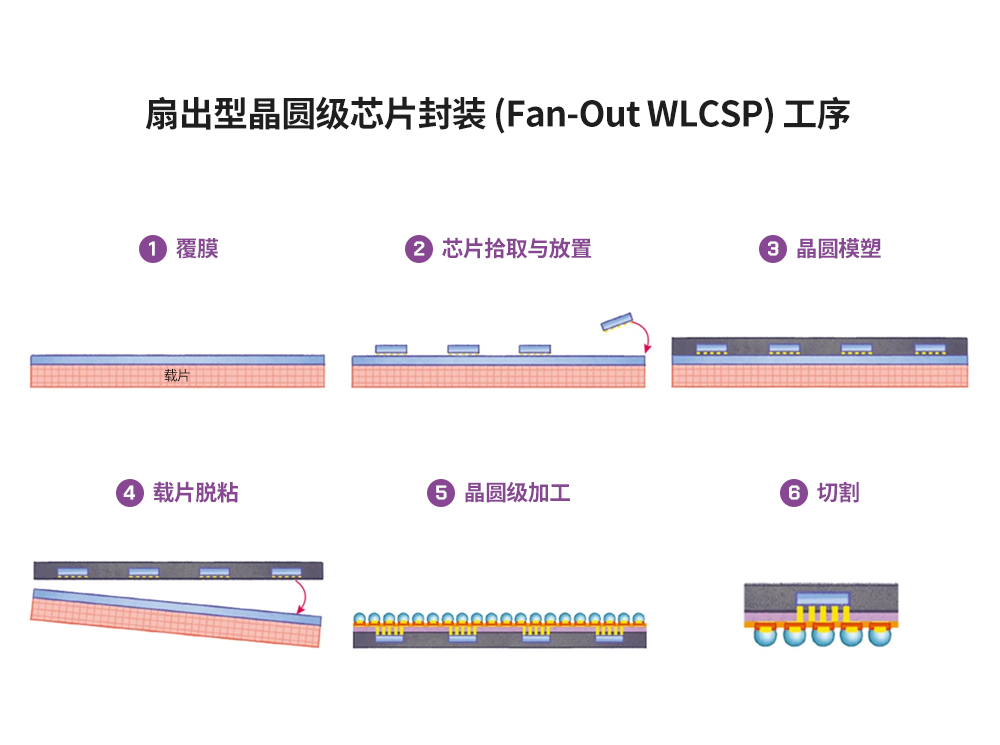
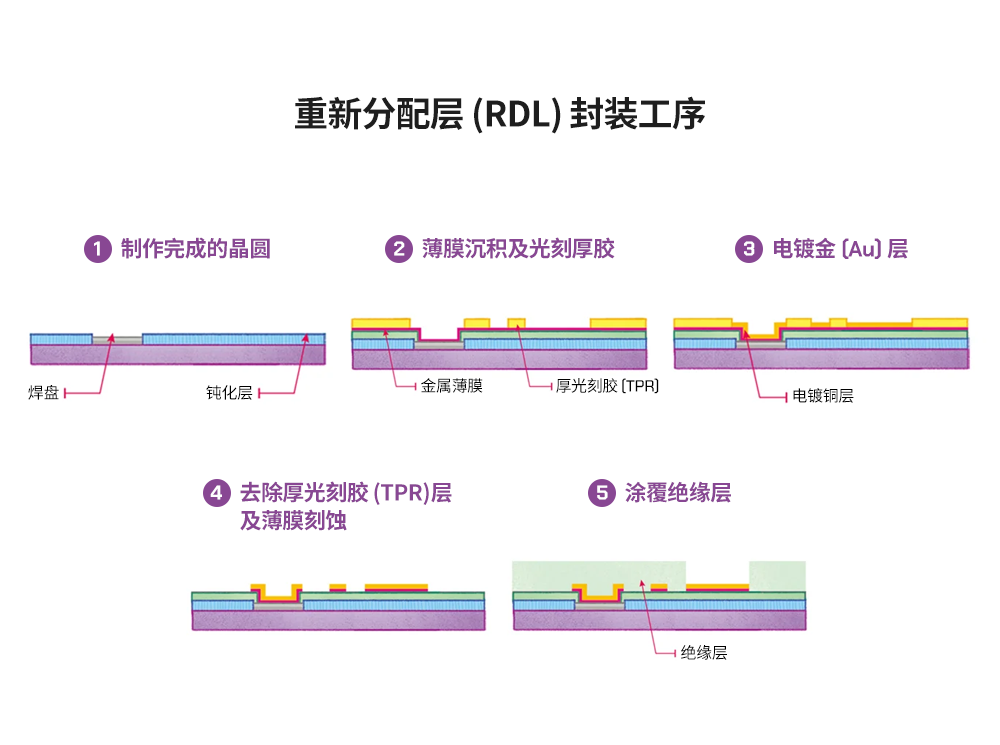
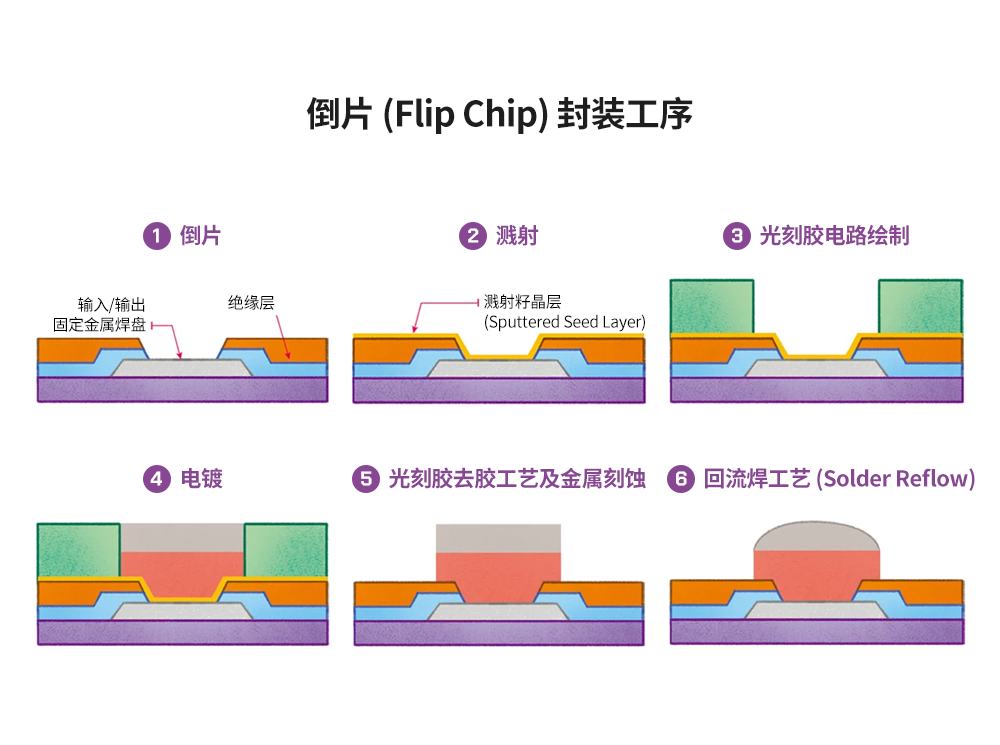

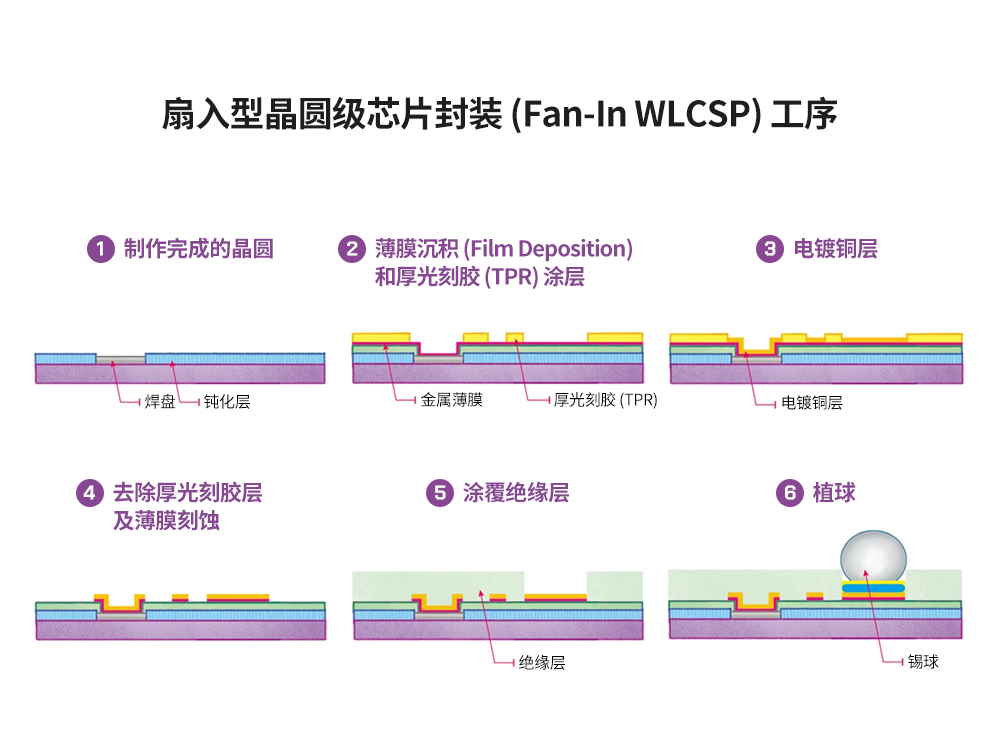
▲圖1:各類晶圓級封裝工藝及相關步驟
光刻工藝:在掩模晶圓上繪制電路圖案
光刻對應的英文是Photolithography,由“-litho(石刻)”和“graphy(繪圖)”組成,是一種印刷技術,換句話說,光刻是一種電路圖案繪制工藝。首先在晶圓上涂覆一層被稱為“光刻膠”的光敏聚合物,然后透過刻有所需圖案的掩模,選擇性地對晶圓進行曝光,對曝光區域進行顯影,以繪制所需的圖案或圖形。該工藝的步驟如圖2所示。
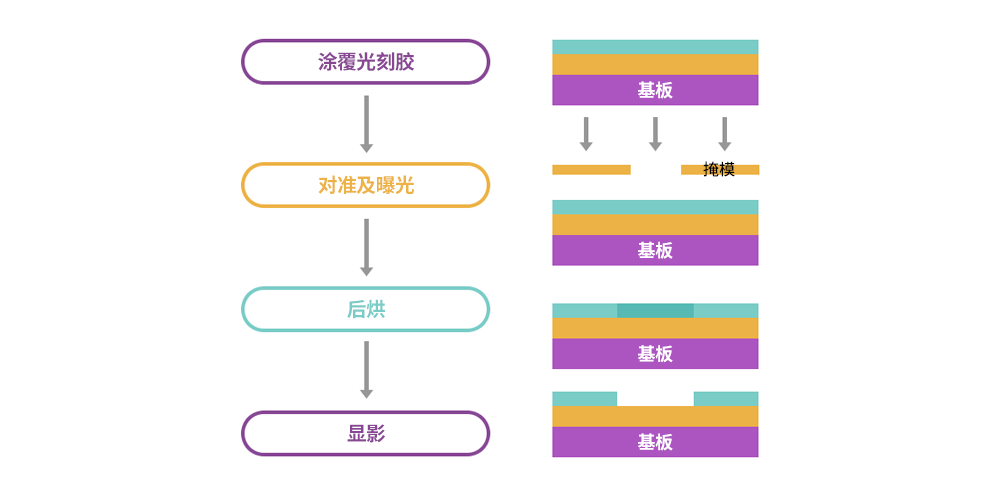
▲圖2:光刻工藝步驟
在晶圓級封裝中,光刻工藝主要用于在絕緣層上繪制圖案,進而使用繪制圖案來創建電鍍層,并通過刻蝕擴散層來形成金屬線路。
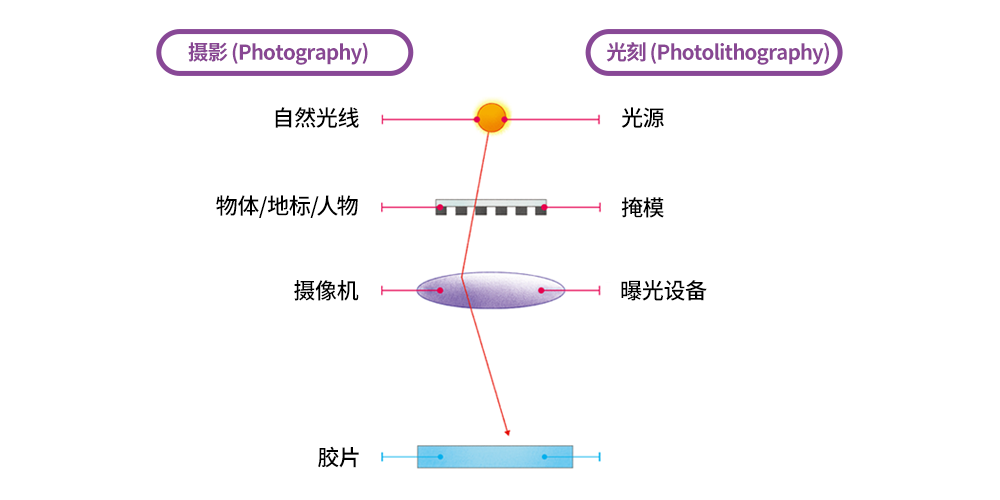
▲圖3:攝影與光刻的對比
為更加清楚地了解光刻工藝,不妨將其與攝影技術進行比較。如圖3所示,攝影以太陽光作為光源來捕捉拍攝對象,對象可以是物體、地標或人物。而光刻則需要特定光源將掩模上的圖案轉移到曝光設備上。另外,攝像機中的膠片也可類比為光刻工藝中涂覆在晶圓上的光刻膠。如圖4所示,我們可以通過三種方法將光刻膠涂覆在晶圓上,包括旋涂(Spin Coating)、薄膜層壓(Film Lamination)和噴涂(Spray Coating)。涂覆光刻膠后,需用通過前烘(Soft Baking)來去除溶劑,以確保粘性光刻膠保留在晶圓上且維持其原本厚度。
如圖5所示,旋涂將粘性光刻膠涂覆在旋轉著的晶圓中心,離心力會使光刻膠向晶圓邊緣擴散,從而以均勻的厚度分散在晶圓上。粘度越高轉速越低,光刻膠就越厚。反之,粘度越低轉速越高,光刻膠就越薄。對于晶圓級封裝而言,特別是倒片封裝,光刻膠層的厚度須達到30 μm至100 μm,才能形成焊接凸點。然而,通過單次旋涂很難達到所需厚度。在某些情況下,需要反復旋涂光刻膠并多次進行前烘。因此,在所需光刻膠層較厚的情況下,使用層壓方法更加有效,因為這種方法從初始階段就能夠使光刻膠薄膜達到所需厚度,同時在處理過程中不會造成晶圓浪費,因此成本效益也更高。但是,如果晶圓結構表面粗糙,則很難將光刻膠膜附著在晶圓表面,此種情況下使用層壓方法,會導致產品缺陷。所以,針對表面非常粗糙的晶圓,可通過噴涂方法,使光刻膠厚度保持均勻。

▲圖4:光刻膠涂覆的三種方法
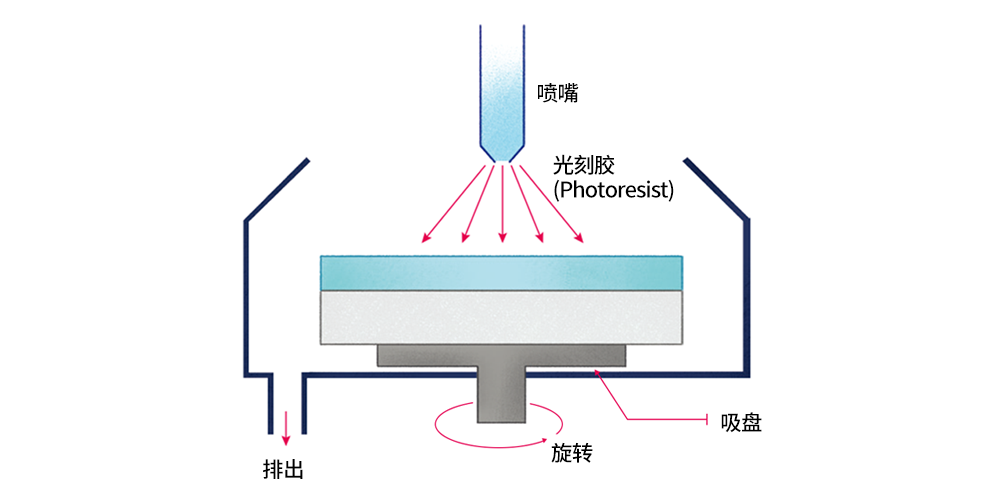
▲圖5:旋涂方法示意圖
完成光刻膠涂覆和前烘后,接下來就需要進行曝光。通過照射,將掩模上的圖案投射到晶圓表面的光刻膠上。由于正性光刻膠(Positive PR)在曝光后會軟化,因此使用正性光刻膠時,需在掩模去除區開孔。負性光刻膠(Negative PR)在曝光后則會硬化,所以需在掩模保留區開孔。晶圓級封裝通常采用掩模對準曝光機(Mask Aligner)^4^或步進式***(Stepper)^5^作為光刻工藝設備。
^4^ 掩模對準曝光機(Mask Aligner): 一種將掩模上的圖案與晶圓進行對準,使光線穿過掩模并照射在晶圓表面的曝光設備。
^5^ 步進式***(Stepper): 一種在工件臺逐步移動時,通過開啟和關閉快門控制光線以進行光刻的機器。
顯影(Development)是一種利用顯影液來溶解因光刻工藝而軟化的光刻膠的工藝。如圖6所示,顯影方法可分為三種,包括:水坑式 顯影(Puddle Development),將顯影液倒入晶圓中心,并進行低速旋轉;浸沒式顯影(Tank Development),將多個晶圓同時浸入顯影液中;噴淋式顯影(Spray Development),將顯影液噴灑到晶圓上。圖7顯示了靜態顯影方法的工作原理。完成靜態顯影后,通過光刻技術使光刻膠形成所需的電路圖案。

▲圖6:三種不同的顯影方法
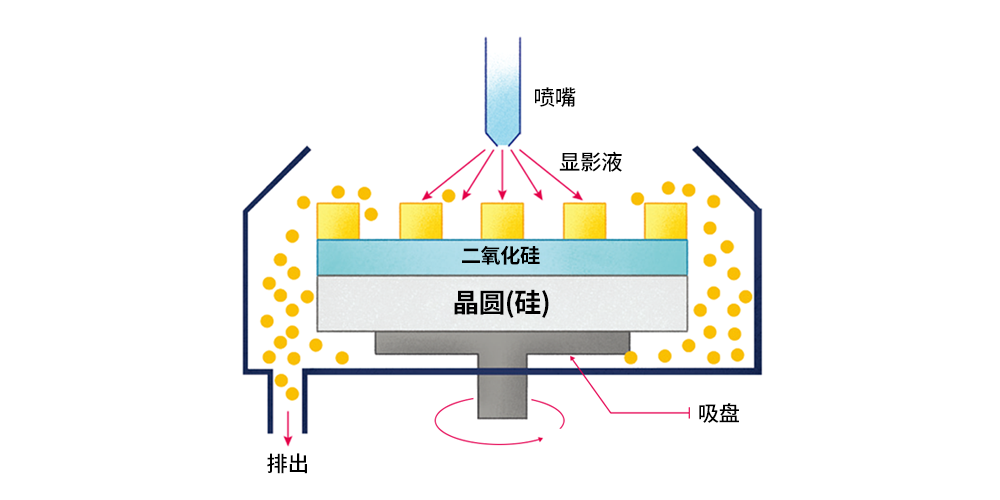
▲圖7:水坑式顯影方法的工作原理
審核編輯:劉清
-
半導體
+關注
關注
335文章
28702瀏覽量
234207 -
晶圓
+關注
關注
52文章
5131瀏覽量
129287 -
Chip
+關注
關注
1文章
59瀏覽量
26814 -
光刻技術
+關注
關注
1文章
151瀏覽量
16140 -
TSV封裝
+關注
關注
0文章
12瀏覽量
2459
原文標題:半導體后端工藝:晶圓級封裝工藝(上)
文章出處:【微信號:閃德半導體,微信公眾號:閃德半導體】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 半導體后端工藝:晶圓級封裝工藝(上)
半導體后端工藝:晶圓級封裝工藝(上)

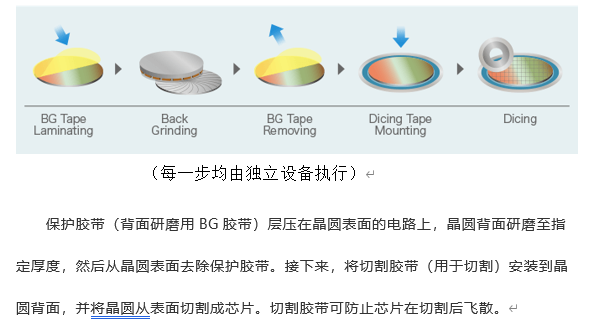
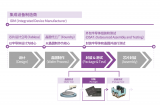

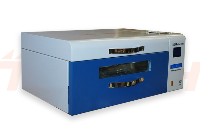












評論