在前幾篇文章中,我們詳細講解了氧化、光刻、刻蝕、沉積等工藝。經過上述工藝,晶圓表面會形成各種半導體元件。SK海力士等半導體制造商會讓晶圓表面布滿晶體管和電容(Capacitor)1;而代工廠或CPU制造商則會讓晶圓底部排列鰭式場效電晶體(FinFET)2等三維晶體管。
1電容(Capacitor):蓄電池等儲存電荷(電能)的設備,用于各種電子產品。在本文中,電容指半導體數據的存儲設備。
2鰭式場效電晶體(FinFET,Fin Field-Effect Transistor):三維MOSFET的一種,因電晶體形狀與魚鰭相似而得名。
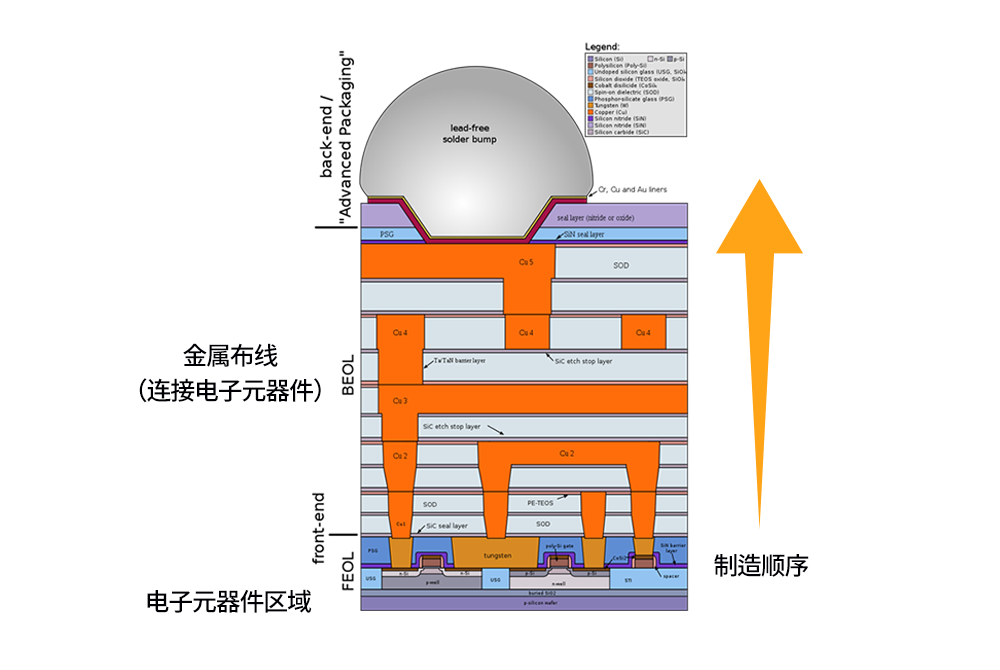
圖1: 電子元器件區域與金屬布線區域(摘自:Cepheiden,查看原文)
單獨的元器件若不經連接,則起不了任何作用。如果不把電子線路板上的元器件焊接起來,它們就無法工作。同樣地,晶圓上的晶體管若沒有相互連接起來,也起不了任何作用。只有把晶體管與外部電源連接起來,它們才能各司其職,正常執行把已處理過的數據傳輸到下一個環節等各種工作。可見,晶圓上的元器件與電源以及其他元器件之間的連接是必要的。更何況,半導體本身就是一個“集成電路”,各個元器件之間需要通過電能來“交流”信息。根據半導體電路圖連接電路的過程,就是本篇要講的“金屬布線”工藝。
相同的元器件,用不同的方式連接,也能形成不同的半導體(CPU、GPU等)。可以說,金屬布線是賦予半導體工藝“目的”的一個過程。

圖2:以金屬布線(黃色部分)連接電子元器件層(紅色部分)(圖中省略了部分結構)(摘自:查看原文)
本篇要講的金屬布線工藝,與前面提到的光刻、刻蝕、沉積等獨立的工藝不同。在半導體制程中,光刻、刻蝕等工藝,其實是為了金屬布線才進行的。在金屬布線過程中,會采用很多與之前的電子元器件層性質不同的配線材料(金屬)。
換言之,不像刻蝕工藝有專門的“刻蝕設備”,金屬布線環節沒有其專門的“設備”,而是要綜合使用各個工藝環節的設備:如移除殘余材料時,使用刻蝕設備;添加新材料時,使用沉積設備;每道工藝之間,則通過光刻設備進行光刻。
導線與元器件的連接:接觸孔
連接電子線路板時,要先用電線連接電子線路板上的各個電子元器件后,再進行焊接。但半導體制程需要從下往上一層一層堆疊。因此,要先做好元器件層后,在其上層生成接觸孔(Contact,連接元器件與導線),然后再進行金屬布線。
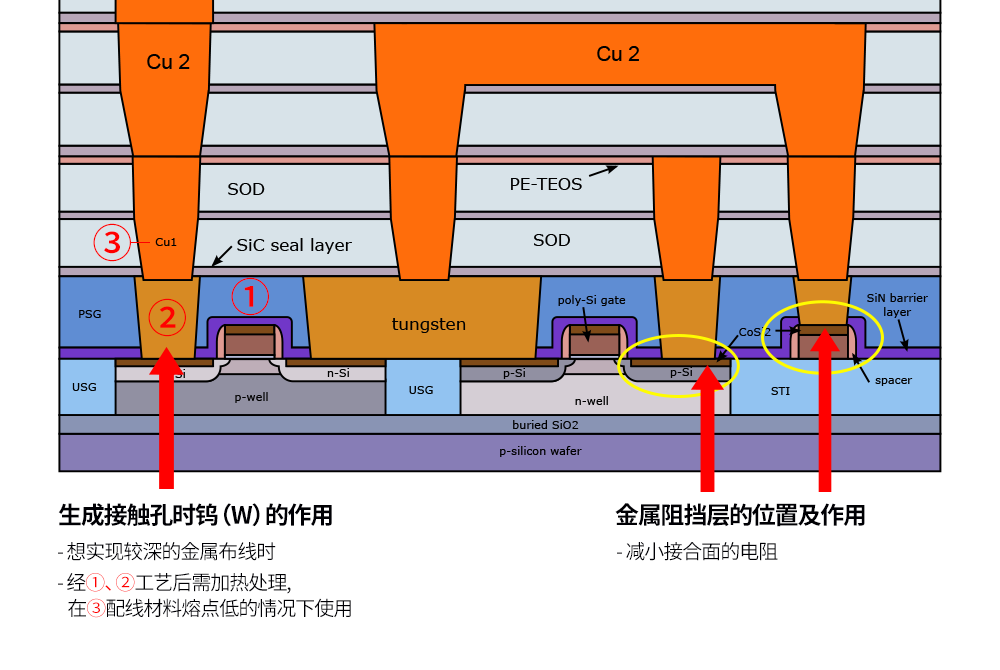
圖3:生成接觸孔時,鎢(W)的作用與金屬阻擋層的作用(摘自:Cepheiden,查看原文)
或許有些讀者會好奇:為什么不跳過“接觸孔”,直接把金屬與元器件連接起來?這還要從半導體的微細化說起。在上一篇中,我們提到了衡量溝槽填充程度的溝槽填充(Gap fill)能力。若使用鋁等配線材料,一旦穿孔稍深一些,就算“沉積”得再好,也無法把溝槽完全填充好,從而容易生產出一些中間有空隙的不良導線。也就是說,如果想實現較深的金屬布線(即元器件層與金屬布線層的距離較遠時),就需要用鎢(W)等溝槽填充能力優秀的配線材料進行沉積,提前把溝槽填充好。或者,生成接觸孔后再進行高溫處理。如果采用鋁等熔點較低的配線材料,需要先用鎢形成接合面后,再連接鋁導線。
在尺度只有頭發直徑數千分之一的微觀世界里,很多問題是我們難以想象的。為解決這些問題,我們必須比較各種對策,不斷尋找最優的方案。前邊提到的鎢配線似乎只有優點,其實不然。作為半導體配線材料,鎢遠不如銅或鋁。鎢的電阻大,如果用它來充當所有配線材料,將大幅提高半導體的功耗。
金屬阻擋層:減少金屬與金屬之間的電阻
元器件與接觸孔之間需要能起到阻擋作用的金屬層(金屬或金屬化合物)——金屬阻擋層(Barrier metal)。連接不同性質的物質時,接合面的電阻3會變大,令半導體的功耗大幅提高。因此,在半導體制程中,有效連接金屬與非金屬材料的難度相當大。形成金屬阻擋層的目的,便是實現非金屬材料與金屬材料間的“自然”過渡。要形成金屬阻擋層,我們要先在硅表面涂敷鈦(Ti)或鈷(Co)等材料,使其與硅發生反應生成硅化物接觸結構(Contact Silicide)。這一過程被稱為硅化工藝(Silicidation) 。
3從物理學講,由于金屬與硅的導帶(Conduction band)4 間存在能量間隙,所以會產生電阻。
4導帶(Conduction Band):在固體能帶結構內,以能級分裂的兩個帶中,用高帶促進固體導電。
此外,金屬阻擋層還可以在各工藝中保護元器件不受損。例如,鋁與硅(Si,晶圓的主要成分)相遇時會發生反應,導致接合面被破壞。因此,如果想在元器件層的近處排布鋁線,就必須在硅與鋁接合面之間形成鈦化合物等阻擋層,防止接合面被破壞。

圖4:采用鋁材料進行金屬布線時,金屬阻擋層的作用
如果以銅取代鋁作為配線材料,金屬阻擋層的作用就更多了。銅的反應能力比鋁還強,可以與比硅更穩定的二氧化硅(SiO2)發生反應。如果銅擴散到二氧化硅里,銅粒子就會滲入到氧化膜中,造成漏電現象。為防止這種情況的發生,要用鉭(Ta)在銅與元器件層接合面形成阻擋層。
導線:元器件與元器件之間的電線
生成接觸孔后,下一步就是連接導線。在半導體制程中,連接導線的過程與一般電線的生產過程非常相似,即先制作線的外皮。在一般的電路連接中,直接采用成品電線即可。但在半導體制程中,需要先“制作電線”。
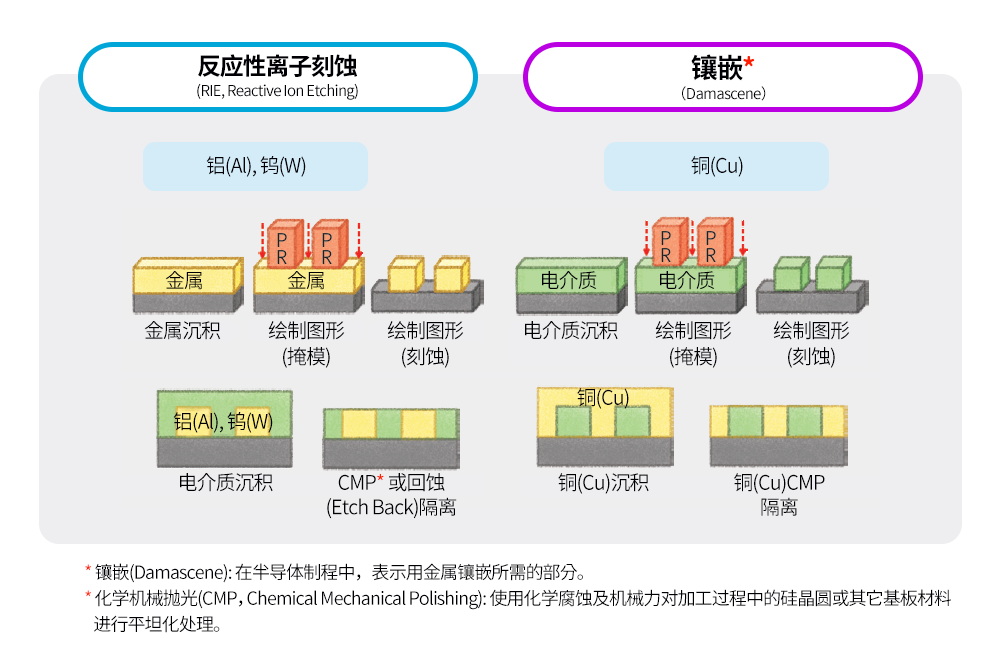
圖5:反應性離子刻蝕(RIE)與鑲嵌(Damascene)工藝的比較(摘自:(株)圖書出版HANOL出版社[半導體制造技術的理解293p])
電線的制作過程因配線材料而異。如果沉積鋁配線,可采用在前幾篇文章講述過的刻蝕和沉積工藝制作:先在整張晶圓表面涂敷金屬膜,再在涂敷光刻膠后進行曝光,然后移除殘余的鋁材料,最后在鋁周圍添加各種絕緣材料。
然而,采用銅作為配線材料時,金屬與電介質層的沉積順序要反過來:即先沉積電介質層,再通過光刻工藝刻蝕電介質層,接著形成銅籽晶層(Seed Layer),在電介質層之間加入銅,最后去除殘余銅。
有些讀者可能會好奇:只是調換了沉積順序,為什么這么重要?如前所述,采用銅布線,就必須涂敷銅籽晶層,為此又新加入了沉積和電鍍(Electroplating,以鋁作為配線材料時不需要電鍍過程)等工藝。日后,為攻克鋁配線帶來的技術難題,除用銅(Cu)來做線材外,我們還需要研發出更多新的工藝。其實,早在100年前,人類就知道銅的導電性要優于鋁。那么,當時為什么沒有把銅用作配線材料?因為,從半導體制造商的角度來看,要以更低廉的成本令導線用于更多的晶體管,半導體制造工藝也需要同步發展,而當時的工藝并無法解決銅配材帶來的新問題。
金屬布線越往上越厚。在半導體元器件中,頻繁交流龐大數據的元器件之間當然要近一些,反之則可以遠些。排列較遠的元器件之間,可以通過上層較厚的金屬布線來進行連接。
不難看出,位于上層的較厚金屬導線無需高難度技術做支撐。半導體制造商在過去制作的有一定厚度的鋁導線到如今也可以直接放到上層。也就是說,上層布線無需采用尖端技術,只要沿用以往的工藝即可。這也是半導體制造商節省投資并縮短工藝學習時間的一個有效方法。
技術的組合
上述技術并非各自獨立存在,而是根據各半導體制造商的不同目的,形成各種不同組合,從而生產出廠商希望制造的多種半導體。例如,與SK海力士等芯片制造商不同,臺積電(TSMC)、英特爾等邏輯半導體5制造商對晶體管的電流控制能力要求比較高。為此,邏輯半導體制造商采用了FinFET等三維晶體管,實現了三維結構的電流,以增加電流通道的面積。在三維晶體管上生成接觸孔,當然要比在DRAM等平面晶體管上難度更大。圖6形象地揭示了這兩種情況,左圖是在平面電流通道生成接觸孔,較容易;右圖是在三維晶體管上生成接觸孔,較難。
5邏輯半導體(logic semiconductors):CPU、GPU等通過處理數字數據來運行電子設備的半導體
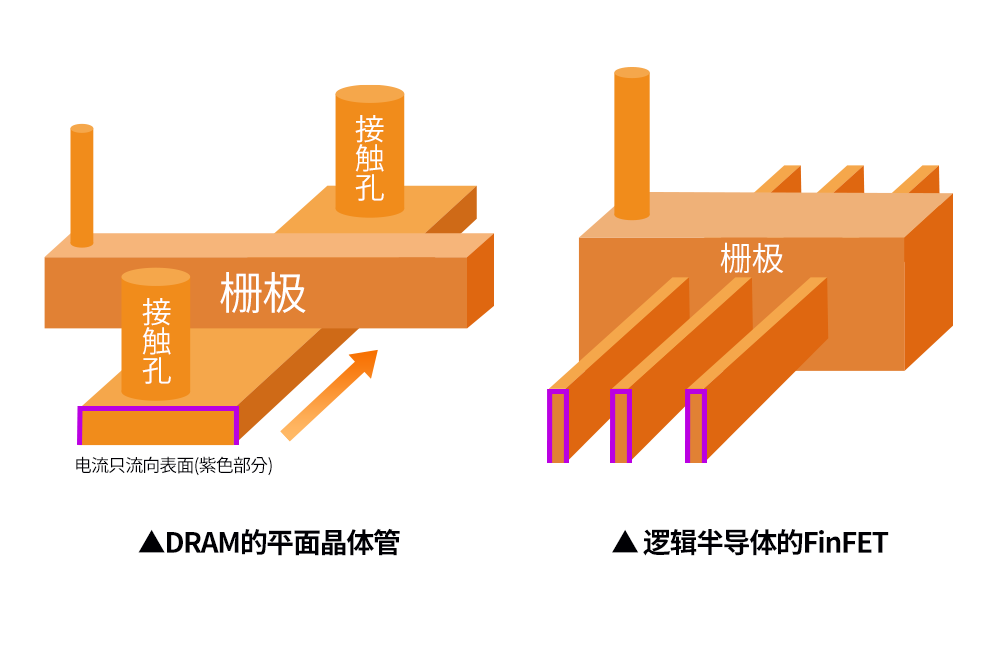
圖6:在邏輯半導體的FinFET生成接觸孔,要遠比在DRAM的平面晶體管生成接觸孔難。
導線的金屬阻擋層也一樣,英特爾在其7納米工藝中,為解決銅的電遷移6現象,試圖用鈷配線代替銅,卻兜了好幾年的圈子。2022年,英特爾在4納米工藝中又重新回到原點,采用銅配線,試圖通過用鉭(Ta)和鈷金屬層包裹銅線來攻克技術難關。英特爾將此稱為“強化銅(Enhanced Cu)”。
6電遷移(EM,Electromigration):指在金屬導線上施加電流時,移動的電荷撞擊金屬原子,使其發生遷移的現象。
隨著半導體的日益微細化,這種新的挑戰將不斷出現。對英特爾等CPU制造商來說,元器件的高速運行至關重要。正是由于CPU制造商非常重視元器件的速率,連抗電遷移性能出色的銅配線也遇到了瓶頸。英特爾的幾番周折正是為了解決銅配線帶來的技術難關。而像SK海力士等芯片制造商,雖然不存在電路運行速率上的問題,但卻在堆疊電容維持電荷容量上遇到了難題。微細化給處于不同制造環境的制造商提出的技術難題各有不同。但可以肯定的是,SK海力士在金屬布線上的難題也終將出現。
結論:“理解”先于“死記硬背”,“多人”先于“個人”
我們一起閱讀了六篇文章,說長也長,說短也短。區區六篇文章,或許連半導體產業的1%都無法囊括。盡管如此,筆者仍然義無反顧地寫下這六篇文章,希望能向未來將引領半導體產業的棟梁們傳達幾點核心信息。
半導體制程可以說是一個“集腋成裘”的過程。一張晶圓需經數百道工藝、數萬人聯手才能完成。盡管每一名作業人員對最終成品的貢獻可能都不及1%,但任何一道工藝出現任何差錯,都會影響半導體的整體運行。半導體制程中,每一名工作人員的工作都不是孤立的。我們要銘記:半導體制程的所有工藝都有機地交融在一起,牽一發而動全身。
另外,我也希望讀者們能通過這六篇文章認識到“理解工藝技術”的重要性。其中,理解技術彼此之間的關系尤為重要。比如,在沉積工藝中,我們要考慮到新添加的材料是否適合進行加熱處理和刻蝕;充分刻蝕后,如果在后續的沉積工藝中,材料的溝槽填充能力不佳,會對整個產品產生影響;繪制微細圖形時,如果***光刻不充分,就要多重曝光7,即使用掩模多次重復沉積和刻蝕。
7多重曝光(Multi Patterning): 通過重復的曝光和刻蝕工藝,追求更高圖形密度和更小工藝節點的技術。
可見,半導體產業不僅是尖端產業,更是需要“可信度”的產業。從業人員需要有較高的溝通和創新能力以及正直的從業態度。在成功研發出新的微細工藝,出現各種技術難關后,要本著正直的態度,將這些新的技術難題與業界分享,然后再聯合起來發揮創新能力,一同將難題攻克。半導體技術的發展是不斷出現問題、不斷解決問題的過程。光刻工藝中,以光刻膠解決浸沒式***帶來的新問題就是一個典型的案例。
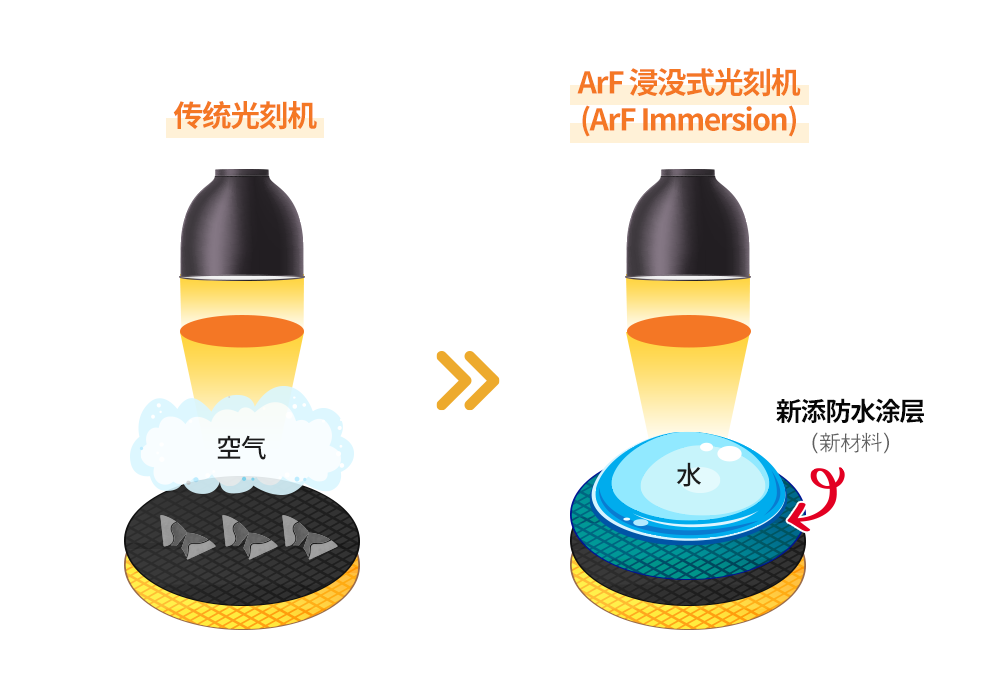
圖7:用光刻膠解決***帶來的新問題
希望讀者們能通過本系列文章對半導體產業的性質有所了解,并通過對技術的不斷深耕成就自己的職業生涯,與各相關部門聯手,制造出全球最有競爭力的半導體產品。
目前,半導體技術在微細化過程中再一次遇到瓶頸。越往后,半導體制造越要傾聽半導體用戶的聲音,通過溝通實現技術研發的能力也將變得越發重要。
來源:SK海力士
審核編輯 黃宇
-
半導體
+關注
關注
335文章
28778瀏覽量
235218 -
電容
+關注
關注
100文章
6242瀏覽量
153731
發布評論請先 登錄
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
有關半導體工藝的問題
半導體工藝講座
半導體前端工藝:金屬布線—為半導體注入生命的連接
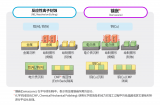





 半導體前端工藝:第六篇(完結篇):金屬布線 —— 為半導體注入生命的連接
半導體前端工藝:第六篇(完結篇):金屬布線 —— 為半導體注入生命的連接


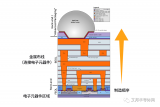
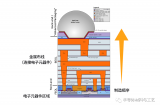
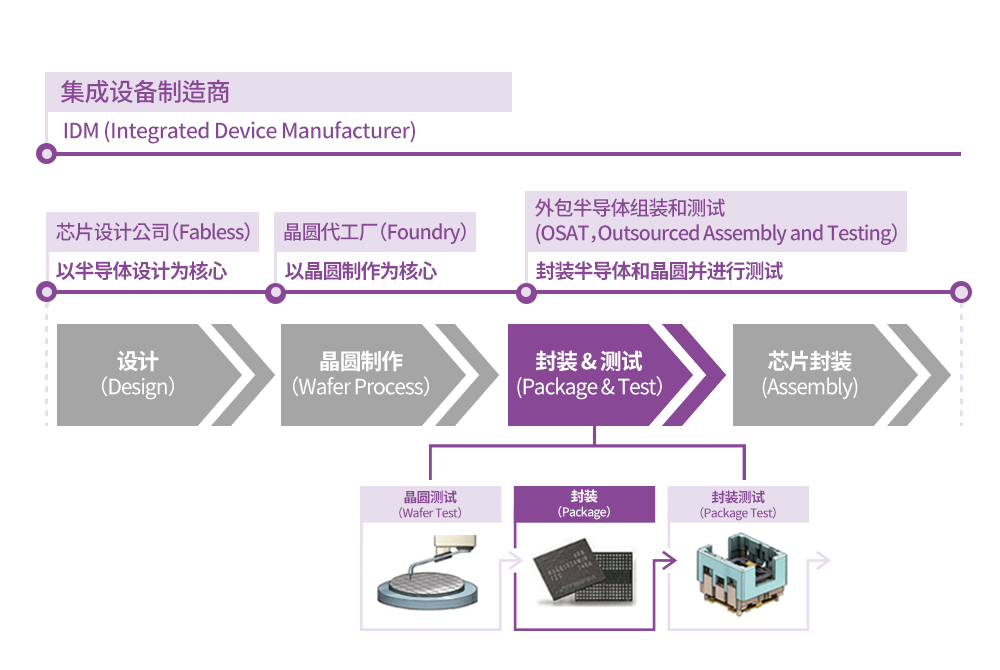
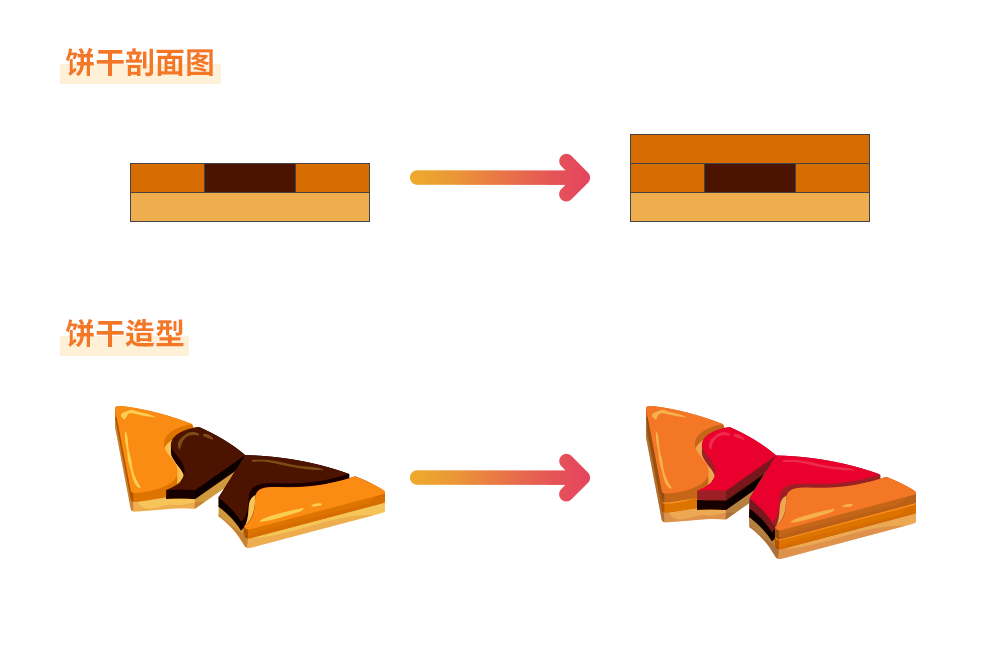

![[<b class='flag-5'>半導體</b><b class='flag-5'>前端</b><b class='flag-5'>工藝</b>:第三<b class='flag-5'>篇</b>] 光刻——<b class='flag-5'>半導體</b>電路的繪制](https://file1.elecfans.com/web2/M00/B1/DB/wKgZomVdgPSAWsXlAAH9_6nQJHk959.png)
![[<b class='flag-5'>半導體</b><b class='flag-5'>前端</b><b class='flag-5'>工藝</b>:第一<b class='flag-5'>篇</b>] 計算機、晶體管的問世與<b class='flag-5'>半導體</b>](https://file1.elecfans.com/web2/M00/B1/DD/wKgZomVdhWOAKTH4AADK6nwzAYk943.png)










評論