MOS是金屬氧化物半導體結構,氧化物是絕緣層,有絕緣層即意味著存在電容。大家知道,電容常見表達式為 ,即電容存儲的電荷是電容與電壓的乘積;
,即電容存儲的電荷是電容與電壓的乘積; 是電流與時間的積分,而MOS中的閾值電壓
是電流與時間的積分,而MOS中的閾值電壓 受到電容的控制,因此電容決定了MOS的開啟速度,進而也就決定了IGBT的頻率響應特性。
受到電容的控制,因此電容決定了MOS的開啟速度,進而也就決定了IGBT的頻率響應特性。
還是以溝槽型IGBT的MOS結構為例,如圖所示,其輸入電容包含兩個部分,一是柵極與源極之間的電容 ,二是柵極與漏極之間的電容
,二是柵極與漏極之間的電容 。
。
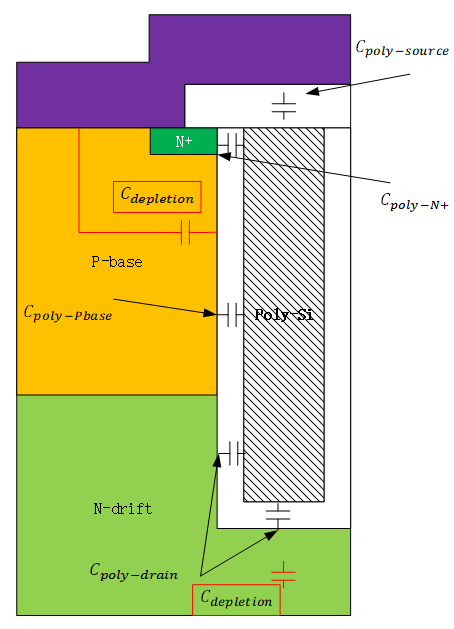
我們先看 ,包括(
,包括( )與
)與 ,以及金屬的重疊部分,即柵極與源極之間的電容
,以及金屬的重疊部分,即柵極與源極之間的電容

等式右邊的各項電容均可根據其幾何尺寸計算得出,

其中, 為真空介電常數,
為真空介電常數, 為氧化物的相對介電常數,
為氧化物的相對介電常數, 為重合面積(注意,這里忽略了重疊的邊緣部分電容)。
為重合面積(注意,這里忽略了重疊的邊緣部分電容)。 的下標加一個“1”,是因為這個表達式還需要修正。
的下標加一個“1”,是因為這個表達式還需要修正。
回顧一下之前對于MOS能帶彎曲的分析,隨著柵極電壓的增加(P型半導體),半導體與氧化硅界面會經歷先耗盡后反型的的過程,最終形成溝道。所以 中還存在一個耗盡電容
中還存在一個耗盡電容 ,與
,與 串聯。
串聯。
 是一個隨柵極電壓變化的電容。當MOS柵極施加負電壓時,柵氧與P型硅表面會產生積累的正電荷,相應地,在柵氧與多晶硅的界面產生負電荷積累,這是一個對
是一個隨柵極電壓變化的電容。當MOS柵極施加負電壓時,柵氧與P型硅表面會產生積累的正電荷,相應地,在柵氧與多晶硅的界面產生負電荷積累,這是一個對 充電的過程,所以
充電的過程,所以 可認為不存在;當MOS柵極施加正電壓時, P型硅表面的空穴被排斥,形成耗盡區,導帶向接近費米能級的方向彎曲,耗盡區的寬度對應
可認為不存在;當MOS柵極施加正電壓時, P型硅表面的空穴被排斥,形成耗盡區,導帶向接近費米能級的方向彎曲,耗盡區的寬度對應 。在前面對MOS閾值電壓的“強反型”說明中,未做具體推導,但給出了強反型的結論,即
。在前面對MOS閾值電壓的“強反型”說明中,未做具體推導,但給出了強反型的結論,即 將隨
將隨 呈指數級增長,根據電容的定義,
呈指數級增長,根據電容的定義,

顯然耗盡區的寬度會隨柵極電壓 的增加而增加,直到反型層形成,耗盡區不再擴展,相應的
的增加而增加,直到反型層形成,耗盡區不再擴展,相應的 達到最小值。所以,可以預期
達到最小值。所以,可以預期 的變化趨勢如下圖所示。
的變化趨勢如下圖所示。
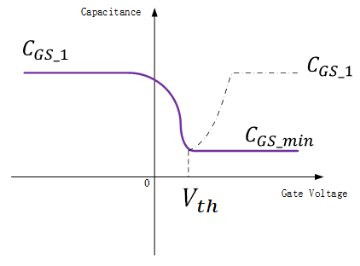
注:因為電容測試必須用交流信號,而反型層的電荷分布可能受隨交流信號的變化而變化,尤其是對于功率MOS而言,反型層中電子很容易從發射極得到補充,所以 在低頻信號下難以測到,經常測到的CV曲線是圖中的虛線所示。
在低頻信號下難以測到,經常測到的CV曲線是圖中的虛線所示。
-
半導體
+關注
關注
335文章
28342瀏覽量
230020 -
IGBT
+關注
關注
1276文章
3931瀏覽量
252618 -
MOS
+關注
關注
32文章
1328瀏覽量
95768 -
電容電壓
+關注
關注
0文章
75瀏覽量
11400 -
閾值電壓
+關注
關注
0文章
97瀏覽量
51749
發布評論請先 登錄
相關推薦
IGBT與MOS管、可控硅的區別 IGBT驅動電路設計

如何識別MOS管和IGBT管?
IGBT和MOS管以及可控硅的區別在哪
IGBT和MOS管區別
MOS管和IGBT管有什么差別
MOS管和IGBT的結構特點與區別

igbt和mos管的區別
igbt與mos管的區別
MOS管和IGBT的結構區別
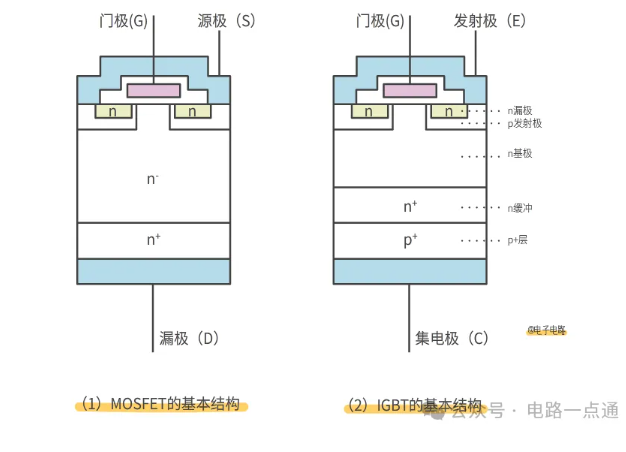





 IGBT中的MOS結構—輸入電容(上)
IGBT中的MOS結構—輸入電容(上)













評論