理論白癡的我寫這個壓力有點(diǎn)小大,水平很有限,初學(xué)者看看,然后再去找對應(yīng)論文看正規(guī)的說法和解釋,別被我誤導(dǎo),老司機(jī)跳過。
1、功率半導(dǎo)體器件簡介
功率半導(dǎo)體器件,以前也被稱為電力電子器件,簡單來說,就是進(jìn)行功率處理的,具有處理高電壓,大電流能力的半導(dǎo)體器件。典型的功率處理,包括變頻、變壓、變流、功率管理等等。早期的功率半導(dǎo)體器件:大功率二極管、晶閘管等等,主要用于工業(yè)和電力系統(tǒng)(正因如此,早期才被稱為電力電子器件)后來,隨著以功率MOSFET器件為代表的新型功率半導(dǎo)體器件的迅速發(fā)展,現(xiàn)在功率半導(dǎo)體器件已經(jīng)非常廣泛,在計(jì)算機(jī)、通行、消費(fèi)電子、汽車電子 為代表的4C行業(yè)(computer、communication、consumer electronics、cartronics)。在大多數(shù)情況下,它是被作為開關(guān)使用(switch),開關(guān),簡單的說,就是用來控制電流的通過和截?cái)唷D敲矗粋€理想的開關(guān),應(yīng)該具有兩個基本的特性:電流通過的時候,這個理想開關(guān)兩端的電壓降是零;電流截?cái)嗟臅r候,這個理想開關(guān)兩端可以承受的電壓可以是任意大小,也就是0~無窮大。
因此,功率半導(dǎo)體器件的研究和發(fā)展,就是圍繞著這個目標(biāo)不斷前進(jìn)的。現(xiàn)在的功率半導(dǎo)體器件,已經(jīng)具有很好的性能了,在要求的電壓電流處理范圍內(nèi),可以接近一個比較理想的開關(guān)。舉幾個例子,功率二極管,晶閘管,還有功率BJT(就是功率雙極型晶體管)這些都是第一代產(chǎn)品了,比較老的了,第二代是以功率MOSFET為代表的新型功率半導(dǎo)體器件,如VDMOS、LDMOS,以及IGBT。VDMOS 即(vertical double-diffusion MOSFET)是縱向器件,柵和源電極在上面,漏極在下面,多用于分立器件;LDMOS 即(Lateraldouble-diffusion MOSFET),是橫向器件,其三個電極(源極柵極漏極)均在硅片上表面,易于集成,多用于功率集成電路領(lǐng)域。IGBT 即(InsulatedGate Bipolar Transistor 絕緣柵雙極型晶體管),可以看作是功率MOS和功率BJT的混合型新器件。(這一段是摘抄與修改)
2、NMOS襯偏效應(yīng)解決的方法
在源端加P+,引出電極和源級短接,保持源和襯底電位一致,消除襯偏效應(yīng)對閾值電壓Vth的影響。直接讓P-body和源級相連理論上也行,但輕摻雜的P-body接觸電阻更大,所以采用源區(qū)加P+的方法來降低接觸電阻。這這只是解決方法之一,不是唯一。
3、淺談MOS
個人覺得MOS是個很重要的概念,知道一些基本原理才能進(jìn)行學(xué)術(shù)研究,所以MOS的特性一定要掌握到位。
下圖是一個典型的NMOS示意圖,源極下方P+是為了消除襯偏效應(yīng)的影響,同時也為了降低接觸電阻。柵氧一般很薄很薄,而且柵氧要求的質(zhì)量很高,氧化層的形成一般有干氧氧化和濕氧氧化,柵氧一般(不是所有)采用干氧氧化,干氧雖然慢,但質(zhì)量高。柵氧上面是多晶硅,多晶硅還需要摻入五價的元素(如磷,砷)形成N型多晶硅。為什么不摻硼這樣的元素形成P型多晶硅,一種說法是柵氧(SiO2)具有吸硼排磷的特性,假如多晶硅里有硼元素,那么就可能會進(jìn)入柵氧,柵氧里便會摻入雜質(zhì),影響柵氧質(zhì)量,甚至?xí)霈F(xiàn)我們極其不希望看到的柵電流。對了,個人覺得,在流片的時候,記得將靠近場氧等氧化層的P-區(qū)增大一下表面濃度哦,不然吸硼排磷,發(fā)現(xiàn)P-body最上面竟然不是P-,而是漂移區(qū),硼都被氧化層吸走了,這就哭了,流片成本那么高,emmm畢竟流片良率問題太重要了。
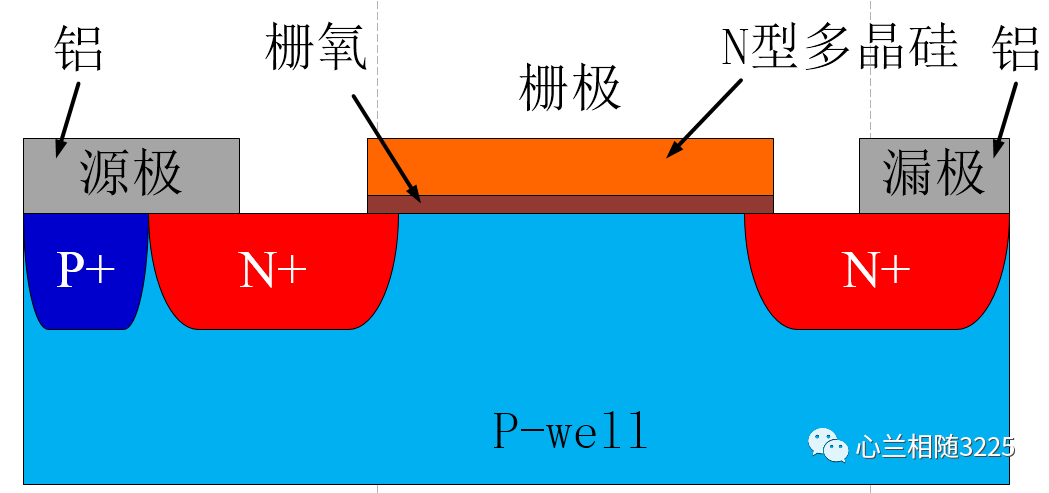
高壓排斥空穴,低壓吸引電子這是大家都認(rèn)同的。柵極加高壓,靠近柵氧的P-well區(qū)空穴便會被排斥開,留下不可移動的硼離子,這些陰離子形成的便是反型層,對于電子來說是低阻區(qū),這就是所謂的溝道,而且,柵壓越大溝道越寬溝道電阻就越小。

當(dāng)柵氧較厚時,pwell濃度較大時,反型較困難,即需要更大的柵壓才能形成反型層,也就是閾值電壓會增大,而且閾值電壓也跟溫度有關(guān)系哦,溫度升高,閾值電壓是降低的,因?yàn)閂th的表達(dá)式中有一項(xiàng)是與表面勢有關(guān)的,而表面勢與溫度的是正比關(guān)系,即溫度升高表面勢增大。在閾值電壓的表達(dá)式中,Vth=Vth0+γ((Φ-Vbs)^0.5-Φ^0.5),顯然第二項(xiàng)是負(fù)值,也就是說表面勢Φ增大Vth減小。
當(dāng)反型層形成了,也就有了電子溝道,一旦漏極電勢大于源極,電子就會從源極經(jīng)過溝道到達(dá)漏極。
下面談?wù)劸€性電流和飽和電流,以及什么叫溝道夾斷。
當(dāng)溝道形成,漏極電壓不大時,這個時候MOS的導(dǎo)通基本是受溝道電阻的影響,所以呈現(xiàn)的是線性區(qū)變化,
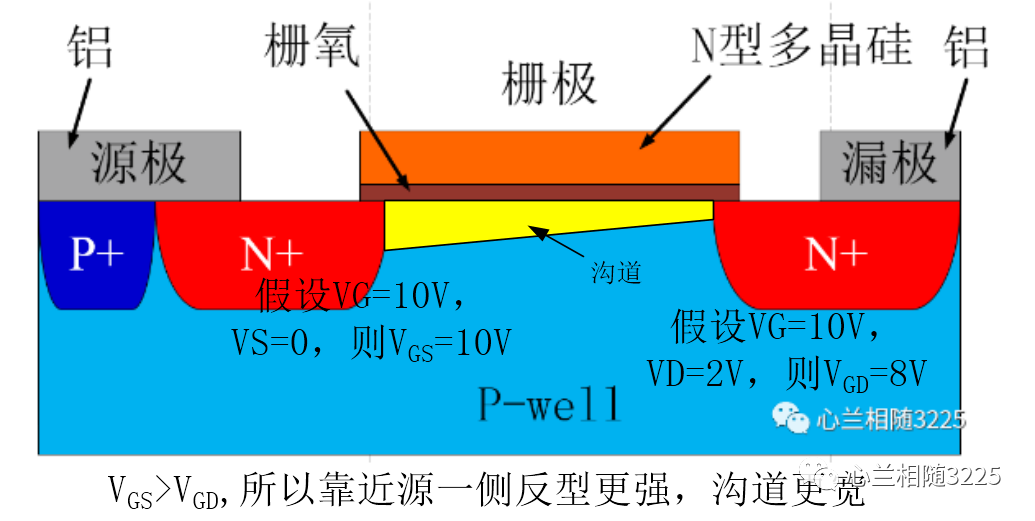
隨著漏壓繼續(xù)增加,靠近漏的溝道消失,形成夾斷,一方面,不是所有的電子都可以通過夾斷區(qū),只有速度高的電子才能在電場作用下強(qiáng)行穿過夾斷區(qū),另一方面,電子也是有飽和速度的,速度達(dá)到一定值不再增加,這就是為什么漏壓增加了,電流卻飽和不增加的原因。在功率器件,比如VDMOS中,飽和區(qū)的電流曲線不是平的,而是上翹的,是因?yàn)閮蓚€P-body之間N-drift區(qū)即JFET區(qū),更多的漏電勢落在了JFET電阻上,所以在溝道夾斷以后還是會電流上翹的現(xiàn)象,也就是準(zhǔn)飽和效應(yīng)。準(zhǔn)飽和效應(yīng)我涉獵較少,對此感興趣的多去查查文獻(xiàn)哦。
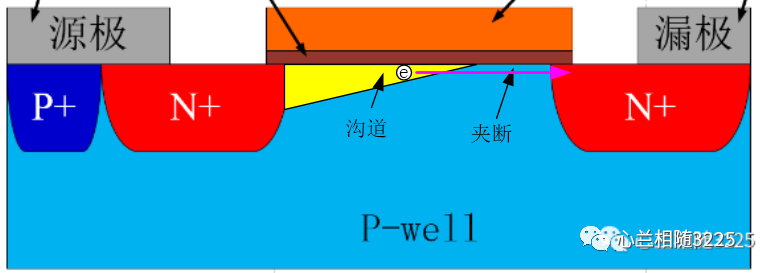

4、硬擊穿和軟擊穿
擊穿分為硬擊穿和軟擊穿,如果BV曲線突然上升,很陡,就稱為硬擊穿,如果BV曲線上升很緩,稱為軟擊穿。


5、查找專利去哪個網(wǎng)站?
查國內(nèi)專利選佰騰網(wǎng),soopat,查國外專利選freepatent online。
6、什么是閂鎖效應(yīng),即latch-up?
IGBT正常導(dǎo)通應(yīng)該是柵下溝道開啟,電子從發(fā)射極出發(fā),經(jīng)過溝道,進(jìn)入漂移區(qū),到達(dá)并聚集在集電極下方,當(dāng)集電極與集電極下方電位大于PN結(jié)的正向?qū)▔航担姌OP+和N-buffer構(gòu)成的PN結(jié)就會開啟,器件不再只有電子電流,而且有空穴電流,進(jìn)入雙極型模式,發(fā)生電導(dǎo)調(diào)制,即大注入(少子數(shù)量大于等于多子數(shù)量),電流能力大大增強(qiáng)。當(dāng)柵壓降低,讓溝道下方電子反型層消失,電子電流就會被切斷,IGBT關(guān)斷。
但是當(dāng)漂移區(qū)的空穴經(jīng)源區(qū)P-body、源區(qū)P+流到源極時,由于P-body區(qū)電阻的存在,在源區(qū)P-body和源區(qū)N+可能產(chǎn)生一定的壓降,當(dāng)該壓降大于由源區(qū)P-body和源區(qū)N+組成的PN結(jié)的正向?qū)▔航禃r,由源區(qū)N+、源區(qū)P-body和N-drift構(gòu)成的寄生NPN就會開啟,此時柵對于溝道電流就失去了控制,無法通過柵壓讓器件關(guān)斷,這就是閂鎖效應(yīng),一般發(fā)生在IGBT內(nèi),示意圖如下。(我自己口述解釋的,很不嚴(yán)謹(jǐn),意思大概懂即可)

工藝上為防正向?qū)ㄆ陂g寄生NPN開啟的方法是增大P-body的濃度,我們知道,摻雜越多,載流子就越多,電阻就越小,P-body電阻小,那么較大電流流過時,就很難在發(fā)射極N+和P-body之間形成0.7伏的正向?qū)▔航担l(fā)射極P-body/N+結(jié)就較難開啟,可以達(dá)到防閂鎖的目的,但是這樣會導(dǎo)致閾值電壓的增大。
7、溫度升高,PN結(jié)擊穿電壓會怎樣變化?
溫度升高,晶格振動劇烈,載流子遷移率因受阻而下降,故相同電壓下,溫度高的,速率更低,需要更大的電壓才能使得載流子達(dá)到雪崩擊穿的速率,因此溫度升高,擊穿電壓是變大的,但是溫度升高,本征激發(fā)的載流子數(shù)目也在變多,所以漏電也會增加,仿真結(jié)果如下。

8、PN+結(jié)的BV和P+N結(jié)的BV(breakdown voltage,擊穿電壓)有何差別?
對于PN+結(jié)來說,空穴是更少的少子,對于P+N結(jié),電子是更少的少子,空穴遷移率小于電子,所以要想達(dá)到雪崩速率,PN+需要更大的電壓,PN+的BV高些,仿真證明如下。

9、SOI技術(shù)的優(yōu)缺點(diǎn)
SOI就是有Psub,BOX和Ndrift的,Si基就是直接在Psub上做N漂移區(qū)的。
SOI全稱:silicon on insulator,絕緣體上硅
SOI優(yōu)點(diǎn):減小了寄生電容,降低了漏電,消除了閂鎖效應(yīng),抑制了襯底脈沖電流的干擾,與現(xiàn)有的硅工藝兼容,可以減少13-20%的工序。
SOI缺點(diǎn):成本高,是Si的六倍以上,散熱困難。
10、RC-IGBT產(chǎn)生snapback原因
對于一般的IGBT,如上面第5條的圖所示, IGBT不存在體二極管,當(dāng)器件關(guān)斷的時候,漂移區(qū)空穴可以通過發(fā)射極P+抽取,但是電子就慘了,沒有路徑讓它回家,集電極的P+對于電子而言是高阻區(qū),于是電子就只能被漂移區(qū)內(nèi)的空穴慢慢復(fù)合掉。復(fù)合的速度哪能比得上抽取的快,所以IGBT最嚴(yán)重的問題就是關(guān)斷速度賊雞兒慢,這就導(dǎo)致了IGBT只能用于大功率,可惜在高頻領(lǐng)域無用武之地。
為了解決這一頭疼問題,必須要讓IGBT關(guān)斷期間長長的拖尾電流消失,怎么辦呢?最簡單的就是也給電子一條回家的路徑,那就是在集電極側(cè)加一個N+區(qū)同時與集電極連接起來,這樣電子的抽取就變快了。IGBT發(fā)射極(E)也被叫陰極,集電極(C)也被叫陽極。
下圖是RC-IGBT,因?yàn)殛枠O多了個N+區(qū)用來提供電子抽取路徑,加快IGBT關(guān)斷的。正常的IGBT是左邊低壓右邊高壓,電流從右向左。但是加了陽極N+之后,左邊可以接高壓,右邊可以接低壓,體二極管可以導(dǎo)通,電流從左向右,實(shí)現(xiàn)了逆向?qū)ǖ墓δ埽越心鎸?dǎo),reverse conduction,這是RC的來歷。由于陽極P/N1結(jié)被短路,RC-IGBT 正向?qū)ǔ跗冢òl(fā)生電壓折回之前)體內(nèi)只有電子電流,陽極P+區(qū)不能向漂移區(qū)注入空穴,漂移區(qū)因此也沒有電導(dǎo)調(diào)制效應(yīng)存在。也就是說,RC-IGBT發(fā)生電壓折回之前的導(dǎo)通電阻實(shí)際非常大,其值接近于相同結(jié)構(gòu)尺寸下VDMOS的導(dǎo)通電阻。當(dāng)陽極P+和N1下方電位大于陽極P/N1結(jié)的內(nèi)建電勢時,陽極P+開始向漂移區(qū)注入空穴,使漂移區(qū)發(fā)生電導(dǎo)調(diào)制效應(yīng),降低漂移區(qū)的電阻。這會導(dǎo)致 RC-IGBT 的電流增大,使 N1下方的電勢進(jìn)一步下降,結(jié)果會使漂移區(qū)有更多的空穴注入和更充分電導(dǎo)調(diào)制效應(yīng),這樣就會形成電流不斷增大而電阻不斷減小的正反饋過程。這個過程反映到輸出特性曲線的結(jié)果,即為 RC-IGBT 的電流增大同時電壓減小的電壓折回現(xiàn)象。
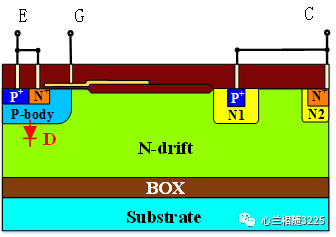
簡單來講就是MOS小電流模式切換到BJT大電流模式需要經(jīng)歷突變這個過程。snapback現(xiàn)象的存在是不希望看到的,因?yàn)橐粋€電壓對應(yīng)值兩個電流,如果兩個玩意并聯(lián),電壓是相同的,可能會存在一個流過電流大一個流過電流小,流過電流大的阻礙就變小,就會導(dǎo)致電流越來越大,可能會引起器件損壞。工程上一般是增大陽極N+和P+之間的距離,這樣可以利用N+和P+之間漂移區(qū)電阻來形成壓降,讓N1下方電勢早點(diǎn)比陽極電位小0.7V(假設(shè)PN結(jié)開啟電壓是0.7V),但這樣又太費(fèi)面積,學(xué)術(shù)上的研究一般是通過讓電子繞路增大上述電阻,這方面論文太多了,感興趣去研究研究呢。

11、MOS二級效應(yīng)有哪些?
溝道長度調(diào)制,背柵效應(yīng),亞閾值效應(yīng)。
溝道長度調(diào)制效應(yīng):溝道夾斷以后,繼續(xù)增大VDS,會導(dǎo)致夾斷點(diǎn)往源極移動,溝道有效長度減小,電阻減小,ID增大
背柵效應(yīng):MOS管的閾值電壓將隨其源極和襯底之間電位的不同而發(fā)生變化。
12、雙線法測電阻與四線法測電阻
電阻測試通常原理是恒流測壓,測量儀器產(chǎn)生恒定數(shù)值的測量電流I,通過兩根測量引線分別接觸待測電阻Rx兩端,當(dāng)電流I流過Rx時,測得Rx兩端電壓為Ux,Rx=Ux/I,但是引線也是有電阻的,尤其在測量微小電阻時,引線上的電阻不能忽略不計(jì),實(shí)際Rx=(Ux+2Ur)/I。
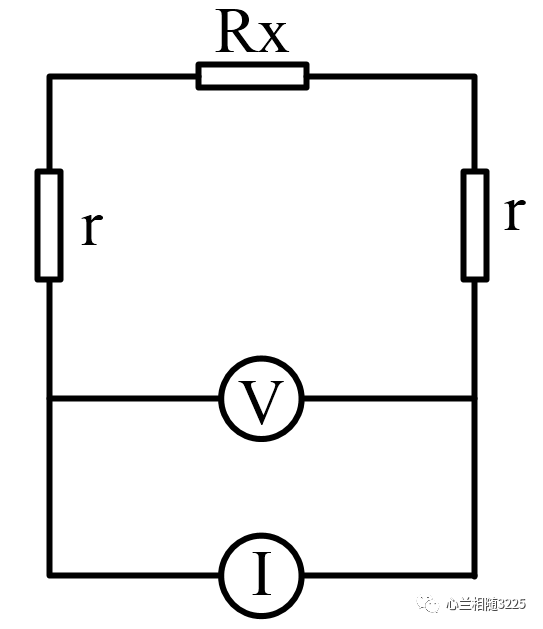
采用四線法測量時,由于四條引線分別形成電壓回路和電流回路,電壓測量回路的阻抗很大,流過的電流可以忽略,Rx=U/I是更加精確的,所以四線法測電阻被廣泛采用。

13、二極管的耐壓過程
功率PiN二極管反偏時的反向擊穿電壓VBR主要是結(jié)的低摻雜一側(cè)的雜質(zhì)濃度決定。考慮一般的非穿通情況,本征i區(qū)的寬度比空間電荷區(qū)的寬度要寬,二極管的擊穿電壓可以由下式來表示:

其中:EBR為臨界擊穿電場強(qiáng)度,ε0為自由空間介電常數(shù), εr為相對介電常數(shù),ND為施主濃度。根據(jù)上式,我們可以看出,要想使二極管具有較高的擊穿電壓 VBR,硅片初始材料應(yīng)具有較低的施主雜質(zhì)濃度 ND,也就是說要具有較高的電阻率。為了能夠讓空間電荷區(qū)在反偏時有足夠的擴(kuò)展空間,F(xiàn)RD 的漂移區(qū)還必須具有比較大的厚度。但對于低正向壓降的要求來說,必須保證載流子具有較長的壽命以保證在正向大注時實(shí)現(xiàn)高度的電導(dǎo)調(diào)制。因此高反向擊穿電壓和低正向壓降對高阻層的要求是相互矛盾的,在器件設(shè)計(jì)時要考慮到。下面我只是想把耗盡過程表達(dá)清楚,耗盡線是我隨便瞎畫的。個人認(rèn)為PN結(jié)的耐壓過程很重要,初學(xué)者一定要去查閱資料文獻(xiàn)將其搞懂。



圖中黑色的數(shù)字,代表各位置的大致電位,這里想表達(dá)的是,電勢只會在耗盡區(qū)進(jìn)行降落,耗盡區(qū)以外的區(qū)域電勢不變,稱為中性區(qū),換句話說,只有耗盡層的展寬程度才是耐壓大小的決定性因素。所以對于高壓應(yīng)用的場合,普遍采用N漂移區(qū)來提升器件的耐壓特性。
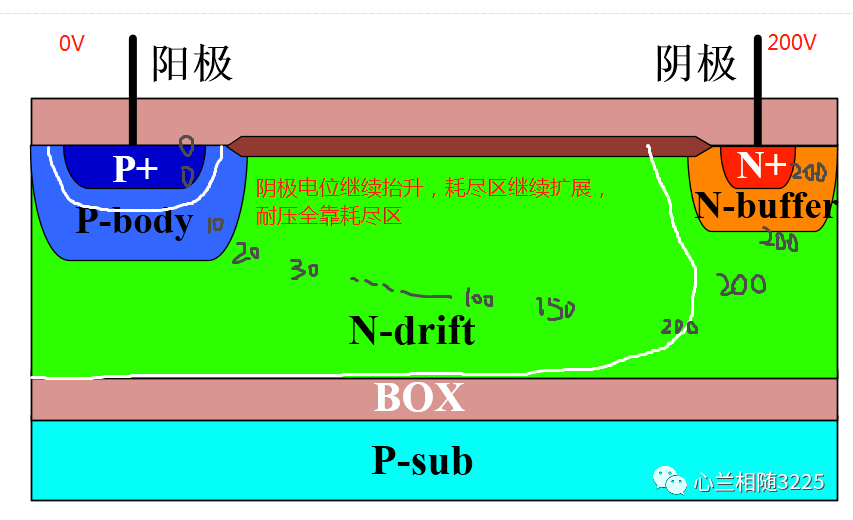

器件提前擊穿原因有很多,比如某處電場太強(qiáng)(通常在鳥嘴處,溝槽柵拐角等這些曲率較小的地方),超過硅基的臨界擊穿電場(一般認(rèn)為25萬-30萬V/m)。
理論這種東西基本上全靠自己去悟,沒有誰可以指導(dǎo)誰,也不是教授博士說的就一定是對的,論文都有錯的,比如很多論文里的NMOS的N說成N-type,但嚴(yán)格來講是指N-channel,從來沒有N-type這種說法。公眾號里寫的肯定有錯誤的地方,但我覺得錯不可怕,如果看一個公眾號可以提起你對這一方向的興趣,從而好像找到了自己的方向,開始去搜索研究論文,激情于仿真,測試等等,我想這個公眾號就是成功的。
-
二極管
+關(guān)注
關(guān)注
148文章
10063瀏覽量
170711 -
MOSFET
+關(guān)注
關(guān)注
150文章
8379瀏覽量
219066 -
晶閘管
+關(guān)注
關(guān)注
35文章
1109瀏覽量
78329 -
BJT
+關(guān)注
關(guān)注
0文章
238瀏覽量
18545 -
功率半導(dǎo)體
+關(guān)注
關(guān)注
23文章
1293瀏覽量
43928
發(fā)布評論請先 登錄
功率半導(dǎo)體器件應(yīng)用手冊
【基礎(chǔ)知識】功率半導(dǎo)體器件的簡介
半導(dǎo)體功率器件的分類
功率半導(dǎo)體器件的定義及分類
什么是基于SiC和GaN的功率半導(dǎo)體器件?
功率半導(dǎo)體器件鳥瞰
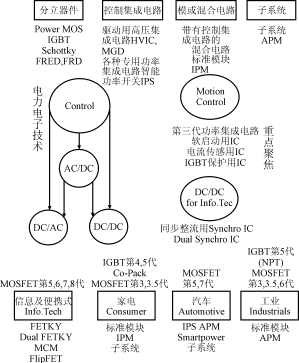
功率半導(dǎo)體的優(yōu)劣勢分析_功率半導(dǎo)體器件用途
功率半導(dǎo)體器件基礎(chǔ)應(yīng)該學(xué)習(xí)什么教材
功率半導(dǎo)體分立器件包括哪些?
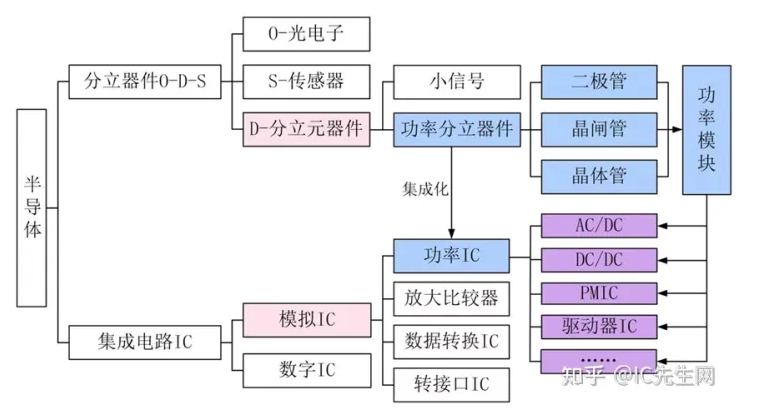
功率半導(dǎo)體的知識總結(jié)(MOSFET/IGBT/功率電子器件/半導(dǎo)體分立器件)
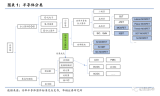
淺談功率半導(dǎo)體器件與普通半導(dǎo)體器件的區(qū)別






 功率半導(dǎo)體器件學(xué)習(xí)筆記(1)
功率半導(dǎo)體器件學(xué)習(xí)筆記(1)










評論