隨著芯片組結構日益推崇并不斷擴大其應用范圍,從高端AI芯片到大眾消費電子市場,預計這將推動先進封裝市場高速增長。業內預計,該市場由此前的不到10%的復合年增長率提升到超越整個半導體行業,甚至超過傳統的后端測試市場。
目前半導體工藝已逼近摩爾定律的物理極限,即將進入“子組件集成”階段。然而,據預測,一旦制程達到或低于3納米,眾多芯片設計將轉而采用芯片組結構。金融機構的數據顯示,芯片組將驅動先進封裝的需求,預計到2024年,全球芯片組市場規模將激增至505億美元。其中,服務器和智能手機將成為主要的應用領域,高性能計算機則更傾向于采用2.5D或3D封裝。
從長遠來看,研究機構MIC表示,高性能GPU的引入將開啟HBM高帶寬內存的新階段,催生先進封裝和異構集成技術的進一步發展,并且將使存儲芯片制造商、IC設計商、硅片制造商以及先進封裝從業人員不得不進行更加緊密的協作。
根據行業預測,2.5D和3D先進封裝市場規模將由現在的92億美元增長至258億美元,每年的復合增長率高達18.7%。
諸如臺積電,三星,英特爾等全球知名半導體大廠都在全力投入高級封裝技術的研發和多芯片整合戰略,以此作為瞄準高端芯片市場的重要策略之一。另外,知名封裝測試制造商日月光已經準備好,隨時可以提供高密度芯片整合解決方案。此外,如安靠,長電科技等公司也迅速加入了先進封裝市場,釋放出全球超過80%先進封裝產能。
-
芯片
+關注
關注
459文章
52464瀏覽量
440203 -
半導體
+關注
關注
335文章
28865瀏覽量
237124 -
先進封裝
+關注
關注
2文章
472瀏覽量
615
發布評論請先 登錄
大摩預測CPO市場年增長率高達172%
半導體材料市場規模不斷增長 國產化持續推進
全球半導體市場規模預測
無人叉車的市場規模怎么樣?適合使用agv的企業有哪些共同點?

液壓市場規模穩健增長,博科測試IPO上市迎發展良機
2024年全球芯片市場規模將達6298億美元
RFID電子標簽預計在2030年全球市場規模將達到75.1億美元

SoC芯片市場前景廣闊,2029年規模將超2000億美元
SoC芯片,市場規模大漲

扇出型 (Fan-Out)封裝市場規模到2028 年將達到38 億美元
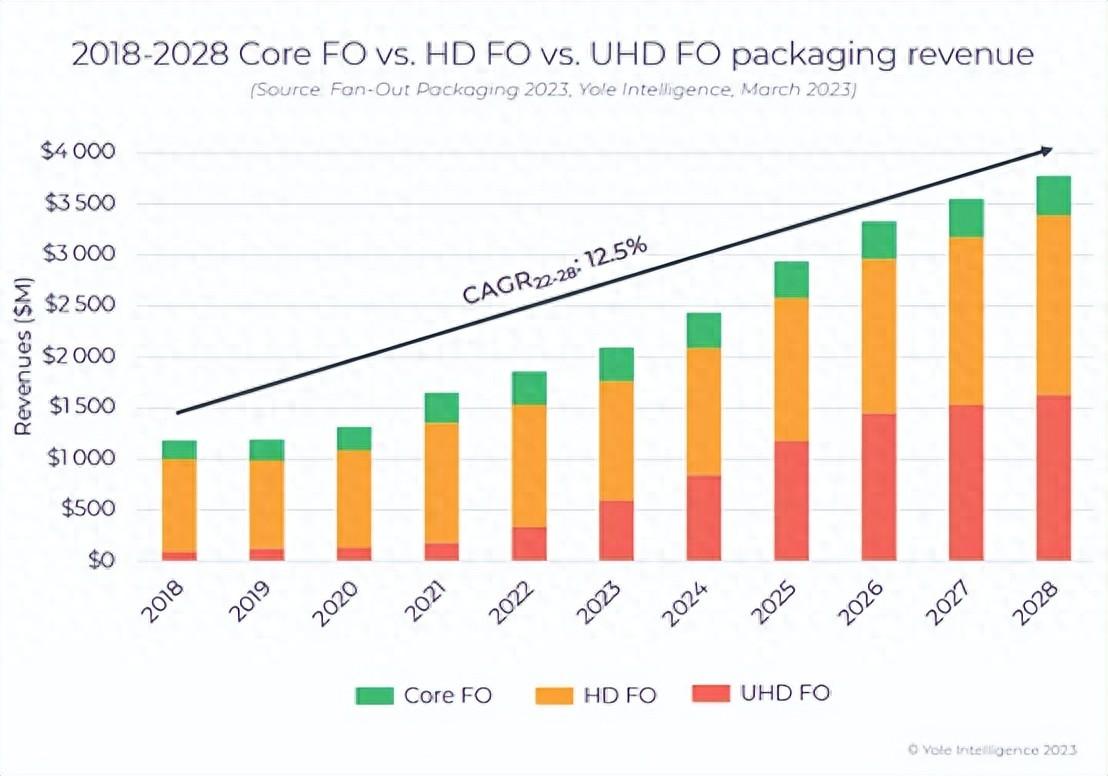





 小芯片架構催生先進封裝需求,市場規模增長率超10%?
小芯片架構催生先進封裝需求,市場規模增長率超10%?














評論