2D芯片設計中通常為二階或三階的效應,在Multi-Die系統(tǒng)中升級為主要效應。考慮到此類復雜架構中存在許多相互依賴關系,上述現(xiàn)象并不奇怪。例如,一個裸片的散熱可能會影響其旁邊組件乃至整個系統(tǒng)的性能。此外,由于散熱變得更加困難,3D設計中的熱和功率傳輸問題會更加嚴重。類似地,來自一個小芯片的信號完整性問題(串擾和電磁干擾等)可能會影響整個系統(tǒng)。諸如此類的大量多物理場效應會妨礙Multi-Die系統(tǒng)的性能。
從單片式SoC轉變到Multi-Die系統(tǒng),需要考慮許多新的因素。在Multi-Die這個新領域,開發(fā)者無法將封裝或單個裸片在整個系統(tǒng)中分開看待。為了獲得理想的系統(tǒng)并加速流程收斂,從技術到裸片和封裝,都必須著眼于整個系統(tǒng),而且要在緊密集成的多目標分析的指導下進行協(xié)同優(yōu)化。我們將這種密切配合的方法稱為系統(tǒng)技術協(xié)同優(yōu)化(STCO)。
STCO最好從構思系統(tǒng)之初就開始進行。從可行性研究和架構規(guī)劃,到實現(xiàn)和簽核,將多物理場效應考慮在內的裸片/封裝全面協(xié)同設計方法對于設計成功至關重要。我們將在下文中進一步介紹協(xié)同設計和協(xié)同優(yōu)化的重要性。
多個裸片的集成會形成相互依賴關系
為了滿足高性能計算(HPC)和人工智能(AI)等工作負載密集型應用對性能、功耗和面積(PPA)的要求,市場對Multi-Die系統(tǒng)的需求日益增長。Multi-Die系統(tǒng)在單個封裝中集成了多個包含不同類型電路的裸片,這是一種加速系統(tǒng)功能擴展的有效方法。有了關鍵性能指標(KPI),開發(fā)者就可以相應地規(guī)劃具體的系統(tǒng)和組件。
單片式SoC中雖然也存在多物理場效應,但通常可以預先建模和分析,并通過設計調整來解決。而對于Multi-Die系統(tǒng),這些效應不加以解決的話,會對整個系統(tǒng)造成更大的損害。
例如:
由于眾多裸片通過Die-to-Die接口相互通信,系統(tǒng)變得更容易受到電磁干擾(EMI)和串擾等信號完整性問題的影響
散熱問題上升為最主要的問題,因為系統(tǒng)中的所有裸片以及它們之間的互連都可能會積聚熱量,從而影響系統(tǒng)的性能和/或時序
系統(tǒng)配電網絡一方面要減輕EMI等影響,另一方面要提供整個芯片系統(tǒng)所需的電力,因此其魯棒性至關重要
芯片制造、組裝和封裝產生的機械應力會影響系統(tǒng)的電氣性能
系統(tǒng)各個裸片的工藝變化會影響系統(tǒng)性能
為了解決這些效應和影響,開發(fā)者必須在Multi-Die系統(tǒng)的背景下進行系統(tǒng)分析,檢查所有物理方面和相互作用,以驗證和優(yōu)化系統(tǒng)。從電氣和熱效應到結構力學,多種屬性必須一起進行仿真,以識別系統(tǒng)層面的電源和信號完整性影響。為此,需要用到統(tǒng)一的STCO解決方案,以提供全面的設計收斂,使每立方毫米的PPA達到最優(yōu)水平。
盡早了解設計權衡
STCO開始于開發(fā)者設計規(guī)劃架構之初。在團隊確定系統(tǒng)的組件以及應當如何對所有組件進行分區(qū)時,團隊需要能夠進行假設分析以了解設計權衡。當轉向實現(xiàn)時,架構的粒度越細,設計收斂到簽核的過程就越順利。在早期設計階段,可獲得的信息有限;但是,系統(tǒng)原型設計有助于回答以下幾個問題:需要多少個裸片?裸片應該如何堆疊?系統(tǒng)中新舊節(jié)點混用有哪些利弊?配電網絡應該如何設計?可能會出現(xiàn)什么樣的散熱問題?當團隊得到一個滿足要求的架構時,便可從可行性研究中獲取輸出,并轉入系統(tǒng)規(guī)劃和原型構建。
新思科技Multi-Die系統(tǒng)解決方案為實現(xiàn)快速的2.5D和3D異構集成提供了一個綜合平臺以支持STCO方法,幫助回答上述的假設分析問題。該解決方案通過以下兩個關鍵組成部分解決多物理場效應:
新思科技3DIC Compiler Multi-Die/封裝協(xié)同設計和協(xié)同優(yōu)化平臺,提供建模功能和相關數(shù)據(jù)點,可指導開發(fā)系統(tǒng)版圖規(guī)劃以實現(xiàn)目標PPA。3DIC Compiler基于新思科技數(shù)字設計系列的Fusion標準單數(shù)據(jù)模型構建,提供一個完整的架構到簽核平臺。
設計分析和簽核技術,解決靜態(tài)時序、信號完整性、電源完整性、散熱、寄生效應和電遷移/IR壓降問題。3DIC Compiler和新思科技簽核解決方案與Ansys RedHawk-SC電熱多物理場技術相集成,為2.5D/3D Multi-Die系統(tǒng)提供多物理場電源完整性、信號完整性、熱完整性和機械應力仿真與分析。
由于Multi-Die系統(tǒng)解決方案的各組成部分緊密集成,開發(fā)者可以及早發(fā)現(xiàn)并解決問題,實現(xiàn)更高的良率。不同的工具可以用于各個方面的分析,但如果這些工具銜接得不好,就可能會錯過重要的“危險信號”,導致開發(fā)者可能不得不在接近流片時才發(fā)現(xiàn)問題,此時再解決問題所花費的成本要高得多。新思科技不斷評估新出現(xiàn)的Multi-Die系統(tǒng)效應,并相應地增強旗下的解決方案。
總結
在Multi-Die系統(tǒng)中,開發(fā)者必須從系統(tǒng)的角度解決多物理場效應,設計和優(yōu)化過程要考慮所有相互依賴關系。通過運用系統(tǒng)技術協(xié)同優(yōu)化方法,并結合集成的可擴展協(xié)同設計、分析和簽核解決方案,開發(fā)者將能夠更高效地實現(xiàn)Multi-Die系統(tǒng)的PPA目標。
審核編輯:劉清
-
芯片設計
+關注
關注
15文章
1087瀏覽量
55669 -
電磁干擾
+關注
關注
36文章
2393瀏覽量
106603 -
人工智能
+關注
關注
1807文章
49029瀏覽量
249653 -
HPC
+關注
關注
0文章
333瀏覽量
24340
原文標題:多物理場效應不是事兒!如何輕松搞定高性能Multi-Die系統(tǒng)?
文章出處:【微信號:Synopsys_CN,微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
新思科技與三星深化合作加速AI和Multi-Die設計
利用新思科技Multi-Die解決方案加快創(chuàng)新速度

英飛凌發(fā)布全新高性能PSOC Control微控制器系列
新思科技助力下一代數(shù)據(jù)中心AI芯片設計

新思科技與英特爾攜手完成UCIe互操作性測試
新思科技全新40G UCIe IP解決方案助力Multi-Die設計
新思科技助力晶圓代工廠迎接Multi-Die設計浪潮
米爾瑞芯微RK3576實測輕松搞定三屏八攝像頭
RK3576有多強?實測三屏八攝像頭輕松搞定

利用Multi-Die設計的AI數(shù)據(jù)中心芯片對40G UCIe IP的需求
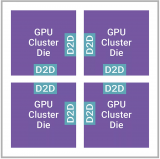
鴻蒙原生頁面高性能解決方案上線OpenHarmony社區(qū) 助力打造高性能原生應用
晟聯(lián)科UCIe+SerDes方案塑造高性能計算(HPC)新未來






 如何輕松搞定高性能Multi-Die系統(tǒng)?
如何輕松搞定高性能Multi-Die系統(tǒng)?

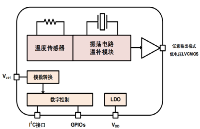










評論