隨著背面供電技術(shù)的完善和新型2D通道材料的采用,英特爾正致力于繼續(xù)推進摩爾定律,在2030年前實現(xiàn)在單個封裝內(nèi)集成1萬億個晶體管。
包括PowerVia背面供電技術(shù)、用于先進封裝的玻璃基板和Foveros Direct技術(shù)預計將在2030年前投產(chǎn)。
12月9日,英特爾在IEDM 2023(2023 IEEE 國際電子器件會議)上展示了使用背面電源觸點將晶體管縮小到1納米及以上范圍的關(guān)鍵技術(shù)。英特爾表示將在2030年前實現(xiàn)在單個封裝內(nèi)集成1萬億個晶體管。
PowerVia背面供電技術(shù)預計將于2024年隨Intel 20A制程節(jié)點推出。
英特爾表示,其將繼續(xù)推進摩爾定律的研究進展,包括背面供電和直接背面觸點(direct backside contacts)的3D堆疊CMOS晶體管,背面供電研發(fā)突破的擴展路徑(如背面觸點),并在同一塊300毫米晶圓上(而非封裝)中實現(xiàn)硅晶體管與氮化鎵(GaN)晶體管的大規(guī)模單片3D集成。
隨著遵循摩爾定律的半導體技術(shù)不斷推進,半導體芯片的集成度越來越高,目前衡量芯片的微觀集成密度的單位也從納米轉(zhuǎn)向埃米(1埃米等于一百億分之一米,是納米的十分之一)。
“我們正在進入制程技術(shù)的埃米時代,展望‘四年五個制程節(jié)點’計劃實現(xiàn)后的未來,持續(xù)創(chuàng)新比以往任何時候都更加重要。”英特爾公司高級副總裁兼組件研究總經(jīng)理桑杰·納塔拉詹(Sanjay Natarajan)表示,“英特爾展示了繼續(xù)推進摩爾定律的研究進展,這顯示了我們有能力面向下一代移動計算需求,開發(fā)實現(xiàn)晶體管進一步微縮和高能效比供電的前沿技術(shù)。”
據(jù)國際數(shù)據(jù)公司(IDC)預計,全球人工智能硬件市場(服務(wù)器)規(guī)模將從2022年的195億美元增長到2026年的347億美元,五年復合增長率達17.3%。其中,用于運行生成式人工智能的服務(wù)器市場規(guī)模在整體人工智能服務(wù)器市場的占比將從2023年的11.9%增長至2026年的31.7%。
據(jù)英特爾透露,包括PowerVia背面供電技術(shù)、用于先進封裝的玻璃基板和Foveros Direct技術(shù)預計將在2030年前投產(chǎn)。
英特爾技術(shù)發(fā)展總監(jiān)毛羅·科布林斯基(Mauro Kobrinsky)表示:“摩爾定律推動著更多晶體管的集成,這又推動著更多的層次和更小的導線,增加了復雜性和成本。每一層次都必須提供信號和電源導線,這通常會導致優(yōu)化妥協(xié)和資源爭奪,形成互聯(lián)瓶頸,事情變得越來越具有挑戰(zhàn)性。”“背面電源從根本上改變了這種情況,通過在器件的兩側(cè)和垂直互連中使用電源過孔。我們明年將能夠在半導體Intel 20A(2nm)和18A(1.8nm)中部署這項技術(shù),這意味著在前面減少導線,因此我們可以放寬間距,不再需要進行優(yōu)化妥協(xié)。”
“在電源過孔之外,我們的研究還涉及背面接觸,這使我們首次能夠連接器件兩側(cè)的晶體管。我們已經(jīng)能夠在研究中制造這些接觸,并且前后接觸無需使用電源過孔進行布線。這使我們能夠減小電池的電容,提高性能并降低功耗。”科布林斯基說。
英特爾認為,晶體管微縮和背面供電是滿足世界對更強大算力指數(shù)級增長需求的關(guān)鍵。隨著背面供電技術(shù)的完善和新型2D通道材料的采用,英特爾致力于繼續(xù)推進摩爾定律,在2030年前實現(xiàn)在單個封裝內(nèi)集成1萬億個晶體管。
審核編輯:黃飛
-
英特爾
+關(guān)注
關(guān)注
61文章
10183瀏覽量
174153 -
摩爾定律
+關(guān)注
關(guān)注
4文章
638瀏覽量
79732 -
晶體管
+關(guān)注
關(guān)注
77文章
9995瀏覽量
140954 -
人工智能
+關(guān)注
關(guān)注
1805文章
48843瀏覽量
247406
原文標題:英特爾:2030年前實現(xiàn)在單個封裝內(nèi)集成1萬億個晶體管
文章出處:【微信號:現(xiàn)代電子技術(shù),微信公眾號:現(xiàn)代電子技術(shù)】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
下一代高速芯片晶體管解制造問題解決了!
英特爾持續(xù)推進核心制程和先進封裝技術(shù)創(chuàng)新,分享最新進展

英特爾先進封裝:助力AI芯片高效集成的技術(shù)力量

詳細解讀英特爾的先進封裝技術(shù)

英特爾IEDM 2024大曬封裝、晶體管、互連等領(lǐng)域技術(shù)突破

英特爾展示互連微縮技術(shù)突破性進展
晶體管與場效應(yīng)管的區(qū)別 晶體管的封裝類型及其特點
英特爾宣布擴容成都封裝測試基地
英特爾擴容在成都的封裝測試基地
技術(shù)前沿:“環(huán)抱”晶體管與“三明治”布線
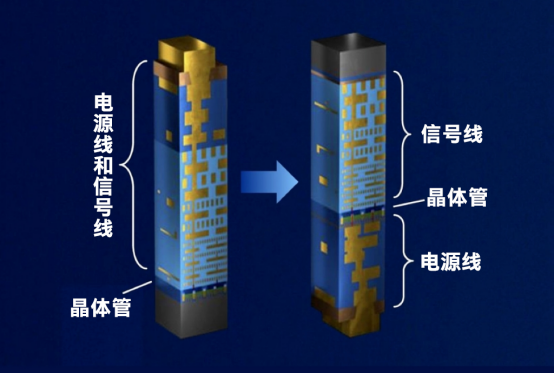
英特爾是如何實現(xiàn)玻璃基板的?
英特爾計劃最快2026年量產(chǎn)玻璃基板
英特爾OCI芯粒在新興AI基礎(chǔ)設(shè)施中實現(xiàn)光學I/O(輸入/輸出)共封裝
英特爾實現(xiàn)光學IO芯粒的完全集成
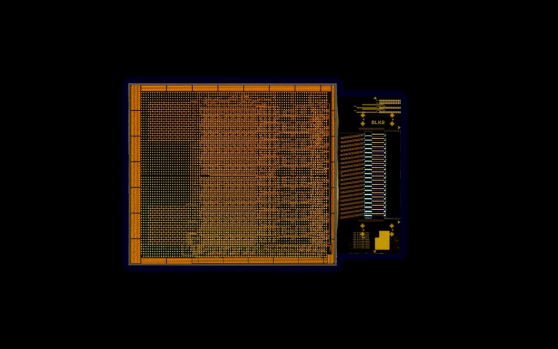





 英特爾:2030年前實現(xiàn)單個封裝內(nèi)集成1萬億個晶體管
英特爾:2030年前實現(xiàn)單個封裝內(nèi)集成1萬億個晶體管










評論