EUV光源系統中的帶外光
目前,商用EUV***采用激光等離子體型-極紫外(LPP-EUV)光源系統,主要由驅動激光器、液滴錫靶、收集鏡組成。在驅動激光器兩次精確轟擊液滴錫靶后,錫將被完全電離并產生高能量的EUV輻射,由收集鏡反射并聚焦到一個焦點(IF點)后進入后續光路的傳輸。
在激發和聚焦EUV的過程中,往往伴隨著其它波段光(Out-of-band, OoB)的產生與匯聚。這些光有的可以使用背景氫氣去除,有的對光刻膠不敏感,因此它們帶來的影響很小。但是,還有些波段的光卻會對整個光刻系統造成嚴重的損傷并影響最終的成像性能,如:300 nm以下的深紫外光(deep ultraviolet, DUV)和紅外光(infrared, IR)。前者產生于激光轟擊錫靶的過程,由于光刻膠對該波段光非常敏感,因此會導致光刻圖案對比度的降低;而后者則來源于驅動激光,其高能量將使光學元件、掩膜、晶圓出現不同程度的加熱現象,從而降低圖案精度并損傷光學元件。不僅如此,收集鏡表面對前者的反射率大小幾乎與EUV相同,而對后者反射率則接近100%,如圖1所示。以IR為例,作為驅動光源的激光器功率要求為20 kW,在經過收集鏡反射與匯聚后,其達到IF點的功率仍有近10%,也就是約2 kW;然而,若要使IR對整個系統幾乎不產生影響,則需要再將其IF點處的功率縮小至少1%,也就是僅20 W以下。在如此高要求下,倘若不對這些OoB輻射進行濾除,使其都經過收集鏡反射并進入到后續光路,將會極大地降低光源系統的性能,因此濾除OoB輻射是非常必要的。
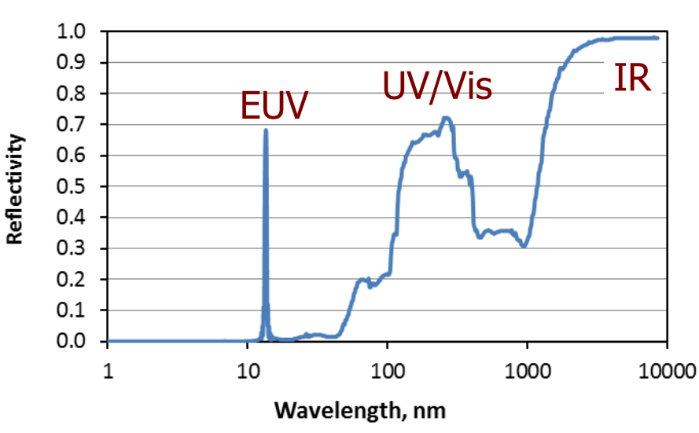
圖1 收集鏡表面鉬/硅多層膜(周期為6.9 nm,鉬/硅比為0.4的50層鉬/硅多層膜)對不同波段光的反射率計算結果 ^[^ ^1]^
EUV***光源系統中的濾波結構
中國科學院上海光機所強場激光物理國家重點實驗室林楠、冷雨欣團隊就EUV***光源系統中存在的帶外波段問題,系統闡述了EUVL光源濾波系統的關鍵技術、主要挑戰和未來趨勢。
在EUVL光源系統中,由等離子體產生的DUV和源于驅動光源的IR通常會對光刻性能和光學系統壽命產生較大的影響,并且收集鏡表面的鉬/硅多層膜結構對其均具有高反射率,因此EUVL光源濾波系統主要針對這二者展開設計。DUV的能量強度較低,使用透射式或反射式的獨立薄膜結構可以實現良好的濾波效果,但由于薄膜結構機械強度較低的特點容易導致薄膜破裂等問題,使用壽命較短。與之相比,具有高能量的IR無法簡單使用薄膜濾波器來濾除,而是需要在收集鏡襯底上加工多層光柵結構并鍍膜(如圖2所示),以將特定波長的IR通過衍射的方式實現濾除并保留盡可能多的EUV輻射(如圖3所示)。該方法對光柵結構的設計、加工與量測均提出了非常高的要求,尤其體現在對光柵表面粗糙度與多層膜均勻性的控制,以及以高度為主的光柵結構參數對反射率的影響,其對我們量測的要求需要達到僅幾納米甚至亞納米量級。就整個EUVL光源系統而言,其濾波對象決定了最終的濾波系統難以單一結構形式存在,其需要同時考慮獨立式的薄膜結構與收集鏡內置光柵結構,以實現對光刻性能產生影響的OoB作整體濾除,從而保證EUV光源的純度。
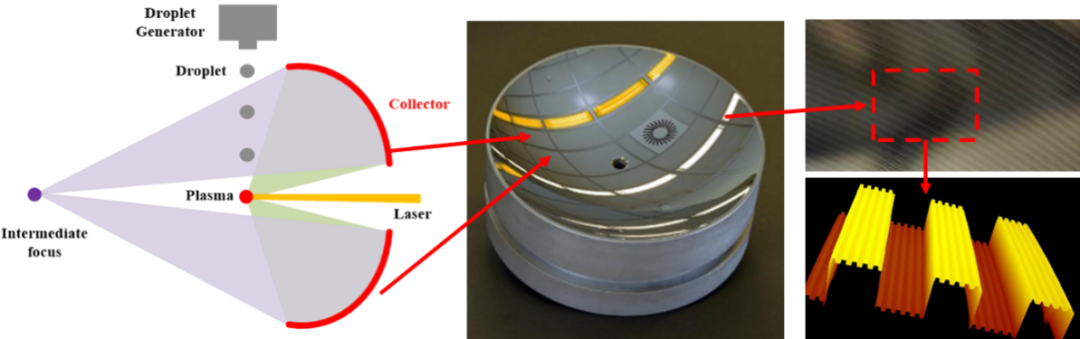
圖2 收集鏡內置光柵結構示意圖

圖3 收集鏡內置光柵結構對IR濾波的原理示意圖
總結與展望
文章綜述了EUVL光源濾波系統的主流技術方案,分析了濾除OoB輻射的關鍵技術,并結合實際應用,探討了目前面臨的主要挑戰與未來發展趨勢。EUV光源的性能決定了光刻圖案的性能,為最終獲得高純度EUV光源,無論是在提升濾波系統的設計方案、工藝制造上的先進性,還是在提升量測方式上的先進性,其都是缺一不可的。
審核編輯:劉清
-
激光器
+關注
關注
17文章
2698瀏覽量
62067 -
濾波系統
+關注
關注
0文章
7瀏覽量
6752 -
EUV光刻機
+關注
關注
2文章
129瀏覽量
15425
原文標題:上海光機所 | 如何獲得高純度的EUV光源?
文章出處:【微信號:光刻人的世界,微信公眾號:光刻人的世界】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
EUV不能只靠高NA,大功率光源也該提上日程了
怎么獲得被測光源的光功率分布?
深圳機器視覺led光源有什么優勢
投影光源的未來是主流光源LED嗎?
UVLED點光源優勢介紹
激光光源DLP拼接技術與LED光源的優劣分析

直流驅動LED光源系統介紹及LED光源技術的分析
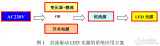
一種基于最先進激光器的新型實驗室EUV光源
哈工大的史詩級成果:DPP-EUV光源
這個光源的波長能成為EUV光刻機新的光源技術






 如何獲得高純度的EUV光源?EUVL光源濾波系統的主流技術方案分析
如何獲得高純度的EUV光源?EUVL光源濾波系統的主流技術方案分析
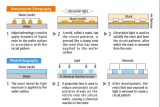










評論