來源:IEEE Spectrum
編譯:化合物半導體雜志
近日,在一場于圣何塞僅限受邀者參加的活動舉行之前的一次獨家采訪中,英特爾通過分享其未來數(shù)據(jù)中心處理器的一覽,概述了它將為其代工客戶提供的新型芯片技術。這些進步包括更密集的邏輯以及內(nèi)部連接性增加16倍的3D堆疊芯片,它們將是該公司與其他公司的芯片架構師共享的首批高端技術之一。
這些新技術將達到英特爾長達數(shù)年轉(zhuǎn)型的頂峰。這家處理器制造商正在從一家只生產(chǎn)自己芯片的公司轉(zhuǎn)變?yōu)橐患掖S,為其他公司生產(chǎn)芯片,并將自己的產(chǎn)品團隊視為另一個客戶。此次圣何塞的IFS Direct Connect活動旨在作為新商業(yè)模式的亮相派對。
英特爾內(nèi)部計劃在代號為Clearwater Forest的服務器CPU中使用這些技術組合。該公司認為該產(chǎn)品是一種具有數(shù)千億個晶體管的片上系統(tǒng),是其代工業(yè)務的其他客戶能夠?qū)崿F(xiàn)的目標的一個例子。
英特爾數(shù)據(jù)中心技術和探路總監(jiān)Eric Fetzer表示,“我們的目標是讓計算達到我們能夠?qū)崿F(xiàn)的最佳每瓦性能”。這意味著會應用該公司最先進的制造技術Intel 18A。
3D堆疊“通過縮短躍點來改善計算和內(nèi)存之間的延遲,同時啟用更大的緩存”
—PUSHKAR RANADE
他補充道:“但是,如果我們將該技術應用于整個系統(tǒng),就會遇到其他潛在問題,系統(tǒng)的某些部分不一定能像其他部分一樣可擴展。邏輯通常可以根據(jù)摩爾定律很好地擴展一代又一代。”而其他功能則不然。例如,SRAM(CPU的高速緩存)一直滯后于邏輯。連接處理器和計算機其余部分的I/O電路則更加落后。
面對這些現(xiàn)實,正如所有領先處理器制造商現(xiàn)在面臨的那樣,英特爾將Clearwater Forest的系統(tǒng)分解為其核心功能,選擇最適合的技術來構建每個功能,并使用一套新技術將它們重新縫合在一起。其結果是CPU架構能夠擴展到多達3000億個晶體管。
在Clearwater Forest中,數(shù)十億個晶體管被分為三種不同類型的硅IC,稱為裸片或小芯片,將其互連并封裝在一起。該系統(tǒng)的核心是使用Intel 18A工藝構建的多達12個處理器核心小芯片。這些小芯片以3D方式堆疊在三個使用Intel 3構建的“基礎芯片”之上,該工藝為今年推出的Sierra Forest CPU制造計算核心。CPU的主高速緩存、電壓調(diào)節(jié)器和內(nèi)部網(wǎng)絡將安裝在基礎芯片上。高級首席工程師Pushkar Ranade表示:“堆疊通過縮短躍點來改善計算和內(nèi)存之間的延遲,同時啟用更大的緩存”。
最后,CPU的I/O系統(tǒng)將位于使用Intel 7構建的兩個芯片上,到2025年,該芯片將落后該公司最先進的工藝整整四代。事實上,這些小芯片與Sierra Forest和Granite Rapids CPU中的小芯片基本相同,從而減少了開發(fā)費用。
以下是相關新技術及其提供的功能:
3D混合鍵合
英特爾當前的芯片堆疊互連技術Foveros將一個芯片連接到另一個芯片,采用的是芯片長期以來與封裝連接方式的大幅縮小版本:焊料的微小“微凸塊”短暫熔化以連接芯片。這使得Meteor Lake CPU中使用的Foveros版本大約每36微米建立一個連接。Clearwater Forest將使用新技術Foveros Direct 3D,該技術不同于基于焊接的方法,可將3D連接的密度提高16倍。
它被稱為“混合鍵合”,類似于將兩個芯片表面的銅焊盤焊接在一起。這些焊盤稍微凹陷并被絕緣體包圍。當將兩個芯片壓在一起時,一個芯片上的絕緣體會粘附到另一芯片上。然后,對堆疊的芯片進行加熱,使銅在間隙中膨脹并粘合在一起,形成永久連接。其競爭對手臺積電在某些AMD CPU中使用混合綁定版本,將額外的高速緩存連接到處理器核心小芯片,并在AMD最新的GPU中將計算小芯片連接到系統(tǒng)的基礎芯片。
Fetzer表示,“混合鍵合互連能夠大幅提高”連接密度。“這種密度對于服務器市場非常重要,特別是因為這種密度驅(qū)動著非常低的皮焦每比特通信。” 如果每比特的能源成本太高,則數(shù)據(jù)從一個硅芯片傳輸?shù)搅硪粋€硅芯片所涉及的能量很容易消耗產(chǎn)品功率預算的很大一部分。Foveros Direct 3D使每比特的成本降至0.05皮焦耳以下,這使其與在硅芯片內(nèi)移動比特所需的能量處于同一水平。
節(jié)省的大部分能源來自于傳輸更少的銅線的數(shù)據(jù)。假設將一個芯片上的512總線連接到另一個芯片上相同大小的總線,這樣兩個芯片可以共享一組連貫的信息。在每個芯片上,這些總線可能窄至每微米10-20根線。要使用當今的36微米間距微凸塊技術將信號從一個芯片傳輸?shù)搅硪粋€芯片,意味著將這些信號分散到一側(cè)數(shù)百平方微米的硅上,然后將它們聚集到另一側(cè)的同一區(qū)域。Fetzer表示,對所有額外的銅和焊料進行充電“很快就會成為延遲和大功率問題”。相比之下,混合鍵合可以在幾個微凸塊占據(jù)的同一區(qū)域中進行總線到總線的連接。
盡管這些好處可能很大,但轉(zhuǎn)向混合鍵合并不容易。要形成混合鍵合,需要將已經(jīng)切割的硅芯片與仍附著在晶圓上的硅芯片連接起來。正確對齊所有連接意味著芯片必須被切割成比微凸塊技術所需的更大的公差。修復和恢復也需要不同的技術。Fetzer 表示,甚至連接失敗的主要方式也是不同的。對于微凸塊,則有可能因連接到相鄰焊點的一點焊料而發(fā)生短路。但對于混合鍵合,危險則是導致連接斷開的缺陷。
背面供電
該公司今年通過其英特爾20A工藝(將先于英特爾18A的工藝)為芯片制造帶來的主要區(qū)別之一是背面供電。在當今的處理器中,所有互連,無論是承載電力還是數(shù)據(jù),都構建在芯片的“正面”硅襯底上方。Foveros和其他3D芯片堆疊技術需要硅通孔、互連,這些互連可以向下鉆穿硅以從另一側(cè)建立連接。但背面電力傳輸更進一步。它將所有電源互連放置在硅下方,基本上將包含晶體管的層夾在兩組互連之間。
這種布置會產(chǎn)生相關影響,因為電源互連和數(shù)據(jù)互連需要不同的功能。電源互連需要較寬以減少電阻,而數(shù)據(jù)互連應較窄以便可以密集封裝。隨著今年下半年Arrow Lake CPU的發(fā)布,英特爾將成為第一家在商用芯片中引入背面供電的芯片制造商。英特爾去年夏天發(fā)布的數(shù)據(jù)顯示,僅背面供電就帶來了6%的性能提升。
英特爾18A工藝技術的背面供電網(wǎng)絡技術將與英特爾20A芯片中的技術基本相同。然而,它在Clearwater Forest中得到了更大的利用。即將推出的CPU在基礎芯片中包含所謂的“片上電壓調(diào)節(jié)器”。使電壓調(diào)節(jié)接近其驅(qū)動的邏輯意味著邏輯可以運行得更快。距離越短,調(diào)節(jié)器就能更快地響應電流需求的變化,同時消耗更少的功率。
由于邏輯芯片使用背面供電,因此電壓調(diào)節(jié)器和芯片邏輯之間的連接電阻要低得多。“通過技術提供的動力以及Foveros堆疊為我們提供了一種非常有效的連接方式,”Fetzer說道。
RibbonFET,下一代
除了背面電源之外,該芯片制造商還采用英特爾20A工藝改用不同的晶體管結構:RibbonFET。RibbonFET是一種納米片或環(huán)柵晶體管,自2011年以來取代了FinFET(CMOS 的主力晶體管)。對于Intel 18A,Clearwater Forest的邏輯芯片將采用第二代RibbonFET工藝制造。Fetzer表示,雖然這些器件本身與Intel 20A中出現(xiàn)的器件沒有太大區(qū)別,但器件的設計具有更大的靈活性。
他還表示,“除了實現(xiàn)高性能CPU所需的功能之外,還有更廣泛的器件可以支持各種代工應用,”這正是Intel 20A工藝的設計目的。
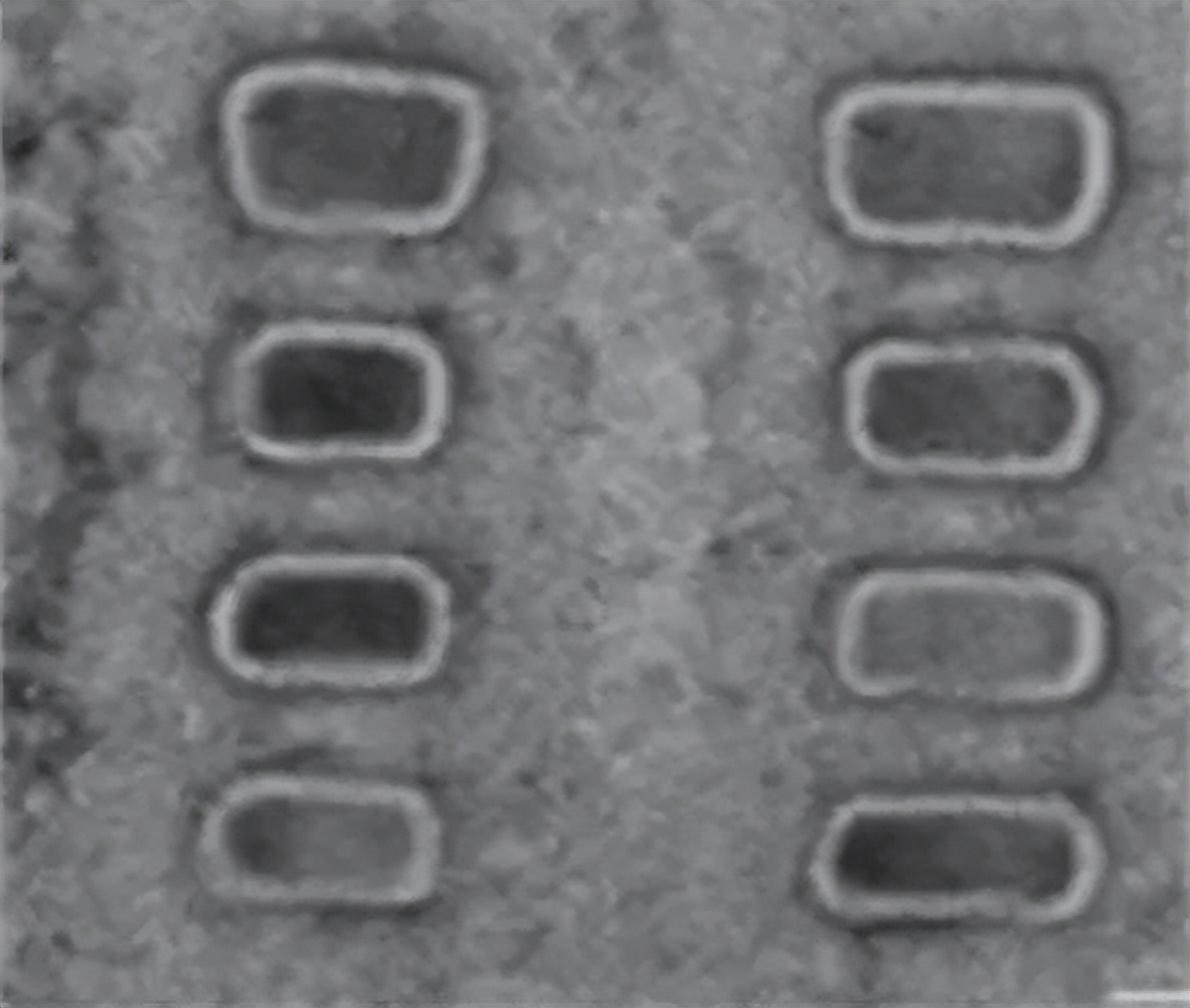
RibbonFET的納米線可以根據(jù)邏輯單元的需要具有不同的寬度。圖源:英特爾
其中一些變化源于FinFET時代失去的一定程度的靈活性。在 FinFET出現(xiàn)之前,采用相同工藝的晶體管可以制成多種寬度,從而允許在性能(伴隨更高電流)和效率(需要更好地控制漏電流)之間進行或多或少的連續(xù)權衡。由于FinFET的主要部分是具有規(guī)定高度和寬度的垂直硅鰭(fin),因此現(xiàn)在必須權衡一個器件具有多少鰭(fin)。因此,使用兩個鰭可以使電流加倍,但沒有辦法將其增加25%或50%。
有了納米片器件,改變晶體管寬度的能力又回來了。Fetzer說道:“RibbonFET技術可在同一技術基礎上實現(xiàn)不同尺寸的焊帶,當我們從英特爾20A轉(zhuǎn)向英特爾18A時,我們在晶體管尺寸方面提供了更大的靈活性。”
這種靈活性意味著設計人員可以用來構建系統(tǒng)的標準單元(基本邏輯塊)可包含具有不同屬性的晶體管。這使得英特爾能夠開發(fā)出一個“增強型庫”,其中包括比英特爾20A工藝的標準單元更小、性能更好或更高效的標準單元。
第二代EMIB
在Clearwater Forest中,處理輸入和輸出的芯片使用第二代英特爾EMIB水平連接到基礎芯片(具有高速緩存和網(wǎng)絡的芯片)。EMIB是一小塊硅,包含一組密集的互連和微凸塊,旨在將一個芯片連接到同一平面上的另一個芯片。硅被嵌入到封裝內(nèi)部,在芯片之間形成一個橋梁。
自Sapphire Rapids于2023年發(fā)布以來,該技術已在英特爾CPU中投入商業(yè)使用。它是一種成本較低的替代方案,可將所有芯片放在硅中介層上,硅中介層是一塊帶有互連圖案的硅片,其大小足以容納所有芯片。系統(tǒng)的芯片可供放置。除了材料成本之外,硅中介層的建造成本可能很高,因為它們通常比標準硅工藝設計的尺寸大幾倍。
第二代EMIB今年與Granite Rapids CPU一起首次亮相,它將微凸塊連接的間距從55微米縮小到45微米,并提高了電線的密度。這種連接的主要挑戰(zhàn)是封裝和硅在加熱時以不同的速率膨脹。這種現(xiàn)象可能會導致翹曲,從而破壞連接。
此外,就Clearwater Forest而言,F(xiàn)etzer說道:“還存在一些獨特的挑戰(zhàn),因為我們將常規(guī)芯片上的EMIB連接到Foveros Direct 3D基礎芯片和堆疊上的EMIB”。他表示,這種情況最近被重新命名為EMIB 3.5技術(以前稱為co-EMIB),需要采取特殊步驟來確保所涉及的應力和應變與Foveros堆疊中的硅兼容,F(xiàn)overos堆疊比普通芯片更薄。
審核編輯 黃宇
-
芯片
+關注
關注
459文章
52291瀏覽量
437635 -
英特爾
+關注
關注
61文章
10182瀏覽量
174137 -
3D芯片
+關注
關注
0文章
52瀏覽量
18715 -
FinFET
+關注
關注
12文章
256瀏覽量
90992 -
EMIB
+關注
關注
0文章
12瀏覽量
3969
發(fā)布評論請先 登錄
新思科技與英特爾在EDA和IP領域展開深度合作
英特爾持續(xù)推進核心制程和先進封裝技術創(chuàng)新,分享最新進展

?超景深3D檢測顯微鏡技術解析
英特爾塑造未來出行:AI增強型軟件定義汽車
英特爾與Stellantis Motorsports攜手推進自適應控制技術
英特爾代工在IEDM 2024展示多項技術突破
英特爾IEDM 2024大曬封裝、晶體管、互連等領域技術突破

英特爾Intel 18A制程芯片2025年量產(chǎn)計劃公布
3D打印技術應用的未來
英特爾推出全新實感深度相機模組D421
立體視覺新手必看:英特爾? 實感? D421深度相機模組






 最新技術!英特爾于IFS Direct Connect會議上公布3D芯片技術、邏輯單元、背面供電等未來代工技術!
最新技術!英特爾于IFS Direct Connect會議上公布3D芯片技術、邏輯單元、背面供電等未來代工技術!
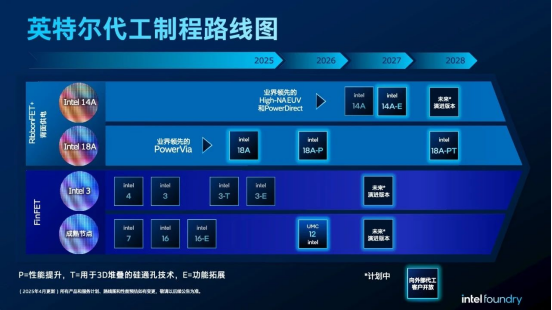










評論