01 過去一年,特思迪“提交的答卷”
2023年對于特思迪來說,可謂是“厚積薄發(fā)”的一年。“相比2022年,特思迪營收增長了81.5%,實現(xiàn)公司連續(xù)4年的年均收入增長率高于80%的高增速;公司的科創(chuàng)屬性繼續(xù)增強,2023年申請國內(nèi)外專利及授權(quán)數(shù)量大幅攀升。”CEO劉泳灃先生在對外演講中披露道。
據(jù)了解,北京特思迪半導(dǎo)體設(shè)備有限公司(簡稱:特思迪),是一家擁有自主知識產(chǎn)權(quán)的國家高新技術(shù)企業(yè),專注于半導(dǎo)體領(lǐng)域超精密平面加工設(shè)備的研發(fā)、生產(chǎn)和銷售。以“引領(lǐng)半導(dǎo)體技術(shù)進步,助力客戶發(fā)展”為使命,致力于成為全球技術(shù)領(lǐng)先的半導(dǎo)體設(shè)備制造企業(yè)。深耕半導(dǎo)體襯底材料、晶圓制造、半導(dǎo)體器件、先進封裝、MEMS等領(lǐng)域的超精密平面加工技術(shù),形成了技術(shù)領(lǐng)先,性能優(yōu)越,工藝穩(wěn)定的核心技術(shù)優(yōu)勢,可提供減薄、拋光、CMP的系統(tǒng)解決方案和工藝設(shè)備。
特思迪多次承擔(dān)國家級、省級重大課題研究,并榮獲國家高新技術(shù)企業(yè)認定。擁有自主知識產(chǎn)權(quán)專利申請及授權(quán)100余項,主要產(chǎn)品核心部件均已國產(chǎn)化,目前已實現(xiàn)化合物半導(dǎo)體專用減薄、拋光設(shè)備的規(guī)模化量產(chǎn)。
02特思迪創(chuàng)新指數(shù)
在其官微“朋友圈”上,“研發(fā)力”、“新產(chǎn)品”、“博士后科研工作站”“知識產(chǎn)權(quán)試點單位”“B輪融資”……無一不體現(xiàn)著特思迪創(chuàng)新指數(shù)!
2023年,特思迪申請并獲得發(fā)明專利19個,實用新型專利4個,海外發(fā)明專利6個。據(jù)統(tǒng)計,目前,特思迪擁有自主知識產(chǎn)權(quán)專利申請及授權(quán)100余項,主要產(chǎn)品核心部件均已國產(chǎn)化,已實現(xiàn)化合物半導(dǎo)體專用減薄、拋光設(shè)備的規(guī)模化量產(chǎn)。
產(chǎn)品優(yōu)化方面,自2020年特思迪成立以來,先后成功發(fā)布多款擁有自主知識產(chǎn)權(quán)的多片式單/雙面拋光機、單片式拋光機、全自動雙軸減薄機、全自動化學(xué)機械拋光機等設(shè)備,工藝指標均達到國際領(lǐng)先水平,獲得頭部企業(yè)規(guī)模化訂單。憑借其強大的研發(fā)實力和先進的技術(shù),在市場競爭中占據(jù)了優(yōu)勢地位,實現(xiàn)了“從起步、發(fā)展到突破,一步一臺階”的穩(wěn)步跨越。2023年,更是突破2項技術(shù)關(guān)卡,自研核心EPD技術(shù),實現(xiàn)多層介質(zhì)、復(fù)雜環(huán)境、大工作距離下100nm及以上晶圓膜厚的原位在線測量以及核心部件電主軸,具備軸高轉(zhuǎn)速、高精度、低摩擦的特點,可實現(xiàn)連續(xù)、高效、穩(wěn)定、高質(zhì)量表面加工效果。新增4臺新設(shè)備,全面布局寬禁帶半導(dǎo)體賽道:
1、雙工位單面拋光機TAP-500Dual,較單機效率提升100%;
2、雙面清洗機TSC-150C,可實現(xiàn)3-6英寸晶圓的雙面刷洗清洗;
3、雙面清洗機TSC-200C,可實現(xiàn)6-8英寸晶圓的雙面刷洗清洗;
4、金剛石拋光機TGP-1060 ,可實現(xiàn)金剛石襯底高速高效研磨拋光。
其中,在碳化硅襯底領(lǐng)域推出了新款雙工位單面拋光機,較單機效率提升100%。自主研發(fā)第一臺全自動CMP后清洗機。為滿足市場對金剛石襯底的加工需求,研發(fā)出金剛石拋光機,可實現(xiàn)金剛石襯底高速高效研磨拋光。各項設(shè)備功能、工藝指標均達到國際一流設(shè)備水平。
同時獲批成立博士后科研工作站。特思迪博士后科研工作站將圍繞公司在半導(dǎo)體磨拋設(shè)備領(lǐng)域的技術(shù)探索,推動公司在技術(shù)突破、產(chǎn)品研發(fā)、人才引進等關(guān)鍵環(huán)節(jié)的發(fā)展進程,標志著特思迪的科技創(chuàng)新戰(zhàn)略和研發(fā)工作進入了新階段。
早在2022年初,華為哈勃投資了特思迪,持有特思迪10%的股權(quán)。2023年10月30日,特思迪又完成B輪融資,投資方包括:臨芯投資、北京市高精尖基金、尚頎資本、中金啟辰、優(yōu)山資本、芯微投資、長石資本、渾璞資本、博眾信合、安芯投資及洪泰基金。
特思迪發(fā)展如此迅速,離不開堅持核心自研,合作互補。更離不開市場需求推動。那么減薄拋光工藝環(huán)節(jié)在半導(dǎo)體產(chǎn)業(yè)究竟占據(jù)什么地位?
03
減薄拋光工藝助力突破摩爾定律
半導(dǎo)體產(chǎn)業(yè)是現(xiàn)代科技發(fā)展的原始驅(qū)動力,代表一個國家科學(xué)技術(shù)發(fā)展最高水平。由于現(xiàn)代計算機、通信和電子設(shè)備引領(lǐng),包括醫(yī)療、汽車、航空航天、工業(yè)自動化等領(lǐng)域的高速發(fā)展,半導(dǎo)體行業(yè)一直處于不斷創(chuàng)新的前沿,而行業(yè)所涉及的微納米尺度制造和加工技術(shù)需要精確的控制和極高的工藝精度——比如,近年來因國際環(huán)境變化而凸顯的“卡脖子”問題中最廣為人知的便是“光刻機”。其實光刻機僅是在晶圓上創(chuàng)建微小的結(jié)構(gòu)和電路的設(shè)備,行業(yè)從晶圓制備到封裝再到芯片集成涉及多個復(fù)雜工序——比如減薄拋光,不僅可以滿足尺寸要求,還可以優(yōu)化器件性能、改善光學(xué)性能、降低功耗、促進堆疊集成等,對于現(xiàn)代半導(dǎo)體器件的高性能和高可靠性起著關(guān)鍵作用。
隨著半導(dǎo)體特征尺寸的不斷減小,集成電路器件單位面積內(nèi)集成的晶體管數(shù)量增長處于極限,多層布線和3D封裝技術(shù)的應(yīng)用成為集成電路制造突破摩爾定律物理極限的重要解決方案。多層布線和3D封裝的加工工藝對集成電路的平整度提出了更高的要求,而化學(xué)機械拋光和機械磨削的晶圓超精密減薄技術(shù)是目前集成電路整體平坦化和減薄的主流加工方式。
晶圓減薄機是實現(xiàn)晶圓減薄工藝的關(guān)鍵設(shè)備。在集成電路后道封裝工藝中,晶圓背面減薄是第一道關(guān)鍵工藝,晶圓減薄能去除晶圓背面多余的基體材料,進而減小芯片封裝體積、提高芯片散熱效率和電氣性能,是實現(xiàn)3D、集成電路制造的關(guān)鍵技術(shù)之一。晶圓在被磨削減薄后需要再經(jīng)過CMP處理,從而獲得表面光滑平整的晶圓。當(dāng)晶圓被減薄到150 μm以下時,傳輸搬運則成為了較大的生產(chǎn)風(fēng)險,尤其是300 mm的大尺寸規(guī)格晶圓物理特性更加脆弱。磨削和CMP的設(shè)備集成可以減少晶圓的搬運次數(shù),降低晶圓破碎的風(fēng)險。先進封裝減薄設(shè)備在向集成化、一體化方向發(fā)展。
另外,研發(fā)新材料體系是突破摩爾定律的另一大嘗試。
近年來,隨著科技的持續(xù)進步,化合物半導(dǎo)體正逐漸成為眾多行業(yè)追求技術(shù)創(chuàng)新和突破的核心力量,特別是在新能源、5G通信、物聯(lián)網(wǎng)(IoT)、自動化駕駛及人工智能(AI)等前沿技術(shù)領(lǐng)域中展現(xiàn)出了巨大的應(yīng)用潛力。根據(jù)Yole Group發(fā)布的《2024年化合物半導(dǎo)體行業(yè)現(xiàn)狀》報告,碳化硅(SiC)、硅基氮化鎵(GaN on Si)、砷化鎵(GaAs)、磷化銦(InP)和藍寶石等襯底在功率電子、射頻(RF)、光子學(xué)和顯示技術(shù)等領(lǐng)域的應(yīng)用越來越廣泛。
其中SiC作為新型的寬禁帶半導(dǎo)體材料,因其出色的物理及電學(xué)特性,越來越受到產(chǎn)業(yè)界的廣泛關(guān)注。SiC功率器件的重要優(yōu)勢在于可以實現(xiàn)更高壓(達數(shù)萬伏)、更高溫(大于500℃)環(huán)境應(yīng)用,突破了硅基功率器件電壓(數(shù)千伏)和溫度(小于150℃)限制。因此,SiC已成為下一代功率半導(dǎo)體器件的重要材料選擇。通常,SiC功率器件采用垂直結(jié)構(gòu),以實現(xiàn)大電流處理能力,但較厚的襯底會在器件的通態(tài)電阻中引入較大的串聯(lián)電阻,限制器件可以承載的極限電流密度。因此,為了充分發(fā)揮SiC器件的優(yōu)勢特性,對襯底進行減薄是十分必要的優(yōu)化工藝手段。
隨著后摩爾時代的到來,大家在新材料領(lǐng)域的研發(fā)投入不斷增長。目前以氧化鎵Ga2O3、氮化鋁AlN、金剛石Diamond為代表的超寬禁帶新興材料,應(yīng)用前景和市場潛力是無需質(zhì)疑的。這類半導(dǎo)體具有禁帶寬度大、耐擊穿、載流子遷移率高、熱導(dǎo)率極高、抗輻照等優(yōu)點,在熱沉、大功率、高頻器件、光學(xué)窗口、量子信息等領(lǐng)域具有極大應(yīng)用潛力。
雖然目前仍處于不斷發(fā)展和完善的階段,但未來將有更多的技術(shù)創(chuàng)新和突破,隨著技術(shù)的進步和產(chǎn)業(yè)化的推進,終端市場對超寬禁帶材料的需求有望增加,相關(guān)產(chǎn)業(yè)也將迎來發(fā)展機遇。
所以說,不管從封裝集成角度,還是新材料體系,減薄拋光工藝是突破摩爾定律關(guān)鍵技術(shù)之一,對于現(xiàn)代半導(dǎo)體器件的高性能和高可靠性起著關(guān)鍵作用。
04
2024年,8英寸碳化硅規(guī)模化量產(chǎn)是行業(yè)突破的關(guān)鍵
當(dāng)前,全球半導(dǎo)體行業(yè)發(fā)展迅速、技術(shù)競爭激烈、市場前景廣闊。受益于國家經(jīng)濟刺激政策的實施以及新能源、新技術(shù)的應(yīng)用,中國的化合物半導(dǎo)體行業(yè)也正在迅速崛起,成為全球半導(dǎo)體行業(yè)中的重要參與者之一,并實現(xiàn)了8寸碳化硅襯底和外延的突破。
SiC產(chǎn)業(yè)的上游原始材料襯底生產(chǎn),是該行業(yè)發(fā)展的關(guān)鍵環(huán)節(jié),直接影響著SiC器件的最終成本。當(dāng)前國內(nèi)生產(chǎn)主要集中在4英寸到6英寸階段,相較于6英寸,8英寸SiC仍存在許多需要克服的工藝和成本上的難題。如何使其襯底成本進一步降低,這是目前國內(nèi)碳化硅行業(yè)亟待克服的難點,也是國內(nèi)SiC產(chǎn)業(yè)發(fā)展的必然趨勢。通過發(fā)展長晶工藝助力襯底良率的提升,這也是源頭解決企業(yè)發(fā)展乃至行業(yè)發(fā)展的重中之重。同時切磨拋工藝是降低制造成本,提升產(chǎn)品良率的第二道關(guān)卡。裝備優(yōu)化至關(guān)重要。尺寸的增大也帶來加工方式的轉(zhuǎn)折,同時對生產(chǎn)設(shè)備提出了更高的要求。
“我們前期在大尺寸晶圓加工設(shè)備的研發(fā)正好能銜接市場變化的需求。公司在研發(fā)新型產(chǎn)品核心零部件及相關(guān)供應(yīng)鏈的自研能力上重點投入,成功研制出的8英寸碳化硅全自動減薄設(shè)備已切入市場,8英寸雙面拋光設(shè)備已通過工藝測試,進入量產(chǎn)階段。該系列設(shè)備突破關(guān)鍵技術(shù)及工藝,進一步推進碳化硅行業(yè)制造降本增效,助推碳化硅行業(yè)向規(guī)模化、低成本方向發(fā)展。”特思迪半導(dǎo)體CEO劉泳灃先生在過去的采訪中提到。
在半導(dǎo)體襯底及器件的加工制造流程中,磨拋是至關(guān)重要的部分,不僅考驗設(shè)備的穩(wěn)定性,對工藝技術(shù)積累和綜合理解方面有更高的要求。
從創(chuàng)立到領(lǐng)軍,特思迪圍繞化合物半導(dǎo)體,在設(shè)備研發(fā)和工藝研究上同步布局。著力在減薄、拋光等核心裝備和核心零部件上發(fā)力突破。特思迪在國內(nèi)碳化硅產(chǎn)業(yè)發(fā)展初期即深度參與下游頭部客戶襯底拋光設(shè)備的合作研發(fā),并伴隨企業(yè)工藝發(fā)展持續(xù)演進技術(shù)及產(chǎn)品,積累了大量的專有技術(shù),逐步向具有高技術(shù)壁壘的產(chǎn)業(yè)鏈上游延伸。同時,特思迪通過關(guān)鍵設(shè)備牽引,解決整線成套設(shè)備國產(chǎn)化,滿足半導(dǎo)體材料的多樣化磨拋工藝需求。通過對磨拋工藝原理深度研究以及對磨拋材料的合理化選擇,可以將不同材質(zhì)的晶圓加工到理想的厚度、面型及表面質(zhì)量,并不斷提升磨拋效率。目前,已成為國內(nèi)為數(shù)不多可為客戶提供減薄、拋光、CMP的系統(tǒng)解決方案和工藝設(shè)備整線輸出的半導(dǎo)體設(shè)備公司。
目前,特思迪在碳化硅襯底領(lǐng)域,其部分單、雙面拋光機產(chǎn)品性能接近海外頭部廠商,已實現(xiàn)國產(chǎn)替代;2022年,特思迪碳化硅襯底磨拋設(shè)備的銷售額取得了300% YoY的增長。在2023年,特思迪碳化硅襯底行業(yè)磨拋設(shè)備銷售額穩(wěn)中向好,設(shè)備出貨量比去年增長87.5%。
05
布局碳基“芯”賽道
對于行業(yè)目前超熱門的金剛石,雖然被譽為終極半導(dǎo)體,但其自身作為半導(dǎo)體材料,目前仍處于基礎(chǔ)研究尚待突破階段,在材料、器件等方面都有大量科學(xué)問題尚需攻克,其中金剛石材料的高成本和小尺寸是制約金剛石功率電子學(xué)發(fā)展的主要障礙,距離實現(xiàn)商業(yè)應(yīng)用尚有較大距離。然而,率先進入市場驗證的是其作為功率器件襯底或者熱沉使用。尤其是金剛石與GaN的結(jié)合,卻能很好解決金剛石市場應(yīng)用開拓推廣需求。以金剛石作為散熱襯底與器件直接鍵合是減小熱阻的理想選擇,然而金剛石的平整度及粗糙度嚴重制約著鍵合的質(zhì)量。
鍵合材料的鍵合面需要極低的粗糙度和平整度,其表面粗糙度往往需要小于1 nm(RMS),這對于其他材料來說可能更容易實現(xiàn),而對于金剛石膜,獲得小于1 nm的粗糙度,難度非常大,一方面金剛石是自然界中硬度最大的材料,另一方面,現(xiàn)階段,散熱領(lǐng)域大多使用的是多晶金剛石膜,這主要是因為尺寸可以做得更大。目前已實現(xiàn)4英寸電子級多晶金剛石的商業(yè)化量產(chǎn),國際最大制備尺寸可達8英寸。但多晶金剛石膜存在較多的晶界,這些晶界往往成為制約粗精度降低的主要因素。高質(zhì)量襯底加工成為行業(yè)難題。
“為滿足市場對金剛石襯底的加工需求,公司積極布局超寬禁帶半導(dǎo)體領(lǐng)域,與材料企業(yè)深度合作,以設(shè)備導(dǎo)入為該領(lǐng)域材料進行產(chǎn)業(yè)化,形成強鏈補鏈作用,滿足國內(nèi)更多的重點應(yīng)用領(lǐng)域突破和發(fā)展。”特思迪半導(dǎo)體CEO劉泳灃先生補充說道。目前,特思迪已成功研發(fā)出金剛石拋光機,可實現(xiàn)金剛石襯底高速高效研磨拋光,并已得到行業(yè)認證。
創(chuàng)新持續(xù)在路上!未來,特思迪將不斷提升布局設(shè)備賽道的創(chuàng)新性和前瞻性,精研設(shè)備技術(shù)與產(chǎn)品創(chuàng)新,推動行業(yè)的快速發(fā)展貢獻重要力量!
CarbonSemi 2024
4月25-26日,DT新材料“助力碳基半導(dǎo)體產(chǎn)業(yè)化進程”為主題,聯(lián)合寧波材料所、甬江實驗室、寧波工程學(xué)院等團隊,在寧波,共同主辦第四屆碳基半導(dǎo)體材料與器件產(chǎn)業(yè)發(fā)展論壇(CarbonSemi 2024),將針對金剛石半導(dǎo)體單晶、多晶晶圓生長、晶圓拋光、加工及應(yīng)用解決方案、以及金剛石與高功率器件鍵合、異質(zhì)集成、加工等話題展開深入探討!
北京特思迪半導(dǎo)體設(shè)備有限公司,將亮相于第四屆碳基半導(dǎo)體材料與器件產(chǎn)業(yè)發(fā)展論壇!歡迎各位朋友蒞臨展位參觀交流!
審核編輯:劉清
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28697瀏覽量
234101 -
晶圓
+關(guān)注
關(guān)注
52文章
5130瀏覽量
129282 -
MEMS技術(shù)
+關(guān)注
關(guān)注
0文章
143瀏覽量
21468 -
碳化硅
+關(guān)注
關(guān)注
25文章
3044瀏覽量
50163 -
3D封裝
+關(guān)注
關(guān)注
8文章
139瀏覽量
27684
原文標題:勇攀“芯”峰,解決金剛石襯底加工難題!特思迪攜手CarbonSemi共繪碳基“芯”版圖
文章出處:【微信號:DT-Semiconductor,微信公眾號:DT半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
國內(nèi)首條碳基集成電路生產(chǎn)線正式投產(chǎn)運營
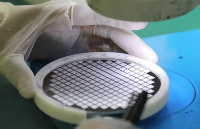
天合光能智慧能源解決方案全球發(fā)布 共繪零碳未來藍圖
安科瑞能源企業(yè)碳資產(chǎn)管理平臺-助力碳交易碳核算

零碳建筑新突破:芯森電子高精度傳感器助力光伏幕墻發(fā)電效能提升

隆基攜手Naif重塑中東地區(qū)能源格局
華為海思正式進入Wi-Fi FEM賽道?
工程行業(yè)中如何做到低碳甚至零碳
英迪芯微榮獲國家級專精特新“小巨人”稱號
碳電表,致力于雙碳減排服務(wù),實現(xiàn)“碳達峰,碳中和”

科思創(chuàng)攜手產(chǎn)學(xué)研合作伙伴,共繪非糧生物基聚氨酯新藍圖
安科瑞碳資產(chǎn)管理平臺助力“碳達峰,碳中和”早日實現(xiàn)






 布局碳基“芯”賽道,特思迪攜手CarbonSemi共繪碳基“芯”版圖
布局碳基“芯”賽道,特思迪攜手CarbonSemi共繪碳基“芯”版圖












評論