共讀好書
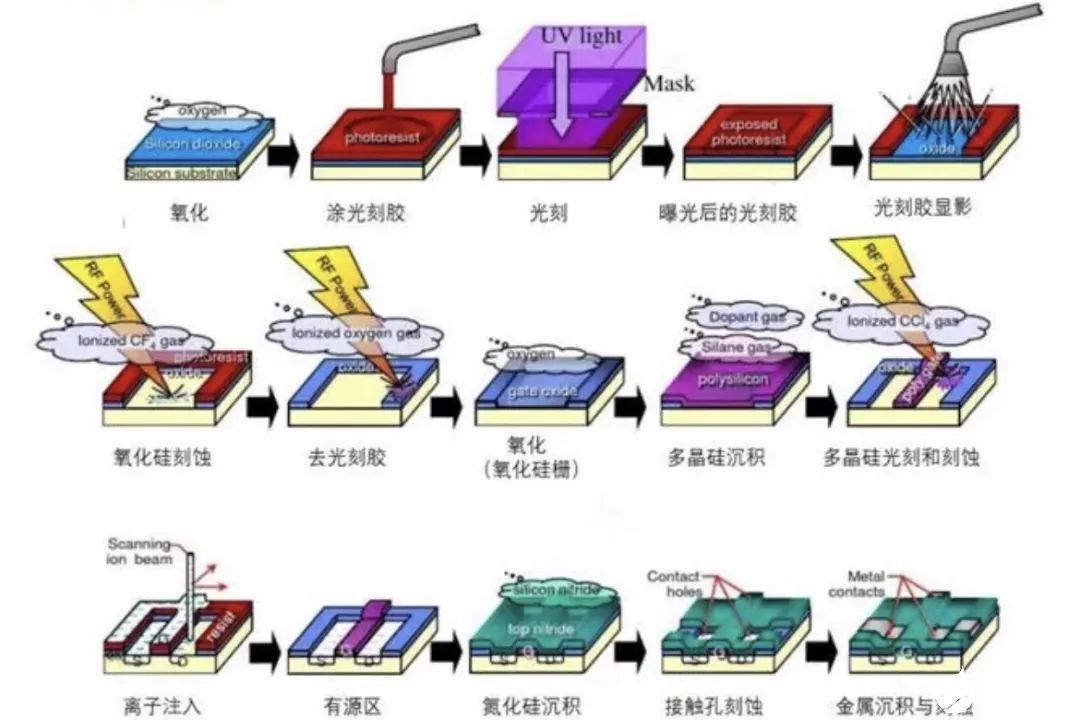

晶圓制造工藝流程
1、 表面清洗
2、 初次氧化
3、 CVD(Chemical Vapor deposition) 法沉積一層 Si3N4 (Hot CVD 或 LPCVD) 。
(1)常壓 CVD (Normal Pressure CVD)
(2)低壓 CVD (Low Pressure CVD)
(3)熱 CVD (Hot CVD)/(thermal CVD)
(4)電漿增強 CVD (Plasma Enhanced CVD)
(5)MOCVD (Metal Organic (6)外延生長法 (LPE)
4、 涂敷光刻膠 (1)光刻膠的涂敷
(2)預烘
(3)曝光
(4)顯影
(5)后烘
(6)腐蝕
(7)光刻膠的去除
5、 此處用干法氧化法將氮化硅去除
6 、離子布植將硼離子 (B+3) 透過 SiO2 膜注入襯底,形成 P 型阱 7、 去除光刻膠,放高溫爐中進行退火處理
8、 用熱磷酸去除氮化硅層,摻雜磷 (P+5) 離子,形成 N 型阱
9、 退火處理,然后用 HF 去除 SiO2 層
10、干法氧化法生成一層 SiO2 層,然后 LPCVD 沉積一層氮化硅
11、利用光刻技術和離子刻蝕技術,保留下柵隔離層上面的氮化硅層
12、濕法氧化,生長未有氮化硅保護的 SiO2 層,形成 PN 之間的隔離區
13、熱磷酸去除氮化硅,然后用 HF 溶液去除柵隔離層位置的 SiO2 ,并重新生成品質更好 的 SiO2 薄膜 , 作為柵極氧化層。
14、LPCVD 沉積多晶硅層,然后涂敷光阻進行光刻,以及等離子蝕刻技術,柵極結構,并氧 化生成 SiO2 保護層。
15、表面涂敷光阻,去除 P 阱區的光阻,注入砷 (As) 離子,形成 NMOS 的源漏極。用同樣的 方法,在 N 阱區,注入 B 離子形成 PMOS 的源漏極。
16、利用 PECVD 沉積一層無摻雜氧化層,保護元件,并進行退火處理。
17、沉積摻雜硼磷的氧化層
18、濺鍍第一層金屬
(1) 薄膜的沉積方法根據其用途的不同而不同,厚度通常小于 1um 。(2) 真空蒸發法( Evaporation Deposition )
(3) 濺鍍( Sputtering Deposition )
19、光刻技術定出 VIA 孔洞,沉積第二層金屬,并刻蝕出連線結構。然后,用 PECVD 法氧 化層和氮化硅保護層。20、光刻和離子刻蝕,定出 PAD 位置 21、最后進行退火處理,以保證整個 Chip 的完整和連線的連接性
晶圓制造總的工藝流程
芯片的制造過程可概分為晶圓處理工序(Wafer Fabrication)、晶圓針測工序(Wafer Probe)、構裝工序(Packaging)、測試工序(InitialTestandFinalTest)等幾個步驟。其中晶圓處理工序和晶圓針測工序為前段(Front End)工序,而構裝工序、測試工序為后 段(Back End)工序。
1、晶圓處理工序:本工序的主要工作是在晶圓上制作電路及電子元件(如晶體管、電容、 邏輯開關等),其處理程序通常與產品種類和所使用的技術有關,但一般基本步驟是先將晶 圓適當清洗,再在其表面進行氧化及化學氣相沉積,然后進行涂膜、曝光、顯影、蝕刻、離 子植入、金屬濺鍍等反復步驟,最終在晶圓上完成數層電路及元件加工與制作。
2、晶圓針測工序:經過上道工序后,晶圓上就形成了一個個的小格,即晶粒,一般情況下, 為便于測試,提高效率,同一片晶圓上制作同一品種、規格的產品;但也可根據需要制作幾 種不同品種、規格的產品。在用針測(Probe)儀對每個晶粒檢測其電氣特性,并將不合格 的晶粒標上記號后,將晶圓切開,分割成一顆顆單獨的晶粒,再按其電氣特性分類,裝入不 同的托盤中,不合格的晶粒則舍棄。
3、構裝工序:就是將單個的晶粒固定在塑膠或陶瓷制的芯片基座上,并把晶粒上蝕刻出的 一些引接線端與基座底部伸出的插腳連接,以作為與外界電路板連接之用,最后蓋上塑膠蓋 板,用膠水封死。其目的是用以保護晶粒避免受到機械刮傷或高溫破壞。到此才算制成了一 塊集成電路芯片(即我們在電腦里可以看到的那些黑色或褐色,兩邊或四邊帶有許多插腳或 引線的矩形小塊)。
4、測試工序:芯片制造的最后一道工序為測試,其又可分為一般測試和特殊測試,前者是 將封裝后的芯片置于各種環境下測試其電氣特性,如消耗功率、運行速度、耐壓度等。經測 試后的芯片,依其電氣特性劃分為不同等級。而特殊測試則是根據客戶特殊需求的技術參數, 從相近參數規格、品種中拿出部分芯片,做有針對性的專門測試,看是否能滿足客戶的特殊 需求,以決定是否須為客戶設計專用芯片。經一般測試合格的產品貼上規格、型號及出廠日 期等標識的標簽并加以包裝后即可出廠。而未通過測試的芯片則視其達到的參數情況定作降 級品或廢品
一些半導體制造名詞解釋
ETCH何謂蝕刻(Etch)?
答:將形成在晶圓表面上的薄膜全部,或特定處所去除至必要厚度的制程。
蝕刻種類:
答:(1) 干蝕刻(2) 濕蝕刻
蝕刻對象依薄膜種類可分為:
答:poly,oxide, metal
何謂 dielectric 蝕刻(介電質蝕刻)?
答:Oxide etch and nitride etch
半導體中一般介電質材質為何?
答:氧化硅/氮化硅
何謂濕式蝕刻
答:利用液相的酸液或溶劑;將不要的薄膜去除
何謂電漿 Plasma?
答:電漿是物質的第四狀態.帶有正,負電荷及中性粒子之總和;其中包含電子,正離子,負離子,中性分子,活性基及發散光子等,產生電漿的方法可使用高溫或高電壓.
何謂干式蝕刻?
答:利用 plasma 將不要的薄膜去除
何謂 Under-etching(蝕刻不足)?
答:系指被蝕刻材料,在被蝕刻途中停止造成應被去除的薄膜仍有殘留
何謂 Over-etching(過蝕刻 )
答:蝕刻過多造成底層被破壞
何謂 Etch rate(蝕刻速率)
答:單位時間內可去除的蝕刻材料厚度或深度
何謂 Seasoning(陳化處理) 答:是在蝕刻室的清凈或更換零件后,為要穩定制程條件,使用仿真(dummy) 晶圓進 行數次的蝕刻循環。
Asher 的主要用途:
答:光阻去除
Wet bench dryer 功用為何?
答:將晶圓表面的水份去除
列舉目前 Wet bench dry 方法:
答:(1) Spin Dryer (2) Marangoni dry (3) IPA Vapor Dry
何謂 Spin Dryer
答:利用離心力將晶圓表面的水份去除
何謂 Maragoni Dryer
答:利用表面張力將晶圓表面的水份去除
何謂 IPA Vapor Dryer
答:利用 IPA(異丙醇)和水共溶原理將晶圓表面的水份去除
測 Particle 時,使用何種測量儀器?
答:Tencor Surfscan
測蝕刻速率時,使用何者量測儀器?
答:膜厚計,測量膜厚差值
何謂 AEI
答:After Etching Inspection 蝕刻后的檢查
AEI 目檢 Wafer 須檢查哪些項目:
答:(1) 正面顏色是否異常及刮傷 (2) 有無缺角及 Particle (3)刻號是否正確
金屬蝕刻機臺轉非金屬蝕刻機臺時應如何處理?
答:清機防止金屬污染問題
金屬蝕刻機臺 asher 的功用為何?
答:去光阻及防止腐蝕
金屬蝕刻后為何不可使用一般硫酸槽進行清洗?
答:因為金屬線會溶于硫酸中
"Hot Plate"機臺是什幺用途?
答:烘烤
Hot Plate 烘烤溫度為何?
答:90~120 度 C
何種氣體為 Poly ETCH 主要使用氣體?
答:Cl2, HBr, HCl
用于 Al 金屬蝕刻的主要氣體為
答:Cl2, BCl3
用于 W 金屬蝕刻的主要氣體為
答:SF6
何種氣體為 oxide vai/contact ETCH 主要使用氣體?
答:C4F8, C5F8, C4F6
硫酸槽的化學成份為:
答:H2SO4/H2O2
AMP 槽的化學成份為:
答:NH4OH/H2O2/H2O
UV curing 是什幺用途?
答:利用 UV 光對光阻進行預處理以加強光阻的強度
"UV curing"用于何種層次?
答:金屬層
何謂 EMO?
答:機臺緊急開關
EMO 作用為何? 答:當機臺有危險發生之顧慮或已不可控制,可緊急按下 濕式蝕刻門上貼有那些警示標示?
答:(1) 警告.內部有嚴重危險.嚴禁打開此門 (2) 機械手臂危險. 嚴禁打開此門 (3) 化 學藥劑危險. 嚴禁打開此門
遇化學溶液泄漏時應如何處置?
答:嚴禁以手去測試漏出之液體. 應以酸堿試紙測試. 并尋找泄漏管路.
遇 IPA 槽著火時應如何處置??
答:立即關閉 IPA 輸送管路并以機臺之滅火器滅火及通知緊急應變小組
BOE 槽之主成份為何?
答:HF(氫氟酸)與 NH4F(氟化銨).
BOE 為那三個英文字縮寫 ?
答:Buffered Oxide Etcher 。
有毒氣體之閥柜(VMB)功用為何?
答:當有毒氣體外泄時可利用抽氣裝置抽走,并防止有毒氣體漏出
電漿的頻率一般 13.56 MHz,為何不用其它頻率?
答:為避免影響通訊品質,目前只開放特定頻率,作為產生電漿之用,如 380~420KHz ,13.56MHz,2.54GHz 等
何謂 ESC(electrical static chuck)
答:利用靜電吸附的原理, 將 Wafer 固定在極板 (Substrate) 上
Asher 主要氣體為
答:O2
Asher 機臺進行蝕刻最關鍵之參數為何?
答:溫度
簡述 TURBO PUMP 原理
答:利用渦輪原理,可將壓力抽至 10-6TORR
熱交換器(HEAT EXCHANGER)之功用為何?
答:將熱能經由介媒傳輸,以達到溫度控制之目地
簡述 BACKSIDE HELIUM COOLING 之原理?
答:藉由氦氣之良好之熱傳導特性,能將芯片上之溫度均勻化
ORIENTER 之用途為何?
答:搜尋 notch 邊,使芯片進反應腔的位置都固定,可追蹤問題
簡述 EPD 之功用
答:偵測蝕刻終點;End point detector 利用波長偵測蝕刻終點
何謂 MFC?
答:mass flow controler 氣體流量控制器;用于控制 反應氣體的流量
GDP 為何?
答:氣體分配盤(gas distribution plate)
GDP 有何作用?
答:均勻地將氣體分布于芯片上方
何謂 isotropic etch?
答:等向性蝕刻;側壁側向蝕刻的機率均等
何謂 anisotropic etch?
答:非等向性蝕刻;側壁側向蝕刻的機率少
何謂 etch 選擇比?
答:不同材質之蝕刻率比值
何謂 AEI CD?
答:蝕刻后特定圖形尺寸之大小,特征尺寸(Critical Dimension)
何謂 CD bias?
答:蝕刻 CD 減蝕刻前黃光 CD
簡述何謂田口式實驗計劃法?
答:利用混合變因安排輔以統計歸納分析
何謂反射功率? 答:蝕刻過程中,所施予之功率并不會完全地被反應腔內接收端所接受,會有部份值反射 掉,此反射之量,稱為反射功率
Load Lock 之功能為何?
答:Wafers 經由 loadlock 后再進出反應腔,確保反應腔維持在真空下不受粉塵及濕度 的影響.
廠務供氣系統中何謂 Bulk Gas ?
答:Bulk Gas 為大氣中普遍存在之制程氣體, 如 N2, O2, Ar 等. 廠務供氣
系統中何謂 Inert Gas?
答:Inert Gas 為一些特殊無強烈毒性的氣體, 如 NH3,CF4, CHF3, SF6 等.
廠務供氣系統中何謂 Toxic Gas ?
答:Toxic Gas 為具有強烈危害人體的毒性氣體, 如 SiH4, Cl2, BCl3 等.
機臺維修時,異常告示排及機臺控制權應如何處理?
答:將告示牌切至異常且將機臺控制權移至維修區以防有人誤動作
冷卻器的冷卻液為何功用 ?
答:傳導熱
Etch 之廢氣有經何種方式處理 ?
答:利用水循環將廢氣溶解之后排放至廢酸槽
何謂 RPM?
答:即 Remote Power Module,系統總電源箱.
火災異常處理程序
答:(1) 立即警告周圍人員. (2) 嘗試 3 秒鐘滅火. (3) 按下 EMO 停止機臺. (4) 關閉 VMB Valve 并通知廠務. (5) 撤離.
一氧化碳(CO)偵測器警報異常處理程序
答:(1) 警告周圍人員. (2) 按 Pause 鍵,暫止 Run 貨. (3) 立即關閉 VMB 閥,并通知廠務. (4) 進行測漏.
高壓電擊異常處理程序
答:(1) 確認安全無慮下,按 EMO 鍵(2) 確認受傷原因(誤觸電源,漏水等)(3) 處理受傷 人員
T/C (傳送 Transfer Chamber) 之功能為何 ?
答:提供一個真空環境, 以利機器手臂在反應腔與晶舟間傳送 Wafer,節省時間.
機臺 PM 時需佩帶面具否
答:是,防毒面具
機臺停滯時間過久 run 貨前需做何動作
答:Seasoning(陳化處理)
何謂 Seasoning(陳化處理)
答:是在蝕刻室的清凈或更換零件后,為要穩定制程條件,使用仿真(dummy) 晶圓進 行數次的蝕刻循環。
何謂日常測機
答:機臺日常檢點項目, 以確認機臺狀況正常
何謂 WAC (Waferless Auto Clean)
答:無 wafer 自動干蝕刻清機
何謂 Dry Clean
答:干蝕刻清機
日常測機量測 etch rate 之目的何在?
答:因為要蝕刻到多少厚度的 film,其中一個重要參數就是蝕刻率 操作酸
堿溶液時,應如何做好安全措施?
答:(1) 穿戴防酸堿手套圍裙安全眼鏡或護目鏡(2) 操作區備有清水與水管以備不時之 需(3) 操作區備有吸酸棉及隔離帶
如何讓 chamber 達到設定的溫度?
答:使用 heater 和 chiller
Chiller之功能為何?
答:用以幫助穩定 chamber 溫度
如何在 chamber 建立真空?
答:(1) 首先確立 chamber parts 組裝完整(2) 以 dry pump 作第一階段的真空建立(3) 當圧力到達 100mTD寺再以 turbo pump 抽真空至 1mT 以下
真空計的功能為何?
答:偵測 chamber 的壓力,確保 wafer 在一定的壓力下 process
Transfer module 之 robot 功用為何?
答:將 wafer 傳進 chamber 與傳出 chamber 之用
何謂 MTBC? (mean time between clean)
答:上一次 wet clean 到這次 wet clean 所經過的時間
RF Generator 是否需要定期檢驗?
答:是需要定期校驗;若未校正功率有可能會變化;如此將影響電漿的組成
為何需要對 etch chamber 溫度做監控?
答:因為溫度會影響制程條件;如 etching rate/均勻度
為何需要注意 dry pump exhaust presure (pump 出口端的氣壓)?
答:因為氣壓若太大會造成 pump 負荷過大;造成 pump 跳掉,影響 chamber 的壓力,直接 影響到 run 貨品質
為何要做漏率測試? (Leak rate )
答: (1) 在 PM 后 PUMP Down 1~2 小時后;為確保 chamber Run 貨時,無大氣進入 chambe 影響 chamber GAS 成份(2) 在日常測試時,為確保 chamber 內來自大氣的泄漏源,故需測漏
機臺發生 Alarm 時應如何處理?
答:(1) 若為火警,立即圧下 EMO(緊急按鈕),并滅火且通知相關人員與主管(2) 若是一 般異常,請先檢查 alarm 訊息再判定異常原因,進而解決問題,若未能處理應立即通知主要負 責人
蝕刻機臺廢氣排放分為那幾類?
答:一般無毒性廢氣/有毒酸性廢氣排放
蝕刻機臺使用的電源為多少伏特(v)?
答:208V 三相
式蝕刻機臺分為那幾個部份?
答:(1) Load/Unload 端 (2) transfer module (3) Chamber process module (4) 真 空系統 (5) GAS system (6)RF system
在半導體程制中,濕制程(wet processing)分那二大頪?
答:(1) 晶圓洗凈(wafer cleaning) (2) 濕蝕刻(wet etching).
晶圓洗凈(wafer cleaning)的設備有那幾種?
答:(1) Batch type(immersion type): a) carrier type b)Cassetteless type (2) Single wafer type(spray type)
晶圓洗凈(wafer cleaning)的目的為何?
答:去除金屬雜質,有機物污染及微塵.
半導體制程有那些污染源?
答:(1) 微粒子(2) 金屬(3) 有機物(4) 微粗糙(5) 天生的氧化物
RCA 清洗制程目的為何?
答:于微影照像后,去除光阻,清洗晶圓,并做到酸堿中和,使晶圓可進行下一個制程.
洗凈溶液 APM(SC-1)--> NH4OHH2O 的目的為何?
答:去除微粒子及有機物
洗凈溶液 SPM--> H2SO4H2O 的目的為何?
答:去除有機物
洗凈溶液 HPM(SC-2)--> HCLH2O 的目的為何?
答:去除金屬
洗凈溶液 DHF--> HF100~1:500)的目的為何?
答:去除自然氧化膜及金屬
洗凈溶液 FPM--> HFH2O 的目的為何?
答:去除自然氧化膜及金屬
洗凈溶液 BHF(BOE)--> HF:NH4F 的目的為何?
答:氧化膜濕式蝕刻
洗凈溶液 熱磷酸--> H3PO4 的目的為何?
答:氮化膜濕式蝕刻
0.25 微米邏輯組件有那五種標準清洗方法?
答:(1) 擴散前清洗(2) 蝕刻后清洗(3) 植入后清洗(4) 沉積前洗清 (5) CMP 后清洗
超音波刷洗(ultrasonic scrubbing)目的為何?
答:去除不溶性的微粒子污染
何謂晶圓盒(POD)清洗? 答:利用去離子水和界面活性劑(surfactant),除去晶圓盒表面的污染. 高壓噴灑(high pressure spray)或刷洗去微粒子在那些制程之后?
答:(1) 鋸晶圓(wafer saw) (2) 晶圓磨薄(wafer lapping) (3) 晶圓拋光(wafer polishing) (4) 化學機械研磨
晶圓濕洗凈設備有那幾種?
答:(1) 多槽全自動洗凈設備 (2) 單槽清洗設備 (3) 單晶圓清洗設備. 單槽
清洗設備的優點?
答:(1) 較佳的環境制程與微粒控制能力. (2) 化學品與純水用量少. (3) 設備調整彈 性度高.
單槽清洗設備的缺點?
答:(1) 產能較低. (2) 晶圓間仍有互相污染
單晶圓清洗設備未來有那些須要突破的地方?
答:產能低與設備成熟度
審核編輯 黃宇
-
光刻
+關注
關注
8文章
344瀏覽量
30622 -
蝕刻
+關注
關注
10文章
424瀏覽量
15992 -
晶圓制造
+關注
關注
7文章
292瀏覽量
24503
發布評論請先 登錄





 晶圓制造工藝流程及一些常用名詞解釋
晶圓制造工藝流程及一些常用名詞解釋











評論