硅片形貌效應在光刻工藝中十分重要,特別是在現代集成電路制造中,如FinFET等先進器件結構以及雙重圖形技術的廣泛應用下,硅片表面的微小不平整性對光刻結果的影響變得尤為顯著。
本文是關于硅片形貌效應及其與底部抗反射涂層(BARC)沉積策略關系的解析,分述如下:
沉積策略比較
多晶硅線附近的光刻膠殘留
雙重圖形技術中的線寬變化
沉積策略比較
1.1 平面化沉積工藝 特點:BARC層頂部形成平面,但在硅片臺階頂部以外的區域,BARC層較厚。 問題:臺階兩側較厚的BARC層導致反射光形成駐波,影響光刻膠的曝光均勻性,產生光刻膠殘留和線條寬度波動。 1.2 保形沉積工藝 特點:BARC層厚度均勻,與硅片表面形貌保持一致。 問題:盡管減少了駐波效應,但硅片或BARC臺階的散射作用降低了臺階兩側光刻膠/BARC界面處的光強,導致線條寬度波動和光刻膠殘留。
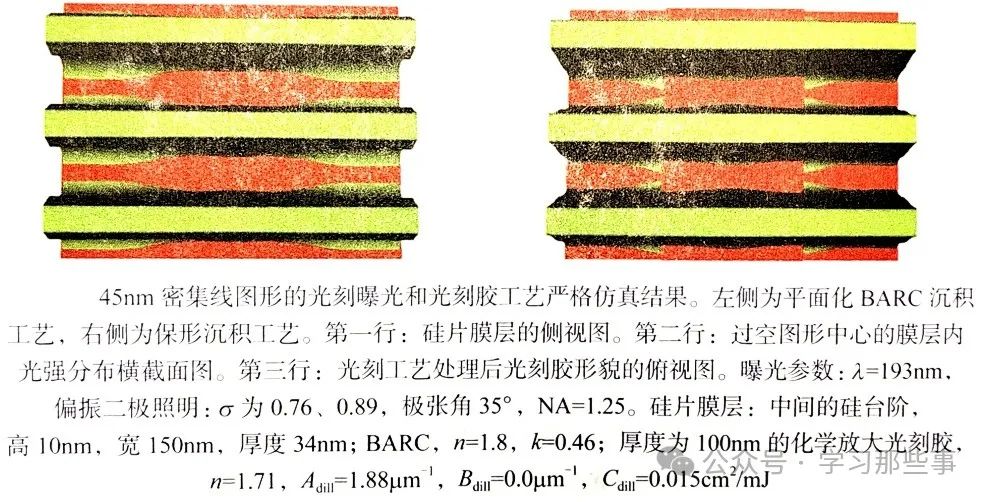
1.3 解決方案與優化方向 優化BARC沉積工藝:進一步開發能夠更精確控制BARC層厚度和均勻性的沉積技術,以減少對光刻膠形貌的負面影響。 結合化學機械拋光(CMP):在BARC沉積前,通過CMP技術進一步改善硅片表面的平整度,降低硅片形貌效應。 光刻工藝參數調整:根據BARC沉積后的硅片表面形貌,調整光刻機的曝光參數(如曝光劑量、焦距等),以優化光刻圖案的質量。 仿真與建模:利用嚴格的電磁場仿真模型對硅片形貌效應進行深入研究,為工藝優化提供理論支持。 綜上所述,硅片形貌效應是現代光刻工藝中不可忽視的重要問題,特別是在先進制造工藝中。通過優化BARC沉積策略和結合其他技術手段,可以有效減輕硅片形貌效應對光刻圖案質量的影響,提高集成電路制造的良品率和性能。未來,隨著制造工藝的進一步發展,對硅片形貌效應的深入研究和精確控制將變得更加重要。
多晶硅線附近的光刻膠殘留
在半導體制造中,多晶硅線作為后續工藝步驟的掩模,其存在會對光刻膠的曝光和顯影過程產生顯著影響。當BARC無法使用或不適用于特定工藝時,多晶硅線對光的散射作用尤為關鍵。 2.1 現象描述 多晶硅線的散射作用:多晶硅線不透光,會將入射光散射到光刻膠的其他位置。頂部散射光在光刻膠內引起駐波效應,而垂直邊緣的散射則降低了兩側區域的曝光劑量。
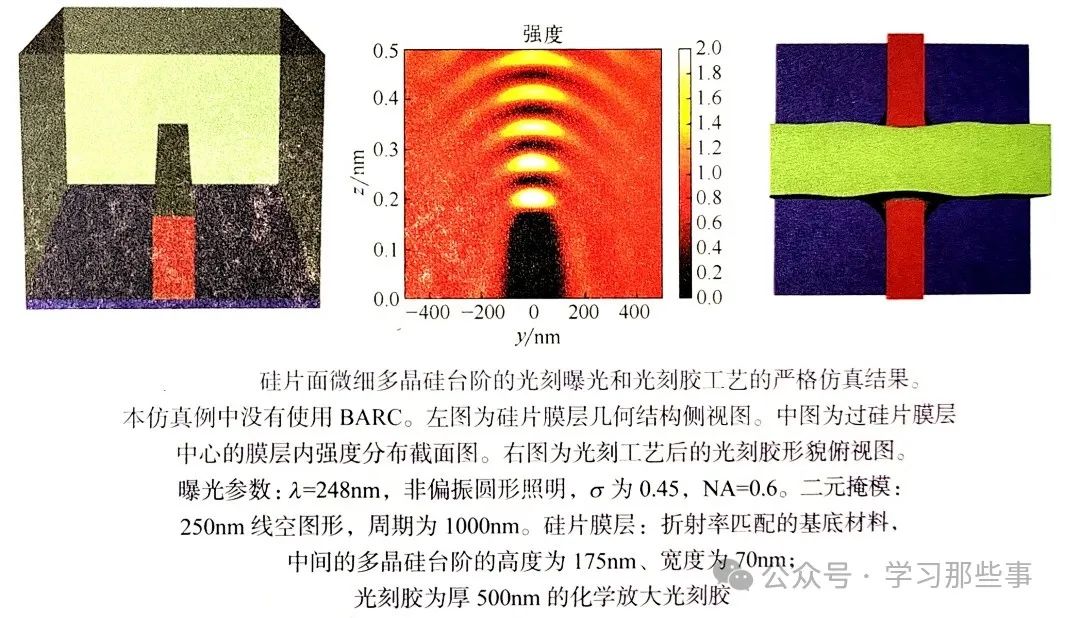
光刻膠殘留:由于多晶硅線兩側曝光劑量減少,光刻膠在這些區域未能充分曝光,導致顯影后形成殘留。 線寬變化:多晶硅線頂部的散射光增加了頂部區域的曝光劑量,可能導致線寬變化。 2.2 解決方案 優化照明條件:采用強離軸照明可以減少光刻膠殘留,因為離軸光能更好地控制曝光劑量的分布。 調整光刻膠配方:開發對散射光更敏感或更耐受的光刻膠材料,以減少殘留和提高圖案質量。 精確控制工藝參數:通過精確控制曝光時間、顯影條件等工藝參數,可以優化光刻膠的曝光和顯影過程,減少殘留。
雙重圖形技術中的線寬變化
雙重圖形技術(DPT)是一種先進的光刻技術,通過多次曝光和刻蝕步驟來形成更精細的圖案。在DPT中,硅片形貌效應對最終圖案的質量具有重要影響。 3.1 現象描述 光刻-凍結-光刻-刻蝕(LFLE)工藝:在第一次曝光和光刻膠工藝步驟后,光刻膠的折射率通過凍結步驟發生變化。這種變化會影響后續曝光過程中的光強分布。 折射率變化的影響:折射率增加導致更多光線偏折進入光刻膠底部,增加了局部曝光劑量。這會導致第二次曝光后線寬發生變化。
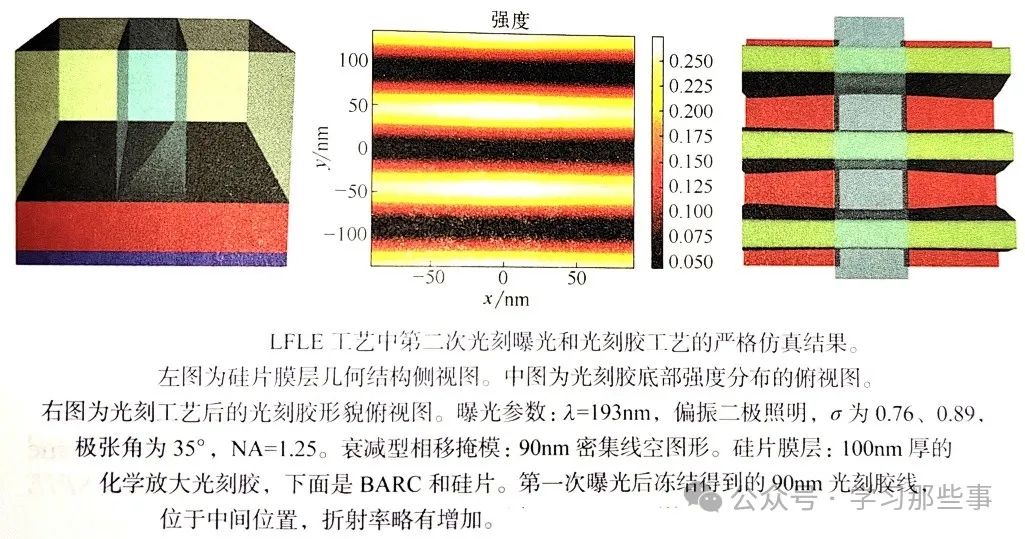
3.2 解決方案
精確控制折射率變化:通過優化凍結步驟的工藝條件,精確控制光刻膠折射率的變化量,以減少對后續曝光過程的影響。 嚴格仿真與優化:利用嚴格電磁場仿真方法,對DPT工藝中的硅片形貌效應進行仿真和優化,以選擇合適的材料和工藝參數。 圖形設計拆分:在圖形設計階段就考慮硅片形貌效應的影響,通過合理的圖形拆分和布局來減少線寬變化。 隨著半導體制造工藝的不斷發展,掩模和硅片面特征尺寸的不斷減小,電磁散射效應在光刻中的重要性日益凸顯。嚴格電磁場仿真方法成為描述這些效應的重要手段。在掩模和硅片形貌效應的研究中,需要綜合考慮材料的光學特性、工藝參數以及照明條件等因素,以優化光刻工藝,提高圖案質量。同時,對于雙重圖形技術等先進工藝,更需要精確控制硅片形貌效應,以確保最終產品的性能和質量。
-
多晶硅
+關注
關注
3文章
248瀏覽量
29788 -
硅片
+關注
關注
13文章
381瀏覽量
35122 -
DPT
+關注
關注
0文章
12瀏覽量
6909
原文標題:硅片形貌效應
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
JCMsuite應用:太陽能電池的抗反射惠更斯超表面模擬
JCMsuite應用:太陽能電池的抗反射惠更斯超表面模擬
太陽能硅片檢測技術--硅片的金字塔檢測-大平臺硅片檢測顯微鏡
電觸頭表面形貌特征
白光LED結構化涂層制備及其應用研究
晶體硅太陽電池反射率與折射率色散效應的關系

MacBook Air會出現防反射涂層問題
MEMS與傳統CMOS刻蝕及沉積工藝的關系
MEMS和傳統CMOS刻蝕與沉積工藝到底有什么關系
新型光學涂層可傳輸和反射相同波長的光
華林科納用于硅探測器設計的紫外線抗反射涂層
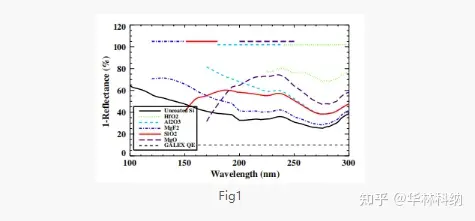





 硅片形貌效應及其與底部抗反射涂層(BARC)沉積策略關系的解析
硅片形貌效應及其與底部抗反射涂層(BARC)沉積策略關系的解析


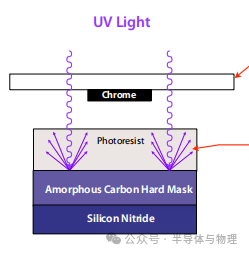










評論