高臺階基底晶圓貼蠟方法是半導(dǎo)體制造中的一個關(guān)鍵步驟,特別是在處理具有高階臺金屬結(jié)構(gòu)的晶圓時。以下是一種有效的高臺階基底晶圓貼蠟方法:
一、方法概述
該方法利用膠厚和蠟厚將高臺階填平,并使用較輕的物理壓力以及抽真空技術(shù)來確保晶圓與陶瓷盤之間的緊密貼合。此方法不僅有效避免高臺階金屬被壓碎,還能保證晶圓片內(nèi)厚度偏差(TTV)值在可接受范圍內(nèi)。
二、具體步驟
勻膠處理:
使用勻膠機對晶圓進行二次勻膠。勻膠機設(shè)定轉(zhuǎn)速為1500r/min,首先進行第一層勻膠,時間為3分鐘,勻膠結(jié)束后對晶圓進行烘干。
再次將晶圓放置在勻膠機內(nèi),在相同轉(zhuǎn)速下進行第二層勻膠,時間為2分鐘。
厚度測量與去邊膠:
使用高度測量儀測量勻膠后的晶圓背面厚度。
對高出的區(qū)域進行去邊膠處理,以確保晶圓背面厚度保持平整。
涂蠟與晶圓粘接:
在加熱至80°C的陶瓷盤上預(yù)涂工業(yè)蠟。
將晶圓通過預(yù)涂的工業(yè)蠟粘接在陶瓷盤上。
施加物理壓力與抽真空:
在晶圓上覆蓋一層直徑大于晶圓直徑的無塵紙。
在無塵紙上放置一個加壓重物(如陶瓷盤),施加較輕的物理壓力。
使用抽真空裝置(包括真空泵、氣管和真空罩)對晶圓進行抽真空處理,時間為5分鐘。
冷卻與檢驗:
抽真空完成后,取出物件并自然冷卻。
去除加壓重物和無塵紙,用酒精清除晶圓背面的蠟漬。
使用測量儀器對晶圓進行測厚檢驗,確保晶圓片內(nèi)厚度偏差小于15um。
三、注意事項
工藝參數(shù)控制:在勻膠、涂蠟、抽真空等步驟中,要嚴(yán)格控制各項工藝參數(shù),以確保加工質(zhì)量和穩(wěn)定性。
設(shè)備維護:定期對勻膠機、測量儀器、抽真空裝置等設(shè)備進行維護和保養(yǎng),確保設(shè)備的精度和可靠性。
環(huán)境要求:在加工過程中,要保持工作環(huán)境的清潔和穩(wěn)定,避免灰塵、振動等因素對加工質(zhì)量的影響。
四、方法優(yōu)勢
低成本:該方法采用低成本及簡單的物理方式進行貼蠟,降低了生產(chǎn)成本。
高效性:通過勻膠、涂蠟、抽真空等步驟的協(xié)同作用,實現(xiàn)了晶圓與陶瓷盤之間的緊密貼合,提高了加工效率。
高質(zhì)量:該方法有效避免了高臺階金屬被壓碎的問題,并能保證晶圓片內(nèi)厚度偏差(TTV)值在可接受范圍內(nèi),從而提高了產(chǎn)品質(zhì)量。
綜上所述,這種高臺階基底晶圓貼蠟方法具有低成本、高效性和高質(zhì)量的優(yōu)勢,適用于半導(dǎo)體制造中需要處理高臺階金屬結(jié)構(gòu)的晶圓。
五、高通量晶圓測厚系統(tǒng)
高通量晶圓測厚系統(tǒng)以光學(xué)相干層析成像原理,可解決晶圓/晶片厚度TTV(Total Thickness Variation,總厚度偏差)、BOW(彎曲度)、WARP(翹曲度),TIR(Total Indicated Reading 總指示讀數(shù),STIR(Site Total Indicated Reading 局部總指示讀數(shù)),LTV(Local Thickness Variation 局部厚度偏差)等這類技術(shù)指標(biāo)。



高通量晶圓測厚系統(tǒng),全新采用的第三代可調(diào)諧掃頻激光技術(shù),傳統(tǒng)上下雙探頭對射掃描方式,可兼容2英寸到12英寸方片和圓片,一次性測量所有平面度及厚度參數(shù)。

1,靈活適用更復(fù)雜的材料,從輕摻到重?fù)?P 型硅 (P++),碳化硅,藍寶石,玻璃,鈮酸鋰等晶圓材料。

重?fù)叫凸瑁◤娢站A的前后表面探測)

粗糙的晶圓表面,(點掃描的第三代掃頻激光,相比靠光譜探測方案,不易受到光譜中相鄰單位的串?dāng)_噪聲影響,因而對測量粗糙表面晶圓)

低反射的碳化硅(SiC)和鈮酸鋰(LiNbO3);(通過對偏振效應(yīng)的補償,加強對低反射晶圓表面測量的信噪比)

絕緣體上硅(SOI)和MEMS,可同時測量多層結(jié)構(gòu),厚度可從μm級到數(shù)百μm 級不等。

可用于測量各類薄膜厚度,厚度最薄可低至4μm ,精度可達1nm。
1,可調(diào)諧掃頻激光的“溫漂”處理能力,體現(xiàn)在極端工作環(huán)境中抗干擾能力強,一改過去傳統(tǒng)晶圓測量對于“主動式減震平臺”的重度依賴,成本顯著降低。

2,靈活的運動控制方式,可兼容2英寸到12英寸方片和圓片測量。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28309瀏覽量
229784 -
晶圓
+關(guān)注
關(guān)注
52文章
5076瀏覽量
128977
發(fā)布評論請先 登錄
相關(guān)推薦
晶圓表面形貌及臺階高度測量方法

什么是晶圓
什么是晶圓級封裝?
晶圓級CSP的錫膏裝配和助焊劑裝配
晶圓級CSP貼裝工藝吸嘴的選擇
晶圓級封裝的方法是什么?
晶圓是什么材質(zhì)_晶圓測試方法
多通道晶圓缺陷檢測方法
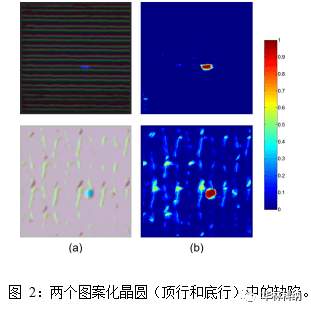





 高臺階基底晶圓貼蠟方法
高臺階基底晶圓貼蠟方法











評論