1高密度PCB(HDI)制造檢驗標準范圍
1.1 范圍
本標準是Q/DKBA3178《PCB檢驗標準》的子標準,包含了HDI制造中遇到的與HDI印制板相關的外觀、結構完整性及可靠性等要求。
本標準適用于深圳宏力捷公司高密度PCB(HDI)的進貨檢驗、采購合同中的技術條文、高密度PCB(HDI)廠資格認證的佐證以及高密度PCB(HDI)設計參考。
1.2 簡介
本標準針對HDI印制板特點,對積層材料、微孔、細線等性能及檢測要求進行了描述。本標準沒有提到的其他條款,依照Q/DKBA3178.1《剛性PCB檢驗標準》執行。
1.3 關鍵詞
PCB、HDI、檢驗
2 規范性引用文件
下列文件中的條款通過本規范的引用而成為本規范的條款。凡是注日期的引用文件,其隨后所有的修改單(不包括勘誤的內容)或修訂版均不適用于本規范,然而,鼓勵根據本規范達成協議的各方研究是否可使用這些文件的最新版本。凡是不注日期的引用文件,其最新版本適用于本規范。
| 序號 | 編號 | 名稱 |
|---|---|---|
| 1 | IPC-6016 | HDI層或板的資格認可與性能規范 |
| 2 | IPC-6011 | PCB通用性能規范 |
| 3 | IPC-6012 | 剛性PCB資格認可與性能規范 |
| 4 | IPC-4104 | HDI和微孔材料規范 |
| 5 | IPC-TM-650 | IPC測試方法手冊 |
3 術語和定義
HDI:High Density Interconnect,高密度互連,也稱BUM(Build-up Multilayer或Build-up PCB),即積層法多層板。積層互聯通常采用微孔技術,一般接點密度>130點/in2,布線密度>在117in/in2 。圖3-1是HDI印制板結構示意圖。
Core:芯層,如圖3-1,HDI印制板中用來做內芯的普通層。
RCC:Resin Coated Copper,背膠銅箔。
LDP:Laser Drillable Prepreg,激光成孔半固化片。
Build-up Layer:積層,如圖3-1,疊積于芯層表面的高密互聯層,通常采用微孔技術。
Microvia:微孔,孔直徑≤0.15mm的盲孔或埋孔。
Target Pad:如圖3-1,微孔底部對應Pad。
Capture Pad:如圖3-1,微孔頂部對應Pad。
Buried Hole:埋孔,如圖3-1,沒有延伸到PCB表面的導通孔。
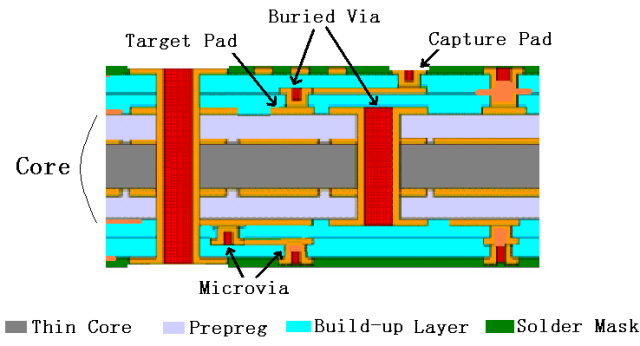
圖3-1 HDI印制板結構示意圖
4 文件優先順序
當各種文件的條款出現沖突時,按如下由高到低的優先順序進行處理:
印制電路板的設計文件(生產主圖)
已批準(簽發)的HDI印制板采購合同或技術協議
本高密度PCB(HDI)檢驗標準
已批準(簽發)的普通印制板采購合同或技術協議
剛性PCB檢驗標準
IPC相關標準
5 材料要求
本章描述HDI印制電路板所用材料基本要求。
5.1 板材
缺省芯層材料為FR-4,缺省積層材料為RCC;在滿足產品性能前提下,積層材料也可采用106(FR-4)、1080(FR-4)及LDP材料。以上材料均需滿足深圳宏力捷Q/DKBA3121《PCB基材性能標準》性能要求。
5.2 銅箔
包括RCC銅箔與芯層板銅箔,主要性能缺省指標如下表:
表5.2-1 銅箔性能指標缺省值
| 特性項目 | 銅箔厚度 | 品質要求 |
|---|---|---|
| RCC | 1/2 Oz;1/3Oz | 抗張強度、延伸率、硬度、MIT耐折性、彈性系數、質量電阻系數、表面粗糙Ra,參考Q/DKBA3178.1《剛性PCB檢驗標準》。 |
| 芯層板銅箔 | 與普通PCB相同 |
5.3 金屬鍍層
微孔鍍銅厚度要求:
表5.3-1 微孔鍍層厚度要求
| 鍍層 | 性能指標 |
|---|---|
| 微孔最薄處銅厚 | ≥12.5um |
6 尺寸要求
本節描述HDI印制板的尺寸精度的特別要求,包括板材、導線、孔等。尺度特性需用帶刻度的≥30倍的放大系統作精確的測量和檢驗。
6.1 板材厚度要求及公差
6.1.1 芯層厚度要求及公差
缺省板材為FR-4覆銅板,其厚度要求及公差要求依據Q/DKBA3178.1《剛性PCB檢驗標準》。
6.1.2 積層厚度要求及公差
缺省積層介質為65~80um的RCC,壓合后平均厚度≥40um,最薄處≥30um。
若設計文件規定積層厚度,其厚度公差依據Q/DKBA3178.1《剛性PCB檢驗標準》。
6.2 導線公差
導線寬度以線路底部寬度為準。其公差要求如下表所示:
表6.2-1 導線精度要求
| 線寬 | 公差 |
|---|---|
| 3 mils | ±0.7 mils |
| ≥4 mils | ± 20% |
6.3 孔徑公差
表6.3-1 孔徑公差要求
| 類型 | 孔徑公差 | 備注 |
|---|---|---|
| 微孔 | ±0.025mm | 微孔孔徑為金屬化前直徑。如下圖 “A” |
| 機械鉆孔式埋孔 | ±0.1mm | 此處“孔徑”指成孔孔徑 |
| 其他類型 | 參考Q/DKBA3178.1《剛性PCB檢驗標準》 |
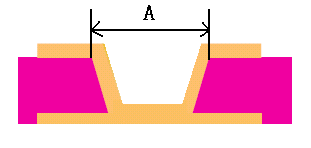
圖6.3-1 微孔孔徑示意圖
6.4 微孔孔位
微孔允許與Target Pad及Capture Pad相切,但不允許破盤。

圖6.4-1 微孔孔位示意圖
7 結構完整性要求
結構完整性要求需在熱應力(Thermal stress)試驗后進行,熱應力試驗方法:依據IPC-TM-650-2.6.8條件B進行。除非特殊要求,要經過5次熱應力后切片。
金相切片的制作要求依照IPC-TM-650-2.1.1或2.1.1.2進行,垂直切片至少檢查3個孔。金相切片的觀察要求在100X ±5%的放大下進行,評判時在200X ±5%的放大下進行,鍍層厚度小于1um時不能用金相切片技術來測量。
7.1 鍍層完整性
[1] 金屬鍍層無裂紋、分離、空洞和污染物;
[2] 微孔底部和Target Pad之間不允許出現未除盡的膠渣或其他雜質。
7.2 介質完整性
測試后無剝離、氣泡、分層、軟化等現象。
7.3 微孔形貌
[1] 微孔直徑應滿足:B≥0.5×A
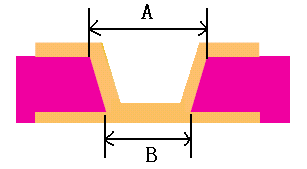
圖7.3-1 微孔形貌
(注:A—微孔頂部電鍍前直徑;B—微孔底部電鍍前直徑。)
[2] 微孔孔口不允許出現“封口”現象:
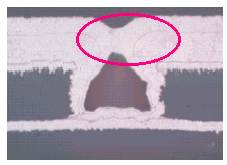
圖7.3-2 微孔孔口形貌
7.4 積層被蝕厚度要求
若采用Large Windows方式,積層介質在工藝過程中(如Desmear)被蝕厚度H≤10um。
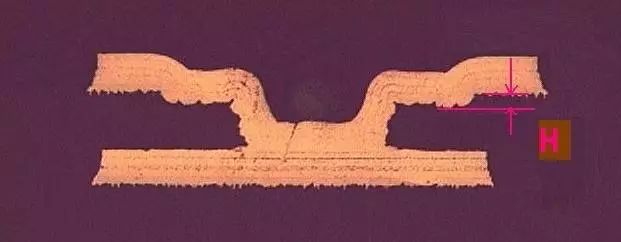
圖7.4-1 積層被蝕厚度
7.5 埋孔塞孔要求
埋孔不能有可見空洞,凸、凹現象不能影響介質厚度的要求。
8 其他測試要求
8.1 附著力測試
表8.1-1 附著力測試要求
| 序號 | 測試目的 | 測試項目 | 測試方法 | 性能指標 | 備注 |
|---|---|---|---|---|---|
| 1 | 綠油附著力 | 膠帶測試 | 同《剛性PCB檢驗標準》 | 同《剛性PCB檢驗標準》,且不能露銅 | 需關注BGA塞孔區 |
| 2 | 金屬和介質附著力 | 剝離強度(Peel Strength) | IPC-TM-650 2.4.8 | ≥5Pound/inch | |
| 3 | 微孔盤浮離(Lift lands) | 熱應力測試(Thermal Stress) | IPC-TM-650 2.6.8條件B | 5次測試后無盤浮離現象 | |
| 4 | 表面安裝盤和NPTH孔盤附著力 | 拉脫強度測試(Bond Strength) | IPC-TM-650-2.4.21.1 | ≥2kg或2kg/cm2 |
9 電氣性能
9.1 電路
絕緣性:線間絕緣電阻大于10MΩ;測試用的網絡電壓要能提供足夠的電流,但不能引起網絡間飛弧;最小測試電壓≥40V。
9.2 介質耐電壓
依照IPC-TM-650-2.5.7進行測試,要求耐壓1000VDC,且在導體間沒有閃光、火花或擊穿。
10 環境要求
10.1 濕熱和絕緣電阻試驗
依照IPC-TM-650-2.6.3進行測試,經過濕熱加壓環境后,絕緣電阻≥500MΩ。
10.2 熱沖擊(Thermal shock)試驗
依照IPC-TM-650-2.6.7.2進行測試,默認條件為Test Condition D,溫度循環為-55~+125℃,樣片的電氣性能首先要滿足要求;測試結果要求導體電阻變化≤10%。
11 特殊要求
HDI印制板若有其他特殊要求時,如Outgassing、有機污染(Organic contamination)、抗菌(Fungus resistance)、抗振動(Vibration)、機械沖擊,則依據IPC-6012進行。
-
pcb
+關注
關注
4362文章
23465瀏覽量
408782 -
印制電路板
+關注
關注
14文章
965瀏覽量
41751 -
HDI
+關注
關注
7文章
212瀏覽量
21841
原文標題:一文了解:高密度PCB(HDI)制造檢驗標準!
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
PCB技術詳解:HDI技術實現高密度互連板

什么是HDI?PCB設計基礎與HDI PCB制造工藝






 高密度PCB(HDI)制造檢驗標準
高密度PCB(HDI)制造檢驗標準













評論