引言
在半導體材料領域,碳化硅(SiC)因其出色的物理和化學特性,如高硬度、高熱導率、高擊穿電場強度等,成為制造高功率、高頻電子器件的理想材料。然而,在大尺寸SiC外延生長過程中,襯底應力問題一直是影響外延片質量和性能的關鍵因素。為了克服這一問題,應力消除外延生長裝置及外延生長方法應運而生。本文將詳細介紹這種裝置和方法的工作原理、技術特點以及應用前景。
應力消除外延生長裝置
應力消除外延生長裝置主要包括上下料室、傳片室、消除應力室和反應室四個部分。這四個部分通過高精度的機械傳動系統和控制系統實現襯底的自動傳遞和工藝參數的精確控制。
上下料室:用于放置待加工的SiC襯底和已加工好的外延片,方便人工操作和設備維護。
傳片室:連接上下料室、消除應力室和反應室,通過機械手實現襯底的快速、精確傳遞。傳片室內部保持潔凈環境,避免襯底在傳遞過程中受到污染。
消除應力室:是裝置的核心部分,用于在高溫、低壓和氮氣氛圍下對SiC襯底進行應力消除處理。消除應力室內部設有加熱裝置、抽空裝置和氮氣通氣裝置,能夠精確控制溫度、壓力和氣體氛圍,從而實現高效的應力消除。
反應室:用于進行SiC外延生長。反應室內部設有加熱裝置、氣體通入裝置和排氣裝置,能夠精確控制溫度、氣體流量和反應時間等工藝參數,從而實現高質量的外延生長。
外延生長方法
應力消除外延生長方法主要包括以下步驟:
襯底準備:將待加工的SiC襯底從上下料室取出,通過傳片室傳遞到消除應力室。
應力消除處理:在消除應力室內,通過高溫(1400℃-1500℃)、低壓(10e-4torr~10e-6torr)和氮氣氛圍對SiC襯底進行應力消除處理。處理時間為7.5分鐘。在氮氣氛圍下進行熱處理,氮分子在低壓下可快速擴散,修復SiC襯底原有的晶格不匹配,從而達到消除應力的目的。
外延生長:將應力消除后的SiC襯底通過傳片室傳遞到反應室。在反應室內,通過精確控制溫度、氣體流量和反應時間等工藝參數,進行SiC外延生長。外延生長完成后,將外延片從反應室中取出,通過傳片室傳遞到上下料室。
技術特點
高效應力消除:通過在消除應力室內進行高溫、低壓和氮氣氛圍下的熱處理,能夠高效消除SiC襯底中的應力,提高外延片的濃厚度均勻性和晶體質量。
精確工藝控制:通過高精度的機械傳動系統和控制系統,能夠精確控制溫度、壓力、氣體流量和反應時間等工藝參數,實現高質量的外延生長。
高制程效率:消除應力處理和外延生長可以在不同的腔室內同時進行,互不影響,從而提高了制程效率。
適用于大尺寸襯底:該裝置和方法特別適用于8英寸等大尺寸SiC襯底的外延生長,能夠解決大尺寸襯底在外延生長過程中遇到的應力問題。
應用前景
應力消除外延生長裝置及外延生長方法在SiC半導體材料領域具有廣闊的應用前景。它可以用于制造高功率、高頻電子器件,如SiC功率二極管、SiC功率晶體管等。這些器件在電動汽車、智能電網、航空航天等領域具有廣泛的應用價值。隨著SiC半導體材料技術的不斷發展,應力消除外延生長裝置及外延生長方法將發揮越來越重要的作用。
結論
應力消除外延生長裝置及外延生長方法是一種高效、精確的SiC外延生長技術。它通過消除SiC襯底中的應力,提高了外延片的濃厚度均勻性和晶體質量。同時,該裝置和方法具有精確工藝控制、高制程效率和適用于大尺寸襯底等優點。在未來,隨著SiC半導體材料技術的不斷進步和應用領域的不斷拓展,應力消除外延生長裝置及外延生長方法將發揮更加重要的作用。
高通量晶圓測厚系統
高通量晶圓測厚系統以光學相干層析成像原理,可解決晶圓/晶片厚度TTV(Total Thickness Variation,總厚度偏差)、BOW(彎曲度)、WARP(翹曲度),TIR(Total Indicated Reading 總指示讀數,STIR(Site Total Indicated Reading 局部總指示讀數),LTV(Local Thickness Variation 局部厚度偏差)等這類技術指標。



高通量晶圓測厚系統,全新采用的第三代可調諧掃頻激光技術,相比傳統上下雙探頭對射掃描方式;可一次性測量所有平面度及厚度參數。

1,靈活適用更復雜的材料,從輕摻到重摻 P 型硅 (P++),碳化硅,藍寶石,玻璃,鈮酸鋰等晶圓材料。

重摻型硅(強吸收晶圓的前后表面探測)

粗糙的晶圓表面,(點掃描的第三代掃頻激光,相比靠光譜探測方案,不易受到光譜中相鄰單位的串擾噪聲影響,因而對測量粗糙表面晶圓)

低反射的碳化硅(SiC)和鈮酸鋰(LiNbO3);(通過對偏振效應的補償,加強對低反射晶圓表面測量的信噪比)

絕緣體上硅(SOI)和MEMS,可同時測量多層結構,厚度可從μm級到數百μm級不等。

可用于測量各類薄膜厚度,厚度最薄可低至 4 μm ,精度可達1nm。
2,可調諧掃頻激光的“溫漂”處理能力,體現在極端工作環境中抗干擾能力強,充分提高重復性測量能力。

3,采用第三代高速掃頻可調諧激光器,一改過去傳統SLD寬頻低相干光源的干涉模式,解決了由于相干長度短,而重度依賴“主動式減震平臺”的情況。卓越的抗干擾,實現小型化設計,同時也可兼容匹配EFEM系統實現產線自動化集成測量。

4,靈活的運動控制方式,可兼容2英寸到12英寸方片和圓片測量。
-
半導體
+關注
關注
334文章
27790瀏覽量
223180 -
SiC
+關注
關注
29文章
2901瀏覽量
62994 -
碳化硅
+關注
關注
25文章
2840瀏覽量
49296
發布評論請先 登錄
相關推薦
氮化鎵外延片工藝介紹 氮化鎵外延片的應用
GaN外延生長方法及生長模式
淺談GaN 異質襯底外延生長方法
SiGe外延工藝及其在外延生長、應變硅應用及GAA結構中的作用

8英寸單片高溫碳化硅外延生長室結構





 應力消除外延生長裝置及外延生長方法
應力消除外延生長裝置及外延生長方法
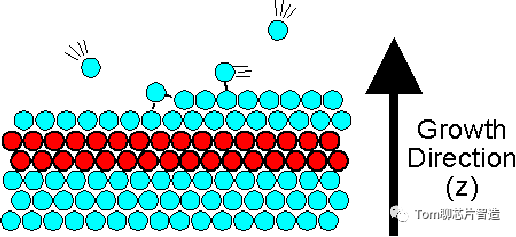
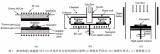
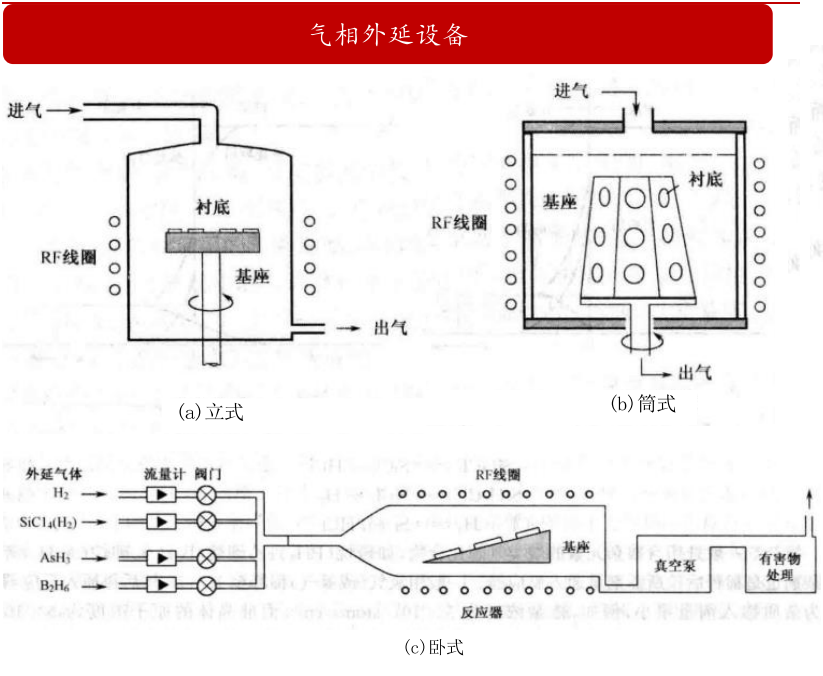











評論