HAST試驗(yàn)的背景與重要性
在電子產(chǎn)品的可靠性評(píng)估體系中,環(huán)境應(yīng)力是引發(fā)故障的關(guān)鍵因素之一。據(jù)美國(guó)Hughes航空公司的統(tǒng)計(jì)數(shù)據(jù)顯示,溫濕度應(yīng)力導(dǎo)致的電子產(chǎn)品故障占比高達(dá)60%,遠(yuǎn)超其他環(huán)境因素。傳統(tǒng)的高溫高濕試驗(yàn)(如85℃/85%RH)雖能模擬濕熱環(huán)境,但測(cè)試周期過(guò)長(zhǎng),難以滿足快速驗(yàn)證產(chǎn)品可靠性的需求。在此背景下,非飽和蒸汽試驗(yàn)(HAST)應(yīng)運(yùn)而生,它通過(guò)增加試驗(yàn)箱內(nèi)的壓力,實(shí)現(xiàn)超過(guò)100℃的高溫高濕條件,顯著加速材料的吸濕速率和老化進(jìn)程,為電子產(chǎn)品可靠性驗(yàn)證提供了新的解決方案。
試驗(yàn)的原理與優(yōu)勢(shì)
HAST試驗(yàn)的核心原理在于利用高溫、高濕和高壓的環(huán)境條件,加速濕氣對(duì)產(chǎn)品的侵入,從而在短時(shí)間內(nèi)暴露產(chǎn)品的潛在缺陷。
與傳統(tǒng)高溫高濕試驗(yàn)相比,HAST試驗(yàn)箱內(nèi)的水蒸氣壓力遠(yuǎn)高于樣品內(nèi)部的水蒸氣分壓,這使得水汽能夠更快速地滲入樣品,加速腐蝕和絕緣劣化過(guò)程。例如,在相同的測(cè)試條件下,傳統(tǒng)的溫濕度偏壓試驗(yàn)可能需要1000小時(shí),而HAST試驗(yàn)僅需96 - 100小時(shí)即可完成,大大縮短了測(cè)試時(shí)間。此外,HAST試驗(yàn)還可以快速激發(fā)PCB和芯片的特定失效模式,如分層、開(kāi)裂、短路、腐蝕及爆米花效應(yīng)等。這些失效模式在實(shí)際使用中可能導(dǎo)致產(chǎn)品性能下降甚至完全失效,通過(guò)HAST試驗(yàn)?zāi)軌蛟谘邪l(fā)階段提前發(fā)現(xiàn)并優(yōu)化設(shè)計(jì),避免這些問(wèn)題在最終用戶使用中出現(xiàn),為企業(yè)節(jié)省了大量的時(shí)間和成本。
應(yīng)用范圍與標(biāo)準(zhǔn)
HAST試驗(yàn)憑借其獨(dú)特的優(yōu)勢(shì),廣泛應(yīng)用于電子、汽車、航天、光伏等多個(gè)行業(yè),尤其適用于評(píng)估非密封封裝(如塑料封裝)器件在潮濕環(huán)境中的可靠性。它可以用于測(cè)試印刷線路板材料的吸濕率、半導(dǎo)體封裝的抗?jié)衲芰Γ约凹铀倮匣瘔勖囼?yàn),幫助企業(yè)在設(shè)計(jì)階段快速暴露產(chǎn)品的缺陷和薄弱環(huán)節(jié),從而縮短試驗(yàn)周期、降低成本。HAST試驗(yàn)的執(zhí)行標(biāo)準(zhǔn)包括IEC 60068 - 2 - 66、JESD22 - A110、JESD22 - A118等。這些標(biāo)準(zhǔn)為不同類型的電子產(chǎn)品和材料提供了詳細(xì)的測(cè)試條件和方法。例如,JESD22 - A110標(biāo)準(zhǔn)規(guī)定了130℃、85%RH、33.3psia(230kPa)的測(cè)試條件,測(cè)試時(shí)間通常為96小時(shí)。這些標(biāo)準(zhǔn)的制定確保了HAST試驗(yàn)的科學(xué)性和可重復(fù)性,使其成為行業(yè)內(nèi)廣泛認(rèn)可的可靠性測(cè)試方法,為電子產(chǎn)品的可靠性評(píng)估提供了統(tǒng)一的規(guī)范和依據(jù)。
失效機(jī)理
在HAST試驗(yàn)中,濕氣的侵入是導(dǎo)致產(chǎn)品失效的主要原因。濕氣可以通過(guò)多種途徑進(jìn)入封裝體,如IC芯片和引線框架吸收的水分、塑封料中的水分、以及塑封工作間的高濕度環(huán)境等。一旦濕氣進(jìn)入封裝體內(nèi)部,就會(huì)引發(fā)一系列失效機(jī)理:
電化學(xué)腐蝕:
濕氣中的水分和雜質(zhì)離子會(huì)引發(fā)IC鋁線的電化學(xué)腐蝕,導(dǎo)致鋁線開(kāi)路或遷移生長(zhǎng),影響電路的正常連接和信號(hào)傳輸。
聚合物材料的解聚:
濕氣的侵入會(huì)降低聚合物材料的結(jié)合能力,導(dǎo)致材料解聚、空洞形成、分層等問(wèn)題,破壞封裝體的完整性和密封性。
爆米花效應(yīng):
封裝體內(nèi)的水分在高溫下汽化,產(chǎn)生高壓,導(dǎo)致封裝體破裂,嚴(yán)重影響產(chǎn)品的外觀和結(jié)構(gòu)完整性。
離子遷移:
在偏壓條件下,濕氣會(huì)引起離子遷移,導(dǎo)致引腳間短路,造成電路故障。這些失效機(jī)理不僅會(huì)影響產(chǎn)品的電氣性能,還可能導(dǎo)致產(chǎn)品的機(jī)械結(jié)構(gòu)損壞,最終影響產(chǎn)品的使用壽命,給用戶帶來(lái)潛在的安全隱患。
結(jié)語(yǔ)
HAST試驗(yàn)作為一種高效的加速老化測(cè)試方法,通過(guò)模擬極端的溫濕度和壓力條件,能夠在短時(shí)間內(nèi)評(píng)估電子產(chǎn)品在潮濕環(huán)境中的可靠性。它不僅能夠快速激發(fā)產(chǎn)品的潛在失效模式,還能幫助企業(yè)優(yōu)化產(chǎn)品設(shè)計(jì)、縮短研發(fā)周期、降低成本。
-
電子產(chǎn)品
+關(guān)注
關(guān)注
6文章
1213瀏覽量
59219 -
測(cè)試
+關(guān)注
關(guān)注
8文章
5653瀏覽量
128475 -
試驗(yàn)
+關(guān)注
關(guān)注
0文章
230瀏覽量
16535
發(fā)布評(píng)論請(qǐng)先 登錄
雙851000h(THB)和HAST96h實(shí)驗(yàn),誰(shuí)的實(shí)驗(yàn)理論壽命更長(zhǎng)?
一文帶你了解步進(jìn)電機(jī)的相關(guān)知識(shí)
測(cè)量非飽和土基質(zhì)吸力的微型傳感器分析
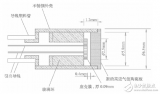
溫度補(bǔ)償對(duì)飽和蒸汽流量計(jì)測(cè)量結(jié)果的影響
壓力補(bǔ)償對(duì)飽和蒸汽流量計(jì)測(cè)量結(jié)果的影響
飽和變壓器與非飽和變壓器有何不同?
HAST非飽和老化試驗(yàn)箱的基礎(chǔ)介紹

高壓加速老化試驗(yàn)箱PCT和HAST的區(qū)別

一文帶你了解紅墨水實(shí)驗(yàn)!






 一文帶你了解什么是非飽和蒸汽實(shí)驗(yàn)(HAST)?
一文帶你了解什么是非飽和蒸汽實(shí)驗(yàn)(HAST)?













評(píng)論