一、環(huán)氧樹脂在IGBT模塊封裝中的應(yīng)用現(xiàn)狀
1. **核心應(yīng)用場景與工藝**
IGBT模塊封裝中,環(huán)氧樹脂主要通過灌封(Potting)和轉(zhuǎn)模成型(Molding)兩種工藝實現(xiàn)。
灌封工藝:采用雙組分環(huán)氧樹脂(含樹脂、固化劑、無機填料等),通過混合、脫泡、灌封及階梯固化(如80℃/1h + 125℃/2h + 140℃/3h)形成高硬度保護層,提升模塊抗機械沖擊性和耐環(huán)境性,廣泛應(yīng)用于軌道交通等高可靠性場景。
大功率IGBT環(huán)氧灌封膠應(yīng)用工藝介紹
山中夜雨人,公眾號:亮說材料大功率IGBT環(huán)氧灌封膠應(yīng)用工藝介紹
轉(zhuǎn)模成型:使用環(huán)氧模塑料(EMC),在高溫模腔中成型,適用于大規(guī)模生產(chǎn)。EMC需滿足低熱膨脹系數(shù)(CTE)、高導(dǎo)熱性(1 W/m·K以上)及低吸水率(<0.1%)等要求,尤其適配電動汽車雙面散熱模塊需求。 ?
環(huán)氧樹脂在大功率IGBT/SiC模塊封裝中的應(yīng)用研究
山中夜雨人,公眾號:亮說材料環(huán)氧樹脂在大功率IGBT/SiC模塊封裝中的應(yīng)用研究
2. 材料性能要求
耐高溫性:需耐受200℃以上高溫,避免傳統(tǒng)雙酚A型環(huán)氧樹脂在高溫下軟化或化學(xué)鍵斷裂。
用于IGBT/碳化硅芯片高功率模塊的液態(tài)環(huán)氧封裝材料
公眾號:艾邦半導(dǎo)體網(wǎng)用于IGBT/碳化硅芯片高功率模塊的液態(tài)環(huán)氧封裝材料
低CTE與高機械強度:CTE需接近芯片材料(如硅或碳化硅),防止熱應(yīng)力導(dǎo)致分層或開裂;拉伸強度需達(dá)40-50 MPa。
電氣絕緣性:介電強度需超過21 kV/mm,體積電阻率達(dá)101? Ω·cm以上,確保高電壓環(huán)境下的可靠性。
3. 典型材料與供應(yīng)商
環(huán)氧灌封膠:如三菱電機的DP樹脂(Direct Potting Resin),通過液態(tài)灌封減少焊料裂紋,提升熱循環(huán)壽命。
EMC樹脂:信越化學(xué)、京瓷化學(xué)等廠商的產(chǎn)品以高填料含量(85%以上二氧化硅)和低翹曲特性主導(dǎo)市場。
二、當(dāng)前技術(shù)挑戰(zhàn)
1. 高溫穩(wěn)定性與耐老化性
傳統(tǒng)環(huán)氧樹脂在200℃以上長期運行時易發(fā)生分子鏈斷裂,導(dǎo)致性能退化,難以適配碳化硅(SiC)IGBT的高溫需求。
2. 固化收縮與CTE不匹配
環(huán)氧樹脂固化收縮率(0.03-0.04%)若與芯片差異過大,會引發(fā)界面應(yīng)力,需通過納米填料(如氧化鋁)改性優(yōu)化。
3. 樹脂析出問題
固化過程中未交聯(lián)的樹脂分子可能析出,污染鍵合區(qū)。需通過分步固化、添加抑制劑(如有機硅化合物)或優(yōu)化基板表面處理(如等離子清洗)加以控制。
三、未來發(fā)展趨勢
1. 材料體系優(yōu)化
耐高溫樹脂開發(fā):采用甲基六氫苯酐(MeHHPA)固化劑、CTBN增韌劑改性環(huán)氧樹脂,提升玻璃化溫度至200℃以上,并增強抗冷熱沖擊能力(如1000次-40~125℃循環(huán))。
納米復(fù)合技術(shù):添加納米氧化鋁或碳化硅填料,改善熱導(dǎo)率(達(dá)1.19 W/m·K)和介電強度(28.28 kV/mm)。
2. 環(huán)保與多功能化
無鹵阻燃與低VOC:開發(fā)綠色EMC樹脂,減少溴系阻燃劑使用,滿足歐盟RoHS標(biāo)準(zhǔn)。
多功能集成:兼具導(dǎo)熱(>1.5 W/m·K)、導(dǎo)電或電磁屏蔽功能的環(huán)氧樹脂,適配智能功率模塊需求。
3. 工藝創(chuàng)新
液態(tài)環(huán)氧直接灌封:省去硅凝膠預(yù)灌步驟,通過低黏度液態(tài)環(huán)氧(如雙組分體系)實現(xiàn)高精度填充,降低熱膨脹系數(shù)差異風(fēng)險。
智能化固化控制:結(jié)合在線監(jiān)測技術(shù)實時調(diào)整固化參數(shù),減少樹脂析出并提升良率。
4. 應(yīng)用場景擴展
碳化硅模塊封裝:針對SiC IGBT的200℃以上運行需求,開發(fā)耐高溫、低CTE的環(huán)氧樹脂,解決傳統(tǒng)硅膠灌封的高溫失效問題。
新能源汽車與可再生能源:適配高功率密度、雙面散熱模塊設(shè)計,提升耐振動性與環(huán)境耐久性。
四、結(jié)論
環(huán)氧樹脂作為IGBT模塊封裝的核心材料,其性能直接決定模塊的可靠性及壽命。當(dāng)前技術(shù)已通過復(fù)合改性和工藝優(yōu)化顯著提升耐熱性與機械強度,但高溫穩(wěn)定性、環(huán)保性及多功能集成仍是未來突破方向。隨著新能源汽車與SiC器件的普及,環(huán)氧樹脂將向高性能化、智能化及綠色化發(fā)展,成為支撐下一代功率電子技術(shù)的關(guān)鍵材料。
-
封裝
+關(guān)注
關(guān)注
128文章
8363瀏覽量
144469 -
IGBT
+關(guān)注
關(guān)注
1276文章
3933瀏覽量
252735 -
環(huán)氧樹脂
+關(guān)注
關(guān)注
0文章
40瀏覽量
9655
原文標(biāo)題:IGBT模塊封裝用環(huán)氧樹脂技術(shù)現(xiàn)狀及未來發(fā)展趨勢分析
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
工業(yè)電機行業(yè)現(xiàn)狀及未來發(fā)展趨勢分析
機械硬盤的未來發(fā)展趨勢探析
適用于內(nèi)窺鏡鏡頭模組的環(huán)氧樹脂封裝膠
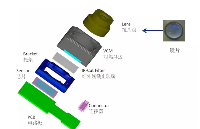
下一代主流SiC IGBT模塊封裝技術(shù)研發(fā)趨勢——環(huán)氧灌封技術(shù)

光模塊技術(shù)發(fā)展趨勢 光模塊常見故障及解決方法
未來物流發(fā)展趨勢與TMS的關(guān)系
驅(qū)動能源革新:環(huán)氧樹脂變壓器1140V變400V的未來

未來的ar技術(shù)發(fā)展趨勢
邊緣計算的未來發(fā)展趨勢
未來AI大模型的發(fā)展趨勢
IGBT和SiC封裝用的環(huán)氧材料

變阻器的未來發(fā)展趨勢和前景如何?是否有替代品出現(xiàn)?
智能制造行業(yè)現(xiàn)狀與發(fā)展趨勢
未來隧道定位導(dǎo)航技術(shù)有哪些發(fā)展趨勢






 IGBT模塊封裝中環(huán)氧樹脂技術(shù)的現(xiàn)狀與未來發(fā)展趨勢探析
IGBT模塊封裝中環(huán)氧樹脂技術(shù)的現(xiàn)狀與未來發(fā)展趨勢探析











評論