文章來源:芯學知
原文作者:芯啟未來
本文介紹帶金屬的中間鍵合技術
鍵合技術主要分為直接鍵合和帶有中間層的鍵合。直接鍵合如硅硅鍵合,陽極鍵合等鍵合條件高,如高溫、高壓等。而帶有中間層的鍵合,所需的溫度更低,壓力也更小。帶金屬的中間層鍵合技術主要包括共晶鍵合、焊料鍵合、熱壓鍵合和反應鍵合等。本文主要對共晶鍵合進行介紹。
共晶鍵合,又稱共晶焊接,指兩種或兩種以上金屬層,在一定的溫度下直接從固體轉化成液態(tài),通過金屬的再結晶在鍵合面形成共晶相的鍵合工藝。共晶鍵合優(yōu)勢是鍵合過程的溫度比直接鍵合低,也比單層金屬的熔點低很多;同時鍵合過程中出氣量很低,可以實現(xiàn)高真空零級封裝;另外,由于共晶鍵合是液相鍵合,因此對鍵合面的平整度、劃痕和顆粒都不敏感,利于保證鍵合良率和批量生產。

圖 Al-Ge鍵合示意圖
常用的共晶鍵合材料體系包括Au-Si,Au-Ge,Al-Ge,Au-Sn和Au-In等。Au-Si和Au-Ge體系的鍵合溫度約400°C,Al-Ge 體系的鍵合溫度約420°C,Au-Sn體系的鍵合溫度約300°C, Au-Sn體系的鍵合溫度約180°C。為實現(xiàn)高真空度封裝,MEMS陀螺儀多采用Al-Ge、Au-Si的共晶鍵合技術。為實現(xiàn)低溫鍵合封裝,在光學MEMS器件,如MEMS微鏡和VCSEL中采用Au-In的共晶鍵合。
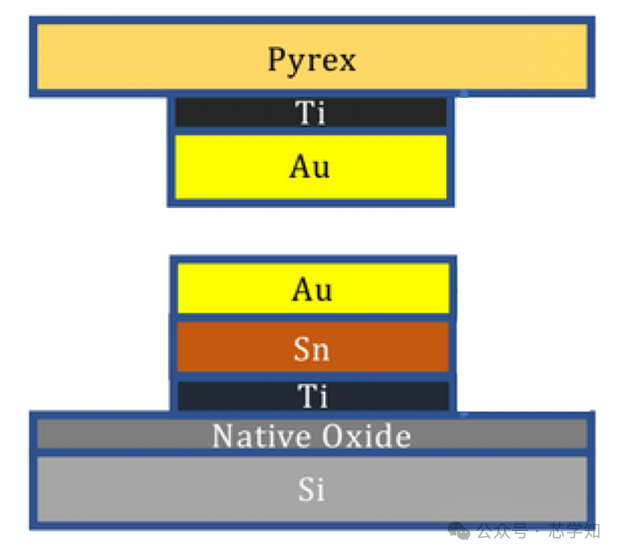
圖 Au-Sn鍵合示意圖
共晶鍵合需要在2片晶圓的鍵合面制作金屬層,制作方法包括濺射和絲印等。Al-Ge鍵合分別在2個鍵合面采用磁控濺射鍍Al和Ge膜,采用刻蝕或剝離的方法進行鍵合區(qū)域的圖形化。根據實際的要求和襯底的情況,決定是否預先制作1μm厚度的UBM(Under Bump Metallization)作為黏附層。Al和Ge膜的厚度通常低于1μm,經過高溫,鍵合界面上的金屬形成互溶液相,形成共晶結構,完成鍵合。
Au-Sn共晶鍵合通常采用在一片待鍵合的晶片鍵合面通過物理氣相沉積的方法制備疊層的Au-Sn層,另一片鍵合的晶片鍵合面通過物理氣相沉積的方法制備Au層,Au和Sn的厚度比例決定了金屬間化合物的成分,金屬間化合物的特性決定了鍵合的質量。常用的厚度比例是Au:Sn=8:2。
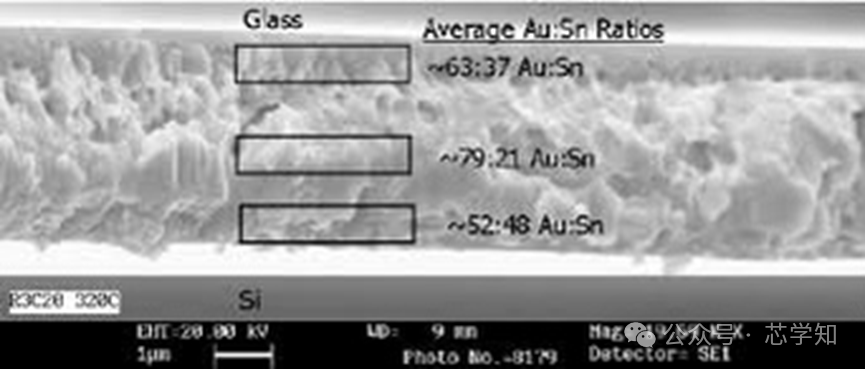
圖 鍵合中間層Au-Sn比例
-
mems
+關注
關注
129文章
4152瀏覽量
194177 -
工藝
+關注
關注
4文章
683瀏覽量
29445 -
焊接
+關注
關注
38文章
3417瀏覽量
61385 -
鍵合
+關注
關注
0文章
82瀏覽量
8103
原文標題:帶金屬的中間鍵合技術如何實現(xiàn)?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
晶圓鍵合中使用的主要技術
帶你一文了解什么是引線鍵合(WireBonding)技術?






 一文詳解共晶鍵合技術
一文詳解共晶鍵合技術




















評論