文章來(lái)源:學(xué)習(xí)那些事
原文作者:小陳婆婆
本文主要講解了芯片與應(yīng)用有關(guān)的失效機(jī)理。
半導(dǎo)體集成電路失效機(jī)理中除了與封裝有關(guān)的失效機(jī)理以外,還有與應(yīng)用有關(guān)的失效機(jī)理,分述如下
輻射引起的失效
與鋁有關(guān)的界面效應(yīng)
金與鋁有關(guān)的界面效應(yīng)
輻射引起的失效
在地球及外層空間環(huán)境中,輻射源分為自然(如宇宙射線)和人造(如核反應(yīng)堆)兩類(lèi),其對(duì)微電子器件的損傷可分為以下三類(lèi):
永久損傷:輻射源移除后,器件性能無(wú)法恢復(fù),如晶格結(jié)構(gòu)永久性破壞或深能級(jí)缺陷形成。
半永久損傷:輻射源移除后,器件性能需較長(zhǎng)時(shí)間(如數(shù)小時(shí)至數(shù)天)才能部分恢復(fù),通常與淺能級(jí)陷阱電荷的緩慢退火有關(guān)。
瞬時(shí)損傷:輻射源移除后,器件性能立即恢復(fù),如單粒子瞬態(tài)(SET)引起的邏輯錯(cuò)誤。
輻射對(duì)器件的影響主要通過(guò)三種形式實(shí)現(xiàn)
瞬時(shí)輻照:高能粒子(如α粒子)直接電離硅材料,產(chǎn)生瞬時(shí)電流脈沖,可能干擾電路邏輯狀態(tài)。
單粒子輻照:?jiǎn)蝹€(gè)重離子(如宇宙射線中的高能粒子)穿過(guò)器件敏感區(qū)域(如MOS管溝道),引發(fā)單粒子翻轉(zhuǎn)(SEU)或單粒子閂鎖(SEL)。
總劑量效應(yīng):長(zhǎng)期累積的低劑量輻射(如γ射線或X射線)導(dǎo)致氧化層中陷阱電荷積累,改變MOS器件閾值電壓,最終引發(fā)功能失效。
輻射損傷的物理機(jī)制
γ射線與X射線:通過(guò)光電效應(yīng)和康普頓散射產(chǎn)生電子-空穴對(duì)。在半導(dǎo)體中,電子-空穴對(duì)可快速?gòu)?fù)合;但在氧化層(SiO?)中,部分空穴被深能級(jí)陷阱俘獲,形成固定正電荷。同時(shí),輻射在Si/SiO?界面引入新界面態(tài),導(dǎo)致MOS器件閾值電壓漂移、漏電流增加及跨導(dǎo)退化。
中子輻照:通過(guò)晶格碰撞產(chǎn)生原子移位(如硅原子離開(kāi)晶格位置),形成空位-間隙對(duì)缺陷。此類(lèi)缺陷顯著縮短雙極器件(如BJT)的載流子壽命,導(dǎo)致電流增益下降,但對(duì)多子導(dǎo)電的MOS器件影響較小。然而,MOS器件對(duì)總劑量效應(yīng)和單粒子效應(yīng)更為敏感,因氧化層電荷積累易導(dǎo)致其閾值電壓偏移。
抗輻射加固設(shè)計(jì)技術(shù)
針對(duì)宇航級(jí)應(yīng)用,需采用以下措施提升器件抗輻射能力:
抗單粒子設(shè)計(jì)
電路級(jí):采用三模冗余(TMR)或錯(cuò)誤校正碼(ECC)屏蔽SEU。
器件級(jí):優(yōu)化版圖布局(如增加敏感節(jié)點(diǎn)電容)以吸收單粒子瞬態(tài)電荷。
抗總劑量效應(yīng)設(shè)計(jì)
工藝優(yōu)化:采用輻射硬化氧化層(如氮氧化硅)減少陷阱電荷積累。
電路補(bǔ)償:集成閾值電壓監(jiān)測(cè)與動(dòng)態(tài)調(diào)整電路。
抗劑量率設(shè)計(jì)
材料選擇:采用高純度硅或外延層減少輻射感生缺陷。
結(jié)構(gòu)設(shè)計(jì):增加保護(hù)環(huán)或深溝槽隔離以防止寄生器件開(kāi)啟。
系統(tǒng)級(jí)加固
屏蔽設(shè)計(jì):利用金屬或陶瓷封裝材料阻擋高能粒子。
冗余與容錯(cuò):通過(guò)模塊化設(shè)計(jì)實(shí)現(xiàn)故障隔離與重構(gòu)。
器件敏感性差異
雙極器件:對(duì)中子位移損傷敏感,但對(duì)總劑量效應(yīng)耐受性較強(qiáng)。
MOS器件:對(duì)總劑量效應(yīng)和單粒子效應(yīng)敏感,但抗中子能力優(yōu)于雙極器件。
Bi-CMOS電路:需綜合優(yōu)化雙極與MOS部分的抗輻射性能,例如通過(guò)隔離技術(shù)減少雙極部分對(duì)MOS的干擾。
與鋁有關(guān)的界面效應(yīng)
鋁作為微電子器件中常用的互連材料,與二氧化硅(SiO?)及硅(Si)的界面反應(yīng)是器件失效的重要誘因,尤其在高溫、高電流密度或輻射環(huán)境下更為顯著。
鋁與二氧化硅(Al-SiO?)的高溫反應(yīng)
在硅基器件中,SiO?常用作介質(zhì)層,而鋁互連線在高溫下會(huì)與SiO?發(fā)生化學(xué)反應(yīng):
4Al + 3SiO? → 2Al?O? + 3Si
該反應(yīng)導(dǎo)致鋁層減薄,若SiO?層被完全消耗,鋁與硅直接接觸,可能引發(fā)PN結(jié)短路。在功率器件中,結(jié)溫升高易形成熱斑,局部加速Al-SiO?反應(yīng),進(jìn)一步加劇失效風(fēng)險(xiǎn)。
預(yù)防措施
優(yōu)化版圖設(shè)計(jì):改善熱分布,降低熱阻,增強(qiáng)散熱能力。
復(fù)合鈍化層:采用SiO?-Al-SiO?或Si?N?-SiO?多層結(jié)構(gòu),抑制鋁與SiO?的直接反應(yīng)。
雙層金屬化:使用Ti-Al、W-Al等復(fù)合金屬替代純鋁,利用阻擋層金屬(如Ti)阻隔鋁與SiO?的接觸。
鋁與硅(Al-Si)的界面失效機(jī)制
鋁與硅的界面反應(yīng)涉及多種物理過(guò)程,可歸納為以下三類(lèi):
(1)固溶體形成與滲透坑
鋁與硅的天然氧化層(SiO?)反應(yīng)后,硅原子向鋁中擴(kuò)散并溶解,形成固溶體。
在共晶溫度(577℃)下,硅在鋁中的溶解度達(dá)1.59%(原子比),導(dǎo)致鋁膜中出現(xiàn)滲透坑。
失效風(fēng)險(xiǎn):滲透坑多發(fā)生于接觸孔邊緣(因應(yīng)力集中和側(cè)向擴(kuò)散),可能穿透淺結(jié)器件的PN結(jié),導(dǎo)致漏電或短路。
(2)硅的電遷移(Electromigration)
溶解在鋁中的硅原子因濃度梯度向外擴(kuò)散,電流作用下電子動(dòng)能加速硅原子沿電子流方向遷移,形成質(zhì)量傳遞與動(dòng)量傳遞。

失效風(fēng)險(xiǎn):硅遷移可導(dǎo)致NPN晶體管基區(qū)接觸孔短路,或使淺結(jié)器件的E-B結(jié)退化。
(3)鋁的熱遷移(Thermomigration)
在高溫、高溫度梯度及高電流密度區(qū)域,鋁-硅界面發(fā)生電熱遷移。鋁沿Si/SiO?界面或縱向滲入硅,形成合金釘(Al spike),穿透PN結(jié)。
對(duì)比其他金屬:金(Au)與硅的共晶點(diǎn)僅377℃,其電熱遷移率高于鋁,需通過(guò)阻擋層(如NiCr、Mo)隔離接觸。
失效模式:
雙極性淺結(jié)器件:E-B結(jié)退化,反向漏電增加,擊穿特性由硬擊穿轉(zhuǎn)為軟擊穿(等效電阻跨接于結(jié)兩端);
NMOS集成電路:輸出端無(wú)保護(hù)電路,鋁在靜電或過(guò)電應(yīng)力下沿Si/SiO?界面形成導(dǎo)電通道,導(dǎo)致N+區(qū)與P襯底短路(電阻約2kΩ)。
預(yù)防措施
(1)材料優(yōu)化
硅鋁合金(Al-Si):含0.1%~0.3%硅的鋁合金可抑制硅進(jìn)一步溶解,同時(shí)提高抗電遷移能力和機(jī)械強(qiáng)度。
金屬硅化物:采用Al-Ti-Si、Al-(Ti/W)-PtSi-Si等多層系統(tǒng),結(jié)合阻擋層金屬(如Ti、Mo)阻隔鋁與硅的直接接觸。
(2)結(jié)構(gòu)改進(jìn)
多晶硅阻擋層:在鋁與硅之間沉積多晶硅膜,抑制界面反應(yīng)。
多層金屬化:使用Ti/Al/TiN等復(fù)合結(jié)構(gòu),降低鋁與硅的互擴(kuò)散。
(3)工藝控制
低溫工藝:避免高溫步驟(如快速單次熱退火),減少鋁與硅的固相反應(yīng)。
電流密度限制:優(yōu)化電路布局,降低局部電流密度,抑制電遷移與熱遷移。
金與鋁的界面效應(yīng)
在微電子封裝中,金(Au)引線或鍵合絲與鋁(Al)互連線的鍵合界面(Au-Al)因化學(xué)勢(shì)差異,長(zhǎng)期使用或高溫(>200℃)存儲(chǔ)后,會(huì)形成多種金屬間化合物(IMCs),導(dǎo)致界面失效。
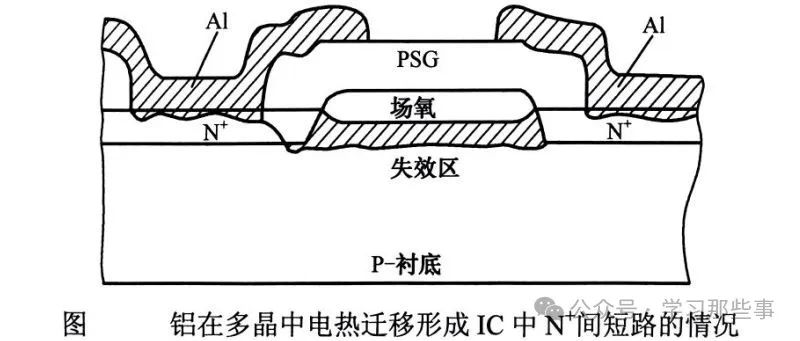
失效機(jī)制
(1)金屬間化合物(IMCs)的形成
Au與Al在高溫下反應(yīng)生成多種IMCs,如Au?Al?、Au?Al、Au?Al、AuAl、AuAl?等。這些化合物的晶格常數(shù)和熱膨脹系數(shù)(CTE)與Au、Al差異顯著,在鍵合點(diǎn)內(nèi)產(chǎn)生應(yīng)力,導(dǎo)致:

機(jī)械性能退化:IMCs(如Au?Al)脆性大,易形成裂紋(白斑),而AuAl?呈紫色(紫斑),進(jìn)一步降低黏附力。
電性能下降:IMCs的電導(dǎo)率低于純金屬,接觸電阻增加,最終引發(fā)開(kāi)路。
(2)柯肯德?tīng)枺↘irkendall)效應(yīng)
在高溫(>300℃)下,Au向Al中的擴(kuò)散速率遠(yuǎn)高于Al向Au中的擴(kuò)散速率,導(dǎo)致Al焊盤(pán)材料被快速消耗。IMCs(如Au?Al)生長(zhǎng)過(guò)程中,Al的缺失形成空洞(Kirkendall空洞),空洞擴(kuò)展至整個(gè)鍵合界面時(shí),Al膜脫落,導(dǎo)致高阻或開(kāi)路。
(3)化合物生長(zhǎng)壓力
IMCs的晶格常數(shù)大于Au和Al,其生長(zhǎng)對(duì)鍵合點(diǎn)施加壓力。在溫度循環(huán)或機(jī)械應(yīng)力下,焊點(diǎn)因壓力累積而裂開(kāi),加速開(kāi)路失效。
失效表現(xiàn)與診斷
開(kāi)路失效:鍵合點(diǎn)電阻急劇升高,但電測(cè)試時(shí)可能出現(xiàn)時(shí)通時(shí)斷現(xiàn)象(因機(jī)械振動(dòng)或熱應(yīng)力暫時(shí)恢復(fù)接觸)。
高溫存儲(chǔ)測(cè)試:將器件置于200℃以上環(huán)境,若開(kāi)路失效復(fù)現(xiàn),可確認(rèn)Au-Al界面退化。
影響因素
材料純度:雜質(zhì)(如硅、銅)加速I(mǎi)MCs生長(zhǎng)。
溫度與時(shí)間:IMCs生長(zhǎng)速率隨溫度升高呈指數(shù)增長(zhǎng),長(zhǎng)期存儲(chǔ)或高溫工作加劇失效。
結(jié)構(gòu)不對(duì)稱:Al焊盤(pán)(厚度約1μm)為有限源,金球?yàn)闊o(wú)限源,導(dǎo)致IMCs向Al側(cè)偏析,加速Al消耗。
預(yù)防措施
(1)工藝優(yōu)化
溫度控制:鍵合溫度≤300℃,避免高溫存儲(chǔ)(<200℃)。
時(shí)間控制:縮短高溫工藝步驟(如鍵合時(shí)間),減少I(mǎi)MCs形成。
(2)材料改進(jìn)
阻擋層:在Au-Al界面插入擴(kuò)散阻擋層(如Ni、TiW),抑制IMCs生長(zhǎng)。
合金化:采用Al-Si合金(含0.5%~1% Si)提高抗電遷移能力,或改用高熔點(diǎn)金屬(如Cu)替代Al。
(3)結(jié)構(gòu)設(shè)計(jì)
多層金屬化:使用Ti/Al/TiN等復(fù)合結(jié)構(gòu),降低Al與Au的直接接觸。
鍵合點(diǎn)優(yōu)化:增大鍵合面積,分散應(yīng)力,減少局部過(guò)熱。
(4)可靠性測(cè)試
加速壽命試驗(yàn):通過(guò)高溫存儲(chǔ)(250℃)、溫度循環(huán)(-65℃~150℃)篩選潛在失效器件。
無(wú)損檢測(cè):利用聲學(xué)顯微鏡(SAM)或掃描電子顯微鏡(SEM)觀察鍵合點(diǎn)空洞和裂紋。
-
芯片
+關(guān)注
關(guān)注
459文章
51836瀏覽量
432387 -
集成電路
+關(guān)注
關(guān)注
5412文章
11837瀏覽量
365815 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28249瀏覽量
228730 -
失效機(jī)理
+關(guān)注
關(guān)注
2文章
29瀏覽量
11748
原文標(biāo)題:芯片與應(yīng)用有關(guān)的失效機(jī)理
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
仿真技術(shù)在半導(dǎo)體和集成電路生產(chǎn)流程優(yōu)化中的應(yīng)用
關(guān)于MIP705半導(dǎo)體集成電路的應(yīng)用
射頻集成電路半導(dǎo)體和CAD技術(shù)討論
芯片,集成電路,半導(dǎo)體含義
芯片,半導(dǎo)體,集成電路,傻傻分不清楚?
集成電路與半導(dǎo)體
半導(dǎo)體集成電路型號(hào)命名法

基于集成電路應(yīng)力測(cè)試認(rèn)證的失效機(jī)理
集成電路封裝失效機(jī)理
半導(dǎo)體集成電路封裝失效機(jī)理詳解






 詳解半導(dǎo)體集成電路的失效機(jī)理
詳解半導(dǎo)體集成電路的失效機(jī)理










評(píng)論