來(lái)源:電子電力實(shí)驗(yàn)室
作者:諸葛英健
本文轉(zhuǎn)自:IEEE TRANSACTIONS ON ELECTRON DEVICES, VOL. 71, NO. 3, MARCH 2024
作者:M. Buffolo et al.
本文由帕多瓦大學(xué)的G. Meneghesso教授和E. Zanoni教授等人合作撰寫。本文針對(duì)當(dāng)前及下一代電力電子領(lǐng)域中市售的碳化硅(SiC)與氮化鎵(GaN)晶體管進(jìn)行了全面綜述與展望。首先討論了GaN與SiC器件的材料特性及結(jié)構(gòu)差異。基于對(duì)市售GaN與SiC功率晶體管的分析,描述了這些技術(shù)的現(xiàn)狀,重點(diǎn)闡述了各技術(shù)平臺(tái)的首選功率變換拓?fù)浼瓣P(guān)鍵特性。同時(shí)回顧了GaN與SiC器件的當(dāng)前及未來(lái)應(yīng)用領(lǐng)域。文章還報(bào)告了與這兩種技術(shù)相關(guān)的主要可靠性問(wèn)題:針對(duì)GaN HEMTs,描述了閾值電壓穩(wěn)定性、動(dòng)態(tài)導(dǎo)通電阻及擊穿限制;針對(duì)SiC MOSFETs,則聚焦于柵極氧化層失效與短路(SC)魯棒性。最后,本文展望了這些材料在不同領(lǐng)域的應(yīng)用前景,并提出了未來(lái)可能的改進(jìn)方向,強(qiáng)調(diào)了對(duì)混合變換器的需求以及性能優(yōu)化與創(chuàng)新工具的結(jié)合。
01引言
當(dāng)前,減少對(duì)化石燃料的依賴是緩解氣候變化的關(guān)鍵目標(biāo)。在此背景下,電力電子變換器的效率提升、可再生能源的利用以及各類車輛與系統(tǒng)的電氣化發(fā)揮著至關(guān)重要的作用[1]。具體而言,提高功率變換器的效率可減少能量損耗,從而提升現(xiàn)有系統(tǒng)(如電源、暖通空調(diào)系統(tǒng)等)的整體效率。這是一種無(wú)需投資新基礎(chǔ)設(shè)施即可顯著節(jié)能的經(jīng)濟(jì)有效方式。近年來(lái),電氣化趨勢(shì)在車輛、廚房電器及環(huán)境加熱系統(tǒng)等高功率日常設(shè)備中尤為顯著,使得效率提升更為迫切[2]。這一需求在需要多級(jí)能量變換(如ac-dc、dc-dc等)的領(lǐng)域(如汽車或光伏系統(tǒng))中尤為重要。采用基于新型材料的晶體管可大幅提升功率變換器的效率,其性能與可靠性均優(yōu)于傳統(tǒng)硅器件。
應(yīng)對(duì)這一挑戰(zhàn)的極具前景的途徑是使用寬禁帶(WBG)半導(dǎo)體。憑借其特性,這類材料可制造出在許多場(chǎng)景下優(yōu)于現(xiàn)有硅基器件的電力電子器件(晶體管、二極管)。表I列出了主要WBG半導(dǎo)體材料的物理特性及其與硅的對(duì)比。與硅相比,WBG材料具有更高的臨界電場(chǎng),支持更高電壓的功率變換器,同時(shí)兼具低導(dǎo)通電阻與高導(dǎo)熱性。在眾多WBG半導(dǎo)體中,碳化硅(SiC)與氮化鎵(GaN)因性能優(yōu)異、技術(shù)成熟且已實(shí)現(xiàn)產(chǎn)業(yè)化,成為高壓開關(guān)器件的首選。目前,多種商用器件已面世并應(yīng)用于諸多領(lǐng)域。此外,氧化鎵、金剛石及氮化鋁等材料雖具有研究?jī)r(jià)值,但其成熟度仍不足以支持短期產(chǎn)業(yè)化。盡管如此,這些材料在特定應(yīng)用中潛力巨大,未來(lái)WBG半導(dǎo)體將在電力電子市場(chǎng)中占據(jù)更重要的地位。基于各材料的獨(dú)特性,預(yù)計(jì)不同技術(shù)將共存,各自聚焦特定應(yīng)用場(chǎng)景。
表1. 用于電力電子的半導(dǎo)體的材料特性
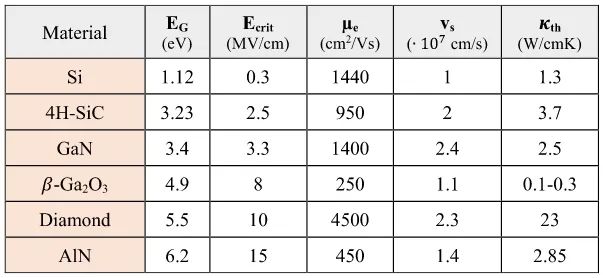
02市售器件
歷史上,WBG半導(dǎo)體中最早引起電力電子領(lǐng)域關(guān)注的是SiC。這主要?dú)w因于其與硅的強(qiáng)相似性,使得現(xiàn)有器件結(jié)構(gòu)可快速移植。此外,SiC的天然氧化物SiO?已在硅基電子領(lǐng)域得到深入研究,推動(dòng)了SiC技術(shù)的快速發(fā)展。自電力電子領(lǐng)域研究啟動(dòng)約十年后(1990年前后),首款SiC肖特基二極管實(shí)現(xiàn)商用[4]。此后,技術(shù)持續(xù)改進(jìn)使SiC MOSFET、JFET及二極管的耐壓范圍擴(kuò)展至1700 V。
GaN最初應(yīng)用于發(fā)光二極管(LED),至1990年左右開始涉足電力電子領(lǐng)域,首款GaN晶體管于1991年問(wèn)世[5][6]。然而,GaN缺乏類似SiC的工業(yè)基礎(chǔ),技術(shù)開發(fā)耗時(shí)更長(zhǎng)。GaN的優(yōu)勢(shì)通過(guò)AlGaN/GaN高電子遷移率晶體管(HEMT)體現(xiàn):其天然二維電子氣(2DEG)可實(shí)現(xiàn)低導(dǎo)通電阻與高開關(guān)頻率。首款商用GaN功率FET較SiC晚十年面世[7]。目前,GaN HEMTs的耐壓已提升至1200 V,但主流產(chǎn)品仍以650 V及以下為主。
1商用SiC與GaN功率管
商用功率晶體管需滿足三大要求:1)耐高壓與高功率;2)低開關(guān)與導(dǎo)通損耗;3)常關(guān)型(Normally-OFF)操作。WBG材料的固有特性使其可滿足前兩項(xiàng)要求,但SiC與GaN的器件結(jié)構(gòu)存在顯著差異。
當(dāng)前市售SiC晶體管主要包括兩種結(jié)構(gòu):垂直MOSFET(平面或溝槽柵)與級(jí)聯(lián)垂直JFET(如圖1(a)-(c))。兩者均實(shí)現(xiàn)常關(guān)操作。而GaN HEMT本質(zhì)為常開型器件,需通過(guò)p-GaN柵極堆棧(如圖1(d))或級(jí)聯(lián)配置(如圖1(e))實(shí)現(xiàn)常關(guān)操作。目前,這兩種是市售GaN FET的主流拓?fù)洹?/p>
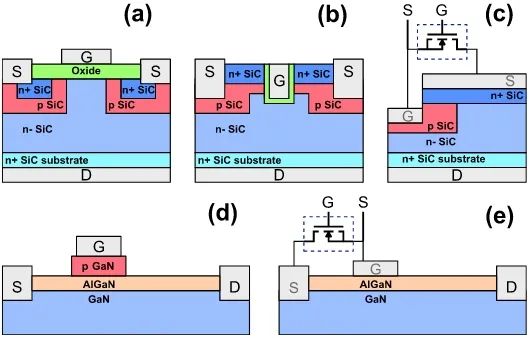
圖1. 商用SiC和GaN功率晶體管中使用的不同半導(dǎo)體結(jié)構(gòu)。( a ) SiC垂直平面柵耗盡型MOSFET。( b ) SiC垂直雙溝槽MOSFET。( c ) SiC垂直共源共柵JFET。( d ) GaN p - GaN柵HEMT。( e ) GaN共源共柵HEMT。
2典型電壓應(yīng)用范圍
目前,SiC器件覆蓋650、900、1000、1200及1700 V等多個(gè)電壓等級(jí),部分產(chǎn)品集成柵極驅(qū)動(dòng)或溫度傳感功能。GaN的電壓范圍從15 V至1200 V,但高壓領(lǐng)域(>650 V)市場(chǎng)份額有限,僅個(gè)別廠商提供900 V與1200 V產(chǎn)品。高于900 V時(shí),SiC仍是首選。GaN廠商還提供集成柵極驅(qū)動(dòng)的單芯片解決方案,以降低電感、提升開關(guān)速度并優(yōu)化熱保護(hù)。
3600/650 V范圍內(nèi)的SiC與GaN功率管
為深入對(duì)比市售產(chǎn)品,表II列出了650 V范圍內(nèi)SiC、GaN及硅器件的關(guān)鍵參數(shù)。其中,GaN e-mode HEMTs的RON×QG(FOM)較SiC與硅器件提升至少四倍(從>1500 mΩ·nC降至<300 mΩ·nC),輸入電容(CIN)與反向恢復(fù)電荷(Qrr)亦顯著優(yōu)化。雷達(dá)圖(如圖2(a)-(b))顯示,GaN e-mode HEMTs在動(dòng)態(tài)性能上表現(xiàn)更優(yōu),而級(jí)聯(lián)GaN HEMTs因含硅MOSFET,開關(guān)速度略遜。
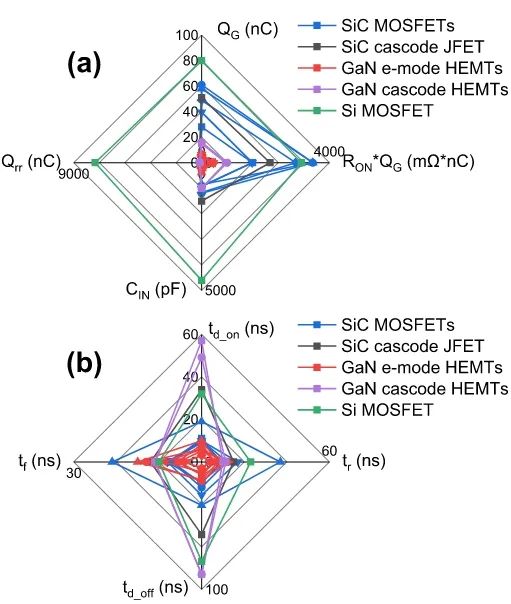
圖2 .650V額定SiC、GaN和Si器件的比較的雷達(dá)圖。
表2. 在600 / 650 V電壓范圍內(nèi),來(lái)自不同廠商的商用SiC和GaN功率管。

高壓領(lǐng)域(900-1200 V)的對(duì)比(如圖3)表明,GaN仍具動(dòng)態(tài)性能優(yōu)勢(shì),但其高壓器件的可靠性與性能仍需優(yōu)化。成本方面,650 V硅器件最廉價(jià),GaN與SiC器件價(jià)格分別高30%與50%,但整體對(duì)BOM影響有限。模塊化設(shè)計(jì)可進(jìn)一步降低寄生參數(shù),提升功率密度。
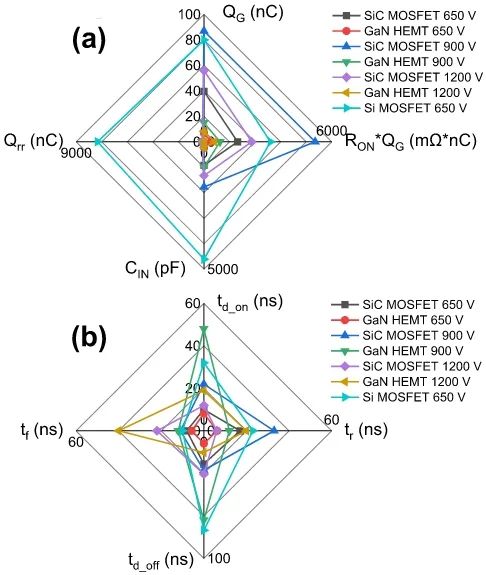
圖3 .表II中報(bào)告的650、900和1200 V級(jí)SiC、GaN和Si器件的雷達(dá)對(duì)比圖。
03應(yīng)用場(chǎng)景
與硅基器件相比,SiC與GaN功率晶體管具有更小的尺寸(得益于>3 MV/cm的更高擊穿電場(chǎng))和更高的工作溫度耐受性(得益于更寬的禁帶寬度)。其導(dǎo)通損耗也因更低的RON而減少,從而提升功率變換器的整體效率,并減少散熱系統(tǒng)需求。從動(dòng)態(tài)性能看,更低的輸入電容與柵極電荷簡(jiǎn)化了驅(qū)動(dòng)設(shè)計(jì),支持更高頻率和更低損耗的操作。SiC與GaN擴(kuò)展了硅MOSFET、IGBT和超結(jié)硅MOSFET的功率與頻率適用范圍(如圖4所示)。
通過(guò)采用SiC與GaN器件實(shí)現(xiàn)的高效dc-ac與dc-dc變換器,可顯著減小電子元件的重量與體積,這對(duì)電動(dòng)汽車(EV)等電池供電應(yīng)用至關(guān)重要,同時(shí)提升功率密度[10]。
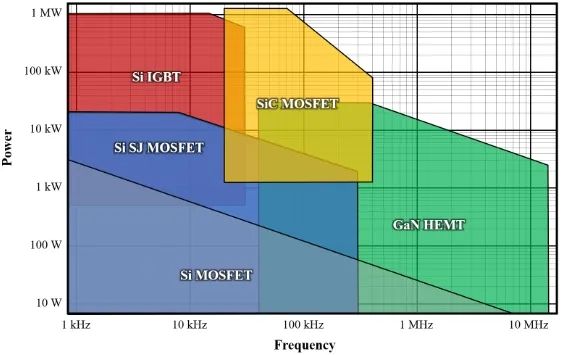
圖4 .不同功率器件的頻率和功率。
1現(xiàn)有應(yīng)用
盡管SiC與GaN基晶體管在多方面具有優(yōu)勢(shì),但其應(yīng)用尚未覆蓋所有潛在受益領(lǐng)域。目前,這兩種器件在以下兩個(gè)主要領(lǐng)域表現(xiàn)突出:
?SiC器件:廣泛用于混合動(dòng)力與電動(dòng)汽車的牽引逆變器(特斯拉自2017年起采用SiC晶體管[15]),并少量應(yīng)用于超跑與賽車的車載充電器(OBC)和牽引逆變器。SiC晶體管當(dāng)前主要面向汽車市場(chǎng)。
?GaN器件:常用于智能手機(jī)與電腦的電源適配器與充電器,其高開關(guān)頻率使基于GaN的ac-dc變換器體積較硅基方案縮小三倍。GaN晶體管在高端光伏逆變器中亦有少量應(yīng)用,表明當(dāng)前GaN功率器件更側(cè)重于消費(fèi)電子領(lǐng)域。
2未來(lái)應(yīng)用
隨著成本持續(xù)下降與耐壓能力提升,SiC與GaN將進(jìn)一步滲透當(dāng)前由硅器件(如MOSFET、IGBT、GTO和晶閘管)主導(dǎo)的領(lǐng)域。具體應(yīng)用方向?qū)⑷Q于目標(biāo)電壓等級(jí)(如圖5所示)。
低于400 V:GaN預(yù)計(jì)主導(dǎo)市場(chǎng),涵蓋家用電源電壓范圍(單相與三相系統(tǒng)),包括家電、消費(fèi)電子(手機(jī)、電腦及其充電器)與數(shù)據(jù)中心電力電子。
400–1200 V:SiC與GaN將協(xié)同共存,具體選擇取決于應(yīng)用功率等級(jí)。此電壓范圍涵蓋可再生能源逆變器、工業(yè)電機(jī)控制及汽車電氣化相關(guān)應(yīng)用。汽車領(lǐng)域?qū)烧呔呶Γ蚋咝А⒕o湊的功率電子部件可提升車輛續(xù)航與性能(如圖6所示的混合/電動(dòng)汽車電氣架構(gòu))。
高于1200 V:SiC將主導(dǎo)電力牽引、風(fēng)力發(fā)電與智能電網(wǎng)應(yīng)用。例如,鐵路牽引系統(tǒng)電壓可達(dá)kV級(jí)(常規(guī)列車最高5 kV),SiC器件可替代硅基GTO與IGBT,提升效率。此外,SiC還可應(yīng)用于25 kV級(jí)高速列車系統(tǒng)。

圖5. GaN和SiC功率器件的可能的應(yīng)用領(lǐng)域。
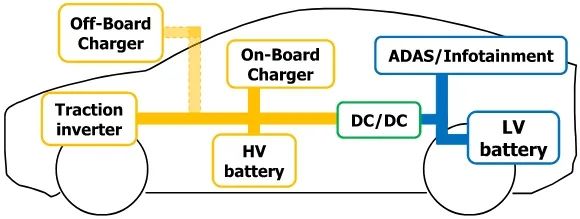
圖6 .混合動(dòng)力/電動(dòng)汽車的主要電氣和電子模塊。
3電路拓?fù)?/p>
當(dāng)前應(yīng)用中,電路拓?fù)涞倪x擇取決于電壓、功率與開關(guān)頻率需求:
GaN應(yīng)用示例(USB-C適配器):
功率<70 W:常用準(zhǔn)諧振反激(quasi-resonant ? ? ? flyback)或有源鉗位反激拓?fù)洌_關(guān)頻率限制在300 kHz以下以避免電磁干擾(EMI)。
功率>250 W:采用軟開關(guān)或零電壓開關(guān)(ZVS)拓?fù)洌ㄈ缰C振LLC拓?fù)洌肎aN的低柵極電荷、輸出電容與反向恢復(fù)電荷優(yōu)勢(shì)提升效率。GaN器件支持無(wú)二極管H橋配置,反向?qū)〒p耗更低[16]。
功率密度:GaN設(shè)計(jì)可實(shí)現(xiàn)1.5–1.9 W/cm3,2015年谷歌LittleBox挑戰(zhàn)賽獲獎(jiǎng)設(shè)計(jì)達(dá)8.7 W/cm3[18]。
SiC應(yīng)用示例:
高功率模塊:采用橋式或斬波拓?fù)洌ㄜ壍澜煌ǎ糜谡淄呒?jí)逆變器。光伏逆變器常用兩電平六管基礎(chǔ)拓?fù)浠蚋咝У娜娖絋型中點(diǎn)鉗位拓?fù)鋄19]。
混合設(shè)計(jì):將SiC二極管集成至傳統(tǒng)變換器,利用其快速反向恢復(fù)與高溫耐受性優(yōu)化性能[21]。
04技術(shù)挑戰(zhàn)
盡管SiC與GaN器件已在多個(gè)應(yīng)用場(chǎng)景中展現(xiàn)優(yōu)勢(shì),但其可靠性與性能仍需持續(xù)優(yōu)化。以下分述兩類器件的關(guān)鍵技術(shù)挑戰(zhàn):
1GaN與SiC晶體管的閾值電壓漂移
功率晶體管開發(fā)中的關(guān)鍵挑戰(zhàn)之一是緩解運(yùn)行過(guò)程中閾值電壓(Vth)的非預(yù)期漂移(正向或負(fù)向)。以常關(guān)型器件為例,正向Vth漂移會(huì)降低過(guò)驅(qū)動(dòng)電壓,導(dǎo)致導(dǎo)通電阻Ron增加,甚至可能觸發(fā)器件過(guò)早關(guān)斷。負(fù)向Vth漂移則可能導(dǎo)致更嚴(yán)重的后果,例如誤開啟或無(wú)法維持關(guān)斷狀態(tài),從而引發(fā)電源線路間的短路(SC),最終導(dǎo)致系統(tǒng)災(zāi)難性故障或不安全工況。
對(duì)于硅基器件,此類問(wèn)題已通過(guò)成熟技術(shù)(如共源共柵配置)得到有效控制。然而,對(duì)于寬禁帶材料器件,這一問(wèn)題仍需解決。研究Vth漂移的典型方法包括偏置溫度不穩(wěn)定性(BTI)測(cè)試,即在柵極施加正偏壓(PBTI)或負(fù)偏壓(NBTI)并結(jié)合不同溫度條件。對(duì)于未優(yōu)化的增強(qiáng)型GaN HEMT,正偏壓應(yīng)力下可能通過(guò)不同機(jī)制同時(shí)引發(fā)正向和負(fù)向Vth漂移(見圖7)。
通過(guò)優(yōu)化柵極堆疊工藝,可平衡電子或空穴的捕獲效應(yīng),從而穩(wěn)定Vth。Vth漂移主要由界面及器件內(nèi)部缺陷引發(fā)的載流子捕獲現(xiàn)象導(dǎo)致(見圖8)。因此,提升界面質(zhì)量與材料純度是緩解此類問(wèn)題的關(guān)鍵[24-26]。
此外,關(guān)斷狀態(tài)下的高壓偏置也可能誘發(fā)Vth漂移。例如,Chen等人[27]發(fā)現(xiàn),在VD=200 V時(shí),Vth正向漂移可達(dá)1 V。此類漏極誘導(dǎo)的漂移機(jī)制尚未被充分研究,是未來(lái)探索的重點(diǎn)方向。

圖7 . 正偏壓下p-GaN柵HEMT中電子與空穴捕獲機(jī)制導(dǎo)致的(a)正向及(b)負(fù)向閾值電壓漂移(參考t = 10 μs時(shí)的初始閾值電壓值)。

圖8 . SiC(a)與GaN(b)功率晶體管柵堆疊中的載流子捕獲機(jī)制對(duì)比。
SiC MOSFET因其采用成熟的SiO2柵介質(zhì)而具有優(yōu)勢(shì),但SiC-SiO2界面質(zhì)量仍遜于Si-SiO2,導(dǎo)致更多缺陷與捕獲現(xiàn)象。在PBTI應(yīng)力下,4H-SiC MOSFET通常表現(xiàn)出正向Vth漂移(幅度遠(yuǎn)低于GaN器件),但在高壓高溫下漂移量可達(dá)1-5 V。此現(xiàn)象歸因于電子隧穿至近界面氧化物陷阱。部分研究[29-31]還觀察到漂移動(dòng)態(tài)分兩階段(見圖9):
初始正向漂移:遵循對(duì)數(shù)時(shí)間依賴性,與界面捕獲相關(guān);
后續(xù)負(fù)向漂移:由氧化物內(nèi)碰撞電離產(chǎn)生的空穴引發(fā),表現(xiàn)為指數(shù)時(shí)間依賴性。
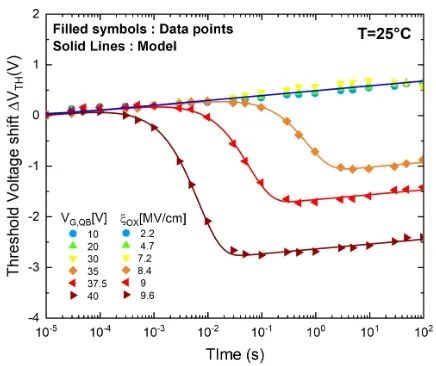
圖9. 4H-SiC n-MOSFET在室溫正偏壓應(yīng)力下的非單調(diào)閾值電壓漂移。
2GaN器件的動(dòng)態(tài)導(dǎo)通電阻增加
共源共柵和增強(qiáng)型GaN HEMT面臨的關(guān)鍵挑戰(zhàn)之一是在關(guān)斷或半導(dǎo)通狀態(tài)下導(dǎo)通電阻的可逆性增加。對(duì)于功率晶體管,關(guān)斷狀態(tài)下漏極承受的高壓會(huì)導(dǎo)致電子注入表面態(tài)[32]或緩沖陷阱[33],從而降低溝道電導(dǎo)率,引發(fā)Ron升高。此外,漏極應(yīng)力下電子捕獲與空穴生成(如緩沖層電子轉(zhuǎn)移至溝道產(chǎn)生空穴)的相互作用[34],以及半導(dǎo)通狀態(tài)(器件開關(guān)過(guò)程中必經(jīng)的操作點(diǎn))會(huì)進(jìn)一步加劇導(dǎo)通電阻的不穩(wěn)定性。
抑制Ron增加的一種方法是采用混合漏極(HD)[35],即在漏極接觸中嵌入p-GaN層,在關(guān)斷和半導(dǎo)通狀態(tài)下注入空穴以抵消電子捕獲效應(yīng),從而維持導(dǎo)通電阻。Fabris等人[36]通過(guò)實(shí)驗(yàn)驗(yàn)證了該方法的有效性,分析了不同漏極靜態(tài)偏置下的Ron。
3GaN晶體管的擊穿機(jī)制
在功率變換器的開關(guān)操作中,多種擊穿機(jī)制可能導(dǎo)致固態(tài)開關(guān)的災(zāi)難性失效。GaN FET需針對(duì)所有擊穿機(jī)制進(jìn)行優(yōu)化,以提升額定電壓和壽命。
1)柵極相關(guān)擊穿
?共源共柵GaN FET:柵極結(jié)構(gòu)與硅基MOSFET類似,可能發(fā)生時(shí)間依賴性介質(zhì)擊穿(TDDB)[37]。
?增強(qiáng)型GaN FET:即使無(wú)柵介質(zhì)層,正偏壓仍會(huì)導(dǎo)致時(shí)間依賴性退化與擊穿[38]。
2)漏極-襯底擊穿
GaN-on-Si器件在電壓遠(yuǎn)超額定值(通常>1000 V)時(shí)易發(fā)生漏極-襯底擊穿[39]。改善措施包括:
?局部襯底去除[39];
?低成本替代方案:采用藍(lán)寶石襯底替代硅襯底(Gupta等人[40]已實(shí)現(xiàn)1200 V GaN器件)。
3)雪崩擊穿特性
GaN HEMT的碰撞電離系數(shù)遠(yuǎn)低于Si/SiC MOSFET,因此其雪崩行為不同。但其動(dòng)態(tài)擊穿電壓(與關(guān)斷脈沖時(shí)長(zhǎng)相關(guān))可顯著高于額定值[41,42],并表現(xiàn)出優(yōu)異的浪涌能力[43]。需進(jìn)一步量化其在開關(guān)瞬態(tài)過(guò)壓事件中的魯棒性。
4GaN晶體管的其他挑戰(zhàn)
由于GaN技術(shù)仍處于早期發(fā)展階段[44],以下問(wèn)題仍需深入研究:
短路與浪涌能量能力
?短路測(cè)試:增強(qiáng)型與共源共柵GaN器件可能表現(xiàn)出不同的退化/失效機(jī)制。
?浪涌能量:與過(guò)壓魯棒性緊密相關(guān),但GaN HEMT無(wú)雪崩能力(Si/SiC器件依賴雪崩能量[47])。GaN器件通常通過(guò)設(shè)計(jì)高動(dòng)態(tài)擊穿電壓來(lái)應(yīng)對(duì)過(guò)壓瞬態(tài)[44]。
5SiC MOSFET的柵氧化層失效
SiC MOSFET的柵氧化層失效是可靠性關(guān)鍵問(wèn)題,主要機(jī)制包括:
失效機(jī)制
1.場(chǎng)驅(qū)動(dòng)失效:外場(chǎng)作用下化學(xué)鍵弱化;
2.電荷隧穿失效:因SiO2/SiC間帶偏移較小,隧穿電流更易發(fā)生。
?福勒-諾德海姆隧穿(高場(chǎng)強(qiáng)、低溫);
?熱輔助隧穿(低場(chǎng)強(qiáng)、高溫)[49]。
可靠性評(píng)估方法
?時(shí)間到失效(TTF):通過(guò)恒壓應(yīng)力測(cè)試評(píng)估TDDB,推算柵介質(zhì)壽命[37]。
?電荷到擊穿(QBD):施加恒流應(yīng)力,計(jì)算擊穿前總電荷量[48]。
測(cè)試注意事項(xiàng)
?過(guò)估計(jì)風(fēng)險(xiǎn):高場(chǎng)強(qiáng)下陷阱生成/捕獲可能導(dǎo)致壽命評(píng)估偏長(zhǎng)[48-50]。
?安全操作區(qū)(SOA):定義柵介質(zhì)的應(yīng)力場(chǎng)強(qiáng)-溫度范圍,確保性能符合規(guī)格[51]。
行業(yè)標(biāo)準(zhǔn)
?汽車領(lǐng)域要求柵氧化層壽命達(dá)108秒量級(jí)。2020年測(cè)試顯示150°C下t63%(63%器件失效時(shí)間)>106秒[50];2021年研究進(jìn)一步驗(yàn)證t63%>108秒[29]。
6SiC MOSFET的短路性能
短路測(cè)試用于評(píng)估器件在嚴(yán)苛工況下的耐受能力,重點(diǎn)關(guān)注參數(shù):
關(guān)鍵指標(biāo)
?短路耐受時(shí)間(τSC):SiC MOSFET需替代τSC≈10μs的Si IGBT。自2013年達(dá)標(biāo)后[55],仍需系統(tǒng)性優(yōu)化。
?臨界能量(EC):器件存儲(chǔ)的臨界能量。
?短路安全操作區(qū)(SCSOA):通過(guò)電壓/電流波形分析定義(見圖10)[54]。
性能提升技術(shù)
?源極電阻法:減少過(guò)驅(qū)動(dòng)電壓以降低電流,但需平衡導(dǎo)通/開關(guān)性能[56]。
?Baliga短路改進(jìn)概念(BaSIC):用Si MOSFET替代源極電阻,顯著提升性能[57,58]。
?結(jié)構(gòu)優(yōu)化:平面DMOSFET比溝槽結(jié)構(gòu)更具短路優(yōu)勢(shì)[59]。

圖10. 帶/不帶源極電阻MOSFET的短路波形對(duì)比(CM1、CM2波形顯示電流峰值與均值降低)。
05展望
當(dāng)前,SiC(碳化硅)和GaN(氮化鎵)器件均處于先進(jìn)的開發(fā)階段。兩者均已實(shí)現(xiàn)商業(yè)化應(yīng)用,并因其在效率、魯棒性和功率密度方面相較于硅基器件的顯著提升而備受贊譽(yù)。未來(lái),針對(duì)這兩種材料的研究將持續(xù)推進(jìn),以解決現(xiàn)存問(wèn)題、提高可靠性并進(jìn)一步增強(qiáng)其優(yōu)勢(shì)。
基于前文分析,若將單一材料視為功率器件的最佳選擇(如硅在集成電路行業(yè)的地位),這一觀點(diǎn)并不正確。實(shí)際上,GaN與SiC各具獨(dú)特性能,可分別優(yōu)化特定應(yīng)用場(chǎng)景。例如,SiC能夠制造高魯棒性器件,適用于大功率開關(guān)變換器;而GaN HEMT則以速度和超高效著稱,這對(duì)提升中低功率變換器的功率/體積比至關(guān)重要。
1GaN器件
未來(lái)GaN的目標(biāo)是突破更高電壓(如1200 V以上)。為實(shí)現(xiàn)這一目標(biāo),需開發(fā)創(chuàng)新的半導(dǎo)體結(jié)構(gòu)(如垂直GaN晶體管)及高性價(jià)比襯底。目前,垂直GaN晶體管尚未達(dá)到廣泛商業(yè)化所需的成熟度。然而,此類器件(包括FinFET、MOSFET和JFET)的推出有望實(shí)現(xiàn)比SiC更低的導(dǎo)通電阻(RON),同時(shí)兼顧雪崩和短路性能。
2SiC器件
SiC的優(yōu)勢(shì)在于其結(jié)構(gòu)簡(jiǎn)單且性能卓越,同時(shí)受益于硅基電子技術(shù)中SiO2的成熟經(jīng)驗(yàn)。這使其能夠有效控制陷阱現(xiàn)象、閾值電壓穩(wěn)定性及擊穿性能。未來(lái),SiC器件將在傳統(tǒng)領(lǐng)域(如汽車電子)和新興領(lǐng)域(如列車牽引、智能電網(wǎng)高壓應(yīng)用)中處理更高功率。例如,得益于效率提升,列車牽引可轉(zhuǎn)向電池供電;而智能電網(wǎng)中的高壓應(yīng)用將支持創(chuàng)新電網(wǎng)管理技術(shù)。
3多材料協(xié)同與系統(tǒng)級(jí)設(shè)計(jì)
在高端應(yīng)用中,GaN、SiC甚至硅器件的共存可能成為實(shí)現(xiàn)最優(yōu)性能與成本平衡的關(guān)鍵。數(shù)學(xué)優(yōu)化工具(如Burkart和Kolar等人[60]提出的多目標(biāo)優(yōu)化方法)可通過(guò)精確建模,充分挖掘不同半導(dǎo)體材料的優(yōu)勢(shì)。此外,在高強(qiáng)度應(yīng)用中,多器件串聯(lián)或并聯(lián)需結(jié)合系統(tǒng)級(jí)設(shè)計(jì),重點(diǎn)關(guān)注熱管理、電流/電壓均衡等問(wèn)題。失衡可能導(dǎo)致靜態(tài)/動(dòng)態(tài)性能波動(dòng)[61],引發(fā)導(dǎo)通/開關(guān)損耗不均、瞬態(tài)電流分布失衡等問(wèn)題,甚至需降額使用以維持安全操作區(qū)(SOA)[62]。
06結(jié)論
本文綜述了商用GaN與SiC功率晶體管的現(xiàn)狀。首先對(duì)比了兩者的材料特性與結(jié)構(gòu)差異,并以650 V器件為例展開分析(該電壓范圍內(nèi)GaN、SiC與硅器件共存)。數(shù)據(jù)顯示,GaN器件在RON× QG(導(dǎo)通電阻與柵極電荷乘積)、輸入電容及反向恢復(fù)電荷等指標(biāo)上表現(xiàn)最優(yōu);而SiC器件雖略遜于GaN,但仍顯著優(yōu)于硅基MOSFET。
GaN在高壓領(lǐng)域性能更優(yōu),但其發(fā)展仍受限于技術(shù)和可靠性問(wèn)題。在此電壓/功率范圍內(nèi),SiC憑借豐富的市場(chǎng)化產(chǎn)品成為可行替代方案。
當(dāng)前,GaN器件主要應(yīng)用于消費(fèi)電子、數(shù)據(jù)中心電源及家用電器;GaN與SiC的共存場(chǎng)景包括光伏和汽車電子;而SiC將主導(dǎo)大功率高壓領(lǐng)域(如智能電網(wǎng)、列車牽引)。
SiC器件在運(yùn)行中表現(xiàn)出高穩(wěn)定性,閾值電壓漂移極小且無(wú)動(dòng)態(tài)導(dǎo)通電阻效應(yīng),適用于惡劣環(huán)境(壽命與短路能力接近IGBT)。GaN雖具備更快的開關(guān)速度,但>1000 V范圍的可靠性仍需優(yōu)化。目前市場(chǎng)已有部分高可靠性GaN器件[63]。
結(jié)語(yǔ)
GaN與SiC功率器件將基于應(yīng)用需求形成互補(bǔ)格局,高頻與高壓特性分別適配不同場(chǎng)景。與硅基器件的競(jìng)爭(zhēng)將推動(dòng)第三代半導(dǎo)體在效率、可靠性和成本三方面的持續(xù)優(yōu)化,加速電力電子系統(tǒng)革新。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28829瀏覽量
236271 -
功率器件
+關(guān)注
關(guān)注
42文章
1927瀏覽量
92568 -
SiC
+關(guān)注
關(guān)注
31文章
3210瀏覽量
64933 -
GaN
+關(guān)注
關(guān)注
19文章
2194瀏覽量
76612
原文標(biāo)題:未來(lái)電力革命雙引擎:GaN與SiC功率器件深度解析
文章出處:【微信號(hào):芯長(zhǎng)征科技,微信公眾號(hào):芯長(zhǎng)征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
具有SiC和GaN的高功率

GaN和SiC功率器件的最佳用例
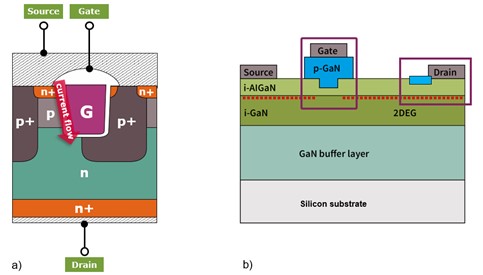
同是功率器件,為什么SiC主要是MOSFET,GaN卻是HEMT
第三代半導(dǎo)體材料盛行,GaN與SiC如何撬動(dòng)新型功率器件
SiC/GaN功率開關(guān)有什么優(yōu)勢(shì)
SiC功率器件概述
SiC功率器件概述
GaN和SiC區(qū)別
什么是基于SiC和GaN的功率半導(dǎo)體器件?
SiC功率器件和GaN功率、射頻器件介紹

GaN與SiC功率器件的特點(diǎn) GaN和SiC的技術(shù)挑戰(zhàn)

SiC與GaN 功率器件中的離子注入技術(shù)挑戰(zhàn)
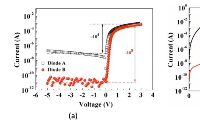





 GaN與SiC功率器件深度解析
GaN與SiC功率器件深度解析












評(píng)論