由深圳瑞沃微半導體科技有限公司發布
瑞沃微作為半導體封裝行業上先進封裝高新技術企業,對CSP(芯片級封裝)技術在不同領域的應用有不同見解。CSP封裝憑借其極致小型化、高集成度和性能優越性,在LED、SI基IC等領域展現出獨特優勢,但也存在一定劣勢。 在LED領域,CSP封裝技術優勢顯著。它實現了封裝體尺寸的極致壓縮,通常不超過芯片自身尺寸的20%,使得LED燈珠更加緊湊。這有助于提升顯示面板的分辨率和亮度,在高清顯示應用中效果突出。
例如,在智能手機、平板電腦等追求極致輕薄的產品中,CSP封裝的LED能夠滿足其對小體積和高性能的需求,助力產品在不犧牲性能的前提下實現更小的體積和更長的續航。 同時,CSP封裝減少了封裝材料的使用,降低了信號傳輸路徑中的阻抗和延遲,提升了LED的整體性能。然而,CSP封裝在LED領域也面臨挑戰。對于硬式顯示器而言,若過度追求輕薄,可能導致產品脆弱,在搬運和運送過程中易出問題。軟式顯示器則依賴自發光技術,LED背光在此處作用有限。而且,LED單顆亮度發展到極限后,背光模組中LED顆數難以減少到極致,否則會出現亮暗不均的光斑,影響顯示效果。
在SI基IC領域,CSP封裝同樣優勢明顯。它通過精簡封裝結構,去除不必要的陶瓷散熱基板、連接線等,實現了封裝體積的最小化,滿足了移動設備、可穿戴設備等對小尺寸的需求。同時,CSP封裝允許在有限的空間內集成更多功能,提高了芯片的集成度,滿足了復雜電子系統的需求。此外,其散熱性能優良,通過焊球直連PCB,熱阻最低可至4.2℃/W,降低了高溫失效風險。不過,CSP封裝在SI基IC領域也存在劣勢。封裝工藝難度較大,倒裝焊二次布線需突破200μm精度,引線鍵合需控制0.5mm以下超短弧線,這對工藝精度要求極高。材料匹配方面,基板與硅片熱膨脹系數(CTE)差異易導致界面應力失效,影響產品的可靠性。
經典案例方面,在LED領域,隆達作為臺灣唯一的垂直整合廠,率先推動CSP LED背光商業化,其CSP產品導入電視大廠已一年,為行業提供了寶貴的經驗。在SI基IC領域,長電科技、通富微電等企業已實現5G基站CSP量產,展示了CSP封裝在高端領域的應用潛力。 CSP封裝技術在LED、SI基IC等領域具有顯著優勢,但也面臨一些挑戰。在實際應用中,需要根據具體需求和場景,權衡利弊,充分發揮其優勢,推動半導體產業的進一步發展。
-
led
+關注
關注
242文章
23847瀏覽量
674120 -
IC
+關注
關注
36文章
6127瀏覽量
179384 -
CSP封裝
+關注
關注
0文章
22瀏覽量
11730
發布評論請先 登錄
CSP芯片級封裝正逐漸滲透到LED領域

LED恒流IC領域的照明方案
什么? 你對CSP的了解還不夠?趕快來圍觀吧!
TVS新型封裝CSP
封裝測試廠淘汰的廢舊QFN、PLCC、BGA、CSP、WL-CSP
CSP封裝的散熱挑戰
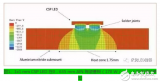





 CSP封裝在LED、SI基IC等領域的優勢、劣勢
CSP封裝在LED、SI基IC等領域的優勢、劣勢

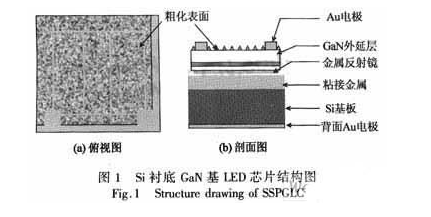











評論