在半導體行業的激烈競爭中,先進封裝技術已成為各大廠商角逐的關鍵領域。英特爾作為行業的重要參與者,近日在電子元件技術大會(ECTC)上披露了多項芯片封裝技術突破,再次吸引了業界的目光。這些創新不僅展現了英特爾在技術研發上的深厚底蘊,也為其在先進封裝市場贏得了新的競爭優勢。
英特爾此次的重大突破之一是 EMIB-T 技術。EMIB-T 全稱為 Embedded Multi-die Interconnect Bridge with TSV,是嵌入式多芯片互連橋接封裝技術的重大升級版本,專為高性能計算和異構集成設計。其技術升級主要體現在三個核心方面。
在信號傳輸與供電優化上,EMIB-T 在傳統 EMIB 的硅橋結構中創新性地嵌入硅通孔(TSV)。傳統 EMIB 采用懸臂式供電路徑,存在較高的電壓降,而 TSV 從封裝底部直接供電,這一改變將電源傳輸電阻降低 30% 以上,極大地減少了電壓降和信號噪聲。這使得它能夠穩定支持 HBM4 和 HBM4e 等高帶寬內存的供電需求,同時兼容 UCIe-A 互連技術,數據傳輸速率可達 32 Gb/s+。舉例來說,在 AI 加速器和數據中心處理器等對供電穩定性和數據傳輸速率要求極高的場景中,EMIB-T 的這一特性能夠確保設備穩定運行,避免因供電不足或信號干擾導致的性能下降。
面對高速信號傳輸中常出現的電磁干擾問題,EMIB-T 在橋接器內部集成了高密度金屬 - 絕緣體 - 金屬(MIM)電容器。這一設計可有效抑制電源噪聲,確保信號完整性。在復雜異構系統中,如同時集成了多種不同功能芯片的 AI 計算平臺,不同芯片間的信號容易相互干擾,而 MIM 電容器的存在使得 EMIB-T 能夠保持穩定的通信性能,保障整個系統的高效運行。
在封裝尺寸與集成密度的提升上,EMIB-T 支持最大 120x180 毫米的封裝尺寸,單個封裝可集成超過 38 個橋接器和 12 個矩形裸片(die)。目前,其凸塊間距已實現 45 微米,未來計劃進一步縮小至 35 微米甚至 25 微米。這種高密度集成能力為 Chiplet 設計提供了更廣闊的空間。以單個封裝中整合 CPU、GPU、HBM 內存和 AI 加速模塊為例,通過 EMIB-T 技術,這些不同功能的芯片能夠緊密協作,顯著提升系統級性能,同時減少了整個系統的體積和功耗。
除了EMIB-T 技術,英特爾還在散熱和熱鍵合技術方面取得進展。隨著人工智能和數據中心應用的迅猛發展,芯片功耗和封裝尺寸不斷增加,散熱成為了關鍵挑戰。英特爾推出的新分散式散熱器設計,通過將散熱器拆分為平板和加強筋,優化了與熱界面材料(TIM)的耦合,減少了約 25% 的 TIM 焊料空隙,大大提升了熱傳導效率。并且,該設計支持集成微通道的散熱器,液體可直接通過一體式熱沉(IHS)冷卻處理器,適用于熱設計功耗(TDP)高達 1000W 的芯片封裝,為高性能計算平臺提供了可靠的熱管理解決方案。
在熱鍵合技術上,英特爾開發了一種針對大型封裝基板的新型熱壓粘合工藝,解決了芯片和基板在粘合過程中的翹曲問題。該工藝通過最小化熱差,提高了制造良率和可靠性,支持更大尺寸的芯片封裝,并實現了更精細的EMIB 連接間距。這不僅增強了 EMIB-T 的互連密度,也為復雜異構芯片設計提供了更高的靈活性。
英特爾的這些先進封裝技術突破具有深遠意義。在行業競爭層面,現代處理器越來越多地采用復雜的異構設計,將多種類型的計算和內存組件集成到單個芯片封裝中,先進封裝技術成為實現這一目標的基石。英特爾憑借這些創新,能夠與臺積電等競爭對手在先進封裝領域展開有力角逐。在市場應用方面,AWS、思科等企業已與英特爾合作,將 EMIB-T 應用于下一代服務器和網絡設備,這表明英特爾的新技術得到了市場的認可,有望在數據中心、邊緣計算和消費電子等多個領域得到廣泛應用。從技術發展趨勢來看,英特爾計劃在 2025 年下半年實現 EMIB-T 封裝的量產,并逐步將凸塊間距從 45 微米縮小至 25 微米,以支持更高密度的芯片集成。隨著玻璃基板技術的成熟,EMIB-T 有望在 2028 年實現單個封裝集成超過 24 顆 HBM,進一步推動內存帶寬的突破。這將對全球半導體封裝技術的發展方向產生深遠影響,引領行業向更高性能、更高集成度的方向發展。
審核編輯 黃宇
-
英特爾
+關注
關注
61文章
10182瀏覽量
174134 -
先進封裝
+關注
關注
2文章
465瀏覽量
547
發布評論請先 登錄
英特爾代工:明確重點廣合作,服務客戶鑄信任
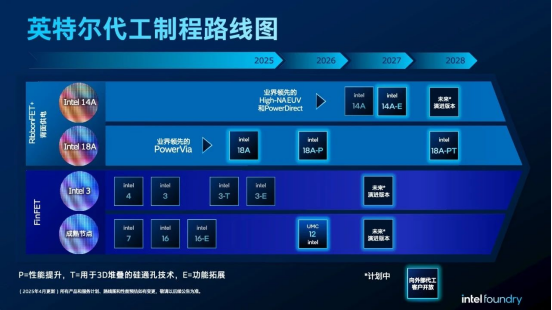
英特爾先進封裝:助力AI芯片高效集成的技術力量

英特爾代工在IEDM 2024展示多項技術突破
英特爾IEDM 2024大曬封裝、晶體管、互連等領域技術突破

英特爾展示互連微縮技術突破性進展
英特爾獲78.6億美元美國芯片補貼
英特爾宣布擴容成都封裝測試基地
英特爾擴容在成都的封裝測試基地
淺談英特爾在先進封裝領域的探索
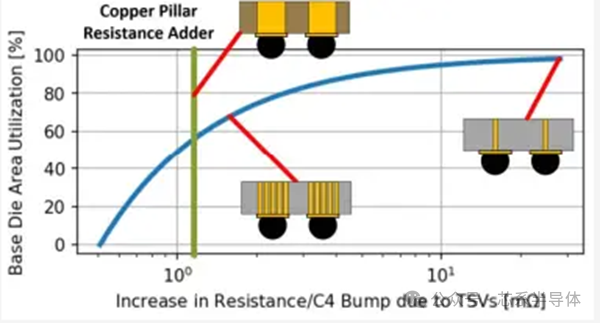





 英特爾先進封裝,新突破
英特爾先進封裝,新突破












評論