離子研磨技術(shù)的重要性
在掃描電子顯微鏡(SEM)觀察中,樣品的前處理方法至關(guān)重要。傳統(tǒng)機(jī)械研磨方法存在諸多弊端,如破壞樣品表面邊緣、產(chǎn)生殘余應(yīng)力等,這使得無法準(zhǔn)確獲取樣品表層納米梯度強(qiáng)化層的真實(shí)、精準(zhǔn)的原位力學(xué)性能。而離子束研磨技術(shù)以其獨(dú)特的優(yōu)勢,能夠有效解決這一難題,為 SEM 觀察提供了高質(zhì)量的樣品制備手段。
離子研磨的工作原理
離子研磨是通過離子撞擊材料表面實(shí)現(xiàn)的。具體來說,離子源中的氬氣(純度需達(dá)到 99.9999%以上)在高真空環(huán)境下,經(jīng)高壓電場電離成氬離子。這些氬離子撞擊樣品表面,通過動量交換將動能傳遞給樣品表面原子,使原子獲得足夠能量逃逸,從而在宏觀上實(shí)現(xiàn)“離子研磨”。高真空環(huán)境是必不可少的,否則高能電子束會因撞擊空氣分子而被吸收或散射,影響研磨效果。與傳統(tǒng)機(jī)械研磨相比,離子研磨具有顯著的優(yōu)勢。例如,在太陽能電池切割加工截面與離子束研磨(CP)加工截面的背散射電子像對比中,傳統(tǒng)機(jī)械研磨的解理面沿晶粒邊界凹凸不平,而經(jīng)過 CP 加工的截面則十分光滑。這種光滑的截面能夠清晰地觀察到一些在傳統(tǒng)研磨中不明顯的結(jié)構(gòu),如位于 ZnO 和 CIGS 之間因成分差異形成的 CdS 層襯度,以及由晶體取向不同產(chǎn)生的通道襯度。
離子研磨設(shè)備的使用要點(diǎn)
在使用離子束研磨設(shè)備時(shí),樣品固定于樣品臺之上,需要切割的部分應(yīng)突出遮擋板 1~1.5mm。屏蔽板的作用是遮蔽非目標(biāo)區(qū)域的離子束,避免損傷,但長時(shí)間轟擊后屏蔽板需要更換。
離子研磨的優(yōu)化方法
為了提高離子研磨的效果,可以采用一些優(yōu)化方法。例如,將氬離子束角度調(diào)節(jié)到 80°以上時(shí),高能粒子轟擊角度和加工平面近似平行,這樣氬離子轟擊樣品表面時(shí),凸出部分被轟擊或者轉(zhuǎn)移到凹陷區(qū)域,長時(shí)間轟擊后可以降低整個(gè)平面的粗糙度,實(shí)現(xiàn)平面拋光。在加工過程中旋轉(zhuǎn)載物臺可以讓研磨范圍更廣。
研磨的應(yīng)用場景
在電池領(lǐng)域,可用于鋰電池電極材料極片的內(nèi)部結(jié)構(gòu)、極片孔隙度的測量,通過孔隙度可以判斷鋰電池材料的吸液性,進(jìn)而判斷鋰電池材料的循環(huán)壽命。在芯片領(lǐng)域,可用于芯片、LED 等失效分析,以及納米量子電子器件、亞波長光學(xué)結(jié)構(gòu),表面等離子元器件等應(yīng)用的微納加工。
CP與FIB的區(qū)別
CP 主要承擔(dān)前處理任務(wù),用于對樣品截面進(jìn)行切割與拋光,之后將處理好的樣品置于 SEM 或 OM 中進(jìn)行觀察;FIB 通常與 SEM 配合使用,能夠在刻蝕樣品的過程中同步觀察,常用于截面分析或 TEM 樣品的制備。
離子研磨技術(shù)作為一種先進(jìn)的樣品前處理方法,在 SEM 觀察中發(fā)揮著重要作用。金鑒實(shí)驗(yàn)室的專業(yè)服務(wù)不僅限于測試和認(rèn)證,還包括失效分析、技術(shù)咨詢和人才培養(yǎng),為客戶提供一站式的解決方案。
-
顯微鏡
+關(guān)注
關(guān)注
0文章
621瀏覽量
24294 -
離子
+關(guān)注
關(guān)注
0文章
103瀏覽量
17292 -
fib
+關(guān)注
關(guān)注
1文章
103瀏覽量
11421
發(fā)布評論請先 登錄
EBSD制樣最有效的方法------氬離子截面拋光儀
鋰電材料截面制樣-氬離子拋光CP離子研磨 金鑒實(shí)驗(yàn)室分享(上)
SEM制樣氬離子拋光檢測
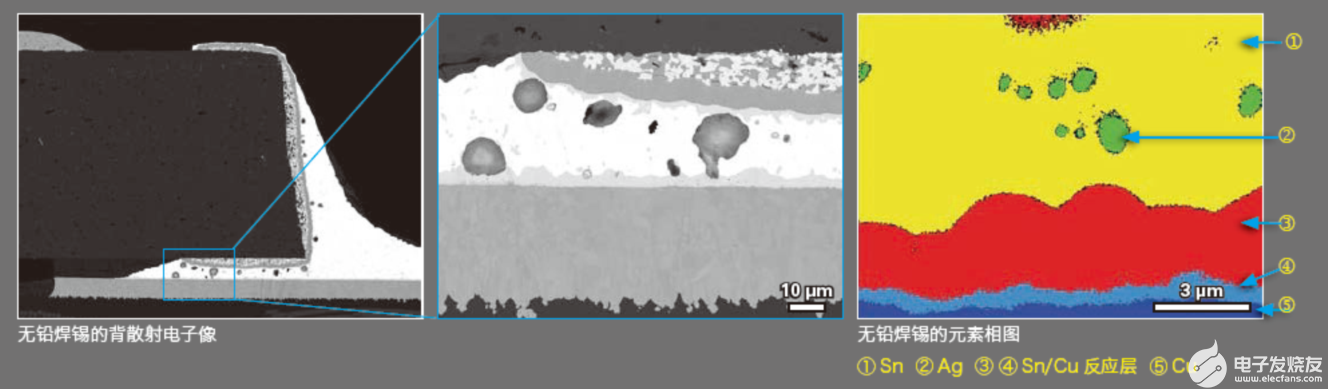
電鏡樣品制備:氬離子拋光優(yōu)勢

利用氬離子拋光技術(shù)還原LED支架鍍層的厚度
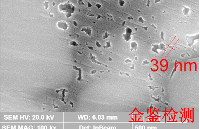
氬離子拋光:技術(shù)特點(diǎn)與優(yōu)勢

氬離子拋光儀/CP離子研磨截面拋光案例
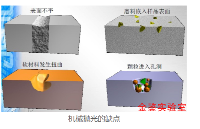





 一文讀懂氬離子拋光和FIB區(qū)別
一文讀懂氬離子拋光和FIB區(qū)別





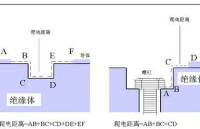












評論