芯片失效分析的主要步驟
芯片開封:去除IC封膠,同時(shí)保持芯片功能的完整無損,保持 die,bond pads,bond wires乃至lead-frame不受損傷,為下一步芯片失效分析實(shí)驗(yàn)做準(zhǔn)備。
SEM 掃描電鏡/EDX成分分析:包括材料結(jié)構(gòu)分析/缺陷觀察、元素組成常規(guī)微區(qū)分析、精確測量元器件尺寸等等。探針測試:以微探針快捷方便地獲取IC內(nèi)部電信號。
鐳射切割:以微激光束切斷線路或芯片上層特定區(qū)域。
EMMI偵測:EMMI微光顯微鏡是一種效率極高的失效分錯(cuò)析工具,提供高靈敏度非破壞性的故障定位方式,可偵測和定位非常微弱的發(fā)光(可見光及近紅外光),由此捕捉各種元件缺陷或異常所產(chǎn)生的漏電流可見光。
OBIRCH應(yīng)用(鐳射光束誘發(fā)阻抗值變化測試):OBIRCH常用于芯片內(nèi)部高阻抗及低阻抗分析,線路漏電路徑分析。利用OBIRCH方法,可以有效地對電路中缺陷定位,如線條中的空洞、通孔下的空洞。通孔底部高阻區(qū)等,也能有效的檢測短路或漏電,是發(fā)光顯微技術(shù)的有力補(bǔ)充。
LG液晶熱點(diǎn)偵測:利用液晶感測到IC漏電處分子排列重組,在顯微鏡下呈現(xiàn)出不同于其它區(qū)域的斑狀影像,找尋在實(shí)際分析中困擾設(shè)計(jì)人員的漏電區(qū)域(超過10mA之故障點(diǎn))。
定點(diǎn)/非定點(diǎn)芯片研磨:移除植于液晶驅(qū)動芯片 Pad上的金凸塊, 保持Pad完好無損,以利后續(xù)分析或rebonding。
X-Ray 無損偵測:檢測IC封裝中的各種缺陷如層剝離、爆裂、空洞以及打線的完整性,PCB制程中可能存在的缺陷如對齊不良或橋接,開路、短路或不正常連接的缺陷,封裝中的錫球完整性。
SAM (SAT)超聲波探傷:可對IC封裝內(nèi)部結(jié)構(gòu)進(jìn)行非破壞性檢測, 有效檢出因水氣或熱能所造成的各種破壞如:o晶元面脫層,o錫球、晶元或填膠中的裂縫,o封裝材料內(nèi)部的氣孔,o各種孔洞如晶元接合面、錫球、填膠等處的孔洞。
關(guān)于芯片失效的難題
對于失效分析,應(yīng)用工程師覺得這是最棘手的問題之一。因?yàn)樾酒栴}通常是在量產(chǎn)階段,甚至是出貨后才開始被真正意識到,此時(shí)可能僅有零零散散的幾個(gè)失效樣品,但這樣的比例足以讓品質(zhì)部追著研發(fā)工程師進(jìn)行一個(gè)詳盡的原因分析。
對于研發(fā)工程師,在排查完外圍電路、生產(chǎn)工藝制程可能造成的損傷后,更多的還需要原廠給予支持進(jìn)行剖片分析。
但是由于缺乏專業(yè)的分析設(shè)備,芯片內(nèi)部設(shè)計(jì)的保密性不可能讓工程師了解得太多,因此對于原廠給予出來的分析報(bào)告,工程師很多時(shí)候其實(shí)處于“被動接受”的處境。

雖然無法了解芯片內(nèi)部的設(shè)計(jì),但其實(shí)我們可以了解芯片廠商相關(guān)失效分析手法,至少在提供給你的報(bào)告上,該有的失效分析是否是嚴(yán)瑾,數(shù)據(jù)是否可靠,你可以做出一定的判斷——
01 電子顯微鏡查看表面異常
失效的芯片樣品到了芯片廠商手里后,首先要做的必然是用高放大倍數(shù)的電子顯微鏡查看芯片表面在物理層面上是否有異常問題,如裂痕、連錫、霉變等異常現(xiàn)象。
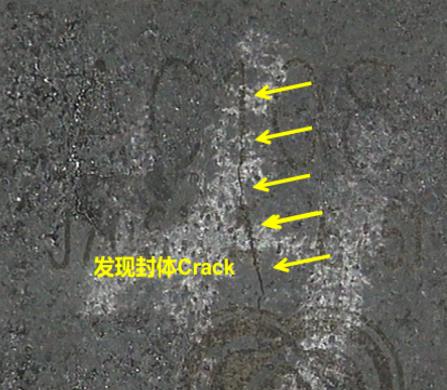
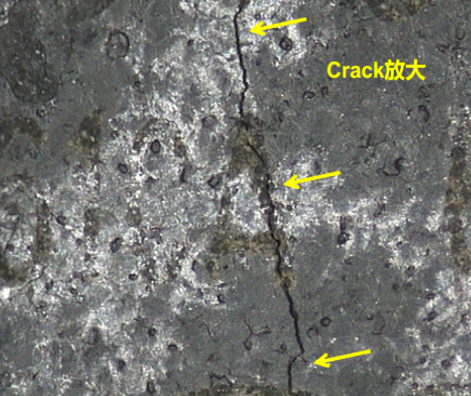
02 X-Ray查看芯片封裝異常
X射線在穿越不同密度物質(zhì)后光強(qiáng)度會產(chǎn)生變化,在無需破壞待測物的情況下利用其產(chǎn)生的對比效果形成的影像可以顯示出待測物的內(nèi)部結(jié)構(gòu)。IC封裝中如層剝離、爆裂、空洞、打線等問題都可以用XRay進(jìn)行完整性檢驗(yàn)。
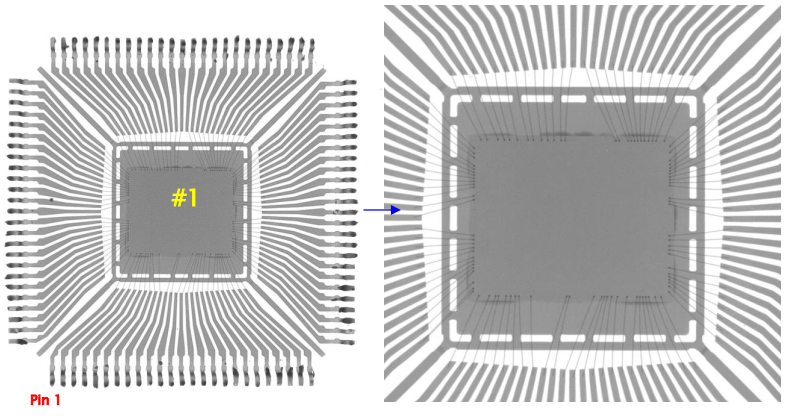
03 CSAM掃描聲學(xué)顯微鏡
掃描聲學(xué)顯微鏡利用高頻超聲波在材料不連續(xù)界面上反射產(chǎn)生的振幅及相位與極性變化來成像,典型的SAM圖像以紅色的警示色表示缺陷所在。
SAM和XRay是一種相互補(bǔ)充的手法,X-Ray對于分層的空氣不敏感,所得出的圖像是樣品厚度的一個(gè)合成體,而SAM可以分層展現(xiàn)樣品內(nèi)部一層層的圖像,因此對于焊接層、填充層、涂覆層等的完整性檢測是SAM的優(yōu)勢。

04 激光誘導(dǎo)定位漏電結(jié)
給IC加上電壓,使其內(nèi)部有微小電流流過,在檢測微電流是否產(chǎn)生變化的同時(shí)在芯片表面用激光進(jìn)行掃描。由于激光束在芯片中部分轉(zhuǎn)化為熱能,因此如果芯片內(nèi)部存在漏電結(jié),缺陷處溫度將無法正常傳導(dǎo)散開,導(dǎo)致缺陷處溫度累計(jì)升高,并進(jìn)一步引起缺陷處電阻及電流的變化。
通過變化區(qū)域與激光束掃描位置的對應(yīng),即可定位出缺陷位置。該技術(shù)是早年日本NEC發(fā)明并申請的專利技術(shù),叫OBIRCH(加電壓檢測電流變化),與該分析手法相似的有TIVA(加電流檢測電壓變化)、VBA(加電壓檢測電壓變化),這三種分析手法本質(zhì)相同,只是為了規(guī)避專利侵權(quán)而做的不同檢測方式而已(TIVA為美國技術(shù)專利,VBA為新加坡技術(shù)專利)。

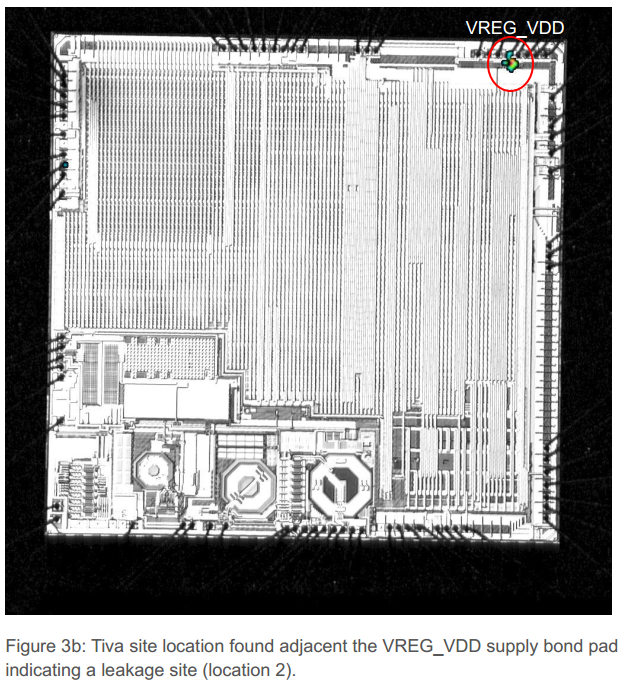
當(dāng)然,在進(jìn)行X-Ray、CASM、OBIRCH之前,可以對每個(gè)管腳進(jìn)行逐漸加電壓并偵測電流曲線是否異常,由此先大概確認(rèn)是否該管腳有失效的可能性。
如下圖所示,藍(lán)色線條為參考電流,所提供的幾個(gè)樣品RFVDD管腳電流均有異常。在確認(rèn)該異常之后,后續(xù)使用X-Ray等儀器時(shí)可以更快速地鎖定缺陷點(diǎn)所在的區(qū)域。
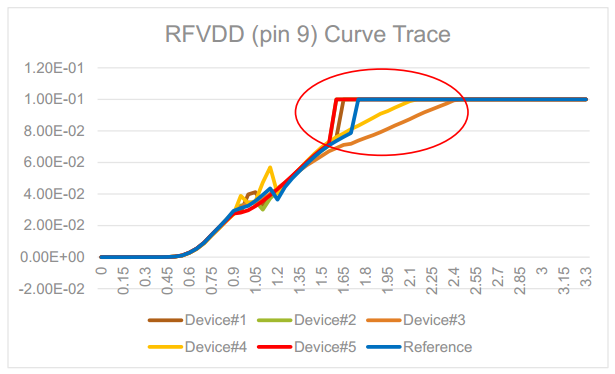
在使用X-Ray等手法定位缺陷區(qū)域后,最終采用機(jī)械剖片、腐蝕液剖片的方法,利用顯微鏡進(jìn)行最后一輪的圖像物理確認(rèn)。
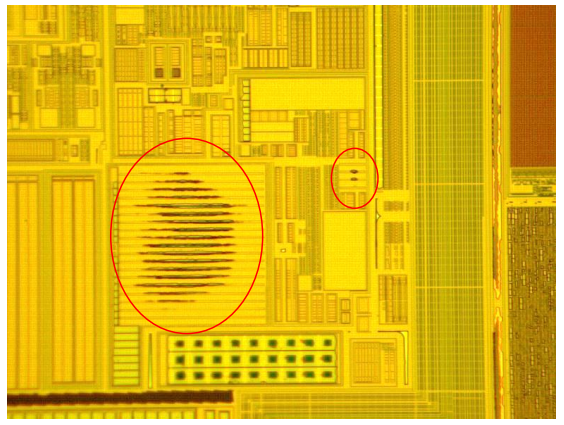
X-Ray 用于失效分析(PCB探傷、分析)
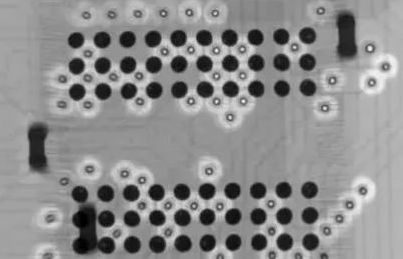
X-Ray 真?zhèn)舞b別----空包彈(圖中可見,未有晶粒)

“徒有其表”
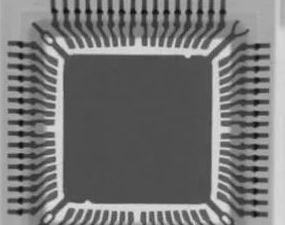
下面這個(gè)才是貨真價(jià)實(shí)的
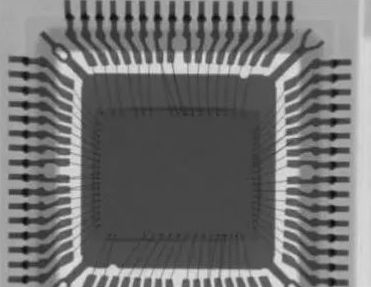
參考文獻(xiàn),見詳細(xì)文件
聲明:
本號對所有原創(chuàng)、轉(zhuǎn)載文章的陳述與觀點(diǎn)均保持中立,推送文章僅供讀者學(xué)習(xí)和交流。文章、圖片等版權(quán)歸原作者享有,如有侵權(quán),聯(lián)系刪除。
-
芯片
+關(guān)注
關(guān)注
459文章
52464瀏覽量
440192 -
元器件
+關(guān)注
關(guān)注
113文章
4833瀏覽量
95022 -
顯微鏡
+關(guān)注
關(guān)注
0文章
619瀏覽量
24252 -
芯片失效分析
+關(guān)注
關(guān)注
0文章
12瀏覽量
190
發(fā)布評論請先 登錄
怎樣進(jìn)行芯片失效分析?
芯片失效分析
失效分析方法---PCB失效分析
芯片失效分析含義,失效分析方法
芯片失效如何進(jìn)行分析
芯片失效分析步驟
常用的芯片失效分析方法
淺談失效分析—失效分析流程

芯片失效分析中常見的測試設(shè)備及其特點(diǎn)
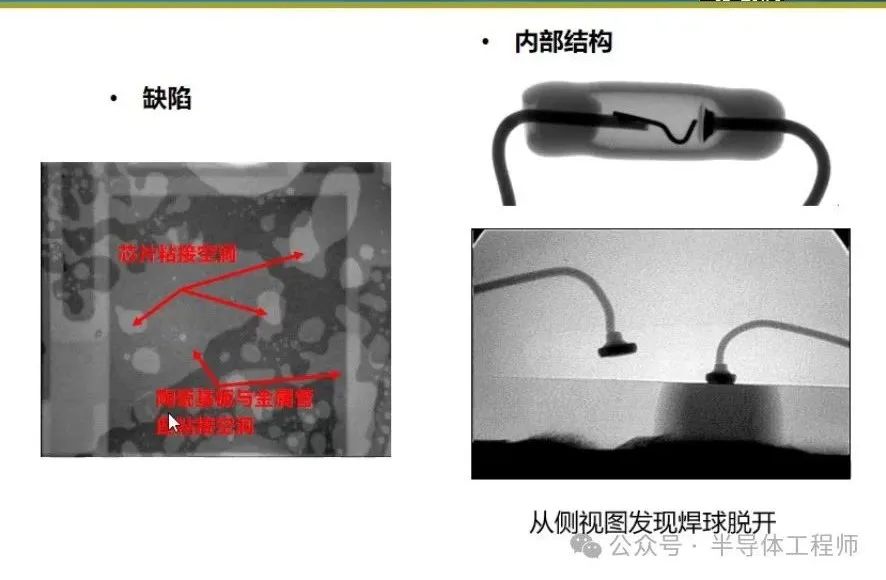





 芯片失效步驟及其失效難題分析!
芯片失效步驟及其失效難題分析!











評論