聚焦離子束掃描電鏡(FIB-SEM)是一種集多種先進技術于一體的微觀分析儀器,其工作原理基于離子束與電子束的協同作用。
掃描電子顯微鏡(SEM)工作機制
掃描電子顯微鏡(SEM)的核心成像邏輯并非傳統透射電鏡(TEM)所依賴的多級電磁透鏡放大,而是以極細的電子探針在樣品表面執行“光柵式”逐點逐行掃描。電子槍產生的初始電子束經 2–3 級電磁透鏡聚焦,最終形成直徑可小至 1 nm 量級的探針。探針在樣品表面按 X、Y 方向順序移動;每一個駐留點(dwell point)都會激發二次電子(SE)、背散射電子(BSE)、吸收電子、X 射線、俄歇電子等信號。
這些信號被專用探測器同步捕獲,其強度實時調制顯像管柵極,從而把樣品表面的形貌、成分、電位等信息映射為熒光屏上的灰度圖像。由于掃描線圈與顯像管共用同一鋸齒波掃描電源,樣品上的物理坐標與屏上像素坐標嚴格一一對應,最終獲得“所見即所得”的高分辨表面圖像。
常用分析方法
1.聚焦離子束-掃描電鏡(FIB-SEM)
FIB-SEM技術通過高能離子束對材料進行精確的切割、蝕刻或沉積,同時利用SEM獲取材料表面的高分辨率圖像。
FIB-SEM的主要組成部分包括離子束系統、電子束系統、樣品室和探測器系統。離子束系統由離子源和離子光學系統組成,離子源提供穩定的離子束流,離子光學系統則包括離子槍、靜電透鏡、掃描線圈等,用于聚焦、掃描和控制離子束的能量和方向。
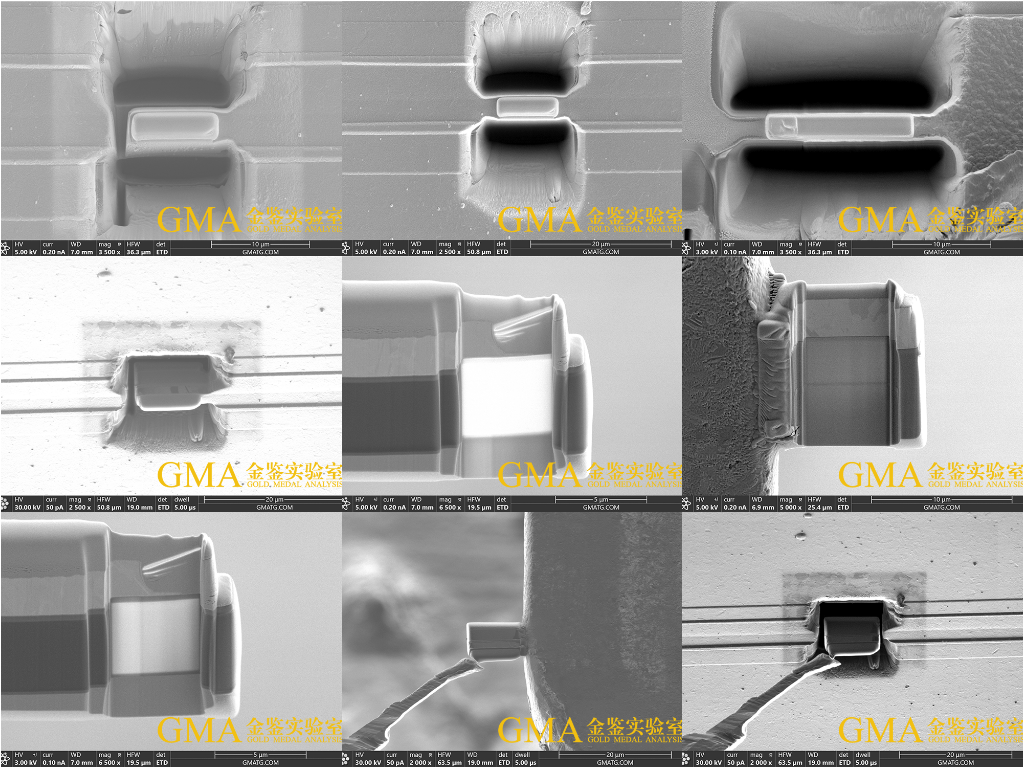
FIB-SEM的檢測項目豐富多樣,主要包括微觀形貌觀察、成分分析、晶體結構分析和微加工。微觀形貌觀察通過二次電子成像,可清晰觀察樣品表面的微觀結構,如納米顆粒的形狀、尺寸分布,材料的表面缺陷等。金鑒實驗室在進行試驗時,嚴格遵循相關標準操作,確保每一個測試環節都精準無誤地符合標準要求。
成分分析則利用背散射電子和背散射離子信號,分析樣品不同區域的化學成分,確定元素的種類和相對含量。晶體結構分析基于電子衍射和離子衍射原理,分析樣品的晶體結構,確定晶格參數、晶體取向等信息。此外,FIB-SEM還可以利用離子束的濺射作用,對樣品進行刻蝕、切割、沉積等微加工操作,制備微納結構。
2.能譜分析技術(EDS)
作為電鏡中最便捷的元素分析手段,能譜分析(Energy Dispersive Spectroscopy,EDS)通過電子束激發樣品原子產生具有特定能量的特征X射線,據此判定材料元素組成。
EDS面掃描(mapping)是表征材料元素空間分布的常規手段,可生成直觀的面分布圖。按照數據處理方式可分為三類:
(1)總計數成像(gross count mapping)
僅對檢測到的特征X射線進行積分計數,并以灰度或偽彩色映射到二維平面。所得圖像僅具備定性意義,可快速顯示元素富集區域,但不提供濃度或絕對含量信息。
(2)定量成像(quantitative mapping,又稱活化學成像)
在譜圖預處理(背景扣除、峰剝離、峰擬合)后,依據標準或標樣將特征X射線強度轉化為元素濃度,生成定量分布圖。該方法可實現空間分辨的元素含量可視化,誤差受標樣質量及基體效應校正精度影響。
(3)物相成像(phase mapping)
通過聚類算法將成分相似的像素歸并為同一化學相,以實現物相而非單元素的空間映射。核心技術為主成分分析(PCA)或獨立成分分析(ICA),先對每點譜線降維提取關鍵特征,再基于相似度矩陣完成像素分類,最終輸出物相分布圖。
結語
聚焦離子束掃描電鏡(FIB-SEM)作為一種重要的微觀分析儀器,在材料科學、生命科學等領域發揮著不可替代的作用。它不僅可以提供高分辨率的微觀形貌圖像,還能進行成分分析、晶體結構分析和微加工等多種操作。
-
SEM
+關注
關注
0文章
259瀏覽量
14927 -
分析儀器
+關注
關注
0文章
110瀏覽量
15341 -
fib
+關注
關注
1文章
102瀏覽量
11421
發布評論請先 登錄
聚焦離子束顯微鏡(FIB-SEM)
FIB-SEM雙束技術及應用介紹
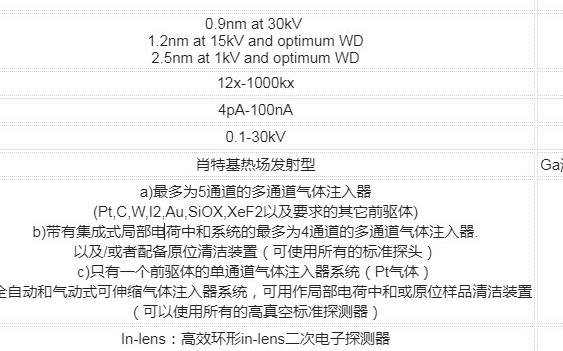
FIB-SEM雙束系統在材料科學領域的應用
聚焦離子束顯微鏡FIB-SEM的詳細介紹

聚焦離子束顯微鏡(FIB-SEM)材料分析

微電子制造中的FIB-SEM雙束系統:技術應用與進展
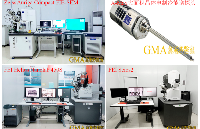
聚焦離子束掃描電鏡(FIB-SEM)技術原理、樣品制備要點及常見問題解答

雙束FIB-SEM系統在材料科學中的應用
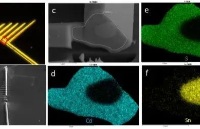
雙束系統(FIB-SEM)在微電子行業的應用探索
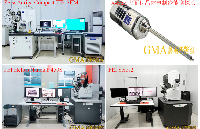
FIB-SEM技術全解析:原理與應用指南
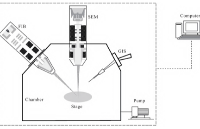
FIB-SEM 雙束技術簡介及其部分應用介紹
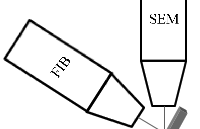
聚焦離子束掃描電鏡雙束系統(FIB-SEM)
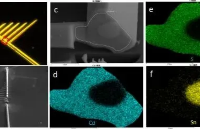
案例展示||FIB-SEM在材料科學領域的應用
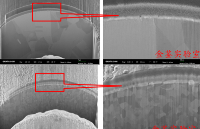
聚焦離子束顯微鏡(FIB-SEM)的應用領域
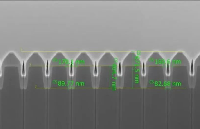





 FIB-SEM的常用分析方法
FIB-SEM的常用分析方法












評論