隨著功率半導體器件向高頻化、集成化方向發展,直接鍍銅(DPC)技術憑借其獨特的優勢成為大功率封裝領域的核心技術。下面由深圳金瑞欣小編將系統闡述DPC工藝中電鍍銅加厚環節的技術要點,并探討行業最新發展趨勢。
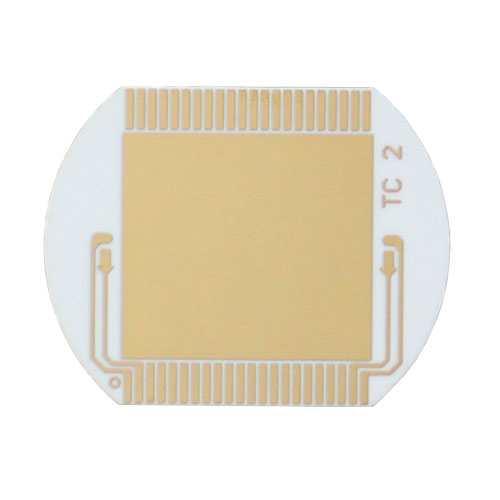
一、電鍍銅加厚工藝的技術價值
在DPC工藝流程中,電鍍銅加厚承擔著將初始銅層(≤1μm)增厚至功能厚度(17-105μm)的關鍵任務。這一工藝不僅決定了基板的導電性能,更直接影響器件的散熱效率、機械強度和長期可靠性。特別值得注意的是,隨著第三代半導體材料的普及,對銅層質量提出了更嚴苛的要求。
二、工藝優化與技術創新
1、前處理工藝革新
采用等離子體活化技術替代傳統化學清洗,在保證表面活性的同時避免化學污染
引入離子注入技術增強界面結合力,使銅層與陶瓷基板的結合強度提升40%以上
2、電鍍過程精準控制
開發新型復合添加劑體系,實現鍍層致密度與平整度的協同優化
應用脈沖反向電鍍技術,顯著提升高深徑比通孔的填充質量
引入在線監測系統,實時調控電流密度和溫度參數
3、后處理工藝突破
采用梯度退火工藝,有效釋放內應力而不影響基板平整度
開發低溫退火技術(250℃以下),適應熱敏感器件的封裝需求
三、行業應用新趨勢
在新能源汽車領域,DPC陶瓷基板正在向超厚銅層(>200μm)方向發展,以滿足800V高壓平臺對功率模塊的需求。5G通信設備則更關注表面精細處理,要求銅層粗糙度控制在納米級別。值得關注的是,在航空航天領域,DPC技術正與新型陶瓷材料結合,開發出適應極端環境的高可靠封裝方案。
四、未來技術挑戰
1、材料層面
開發高純度電解液體系,減少雜質引入
研究納米增強銅復合材料,提升機械性能
2、工藝層面
突破超厚銅層(300μm以上)的無缺陷沉積技術
開發環境友好型前處理工藝
3、裝備層面
研制智能化電鍍設備,實現工藝參數的自適應調節
開發在線質量檢測系統,提升過程控制能力
總結
電鍍銅加厚技術作為DPC工藝的核心環節,其發展水平直接關系到功率電子器件的性能突破。未來需要材料、工藝、裝備等多領域的協同創新,以滿足新興應用場景對封裝技術提出的更高要求。特別值得關注的是,隨著人工智能技術的引入,電鍍工藝的智能化控制將成為重要發展方向。
金瑞欣擁有十年pcb行業經驗,四年多陶瓷電路板制作經驗。為企業提供高精密單、雙面陶瓷電路板,多層陶瓷電路板定制生產,若您有相關需求,歡迎與我們聯系,我們將竭誠為您服務。
-
電鍍銅
+關注
關注
0文章
27瀏覽量
9284 -
基板
+關注
關注
2文章
306瀏覽量
23529 -
陶瓷基板
+關注
關注
5文章
246瀏覽量
11846
發布評論請先 登錄
為什么你需要一塊DPC陶瓷基板
干貨:PCB電鍍銅前準備工藝有哪些?
一文讀懂電鍍銅前準備工藝
什么是覆銅陶瓷基板DPC工藝?
DPC、AMB、DBC覆銅陶瓷基板技術對比與應用選擇






 DPC陶瓷基板電鍍銅加厚工藝研究
DPC陶瓷基板電鍍銅加厚工藝研究


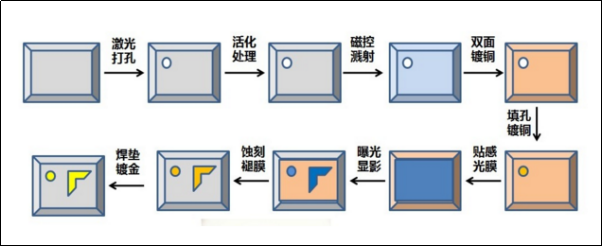
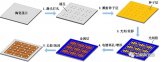












評論