光刻工藝是半導體制造中最為重要的工藝步驟之一。主要作用是將掩膜板上的圖形復制到硅片上,為下一步進行刻蝕或者離子注入工序做好準備。光刻的成本約為整個硅片制造工藝的1/3,耗費時間約占整個硅片工藝的40~60%。
***是生產線上最貴的機臺,5~15百萬美元/臺。主要是貴在成像系統(由15~20個直 徑為200~300mm的透鏡組成)和定位系統(定位精度小于10nm)。其折舊速度非常快,大約3~9萬人民幣/天,所以也稱之為印鈔機。光刻部分的主 要機臺包括兩部分:軌道機(Tracker),用于涂膠顯影;掃描曝光機(Scanning )
光刻工藝的要求:光刻工具具有高的分辨率;光刻膠具有高的光學敏感性;準確地對準;大尺寸硅片的制造;低的缺陷密度。

光刻工藝過程
一般的光刻工藝要經歷硅片表面清洗烘干、涂底、旋涂光刻膠、軟烘、對準曝光、后烘、顯影、硬烘、刻蝕、檢測等工序。
1、硅片清洗烘干(Cleaning and Pre-Baking)
方法:濕法清洗+去離子水沖洗+脫水烘焙(熱板150~2500C,1~2分鐘,氮氣保護)
目的:a、除去表面的污染物(顆粒、有機物、工藝殘余、可動離子);b、除去水蒸氣,是基底表面由親水性變為憎水性,增強表面的黏附性(對光刻膠或者是HMDS-〉六甲基二硅胺烷)。
2、涂底(Priming)
方法:a、氣相成底膜的熱板涂底。HMDS蒸氣淀積,200~2500C,30秒鐘;優點:涂底均勻、避免顆粒污染;b、旋轉涂底。缺點:顆粒污染、涂底不均勻、HMDS用量大。
目的:使表面具有疏水性,增強基底表面與光刻膠的黏附性。
3、旋轉涂膠(Spin-on PR Coating)
方法:a、靜態涂膠(Static)。硅片靜止時,滴膠、加速旋轉、甩膠、揮發溶劑(原光刻膠的溶劑約占65~85%,旋涂后約占10~20%);
b、動態(Dynamic)。低速旋轉(500rpm_rotation per minute)、滴膠、加速旋轉(3000rpm)、甩膠、揮發溶劑。
決定光刻膠涂膠厚度的關鍵參數:光刻膠的黏度(Viscosity),黏度越低,光刻膠的厚度越薄;旋轉速度,速度越快,厚度越薄;
影響光刻膠厚度均運性的參數:旋轉加速度,加速越快越均勻;與旋轉加速的時間點有關。
一般旋涂光刻膠的厚度與曝光的光源波長有關(因為不同級別的曝光波長對應不同的光刻膠種類和分辨率):
I-line最厚,約0.7~3μm;KrF的厚度約0.4~0.9μm;ArF的厚度約0.2~0.5μm。
4、軟烘(Soft Baking)
方法:真空熱板,85~120℃,30~60秒;
目的:除去溶劑(4~7%);增強黏附性;釋放光刻膠膜內的應力;防止光刻膠玷污設備;
邊緣光刻膠的去除(EBR,Edge Bead Removal)。光刻膠涂覆后,在硅片邊緣的正反兩面都會有光刻膠的堆積。邊緣的光刻膠一般涂布不均勻,不能得到很好的圖形,而且容易發生剝離(Peeling)而影響其它部分的圖形。所以需要去除。
方法:a、化學的方法(Chemical EBR)。軟烘后,用PGMEA或EGMEA去邊溶劑,噴出少量在正反面邊緣出,并小心控制不要到達光刻膠有效區域;b、光學方法(Optical EBR)。即硅片邊緣曝光(WEE,Wafer Edge Exposure)。在完成圖形的曝光后,用激光曝光硅片邊緣,然后在顯影或特殊溶劑中溶解
5、對準并曝光(Alignment and Exposure)
對準方法:a、預對準,通過硅片上的notch或者flat進行激光自動對準;b、通過對準標志(Align Mark),位于切割槽(Scribe Line)上。另外層間對準,即套刻精度(Overlay),保證圖形與硅片上已經存在的圖形之間的對準。
曝光中最重要的兩個參數是:曝光能量(Energy)和焦距(Focus)。如果能量和焦距調整不好,就不能得到要求的分辨率和大小的圖形。表現為圖形的關鍵尺寸超出要求的范圍。
曝光方法:a、接觸式曝光(Contact Printing)。掩膜板直接與光刻膠層接觸。曝光出來的圖形與掩膜板上的圖形分辨率相當,設備簡單。缺點:光刻膠污染掩膜板;掩膜板的磨損,壽命很低(只能使用5~25次);1970前使用,分辨率〉0.5μm。
b、接近式曝光(Proximity Printing)。掩膜板與光刻膠層的略微分開,大約為10~50μm。可以避免與光刻膠直接接觸而引起的掩膜板損傷。但是同時引入了衍射效應,降低了分辨率。1970后適用,但是其最大分辨率僅為2~4μm。
c、投影式曝光(Projection Printing)。在掩膜板與光刻膠之間使用透鏡聚集光實現曝光。一般掩膜板的尺寸會以需要轉移圖形的4倍制作。優點:提高了分辨率;掩膜板的制作更加容易;掩膜板上的缺陷影響減小。
投影式曝光分類:掃描投影曝光(Scanning Project Printing)。70年代末~80年代初,〉1μm工藝;掩膜板1:1,全尺寸;
步進重復投影曝光(Stepping-repeating Project Printing或稱作Stepper)。80年代末~90年代,0.35μm(I line)~0.25μm(DUV)。掩膜板縮小比例(4:1),曝光區域(Exposure Field)22×22mm(一次曝光所能覆蓋的區域)。增加了棱鏡系統的制作難度。
掃描步進投影曝光(Scanning-Stepping Project Printing)。90年代末~至今,用于≤0.18μm工藝。采用6英寸的掩膜板按照4:1的比例曝光,曝光區域(Exposure Field)26×33mm。優點:增大了每次曝光的視場;提供硅片表面不平整的補償;提高整個硅片的尺寸均勻性。但是,同時因為需要反向運動,增加了機 械系統的精度要求。
在曝光過程中,需要對不同的參數和可能缺陷進行跟蹤和控制,會用到檢測控制芯片/控片 (Monitor Chip)。根據不同的檢測控制對象,可以分為以下幾種:a、顆粒控片(Particle MC):用于芯片上微小顆粒的監控,使用前其顆粒數應小于10顆;b、卡盤顆粒控片(Chuck Particle MC):測試***上的卡盤平坦度的專用芯片,其平坦度要求非常高;c、焦距控片(Focus MC):作為***監控焦距監控;d、關鍵尺寸控片(Critical Dimension MC):用于光刻區關鍵尺寸穩定性的監控;e、光刻膠厚度控片(PhotoResist Thickness MC):光刻膠厚度測量;f、光刻缺陷控片(PDM,Photo Defect Monitor):光刻膠缺陷監控。
舉例:0.18μm的CMOS掃描步進光刻工藝。
光源:KrF氟化氪DUV光源(248nm) ;數值孔徑NA:0.6~0.7;焦深DOF:0.7μm
分辨率Resolution:0.18~0.25μm
(一般采用了偏軸照明OAI_Off- Axis Illumination和相移掩膜板技術PSM_Phase Shift Mask增強);
套刻精度Overlay:65nm;產能Throughput:30~60wafers/hour(200mm);視場尺寸Field Size:25×32mm;
6、后烘(PEB,Post Exposure Baking)
方法:熱板,110~1300C,1分鐘。
目的:a、減少駐波效應;b、激發化學增強光刻膠的PAG產生的酸與光刻膠上的保護基團發生反應并移除基團使之能溶解于顯影液。
7、顯影(Development)
方法:a、整盒硅片浸沒式顯影(Batch Development)。缺點:顯影液消耗很大;顯影的均勻性差;
b、連續噴霧顯影(Continuous Spray Development)/自動旋轉顯影(Auto-rotation Development)。一個或多個噴嘴噴灑顯影液在硅片表面,同時硅片低速旋轉(100~500rpm)。噴嘴噴霧模式和硅片旋轉速度是實現硅片間溶 解率和均勻性的可重復性的關鍵調節參數。
c、水坑(旋覆浸沒)式顯影(Puddle Development)。噴覆足夠(不能太多,最小化背面濕度)的顯影液到硅片表面,并形成水坑形狀(顯影液的流動保持較低,以減少邊緣顯影速率的變 化)。硅片固定或慢慢旋轉。一般采用多次旋覆顯影液:第一次涂覆、保持10~30秒、去除;第二次涂覆、保持、去除。然后用去離子水沖洗(去除硅片兩面的 所有化學品)并旋轉甩干。優點:顯影液用量少;硅片顯影均勻;最小化了溫度梯度。
顯影液:a、正性光刻膠的顯影液。正膠的顯影液位堿性水溶液。KOH和NaOH因為會帶來可 動離子污染(MIC,Movable Ion Contamination),所以在IC制造中一般不用。最普通的正膠顯影液是四甲基氫氧化銨(TMAH)(標準當量濃度為0.26,溫度 15~250C)。在I線光刻膠曝光中會生成羧酸,TMAH顯影液中的堿與酸中和使曝光的光刻膠溶解于顯影液,而未曝光的光刻膠沒有影響;在化學放大光刻 膠(CAR,Chemical Amplified Resist)中包含的酚醛樹脂以PHS形式存在。CAR中的PAG產生的酸會去除PHS中的保護基團(t-BOC),從而使PHS快速溶解于TMAH顯 影液中。整個顯影過程中,TMAH沒有同PHS發生反應。
b、負性光刻膠的顯影液。二甲苯。清洗液為乙酸丁脂或乙醇、三氯乙烯。
顯影中的常見問題:a、顯影不完全(Incomplete Development)。表面還殘留有光刻膠。顯影液不足造成;b、顯影不夠(Under Development)。顯影的側壁不垂直,由顯影時間不足造成;c、過度顯影(Over Development)。靠近表面的光刻膠被顯影液過度溶解,形成臺階。顯影時間太長。
8、硬烘(Hard Baking)
方法:熱板,100~1300C(略高于玻璃化溫度Tg),1~2分鐘。
目的:a、完全蒸發掉光刻膠里面的溶劑(以免在污染后續的離子注入環境,例如DNQ酚醛樹脂 光刻膠中的氮會引起光刻膠局部爆裂);b、堅膜,以提高光刻膠在離子注入或刻蝕中保護下表面的能力;c、進一步增強光刻膠與硅片表面之間的黏附性;d、進 一步減少駐波效應(Standing Wave Effect)。
常見問題:a、烘烤不足(Underbake)。減弱光刻膠的強度(抗刻蝕能力和離子注入中 的阻擋能力);降低針孔填充能力(Gapfill Capability for the needle hole);降低與基底的黏附能力。b、烘烤過度(Overbake)。引起光刻膠的流動,使圖形精度降低,分辨率變差。
另外還可以用深紫外線(DUV,Deep Ultra-Violet)堅膜。使正性光刻膠樹脂發生交聯形成一層薄的表面硬殼,增加光刻膠的熱穩定性。在后面的等離子刻蝕和離子注入(125~2000C)工藝中減少因光刻膠高溫流動而引起分辨率的降低。
-
半導體
+關注
關注
335文章
27830瀏覽量
223669 -
定位系統
+關注
關注
10文章
589瀏覽量
36550 -
硅片
+關注
關注
13文章
369瀏覽量
34778
原文標題:半導體的光刻工藝全過程技術詳解!
文章出處:【微信號:xinlun99,微信公眾號:芯論】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
光刻工藝的基本步驟
淺談半導體制造中的光刻工藝

電流鏡設計步驟詳解【全過程】
LED生產工藝,led的制作流程全過程!
什么是光刻工藝?光刻的基本原理

光刻工藝的基本知識





 詳解半導體的光刻工藝全過程
詳解半導體的光刻工藝全過程
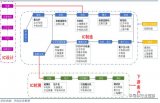












評論