IGBT承受過電流的時間僅為幾微秒,耐過流量小,因此使用IGBT首要注意的是如何進行IGBT保護電路設計。
2011-12-17 00:14:00 8626
8626 
本文首先介紹了IGBT的概念與結構,其次對IGB模塊原理電路進行了分析以及介紹了變頻器IGBT模塊常見故障處理,最后介紹了變頻器IGBT模塊檢測方法以及IGBT模塊的靜態測量。
2018-05-22 09:15:53 9392
9392 IGBT模塊是一種模塊化半導體產品,由IGBT(絕緣柵雙極晶體管芯片)和續流二極管芯片(續流二極管芯片)通過特定的電路橋封裝而成。封裝后的IGBT模塊直接應用于逆變器、UPS等設備。
2023-02-22 15:11:41 2220
2220 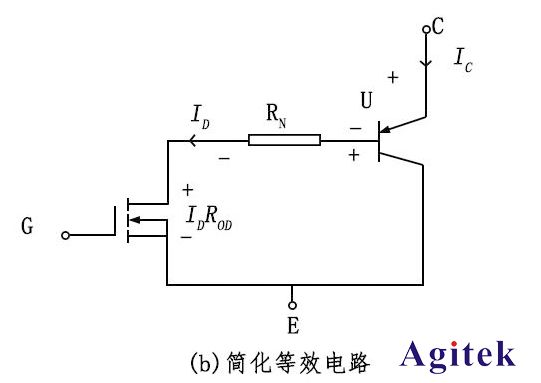
、Miner 線性累 積損傷準則等評估整車壽命周期內 IGBT 模塊的熱疲勞壽命,最后結合電機控制器總成的試驗現狀,提出總成級試 驗中進行 IGBT 加速試驗的可行性方案。
2023-05-05 10:34:52 892
892 
? 針對汽車 IGBT 模塊的主要失效原理和引線鍵合壽命短板,結合仿真分析進行了功率循環試驗設計,結溫差?ΔTj 和流經鍵合線的電流 IC 是影響鍵合點壽命的主要加速因子,中間溫度(Tjm
2023-08-08 10:59:38 772
772 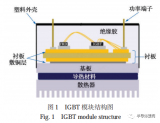
器件的壽命是對于不同場景使用而言的,不同環境下每個器件的壽命有所差別。影響器件使用時間的首先是器件本身的性能,其次是它的工作環境。
2023-11-09 17:36:52 874
874 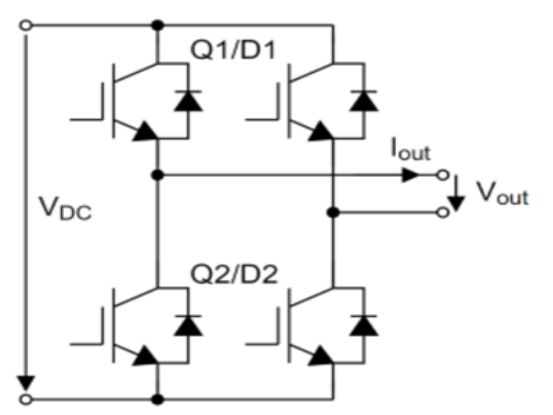
本帖最后由 sunflowerzt 于 2017-12-4 16:45 編輯
4G模塊如何進行視頻傳輸?
2017-12-04 15:52:44
有利于提高功率模塊的效率。然而,只降低損耗還遠遠不夠。器件本身的開關特性也是一個重要問題。全新型號的IGBT針對應用要求進行了優化。IGBT4-T4擁有比低功率IGBT3-T3芯片略高的軟度,而
2018-12-07 10:23:42
IGBT模塊是由哪些模塊組成的?IGBT模塊有哪些特點?IGBT模塊有哪些應用呢?
2021-11-02 07:39:10
通電阻小等特點,因而廣泛應用在變頻器的逆變電路中。但由于 IGBT模塊的耐過流能力與耐過壓能力較差,一旦出現意外就會使它損壞。為此,必須但對IGBT模塊進行相關保護 本文從實際應用出發,總結出了過流、過
2012-06-19 11:26:00
能有著重要的影響。 河北工業大學省部共建電工裝備可靠性與智能化國家重點實驗室的研究人員,針對現階段仍存在的問題,對于不同功率循環下的IGBT的熱退化特性進行了研究。設計了動態實驗,對不同的工作模式下IGBT模塊的退化
2020-12-10 15:06:03
3.1 設備簡述 IGBT高壓反偏試驗是在一定溫度條件(125℃)下,按照規定的時間和電壓,對IGBT施加反偏電壓,從而對器件進行質量檢驗和耐久性評估的一種主要試驗方法。EN-320測試系統是專為
2018-08-29 21:20:11
各位大神好,想請教一個問題。我現在手上有一個IGBT模塊,型號是FF150RT12R4。我現在想找一個驅動這個IGBT模塊的驅動模塊,是驅動模塊,不是驅動芯片,我在網上查找到了EXB840,但是這個驅動年份有些久遠,所以想問有沒有類似的新產品,求推薦型號。
2021-01-04 10:40:43
ESP32模塊與STM32F104RCT6主控芯片之間是如何進行連接的?怎樣去調試呢?
2021-11-04 06:45:13
FreeRTOS 是什么?FreeRTOS實時操作系統是如何進行移植的呢?有哪些步驟?
2021-10-27 06:25:04
IIC協議是什么?IIC協議用來干什么?IIC協議是如何進行通信的呢?
2022-02-10 07:07:13
USB OTG的工作原理是什么?IP設計原理是什么?如何進行IP模塊設計?USB OTG IP核有什么特性?如何對USB OTG IP核進行FPGA驗證?
2021-04-27 06:44:33
OLED屏幕的串口是如何進行連接的?怎樣去編寫其程序呢?
2022-01-21 06:49:13
最近要布一塊使用WIFI模塊的板子,對于WIFI模塊,我是第一次使用,沒有經驗。對于WIFI模塊的布局布線,該如何進行,才能減少對其他電路的EMI,改善EMC呢,請大牛指導,謝謝!
2015-08-04 23:57:21
怎樣去安裝seria呢?ROS的serial是如何進行通信的?
2021-12-06 06:31:43
STM32 USART串口接收數據的具體步驟有哪些?STM32 USART串口是如何進行數據處理的呢?
2021-11-25 08:56:51
通過單片機讀取傳感器的數據怎樣通過uart串口通信傳送至ESP8266呢?STM32與ESP8266的uart是如何進行通信的呢?
2021-12-14 06:38:01
怎樣去使用matlab serial函數呢?STM32與matlab串口是如何進行通信的?
2021-11-18 06:57:51
什么是GPS模塊?GPS數據類型及格式有哪些?stm32與GPS模塊之間的數據是如何進行傳輸的呢?
2021-12-10 06:07:09
求助各位大俠下面這段程序中的void image_projecting ()函數該如何進行優化呢?進行線性匯編的話該如何進行代碼修改呢?* FILENAME: app_process.c
2014-06-17 21:22:49
電壓為 1200V、額定電流范圍為 50A-200A 的 IGBT 模塊)中的 ISO5852S 進行性能評估。評估的一些重要功能和性能包括使用 DESAT 檢測的短路保護、軟關斷、在不同逆變器 dv
2018-12-27 11:41:40
怎樣去編寫SimpleFOC硬件端程序呢?上位機與SimpleFOC是如何進行連接的?
2021-12-21 06:44:57
使用INA226如何進行程序與模塊測試
2021-10-13 06:47:18
今天使用論壇金幣兌換的Nucleo板子進行測試,采用mbed的方式完成LED燈點亮和外部按鍵中斷功能,感覺確實程序編寫簡單,可以幾句話,幾分鐘就完成一個簡單的功能,可是有一個困惑,不可能出來的程序都是可以用的,沒有一點問題,使用mbed如何進行程序調試呢?是不是要導出成IAR然后調試呢?
2018-11-07 08:35:19
單片機模塊化是如何進行編程的?
2021-10-21 06:20:38
單片機:AT89C51,藍牙模塊:HC-05藍牙模塊。他們如何進行通信?
2017-03-26 17:39:24
變頻器的參數有數百甚至上千個,對這些參數進行合理正確的設置是使變頻器高效運行并且滿足用戶要求的前提,那么,如何進行設置呢?本文以西門子MicroMaster440變頻器為例進行說明。1 變頻器的控制
2021-09-03 07:43:06
在按鍵菜單功能中,如何進行菜單的選擇呢?如何實現基于單片機等C語言開發環境的菜單程序設計?
2021-11-02 06:05:58
如何去建立一個二級菜單?在按鍵菜單功能中,如何進行菜單的選擇呢?
2021-07-15 07:46:01
較差,一旦出現意外就會使它損壞。為此,必須但對IGBT進行相關保護。 過流保護生產廠家對IGBT提供的安全工作區有嚴格的限制條件,且IGBT承受過電流的時間僅為幾微秒(SCR、GTR等器件承受過流時間為
2011-10-28 15:21:54
什么是模擬信號和數字信號呢?如何進行AD模數轉換呢?AD轉換的主要性能指標是什么?
2022-01-20 07:11:18
Flash存儲器模塊是什么?它包含哪些部分?如何進行Flash存儲器模塊的自編程操作?
2021-04-26 07:14:53
如何進行一個proteus仿真STM32的測試呢?其操作流程是怎樣的?
2021-11-25 09:16:47
大家好,我打算通過手機app進行cc3200的SmartConfig,使cc3200和手機連到同一個局域網。cc3200SmartConfig的過程中沒有返回手機的IP地址和端口,那我應該如何進行
2020-06-13 19:14:32
數字信號處理是如何定義的?如何進行數字信號處理呢?有哪幾個基本步驟呢?
2021-06-22 06:46:45
定時器回調函數是如何進行工作的呢?
2022-01-21 07:56:35
對linux下的中斷服務程序如何進行編寫呢?
2021-10-29 06:11:14
對永磁無刷電機如何進行調速呢?有哪些操作步驟?
2021-08-11 06:24:22
屏蔽泵的工作原理是什么?屏蔽泵有哪幾種損壞情況呢?如何進行檢修呢?
2021-11-11 07:39:13
MPU9250是什么?MPU9250模塊有何功能?開關電源是如何進行供電的呢?有哪些注意事項?
2021-12-23 07:25:41
怎樣去設計BLDC通過IGBT進行驅動的電路呢?BLDC電機中的死區時間究竟是指什么?
2021-09-18 08:56:44
現急需FF1200R17IP5英飛凌原廠的IGBT模塊,有誰有渠道的幫幫忙!
2020-01-12 10:47:52
教rookie如何進行簡單的單片機模塊編程
2014-03-13 22:09:48
教rookie如何進行簡單的單片機模塊編程
2014-03-13 22:11:13
模擬地和數字地之間是如何進行連接的?電感與磁珠的區別在哪?電感和磁珠的什么聯系與區別呢?
2021-11-04 06:15:20
請問一下同主頻的DSP和ARM的性能如何進行比較呢?* 為什么ARM比較適用于控制,而DSP使用于大量數據處理呢?
2022-06-29 15:36:39
三菱igbt模塊資料
三菱電機第5代IGBT模塊和IPM模塊應用手冊
Mitsubishi ElectricThe 5th Generation IGBT Modules & IPM ModulesApplication Note
2007-12-22 10:58:18 197
197
IGBT模塊驅動及保護技術
摘要:對IGBT柵極驅動特性、柵極串聯電阻及其驅動電路進行了探討。提出了慢降柵壓過流保護和過
2009-07-15 07:57:59 2426
2426 
英飛凌全新.XT技術大幅延長IGBT模塊使用壽命
2010年5月6日,德國Neubiberg訊——英飛凌科技股份公司在紐倫堡舉行的2010 PCIM歐洲展會(2010年5月4日至6日
2010-05-13 09:16:10 1061
1061 變壓器壽命評估是以變壓器在各種負荷及周邊環境下多個生命體征為基礎量,進行其壽命損耗或壽命損耗預期的計算與分析,為供電企業制定科學的運行、檢修策略提供依據。從而統籌處理好安全、壽命和周期成本三者的關系
2017-06-20 10:33:48 1537
1537 的長期隨機變化。因此,本文建立了一種能夠綜合計及IGBT模塊熱載荷的復雜時間常數特性影響的壽命評估模型。分析了實際風電場中不同時間常數熱載荷的壽命消耗特點,以及風速分布與壽命消耗之間的關系。研究了不同氣溫等效方法對壽
2018-01-26 11:26:00 0
0 在一些電力電子應用場合,不僅需要高壓IGBT模塊有優異的性能,還需要具有相當高的可靠性;為了滿足實際需求,希望高壓IGBT模塊的壽命能達到30年,所以,高壓IGBT模塊的壽命預估非常重要。
2018-03-13 16:34:42 10729
10729 本文檔的主要內容詳細介紹的是如何進行3/2變換和2/3變換方程及模塊的建立詳細原理圖說明。
2019-04-30 08:00:00 44
44 本文檔的主要內容詳細介紹的是使用樹莓派設計智能小車教程之如何進行樹莓派模塊安裝資料免費下載。
2019-06-24 08:00:00 21
21 電磁爐又不能用了,估計又是IGBT功率管壞了,真是郁悶啊!我想很多朋友的朋友的電池爐損壞,功率管是損壞的最多的吧,那怎樣來檢查功率管的好壞,至少你手中要有一塊萬用表指針型的那種就行。然后接下來看看我是怎么做的。
2020-02-27 08:00:00 0
0 本文就跟大家聊一聊75 Ohm系統下的信號測試,對于這種信號的測試,如果頻譜儀支持75 Ohm系統阻抗,可以直接進行測試。但是,絕大多數通用頻譜儀只有50 Ohm系統阻抗,如何進行準確的測試呢?
2020-06-09 09:20:35 6274
6274 電源模塊PCB設計是PCB設計師的入門技能,如何進行電源模塊的PCB設計?有以下幾個要點: 1、找到輸入和輸出的功率回路。 (電感按照電流擺放圖) 2、以IC為基準,將輸出電感按照電流方向先擺放
2021-01-27 12:34:07 3422
3422 
IGBT模塊動態參數是評估IGBT模塊開關性能如開關頻率、開關損耗、死區時間、驅動功率等的重要依據,本文重點討論以下動態參數:模塊內部柵極電阻、外部柵極電阻、外部柵極電容、IGBT寄生電容參數、柵極充電電荷、IGBT開關時間參數,結合IGBT模塊靜態參數可全面評估IGBT芯片的性能。
2020-11-17 08:00:00 24
24 車輛運行時,特別實在擁堵的路況時的頻繁啟停,此時控制器的IGBT模塊工作電流會相應的頻繁升降,從而導致IGBT的結溫快速變化,對于IGBT模塊的壽命是個很大的考驗;
2021-02-01 13:58:03 4411
4411 
通過對碼來實現。 SK509開關量模塊如何進行對碼? 即時工作模式 選擇即時模式后,如果沒有對過碼,則是正常一對一的使用場合。任何一方的輸入改變都會同步到對方模塊的輸出,系統為雙向通訊制式。每個模塊都有獨立的四路輸入信號和四
2021-07-08 14:53:02 1478
1478 如何進行OPCDCOM配置(四會理士電源技術有限公司招聘)-如何進行OPCDCOM配置? ? ? ? ? ? ? ? ? ? ??
2021-09-18 14:23:09 11
11 為了計算IGBT的功率循環壽命,英飛凌在線仿真平臺IPOSIM新推出了壽命評估服務,只需輕輕點擊幾次,即可獲取功率模塊的壽命。
2022-04-07 17:36:19 2048
2048 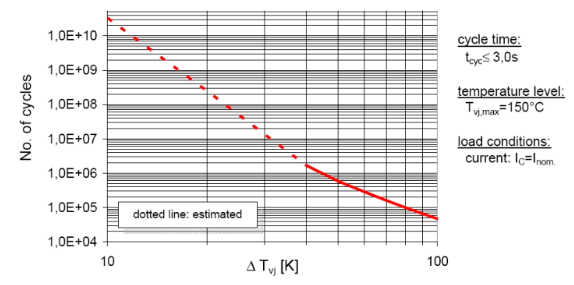
諸如高環境溫度、暴露于機械沖擊以及特定的驅動循環等環境條件,要求對IGBT功率模塊的機械和電氣特性給予特別的關注,以便在整個使用壽命期間能確保其性能得到充分發揮,并保持很高的可靠性。本文對IGBT
2022-08-06 14:54:53 1999
1999 電池壽命和低功耗是現代電池供電電子產品的持續關注點。在設計過程開始時估計它們可能非常具有挑戰性。事實上,電池壽命和功耗幾乎取決于所有設備特性:它的硬件、電池、固件、用例和它的環境。如果這些系統方面中的每一個都可以或多或少地準確地進行評估,那么在同一設計空間中考慮它們是一項復雜的任務。
2022-08-08 09:23:06 656
656 
如何進行電源設計 - 第1部分
2022-11-02 08:16:07 1
1 諸如高環境溫度、暴露于機械沖擊以及特定的驅動循環等環境條件,要求對IGBT功率模塊的機械和電氣特性給予特別的關注,以便在整個使用壽命期間能確保其性能得到充分發揮,并保持很高的可靠性。本文對IGBT的功率和熱循環進行了探討。
2022-12-02 11:46:35 968
968 隨著我國武器裝備系統復雜性提升和功率等級提升,對IGBT模塊的需求劇增,IGBT可靠性直接影響裝備系統的可靠性。選取同一封裝不同材料陶瓷基板的IGBT模塊,分別進行了溫度循環試驗和介質耐電壓試驗
2023-02-01 15:48:05 3470
3470 與傳統單面散熱 IGBT 模塊不同,雙面散熱汽車 IGBT 模塊同時向正、反兩面傳導熱量,其熱測試評估方式需重新考量。本文進行雙面散熱汽車 IGBT 模塊熱測試工裝開發與熱界面材料選型,同時對比研究
2023-02-08 12:49:00 1123
1123 IGBT模塊接口是一種用于連接IGBT模塊和其他電子設備的接口。
2023-02-17 18:21:21 1011
1011 IGBT(Insulated Gate Bipolar Transistor)模塊是一種功率半導體器件,它是由多個IGBT芯片、反并聯二極管、驅動電路、保護電路等組成的集成模塊。IGBT模塊通常根據結構、電壓、電流、功率等參數進行分類。
2023-02-20 17:32:25 4883
4883 隨著半導體技術的迅速發展以及絕緣柵雙極型晶體管(insulatedgatebipolartranslator,IGBT)模塊的普遍應用,電力電子可靠性要求不斷提高,而過熱失效這一主要失效原因亦成為
2023-04-04 10:14:09 965
965 
根據IGBT的產品分類來看,按照其封裝形式的不同,可分為IGBT分立器件、IPM模塊和IGBT模塊。
2023-07-22 16:09:30 1502
1502 
IGBT模塊動態參數是評估IGBT模塊開關性能如開關頻率、開關損耗、死區時間、驅動功率等的重要依據,本文重點討論以下動態參數:模塊內部柵極電阻、外部柵極電阻、外部柵極電容、IGBT寄生電容參數、柵極充電電荷、IGBT開關時間參數,結合IGBT模塊靜態參數可全面評估IGBT芯片的性能。
2023-07-28 10:19:54 3294
3294 
針對汽車 IGBT 模塊的主要失效原理和引線鍵合壽命短板,結合仿真分析進行了功率循環試驗設計,結溫差 ΔTj 和流經鍵合線的電流 IC 是影響鍵合點壽命的主要加速因子,中間溫度(Tjm
2023-08-08 10:56:36 1216
1216 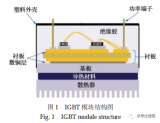
安全光幕如何進行安全保護? 許多機械設備在安裝好安全光幕之后,都需要進行安全光幕的調試工作,以防止設備及安全光幕在正式運行時出現問題。那么安裝安全光幕之后,光幕的調試步驟應該如何進行呢? 1:檢測
2023-08-30 09:35:53 240
240 
IGBT是如今被廣泛應用的一款新型復合電子器件,而IGBT測試也變的尤為重要,其中動態測試參數是IGBT模塊測試一項重要內容,IGBT動態測試參數是評估IGBT模塊開關性能的重要依據。其動態測試參數主要有:主要參數有開關參數、柵極電阻、柵極電荷、寄生電容等。
2023-10-09 15:14:35 644
644 
DC電源模塊的價格因素是什么?如何進行成本優化?
2023-11-08 10:52:12 283
283 
。IGBT的應用領域廣泛,包括變頻器、電機驅動、電力電子設備等。 IGBT模塊是指將多個IGBT芯片和驅動電路封裝在一個模塊內,使得IGBT能夠方便地進行安裝和維護。IGBT模塊通常由IGBT芯片、散熱器
2024-01-18 17:31:23 1082
1082
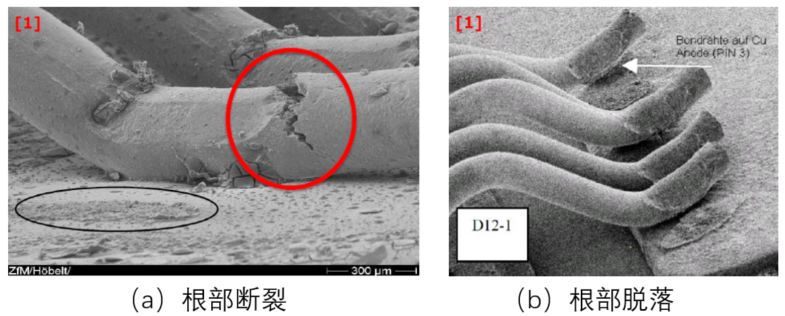

 圖3 焊接層開裂SEM圖
圖3 焊接層開裂SEM圖
 圖5 功率循環測試示意圖
圖5 功率循環測試示意圖




 圖10 SEMISEL仿真參數設置
圖10 SEMISEL仿真參數設置



 圖15 雨流算法簡化溫度波動
圖15 雨流算法簡化溫度波動
 電子發燒友App
電子發燒友App










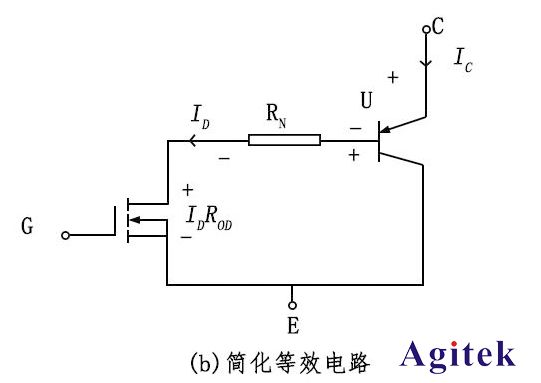

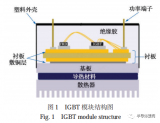
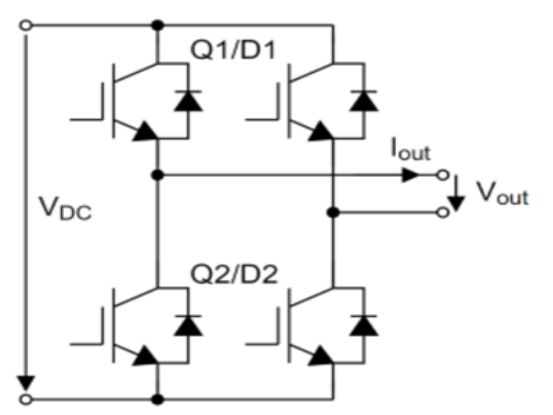





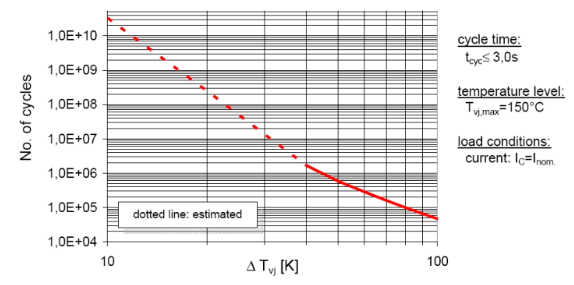




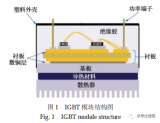













評論