高層摘要
印刷電路板?(PCB)?性能的很多方面是在深化設(shè)計期間確定的,例如:出于時序原因而讓一條走線具有特定長度。元器件之間的溫度差也會影響時序問題。PCB 設(shè)計的熱問題主要是在元器件(即芯片封裝)選擇和布局階段?“鎖定”。在這之后,如果發(fā)現(xiàn)元器件運行溫度過高,只能采取補救措施。我們倡導(dǎo)從系統(tǒng)或外殼層次開始的由上至下設(shè)計方法1,以便了解電子設(shè)備的熱環(huán)境,這對氣冷電子設(shè)備非常重要。早期設(shè)計中關(guān)于氣流均勻性的假設(shè)若在后期被證明無法實現(xiàn),將對產(chǎn)品的商業(yè)可行性帶來災(zāi)難性影響,并最終失去市場機會。?
-特許工程師約翰?·?帕里?(John?Parry)博士和拜倫?·?布萊克莫爾?(Byron?Blackmore)
優(yōu)化熱布局
“盡早開始并從簡單的做起”,這是金科玉律。負責(zé)產(chǎn)品熱完整性的機械工程師應(yīng)當向電子工程師提供盡可能多的反饋意見以指導(dǎo)設(shè)計,優(yōu)化其所做選擇的熱影響,尤其是在早期設(shè)計中。 從機械工程師的角度看,在PCB層,這意味著幫助選擇封裝和理想元器件位置,以利用系統(tǒng)氣流進行散熱。當然,布局和封裝選擇主要取決于電子性能與成本考慮。但是,應(yīng)當盡可能弄清這些選擇會給熱性能帶來怎樣的后果,因為溫度和散熱同樣會影響性能與成本。
1:開始預(yù)布置/預(yù)布局
在電子設(shè)計流程中,完成布局之前有大量工作可以做。事實上,在此之前,就需要將熱考慮對設(shè)計的任何影響計算在內(nèi)。利用機殼的簡單表示就可以完成大量工作1,提供有關(guān)電路板上氣流分布的信息。
首先,簡單地將電路板的總功率分配到電路板的整個表面。據(jù)此生成的溫度圖會指示出任何因為氣流分布不當而引起的高溫區(qū)域,機殼層氣流應(yīng)當在PCB設(shè)計之前進行優(yōu)化。對此,您可以將電路板視作一個具有?5Wm?1K?1到10Wm?1K?1各向同性熱導(dǎo)率的模塊。這個階段獲得的結(jié)果對所選的值不太敏感。
需要注意的是:元器件會局部地將熱量注入電路板中,因此元器件下方的電路板中的熱通量密度會高于電路板的平均值。于是,局部板溫會高于仿真預(yù)測值,因此不應(yīng)使用這一階段得出的板溫來估算元器件溫度。要估算元器件溫度,必須優(yōu)化模型。
如果任一點的板溫接近元器件外殼上限溫度,那么一旦用離散方式表示元器件熱源,就極有可能超過此限值。例如,若已知一個或多個元器件需要散熱器,這種情況就可能出現(xiàn)。 ?
2:獲取元器件功率(猜測) 為此,對于設(shè)計中將會使用的主要散熱元器件,必須知道其功率預(yù)算的理想猜測值,以及其封裝的大致尺寸,這一點非常重要。這樣您就可以在仿真中將其描述為封裝熱源,并將其余熱量均勻分配到電路板表面。 在研究和選擇零件之前,即在項目的原理圖階段開始時,系統(tǒng)架構(gòu)師已對需要哪些關(guān)鍵組件、哪些組件需要靠近什么位置、組件尺寸等有所了解。例如,他們可能會使用其他產(chǎn)品的某些組件,或保留上一代產(chǎn)品的組件。 ?
3:選擇封裝之前使用三維元器件模型 盡管比較困難,但在最終選定元器件之前,嘗試在仿真中包含某種形式的三維元器件模型至關(guān)重要。在此階段之前反饋熱結(jié)果,就更有可能在封裝選擇標準過程中考慮熱性能。某些集成電路(IC)提供多種封裝樣式,但從熱角度看,并非所有封裝樣式的性能都一樣好。因此,如果選擇了適當?shù)姆庋b,后期可能不需要使用散熱器。 元器件溫度(殼溫或結(jié)溫,取決于制造商如何指定元器件規(guī)格)是表明設(shè)計在熱方面是否合格的關(guān)鍵指標。然而,在此階段,我們只能獲得元器件溫度的粗略估算值。 如果缺少其他信息,能派上用場的簡單三維元器件模型是導(dǎo)熱塊。Simcenter Flotherm軟件的材料屬性經(jīng)過定制,針對不同封裝樣式產(chǎn)生不同的預(yù)計殼溫。 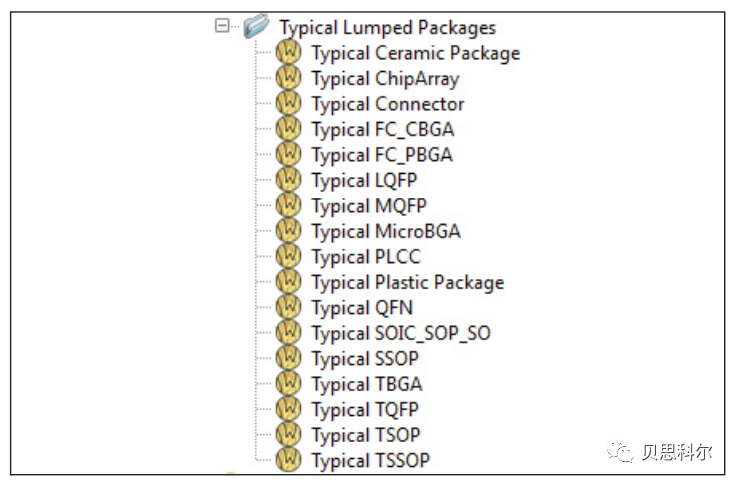 圖1:Simcenter FloTHERM中的集總封裝材料。
圖1:Simcenter FloTHERM中的集總封裝材料。
? 塑封元器件建議使用5Wm?1K?1至10Wm?1K?1的熱導(dǎo)率2,陶瓷元器件建議使用15Wm?1K?1。5Wm?1K?1顯然對應(yīng)最壞情況下的殼溫數(shù)值。 以三維方式表示封裝主體后,相關(guān)人員便可考慮元器件對局部氣流以及任何下游元器件的影響。較大元器件會阻擋冷卻空氣流動到較小、較低的元器件;元器件背后的尾流區(qū)是同樣的空氣不斷循環(huán)流動的區(qū)域,因而該區(qū)域中所有元器件的溫度可能都很高。建議將所有矩形元器件對齊,使其長邊與主要氣體流動方向平行。這不僅會降低總體壓降(因為氣流遇到的阻礙更少),而且會縮小尾流區(qū),盡可能減少對下游元器件的影響。 ?
4:反饋熱結(jié)果 在這一階段,您可以開始將有關(guān)PCB性能的信息反饋給PCB設(shè)計團隊。雖然這個階段的仿真相對粗糙,但主要仿真結(jié)果(即電路板上的氣流分布和相應(yīng)的板溫圖)極具參考價值,您可以借此顯示如何處理可用的冷卻空氣,以及對元器件溫度可能造成的影響。 必須強調(diào)的是,這些標稱元器件殼溫值會發(fā)生變化,因為它們基于以下條件: ?假定的布局 ?粗略的功率估算 ?封裝選擇的不確定性 ?PCB中未知的疊層和銅層分布 ?散熱器初步尺寸和設(shè)計(若已經(jīng)知道是必需的) ? 但即便如此,它仍然是一個有用的起點,既有助于了解系統(tǒng)性能,又提供了一個可隨著設(shè)計的展開不斷進行優(yōu)化的模型。這個模型帶來了有效平臺,可用于調(diào)查元器件布置對元器件及其相鄰元器件的溫度影響,從而據(jù)此結(jié)果輕松調(diào)整,而且模型的重新運行通常也只需要幾分鐘,而不是數(shù)小時。 結(jié)果會在一定程度上反映哪些元器件(若有)可能需要某種形式的散熱器,接下來可以對此進行研究。另外,一旦獲知關(guān)于封裝選擇的更多信息,有些元器件的模型可能需要進一步優(yōu)化,因此這種試驗有助于了解在開發(fā)熱模型時應(yīng)優(yōu)先關(guān)注哪些方面。 ?
5:盡早確定散熱器尺寸 對于任何可能過熱的元器件,都應(yīng)當研究能否通過散熱器來有效地降低元器件溫度。如果氣流方向主要與封裝的一側(cè)垂直,則板型(或擠壓)鰭片散熱器可能更合適。否則,應(yīng)當考慮柱狀鰭片散熱器。 Simcenter Flotherm和Simcenter Flotherm XT提供了散熱器SmartPart,可用于通過參數(shù)定義散熱器幾何形狀。首先將散熱器的基座尺寸設(shè)為與封裝相同,然后研究不同的鰭片數(shù)量、鰭片高度和厚度的散熱效果。此舉是為了確定能否將散熱器簡單地安裝在封裝頂部,或者是否需要更大的散熱器。對于后一種情況,我們還要了解用于機械安裝的電路板基板面(參見圖2),因為此信息需要盡早反饋給PCB設(shè)計團隊。若如此,則必須選擇一個能提供充分散熱的現(xiàn)有散熱器,或者在電路板布線之前設(shè)計一個定制散熱器,因為散熱器的機械安裝可能會影響元器件布置。 散熱器本質(zhì)上是面積擴展裝置,旨在擴大空氣流通的表面來增加與空氣的對流熱傳遞。散熱器一般由鋁合金制成,以便熱量能夠有效擴散到整個基座并達到鰭片。基座充當散熱器,有助于降低元器件溫度。首先使用較短且間距較寬的鰭片,以便盡可能減少對氣流的阻礙以及散熱器引起的尾流,進而降低對下游元器件散熱的影響。 ? ? ? 如果結(jié)果表明,元器件可以利用安裝于自身的相對較小的散熱器來散熱,這項活動就可以到此為止,但后期還需要重新審視。 使用散熱器時,必須考慮封裝與散熱器之間的熱學(xué)界面材料(TIM)的熱阻。最終選擇取決于很多因素,但在設(shè)計早期中,使用厚度約0.2mm(毫米)、熱導(dǎo)率約1.0Wm?1K?1的標準導(dǎo)熱墊是比較保險的選擇。
? 6:精確表示元器件 反饋信息給PCB設(shè)計團隊以幫助其選擇和布置元器件之后,還可以指導(dǎo)其使用密切相關(guān)的熱指標來比較候選元器件的熱性能。
對于沒有散熱器的組件,可用于比較的密切相關(guān)的熱指標是聯(lián)接對電路板電阻。3對于預(yù)計有散熱器的組件,聯(lián)接對電路板電阻相關(guān)度較高,因為電阻通常是針對與散熱器的接觸面而定義的。?對于晶體管輪廓(TO)型封裝,該接觸面通常是焊接在PCB上。若這兩個指標均可用,則可以按電子元件工業(yè)聯(lián)合會(JEDEC)標準創(chuàng)建一個雙熱阻模型(參見圖3),并重新運行熱模型以獲得第一個結(jié)溫估算值。? 在預(yù)測精度方面,再上一個級別則是DELPHI模型。?相較于雙電阻模型,DELPHI模型更適用于散熱器,因為頂面分為不同溫度的內(nèi)部和外部區(qū)域,可用來初步研究散熱器底座厚度的影響。然而,對于需要散熱器且熱特性較為關(guān)鍵的封裝,建議使用詳細模型。 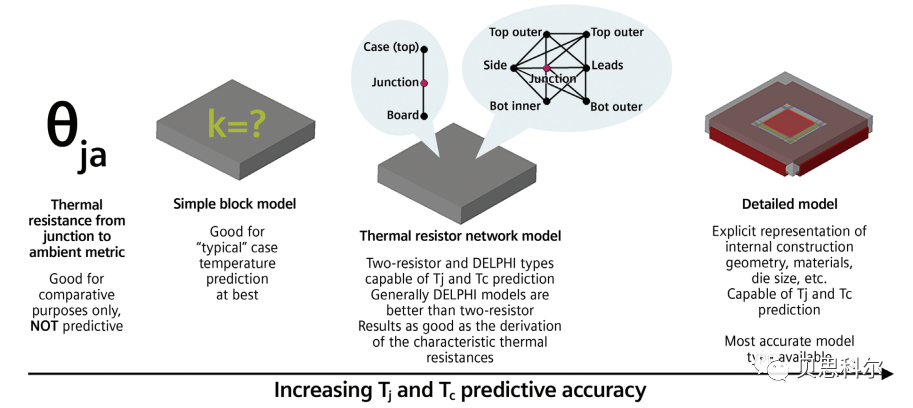 圖 3:用于設(shè)計的封裝熱信息的保真度層級。 ?
圖 3:用于設(shè)計的封裝熱信息的保真度層級。 ?
此外,建議在互聯(lián)網(wǎng)上搜索元器件產(chǎn)品說明,看看是否有任何可用的Simcenter FloTHERM模型;若沒有,可向供應(yīng)商申請Simcenter FloTHERM模型。有時候,獲得這些模型需要遵守保密協(xié)議(NDA)。Simcenter FloTHERM作為廣泛使用的電子散熱計算流體力學(xué)(CFD)軟件,許多領(lǐng)先的IC封裝供應(yīng)商都可為其提供熱模型。這也是Simcenter FloTHERM PACK真正體現(xiàn)其價值的地方。大約70%的Simcenter FloTHERM PACK用戶是系統(tǒng)集成商,他們只需要知道封裝樣式、主體尺寸和引線數(shù)量,就能利用Simcenter FloTHERM PACK的JEDEC封裝向?qū)捎写硇缘姆庋b熱模型。Simcenter FloTHERM PACK還為您提供了所有輸入數(shù)據(jù)的完全訪問權(quán),因此,只要獲得關(guān)于封裝的更多信息,就能立即更新模型,并生成雙熱阻模型、DELPHI模型?和詳細模型。因此,隨著設(shè)計的展開,您可以輕松地優(yōu)化元器件熱模型。
? 7:不要忽略電路板細節(jié)
一旦獲得元器件封裝和熱源估算信息,并將元器件作為三維導(dǎo)熱塊建模,就可以開始研究結(jié)果對電路板熱導(dǎo)率的敏感度。因此,這項活動可以而且確實應(yīng)當與元器件模型優(yōu)化同時進行。 在實際應(yīng)用中,PCB熱導(dǎo)率并不存在單一值。PCB由銅和介電材料組成,并且銅的導(dǎo)熱性能高出大約1,000倍,因此,電介質(zhì)在各層之間和各條走線之間形成了熱隔離。在對電路板進行布線之前的早期設(shè)計中,可使用浮動變化固定在一定范圍內(nèi)(比如5Wm?1K?1到15Wm?1K?1)的簡單各向同性熱導(dǎo)率值來了解PCB熱性能對仿真結(jié)果有多大影響。在深化設(shè)計期間,需要對電路板的這一熱表示加以改進。 一旦大致確定布置,PCB設(shè)計團隊的下一步工作便是原理圖捕捉和電氣仿真(例如時序)。在獲得原理圖之后、電路板布線之前可以獲得的有用信息是電路板疊層。 務(wù)必估算電路板可能會有多少信號層和電源/接地層。PCB表面上的走線會在局部將熱量從封裝互連(引線或焊球)擴散出去,而埋入的電源和接地層則會在宏觀上提高層內(nèi)熱導(dǎo)率。 從熱角度看,這些含銅層對PCB性能的貢獻受其厚度影響。常見的厚度是0.50盎司(Oz)或1.0Oz銅。Oz表示以盎司為單位均勻分布在一平方英尺面積上的銅的重量。??1Oz等于1.37mil(千分之一英寸)或0.0347mm。 一旦獲得PCB中各類型(信號或電源/接地)的層數(shù)估算值,便可升級PCB模型以包括上述各個層。布線之前,需要估算各個非介電層的覆銅厚度和百分比。電源和接地層應(yīng)使用1Oz厚度,走線層應(yīng)使用0.5Oz厚度,覆銅百分比分別假定為80%和20%。電介質(zhì)對面積平均熱導(dǎo)率(包括層內(nèi)和層間)幾乎無影響,因此可以認為這些層的熱導(dǎo)率分別為銅熱導(dǎo)率的80%和20%。 介電層的下限厚度取決于任一面上為補償熱膨脹系數(shù)差異而需要的銅厚度?,然后便可計算板的總厚度。 對于小型、大功率、低引腳數(shù)的封裝,電路板上走線的長度尺度在數(shù)量級方面與封裝類似,因此在電子設(shè)計自動化(EDA)系統(tǒng)提供這些信息之前,有必要在與封裝類似的幾何細節(jié)級別上對這些特性進行建模。例如,在對封裝進行詳細建模時,代表TO封裝上所焊接的銅墊,以及封裝上的局部走線。對焊盤下方用來將熱量導(dǎo)向埋入接地層的所有熱過孔進行建模時,也應(yīng)采取類似的做法。 ?
8:從EDA系統(tǒng)導(dǎo)入數(shù)據(jù)
Simcenter FloTHERM和Simcenter FloTHERM XT具有全面的EDA接口功能,以便從所有主要EDA系統(tǒng)導(dǎo)入數(shù)據(jù),包括:SPADS軟件、Boardstation軟件、Xpedition軟件、Cadence Allegro和Zuken CR5000。 從EDA系統(tǒng)導(dǎo)入元器件布置數(shù)據(jù)可確保熱設(shè)計工具內(nèi)的布置正確;布局一旦有變化,即應(yīng)重新導(dǎo)入。利用Simcenter FloTHERM XT的FloEDA Bridge軟件,一鍵即可重新導(dǎo)入PCB設(shè)計數(shù)據(jù)更新,關(guān)于用戶如何篩選此數(shù)據(jù)的所有現(xiàn)有設(shè)置都會保留。 詳細PCB建模涉及從EDA系統(tǒng)導(dǎo)入疊層、走線層布線、過孔分布以及電源和接地層上的銅皮形狀。
? 9:在設(shè)計流程中提前考慮PCB熱設(shè)計 本著持續(xù)改進的精神,應(yīng)當努力在下一個項目的設(shè)計流程中將熱設(shè)計提前。 在某種程度上,這將使機械角度的熱設(shè)計與電氣角度的熱設(shè)計同步進行。順利的話,這兩種方法可相輔相成,使得熱設(shè)計完成得更快、更可靠,結(jié)果也會優(yōu)于分步進行熱設(shè)計的情形。關(guān)鍵是不同專業(yè)對各流程可以且應(yīng)當完成哪些工作達成共識,這也正是本文的意圖。 ?
10:與EDA流程協(xié)同設(shè)計 最終目標是與EDA流程協(xié)同進行熱設(shè)計。近年來,PCB走線的電流密度和電源平面層上不同區(qū)域之間的直通頸縮不斷增加,使得焦耳(或歐姆)加熱成為PCB設(shè)計中一個越來越嚴重的問題,對電路板的電氣性能和熱性能都有影響。為了幫助電子設(shè)計人員應(yīng)對這個問題,西門子在布局和布線工具集之外推出了HyperLynx Thermal和HyperLynx PI軟件(用于電源完整性)等精密分析工具。 除了有源元器件耗散的熱量之外,焦耳加熱會在PCB中產(chǎn)生額外的熱源。Simcenter FloTHERM可用于逐層導(dǎo)入詳細的熱源圖并疊加到PCB的詳細模型上,從而正確地計入這種熱源。 Simcenter FloTHERM等CFD軟件可以極為精確地表示PCB的對流散熱以及與周圍物體的輻射熱交換。結(jié)束整個系統(tǒng)的熱設(shè)計之前,建議將PCB中焦耳加熱所產(chǎn)生的熱源從HyperLynx PI導(dǎo)入Simcenter FloTHERM或Simcenter FloTHERM XT。 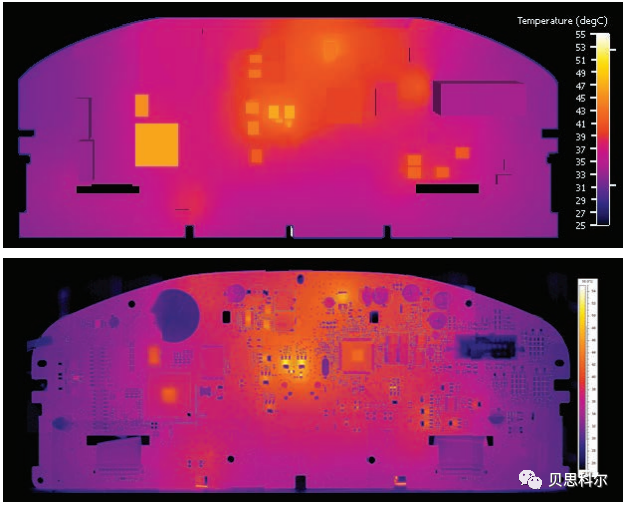 圖 4:設(shè)計期間的 CFD 結(jié)果與利用紅外攝像機測量的實際 PCB 的對比。
圖 4:設(shè)計期間的 CFD 結(jié)果與利用紅外攝像機測量的實際 PCB 的對比。
結(jié)語
本白皮書概要介紹了PCB熱設(shè)計的重要考慮事項,但并非面面俱到。如果您負責(zé)PCB級別熱設(shè)計,想了解西門子的熱設(shè)計軟件如何能夠幫助您,以及什么產(chǎn)品適合您,敬請聯(lián)系我們。Simcenter還提供了連接Xcelerator Share的機會。Xcelerator Share是以工程為中心的云解決方案,尤為適合協(xié)同;借助Xcelerator Share,各種規(guī)模的團隊都可以通過合適的訪問控制與關(guān)鍵利益相關(guān)方安全地展開合作,包括設(shè)計師、經(jīng)理、測試工程師、供應(yīng)商、客戶等。這樣便打造了以項目為基礎(chǔ)的可擴展工作空間,可以更靈活地開發(fā)產(chǎn)品。項目成員可以隨時在任何設(shè)備上查看和批注設(shè)計、共享仿真模板和審核仿真結(jié)果。 ?
參考文獻
1. 12 Key Considerations in Enclosure Thermal Design… A High-Level ‘How To’ Guide,Mentor Graphics white paper, 2014.
2. Tony Kordyban, Estimating the Influence of PCB and Component Thermal Conductivity on Component Temperatures in Natural Convection, Third InternationalSimcenter Flotherm User Conference, September 1994, Guildford, UK.
3. Integrated Circuit Thermal Test Method Environmental Conditions — Junction-toBoard.JEDEC JESD51-8, October 1999.
4. Transient Dual Interface Test Method for the Measurement of the ThermalResistance Junction to Case of Semiconductor Devices with Heat Flow Through aSingle Path.JEDEC Standard JESD51-14, November 2010
5.Two-Resistor Compact Thermal Model Guideline.JEDEC Guideline JESD15-3, July2008.
6.DELPHI Compact Thermal Model Guideline.JEDEC Guideline JESD15-4, October2008.
7.https://en.wikipedia.org/wiki/Printed_circuit_board
8.http://www.pcbuniverse.com/pcbu-tech-tips.php?a=4
編輯:黃飛
?
 電子發(fā)燒友App
電子發(fā)燒友App











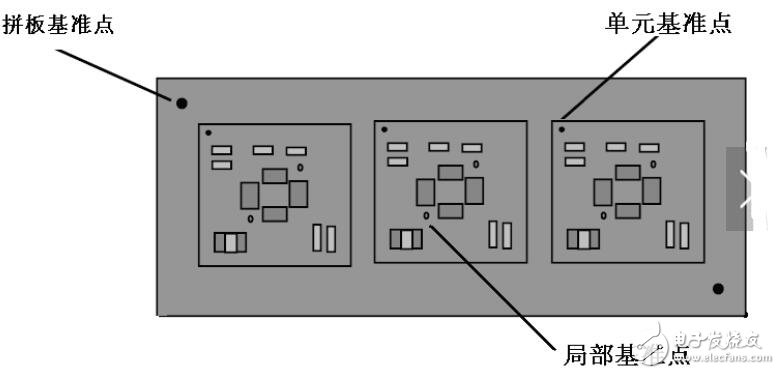
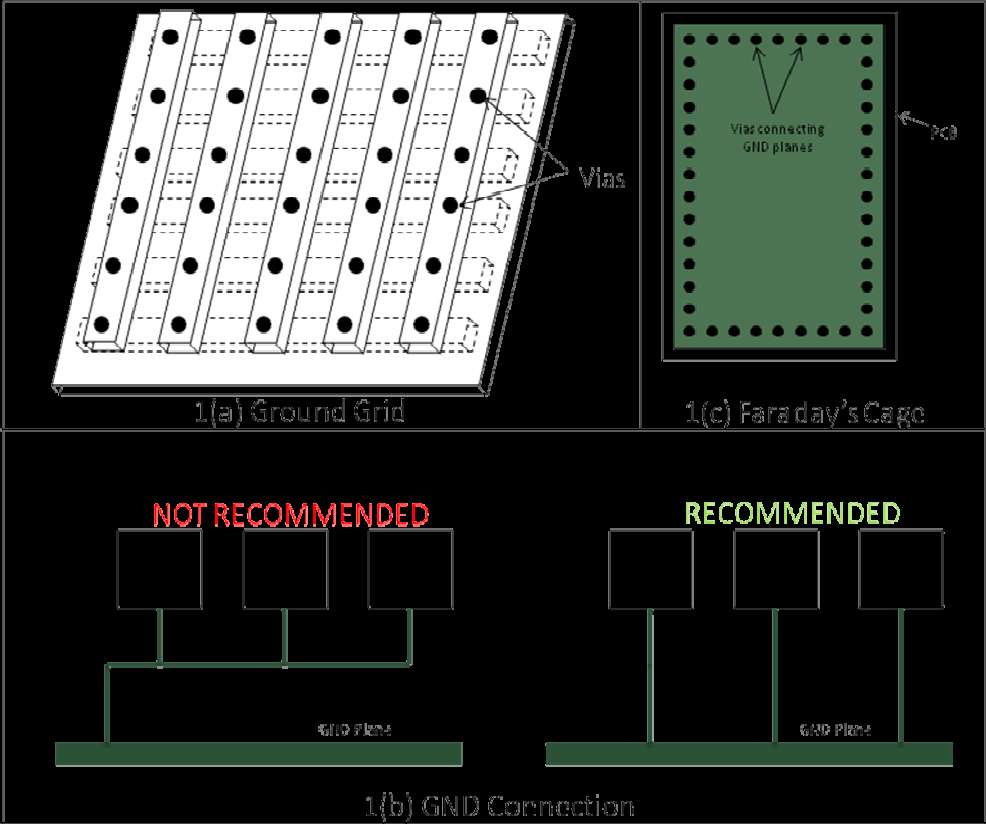











評論