劉勁松 郭 儉
摘要:
為了應對半導體芯片高密度、高性能與小體積、小尺寸之間日益嚴峻的挑戰,3D 芯片封裝技術應運而生。從工藝和裝備兩個角度詮釋了 3D 封裝技術;介紹了國內外 3D 封裝技術的研究現狀和國內市場對 3D 高端封裝制造設備植球機的需求。介紹了晶圓植球這一 3D 封裝技術的工藝路線和關鍵技術,以及研制的這一裝備的技術創新點。以晶圓植球機 X - Y - θ 植球平臺為例,分析了選型的技術參數。封裝技術的研究和植球機的研發,為我國高端芯片封裝制造業的同行提供了從技術理論到實踐應用的參考。
0 引言
3D 芯片封裝技術在組裝密度、信號傳輸速度、電性能及可靠性方面的獨特優勢,目前已成為能最大限度地提高芯片集成度和提高高速單片 IC 性能,制作高速電子系統,實現終端產品小型化、多功能化、高可靠性和高性能的最有效途徑。3D 封裝的主要優勢為:具有最小的尺寸和質量,將不同種類的技術集成到單個封裝中,用短的垂直互連代替長的 2D互連,降低寄生效應和功耗等。
國際上公認最具商業價值的芯片就是 BGA/WLP(Ball Grid Array/Wafer Level Package)等 3D 封裝形式的處理器產品,美國 TI 為全球最大生產商。3D 芯片封裝最主要的設備及工藝就是植球設備和工藝,目前該項技術和設備均被國外公司所壟斷,其進口設備售價昂貴、售后技術支持效果不佳,嚴重影響了我國芯片廠的產品換代升級進程。掌握這項技術并研發出晶圓級植球機具有重大戰略意義,將推動我國3D 芯片封裝技術的發展。這一國內設備及工藝技術的誕生將改變國產芯片廠為外資品牌低端來料加工的歷史,可以生產中國自主品牌的芯片。
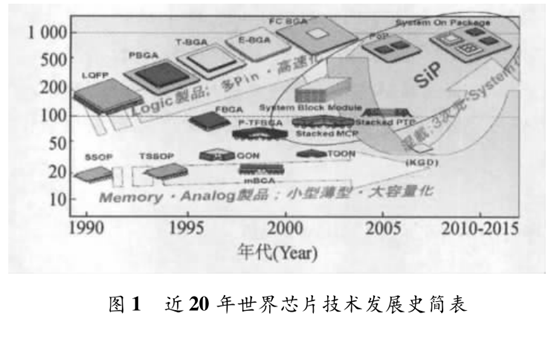
1 國內外產業技術現狀分析
高密度 3D 芯片封裝技術是國內外近幾年飛速發展的微電子封裝技術。疊層型 3D 封裝是應用最廣泛的一種,各層互連可以是線焊、倒裝焊、硅通孔或是這三種方式的混合。不管是哪種具體的實現形式,3D 封裝有幾個共性的難點:凸點制作、通孔制作、芯片減薄和劃片、散熱及電路性能等。目前,3D層疊中的微焊點主要使用超細間距和高密度凸點陣列實現。晶圓上形成凸點有三種形式:電鍍方式、印刷錫膏固化方式和植球方式。電鍍方式具有造價貴、制造周期長、環境污染、工藝復雜和參數不穩定等缺點;印刷錫膏方式不容易控制凸點高度,很難制作小于 200 μm 的凸點。植球方式工藝穩定。目前,材料廠商可以提供質量穩定的 60 ~ 250 μm 的錫球用于量產。2002 年從 Intel 公司首倡推廣使用晶圓植球技術開始,正逐漸被大多數客戶所接受,這種方式的成本也隨焊球和設備價格的下降而迅速下降,更具性價比優勢。層疊后的芯片與 PCB 等載體相連時,又廣泛運用到 BGA 基板植球技術。
晶圓級微球植球機及周邊的微芯片檢測提取設備和 BGA 基板植球機設備的技術和專利近乎全部掌握在國外廠商手中,技術標準由國外公司制定;國內企業研發工作面臨國外廠商的技術封鎖。針對該類設備的相關專利保護,具體進行了深入的研究工作,研發了新的實現方式,設計新型的結構,申請專利保護我們的知識產權,并且已經有幾款發明專利獲得受理和授權。
2 我國市場需求分析
早在 20 世紀 60 年代,美國和日本就開始研究BGA 植球技術,并在 20 世紀 90 年代末開始出現BGA 封裝規模化生產。晶圓級微球植球機的技術源自基板植球機。我國內資企業在 2008 年左右引入首套 BGA 基板植球機,2010 年就開始了晶圓植球機的采購。
晶圓級微球植球機和 BGA 基板植球機是高端IC 封裝設備的關鍵設備之一,可以和前后設備組成完整的 3D 芯片封裝生產線。隨著網絡通信領域技術的迅猛發展,數字電視、信息家電和 3G/4G 手機等產品大量需要高端 IC 電路產品,進而對高引腳數的 MCM、BGA、CSP、SiP、PiP、PoP 等 3D 芯片封裝中高端產品的需求十分旺盛。
保守估計,2013 年全球半導體設備市場較 2012年將萎縮 6% 左右;然而我國半導體專用設備市場將繼續增長,預計達到 40 億美元規模。封裝測試設備占國內半導體專用設備市場在 40%以上,超過 16億美元。其中約 10%為 3D 芯片封裝植球設備這樣的高密度高端 IC 封裝設備,而且逐年迅猛增長。晶圓植球機全球 2013 年銷售預期將達到 20 條線并將保持年均 25% 以上的增長。中國大陸封裝廠剛開始采用此類技術,設備需求持續強勁增長,預計中國大陸市場將保持 30%以上的年均增長,具有良好的市場前景。
3 裝備設計目標及技術工藝路線
裝備設計目標是研究晶圓植球技術及設備并實現產業化,具體研制用于 3D 芯片封裝的晶圓級微球植球設備的系統結構與功能,設計出簡潔而可靠的能夠實現穩定、高良率植球的機構,完成具有自主知識產權和多項專利技術的晶圓級微球植球機和并產業化,打破國外技術封鎖。設備技術指標達到世界同期水平,并提供給國內大型封測骨干企業進行驗證生產。
晶圓級微球植球機主要產品技術指標如下。硅片尺寸:6/8/12 inch;最小端子間距:200 μm;錫球直徑:Ф100 μm ~ Ф500 μm;UPH:20;印刷和植球對位精度: ±30 μm;植球成功率:99. 995%。
以上主要技術性能指標為國際同期水平,上海微松公司針對該類設備的技術研發已經獲得多項授權專利,擁有發明專利的晶圓級微球植球用彈性體壓入裝置、微球自動收集及供球循環設備、BGA 基板植球用焊球定位自動供給機構等技術,克服了一些國外設備具有的缺點和不足,具有更高的性價比。
晶圓級微球植球機工藝和技術路線如下。
(1)將晶圓盒放置到上料位后,機械手自動抓取晶圓進行預對準后放置到工作臺上;
(2)助焊劑和焊球的上料;
(3)圖像處理系統對晶圓和網板進行認識和處理,計算晶圓與印刷網板/植球網板的對位信息;
(4)根據視覺認識的處理結果把晶圓和印刷網板對位,執行助焊劑印刷;
(5)自動清洗機構對印刷網板進行清洗;
(6)根據視覺認識的處理結果把晶圓和植球網板對位,執行植球;
(7)自動清洗機構對植球網板進行清洗;
(8)機械手自動將晶圓從工作臺上抓取,放回晶圓盒中。具體流程如圖 2 所示。

4 關鍵技術分析
3D 芯片封裝植球裝備技術的研發解決了國內產業急需的關鍵技術,形成了如下創新點。
4. 1 超精密絲網印刷技術
晶圓級植球工藝中,絲網印刷用網板是微米級的薄板,晶圓和刮刀與網板的接觸都會造成印刷網板的彈性變形。需要對這種變形加以控制、尋找合適的工藝參數并最終實現精確的助焊劑印刷量控制并實現微米級的印刷精度,如圖 3 所示。
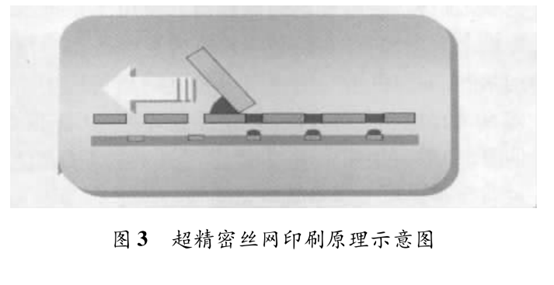
4. 2 自動網板清潔技術
需要設計全自動的清潔紙傳送和清潔液供給系統,實現對印刷網板和植球網板的自動清洗,以保證最終的植球質量,如圖 4 所示。
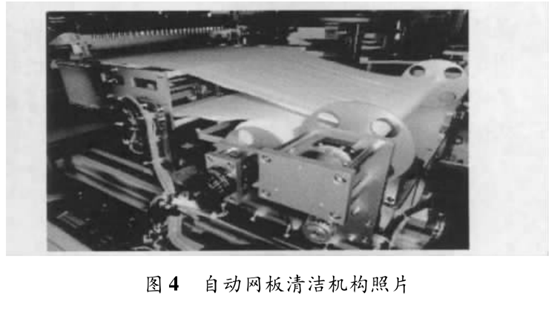
4. 3 晶圓級微球搭載技術
通過研究球徑、晶圓尺寸和壓力的關系曲線,研究測量反饋系統的誤差校正算法,設計實現 Z 軸壓力的精確控制以實現良好的植球效果。研究焊球流量與植球效果的匹配關系,設計實現焊球的自動供球、回收和循環系統。原理示意圖,如圖 5 所示。
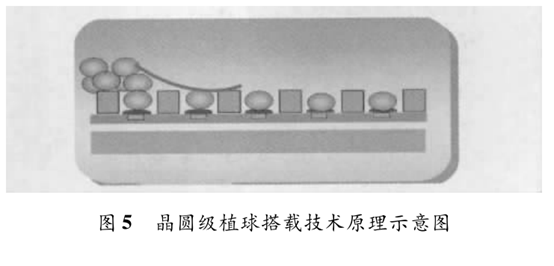
4. 4 生產管理系統軟件
一個大系統在運行過程中,需要為操作人員提供各種數據和參數,也需要為生產中的各項指標提供可追溯和分析數據庫;因此生產管理系統軟件也是核心技術。
4. 5 精密定位系統與算法
0. 1 μm 的分辨率,1 μm 的絕對定位精度,2 m的有效行程,定位技術的成熟與否決定了系統的可靠性。本裝備的 X - Y - θ 植球平臺是整個系統的基礎,下面將用一個章節分析其特點與選型。最多 50 軸(電機)同時控制,在控制各種電機(直線,伺服,步進)的同時,采集傳感器過來的 I/O 信號。運動控制算法也是系統研發的核心技術。
5 X - Y - θ 植球平臺的選型
X - Y - θ 三自由度植球平臺是晶圓級微球植球機核心工作單元,主要由直線電機、DD(直接驅動)電機、內外圈同步帶起升機構、網板支撐平臺和精密支撐治具組成,可分別對 6 英寸、8 英寸和 12 英寸晶圓進行高精度定位,完成印刷和植球動作,結構如圖 6 所示。其對應的搭載建模技術是晶圓植球機的關鍵技術。下面詳細分析 X - Y - θ 植球平臺搭載建模過程以及重復定位與絕對定位誤差計算。
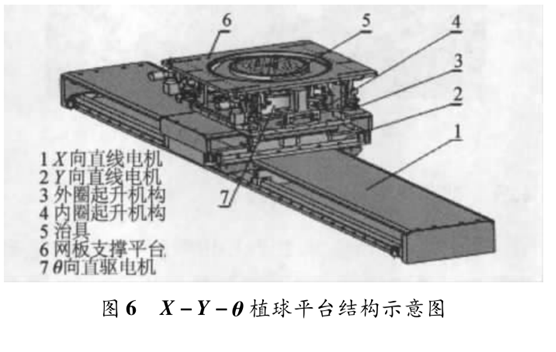
精密支撐治具上等徑陣列出若干小孔,真空吸住晶圓,由θ 向 DD 電機驅動,其技術參數如下。

負載和 θ 向 DD 電機由直線電機驅動,其工作模式如圖 7 所示;誤差分析示意圖如圖 8 所示。


根據設定的工作模式計算出有效行程 L s1 和 L s2與峰值載荷 F b1 和 F b2 ,分別選用合適的 Y 向和 X 向直線電機。
X - Y - θ 植球平臺聯動時,每一向都存在著重復定位誤差和絕對定位誤差,重復定位誤差可以由程序原點復歸解決,而絕對定位誤差很難消除,X向、Y 向和 θ 向絕對定位誤差的累積將導致植球機植球失敗。理論上 X 向進給 x 0 mm,Y 向進給 y 0 mm,θ 向旋轉 θ 0 °,距離晶圓中心 Q'點的 r 0 處某一植球點坐標為 P(x 0 ,y 0 ,z 0 )。而實際上,X 向和 Y 向進給動作完成后,晶圓中心 Q'點可能是 C'點,這是由于X 向和 Y 向絕對定位誤差的累積造成的。其實,晶圓中心是 C'點只是其中一種可能,X 向和 Y 向聯動的絕對定位誤差是整個矩形 ABCD,那么晶圓中心可能是其對應的矩形 A'B'C'D'內任意一點(包括邊界),圖中未作出。θ向旋轉動作后,理想狀態下,植球點 P 只偏移到了 P 1 點,事實上,由于θ 向也存在著絕對定位誤差,這將導致 P 1 點偏移到圓弧P 2 P)3 上任意一點。以極限位置 P 2 ,討論X - Y - θ 植球平臺聯動累積絕對定位誤差δ。設P 2 (x 2 ,y 2 ,z 2 ),旋轉矩陣為 R,平移矩陣為 T,植球允許誤差[ ] δ ,錫球直徑 d,則


6 結論與展望
通過詳細闡述 3D 芯片封裝植球裝備技術的總體工藝流程和技術要求,特別是對晶圓植球機和BGA 基板植球機的原理和技術規格的重點介紹,希望對我國自主發展高端芯片封裝業具有指導意義。從工藝和裝備角度為國內同行貢獻了詳細嚴謹的專業知識。
(1)3D 芯片植球是高端 WLP/BGA 封裝必備的裝備,此項技術是解決我國高端芯片不能自給局面的必要手段。
(2)上海微松公司聯合上海理工大學已經掌握了該項技術,培養了一批開發設計人才,隨著 8/12英寸晶圓級及 BGA 基板級的商品機的持續開發,我國在此領域的自主創新將進入深水區。
(3)我國封裝設備市場巨大,關鍵技術卻控制在外國企業的手中,突破封鎖,發展民族產業是我們的重任。
審核編輯:湯梓紅
 電子發燒友App
電子發燒友App






























評論