***地區科技部長陳良基9日表示,半導體為產業競爭力核心,臺積電10納米制程已進入量產,2年后將進入7納米,不到5年將進入3納米、2納米,屆時將面臨物理極限,必須要透過基礎研究突破。
陳良基在行政院新首長上任聯合記者會上表示,上任后將推動3件工作,第一支援學術研究;第二提振與推動產業技術創新,將相關技術透過研究轉化成產業產品;第三建置國內相關科技研究環境,支持及維運科學園區發展。
他強調,負責科研獎助的科技部并非冷門單位,他所提供的研究是與民眾未來切身相關的產品,例如目前手機上的虛擬實境與未來的人工智慧技術。
科技研究對***非常重要,陳良基說,他對自己立下使命標竿,期持續以科技研究創造***的價值,也期盼于任內首先要連結學界研發成果與科技業界緊密結合,持續打底基礎研究。
以臺積電為例,10納米制程已進入量產,2年后將進入7納米,不到5年將進入3納米、2納米,屆時將面臨物理極限,須透過基礎研究突破。除半導體外,其他業界也需要基礎研究支撐,科技部未來將結合學術界、產業界,共同推動產學聯盟,期每年組成5-10個產學聯盟。
臺積電百人團隊投入3nm
去年下半年,臺積電共同CEO劉德音首次透露了3nm制程的進度,他表示,目前組織了300~400人的團隊研發中。根據規劃, 臺積電的10nm、7nm都會用上EUV極紫外光刻技術,更遙遠的5nm也會如此,而且還會加入新的多重電子束技術(multipe e-beam)。
這兩年業界在進入FinFET時代之后速度有所放慢,Intel的14nm制程延期一兩年,直接導致他們放棄了Tick-Tock戰略。Intel最初對制程進展的時間表還很樂觀,上面這張前幾年的路線圖中,10nm制程預計在2015年之后量產,但實際上是在明年下半年,延期了差不多2年,后面的7nm制程尚未公布具體量產時間,5nm等制程就更不用說了。因為就物理原理而言,7納米的晶體管堪稱物理極限,一旦晶體管的大小低于這一數字,晶體管之間就會產生所謂“量子隧穿”效應,使數據的交換紊亂,為芯片制造帶來巨大挑戰。也體了現在臺積電深厚的技術底蘊。今年年底量產的10nm工藝上臺積電就使用了EUV極紫外光刻技術,再往后的7nm、5nm也會采用這一技術,其中5nm還將使用多重電子束技術,以解決以上的物理難關。
目前的情況是,包括Intel、TSMC、三星在內,他們的10nm制程早已研發完畢,已經在準備量產。下下代的7nm制程已經在規劃中了,技術研發也差不多了,已經準備在明年開始流片。再具體一些,TSMC公司聯席CEO劉德音之前透露了該公司的制程路線圖——2017年Q1正式量產,7nm制程投產也在計劃中。
至于更先進的5nm制程,目前還在積極規劃,而3nm制程也組建了300-400人的團隊在攻關了。如果沒記錯的話,這應該是首次有半導體公司提到3nm制程進展,此前見諸報導中最多提到5nm制程,3nm制程鮮有人提及——話說連廠商現在也不能保證3nm制程到底何時推出吧,從5nm進展來看,小編估計至少是2025-2030年的事了。
技術面臨的挑戰
但那么先進的制程,會面臨多方面的挑戰,首先就是來自材料本身的極限。
產業顧問機構IC Knowledge總裁Scotten Jones認為,納米節點將在2019年開始在某些制程步驟采用EUV技術,或許仍得采用某種形式的FinFET晶體管;至于再往下到3.5納米節點,將會進展至采用水平納米線(horizontal nanowire),而該節點應該會是經典半導體制程微縮的終點;其后2.5納米節點堆棧n型與p型納米線,可望在2025年將晶體管密度增加60~70 %。
而EUV光刻機也是一大障礙。
Globalfoundries技術長Gary Patton在2016年10月來臺與本地媒體分享該公司最新技術與策略方向時則表示,他預期EUV微影技術要到2019年才會邁入成熟,而Globalfoundries在該時間點之前就會量產的7納米制程應該不會采用該技術。
市場研究機構Semiconductor Advisors的分析師Robert Maire認為:「EUV微影真正開始量產應該是會在2020年;」他指出,臺積電(TSMC)已經宣布了將在5納米節點采用EUV微影的計劃;而英特爾則可能會在7納米采用EUV微影,與臺積電的5納米節點量產時程相當, 時程預計是在2019年。
Patton表示,人工智能、云端運算、高速通訊等應用,目前最尖端的3D晶體管FinFET制程是理想選擇,目前該技術進入14納米節點量產、已經成熟而且對高階應用有價值;至于對運算性能要求較低、也以較低功率運作的各種嵌入式裝置,例如物聯網設備,其實就不一定要用到最尖端的FinFET制程,否則并不符合成本效益。
GlobalFoundries提供的其他技術選項是全空乏絕緣上覆硅(Fully depleted silicon-on-insulator,FD-SOI)制程;Patton指出,該公司準備在2017年量產的22納米FD-SOI制程,在成本上與成熟的28納米平面晶體管制程相當,但能達到類似FinFET制程的性能,而且功耗更低、 封裝尺寸更小,也更適合與RF組件的整合。
在封裝技術方面,Patton表示在過去一年來,Globalfoundries看到2.5D與3D芯片堆棧的客戶需求有大幅成長的趨勢;目前該公司可提供應用于32~22納米深度溝槽式晶圓的「智能中介層」(interposer),具備去耦電容,能支持低功率應用的芯片堆棧。
在芯片堆棧技術方面,***半導體產業協會(TSIA)理事長、鈺創科技董事長盧超群表示,過去15年來IC產業已經達成了「類似以微觀建筑技術造高樓」的突破,發明3D甚至超越3D的異質性晶粒排列或堆棧方法;再加上半導體廠商在晶圓級封裝技術(WLP)上的研發成果──例如臺積電的整合型扇出(Integrated Fan-out,Info)與整合型扇出-封裝內建封裝技術(InFO-PoP)。
將IC制造與封測一體化,是工藝前進的保證,也會是讓摩爾定律延續更長壽命的關鍵。
 電子發燒友App
電子發燒友App









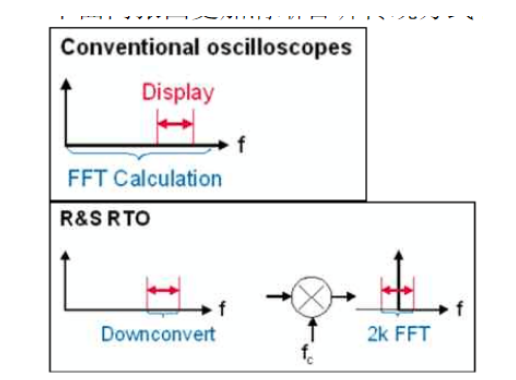













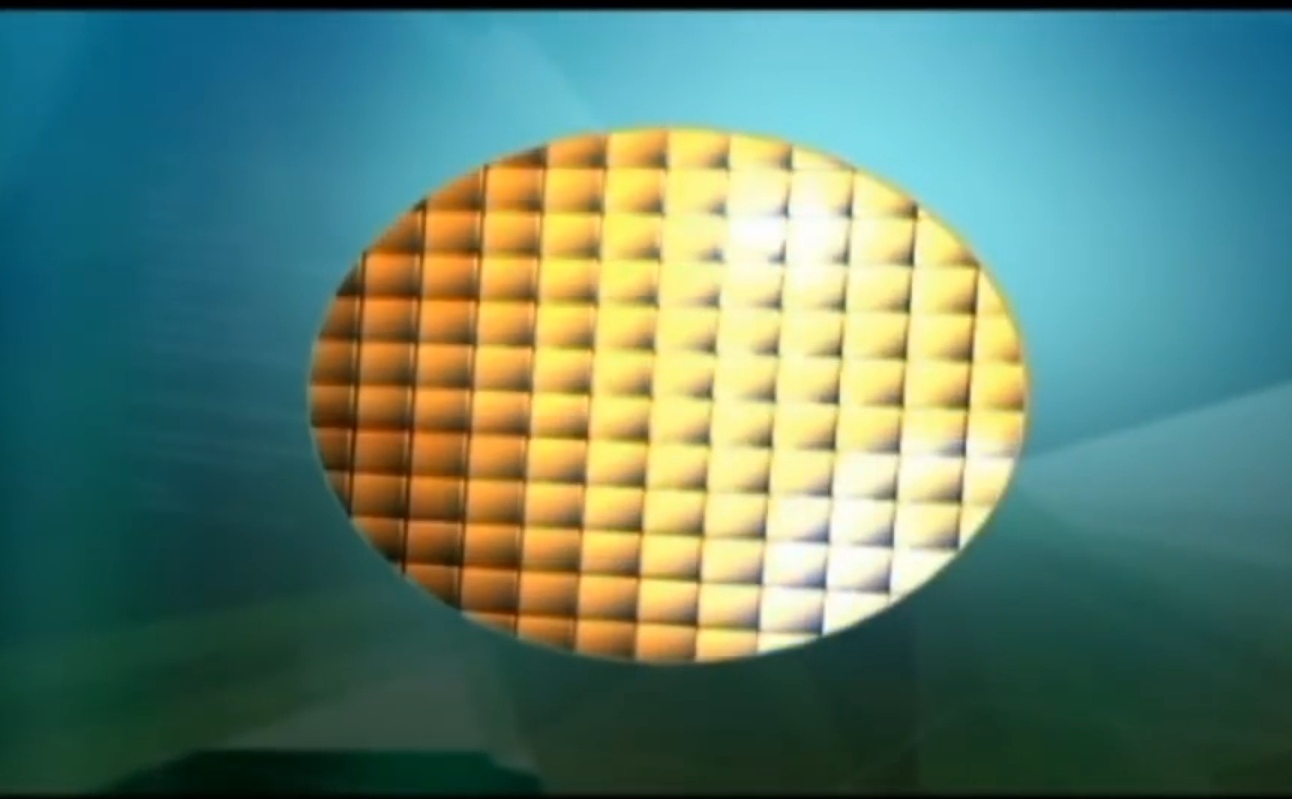
























評論