基本功率集成電路工藝詳解
2022-11-29 10:22:22 610
610 本文來自“集成芯片與芯粒技術白皮書”,本文重點介紹了發展集成芯片和芯粒的重要意義。
2023-12-05 10:18:56 831
831 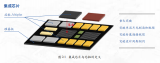
`什么是芯片反向設計?反向設計其實就是芯片反向設計,它是通過對芯片內部電路的提取與分析、整理,實現對芯片技術原理、設計思路、工藝制造、結構機制等方面的深入洞悉,可用來驗證設計框架或者分析信息流在技術上
2018-09-14 18:26:19
個10 _F鉭電容,該電容可以遠離電源引腳放置。一般而言,其它精密集成電路可以共享該鉭電容。
總結:
AD8475使用起來非常方便,只要注意了上面幾種,基本上能夠得到準確的輸出。實測8475的輸出
2023-12-22 08:12:29
1、2、3、ARM嵌入式開發之ARM指令與ARM匯編入門4、ARM嵌入式開發之ARM匯編高級教程與APCS規范詳解視頻下載地址:內容:01_ARM嵌入式開發之ARM基礎概念介紹...
2021-12-23 06:45:18
DC/DC開關電源中接地反彈的詳解
2021-01-28 06:17:31
Logic), 就是FPGA部分。 1.1 PS和PL互聯技術 ZYNQ作為將高性能ARM Cortex-A53系列處理器與高性能FPGA在單芯片內緊密結合的產品,為了實現ARM處理器和FPGA
2021-01-07 17:11:26
OCPack技術方案總結
2020-11-05 06:31:41
(Timer)、USB、A/D轉換、UART、PLC、DMA等周邊接口,甚至LCD驅動電路都整合在單一芯片上,形成芯片級的計算機,為不同的應用場合做不同組合控制。諸如手機、PC外圍、遙控器,至汽車電子、工業上的步進馬達、機器手臂的控制等,都可見到MCU的身影。
2020-10-23 12:29:10
對于電子工程師而言,接地技術在日常工作中是不可缺少的。但是,究竟有沒有一種通用的接地方法可以參考呢?答案很明確,沒有。任何學習的過程都沒有捷徑,只有耐心的他是學習才是最后的路徑。接地方式←接地目的
2020-11-02 08:19:26
來源:nick_5541電源產品在做驗證時,經常會遭遇到電磁干擾(EMI)的問題,有時處理起來需花費非常多的時間,許多工程師在對策電磁干擾時也是經驗重于理論,知道哪個頻段要對策那些組件,但對于理論上
2020-10-22 13:44:56
文/Boone來源:中關村在線,智慧產品圈等中興事件引起了全球的轟動,大家的目光聚集在服務器、計算機、存儲底層芯片技術缺乏之上。紫光等國產芯片供應商股票應聲上漲。此次事件...
2021-07-26 06:41:06
標準封裝件,形成一個系統或者子系統。從架構上來講SiP是將多種功能芯片,包括處理器、存儲器等功能芯片集成在一個封裝內,從而實現一個基本完整的功能。與SOC(片上系統)相對應。不同的是系統級封裝是采用
2017-09-18 11:34:51
,隨著技術的發展,將一整個系統做在一個芯片上的技術也已經出現多年——SoC技術)(2)模塊級在整個系統中分為很多功能模塊各司其職。有的管理電源,有的負責通信,有的負責顯示,有的負責發聲,有的負責統領全局
2019-04-13 08:00:00
芯片由集成電路經過設計、制造、封裝等一系列操作后形成,一般來說,集成電路更著重電路的設計和布局布線,而芯片更看重電路的集成、生產和封裝這三大環節。但在日常生活中,“集成電路”和“芯片”兩者常被當作
2021-07-29 08:19:21
MCU為什么不集成晶振呢?芯片外圍電路不集成進入芯片內部的原因是什么?
2021-10-25 08:47:43
中小規模集成電路(IC)均采用這種封裝形式,其引腳數一般不超過100個。采用DIP封裝的CPU芯片有兩排引腳,需要插入到具有DIP結構的芯片插座上。當然,也可以直接插在有相同焊孔數和幾何排列的電路板
2018-11-23 16:59:52
;?引腳數。引腳數越多,越高級,但是工藝難度也相應增加;其中,CSP由于采用了FlipChip技術和裸片封裝,達到了 芯片面積/封裝面積=1:1,為目前最高級的技術;芯片封裝測試流程詳解ppt[hide]暫時不能上傳附件 等下補上[/hide]
2012-01-13 11:46:32
;磚瓦"還很貴.一般來說,"芯片"成本最能影響整機的成本。 微電子技術涉及的行業很多,包括化工、光電技術、半導體材料、精密設備制造、軟件等,其中又以集成電路技術為核心,包括
2013-06-26 16:38:00
。集成電路技術包括芯片制造技術與設計技術,主要體現在加工設備,加工工藝,封裝測試,批量生產及設計創新的能力上。四、芯片和集成電路有什么區別?要表達的側重點不同。芯片就是芯片,一般是指你肉眼能夠看到的長滿
2020-02-18 13:23:44
``電磁兼容設計通常要運用各項控制技術,一般來說,越接近EMI源,實現EM控制所需的成本就越小。PCB上的集成電路芯片是EMI最主要的能量來源,因此,如果能夠深入了解集成電路芯片的內部特征,可以簡化
2017-12-28 10:42:16
詳解面向TDD系統手機的SAW濾波器的技術動向
2021-05-10 06:18:34
(systemonchip,SOC)。片上系統就是將整個系統集成到單一半導體芯片上。更確切地說,片上系統是指綜合數字和模擬技術,并將I/O、各種轉換器件、存儲器和MPU集成在同一封裝內,能夠高效實現特定功能的IC。片上
2019-02-26 09:51:21
請問哪位大神知道這種集成芯片,上面的印字寫的是USObB,封裝是SC70(DCK),請問這種集成芯片的具體型號是什么?謝謝
2016-01-26 14:08:52
集成芯片是如何實現便捷無線應用的?
2021-05-27 06:43:31
CMOS設計人員多年來一直把各種功能集成到大型集成電路中。在通信終端中,到目前一直有兩個RF元器件沒有集成,即濾波器和RF功放器,這兩種器件采用的構建技術都不兼容芯片上CMOS集成。在傳統上,濾波器
2019-06-26 08:17:57
,薄膜IPD集成無源元件,可因不同的產品應用,制作在不同的基板上,基板可選擇硅晶片.氧化鋁陶瓷基板.玻璃基板.薄膜IPD集成無源元件技術可以集成薄膜電阻.電容和電感于一體,其制程技術開發,包括:微影
2018-09-11 16:12:05
《集成電路芯片封裝技術》是一本通用的集成電路芯片封裝技術通用教材,全書共分13章,內容包括:集成電路芯片封裝概述、封裝工藝流程、厚膜與薄膜技術、焊接材料、印制電路板、元件與電路板的連接、封膠材料
2012-01-13 13:59:52
和其他LSI集成電路都起著重要的作用。新一代CPU的出現常常伴隨著新的封裝形式的使用。芯片的封裝技術已經歷了好幾代的變遷,從DIP、QFP、PGA、BGA到CSP再到MCM,技術指標一代比一代先進,包括
2018-08-28 11:58:30
集成電路芯片封裝技術知識詳解本電子書對封裝介紹的非常詳細,所以和大家分享。因為太大,沒有上傳。請點擊下載。[此貼子已經被作者于2008-5-12 22:45:41編輯過]
2008-05-12 22:44:28
,集成電路也可以稱為微芯片,基本上是由硅等半導體材料制成的小芯片上的一些分立電路的集合集成電路它是一種電路,其中所有分立元件(如無源元件和有源元件)都在單晶芯片上制造第一個半導體芯片各裝有兩個晶體管
2022-03-31 10:46:06
碼邏輯電路,兩者都是植在同一塊硅片上。生物科技:人類基因圖譜計劃的目的是對人體內的脫氧核糖核酸(DNA)中約80000個基因進行譯碼;其中主要利用生物芯片(用集成電路技術制造,并植有特定DNA排序的芯片)來
2009-08-20 17:58:52
DIP封裝(Dual In-line Package),也叫雙列直插式封裝技術,指采用雙列直插形式封裝的集成電路芯片,絕大多數中小規模集成電路均采用這種封裝形式,其引腳數一般不超過100。DIP封裝
2018-08-23 09:33:08
內部世界與外部電路的橋梁——芯片上的接點用導線連接到封裝外殼的引腳上,這些引腳又通過印刷電路板上的導線與其他器件建立連接。因此,對于很多集成電路產品而言,封裝技術都是非常關鍵的一環。 目前采用
2018-08-29 10:20:46
硬件設計:電源設計--DC/DC工作原理及芯片詳解參考資料:DC/DC降壓電源芯片內部設計原理和結構MP2315(DC/DC電源芯片)解讀DC/DC電源詳解第一次寫博客,不喜勿噴,謝謝!!! DC
2021-11-11 08:49:58
清晰度或者解決各種各樣的音視頻問題。電子發燒友特意舉辦了這次音視頻技術博客大賽,給大家提供一個分享的平臺。所有涉及音視頻技術的博文,都可以在這里投稿,謝謝參與。本活動旨在建立一個技術交流平臺,鼓勵廣大
2013-11-12 19:50:40
,分享你的設計感悟、設計實例以及設計技巧。月月有禮品,季季有驚喜,希望藉由原創博客大賽的平臺揚起您遠航的風帆,成為受網友追捧的電子設計達人。本活動旨在建立一個技術交流平臺,鼓勵廣大參賽者發揮創造、創新
2013-10-22 00:10:25
FAT32文件系統詳解
2016-08-17 12:34:56
HD無線電的數據與音頻處理技術詳解,不看肯定后悔
2021-05-28 07:08:32
新手學著學長們發個帖子,希望大家支持!LM324芯片詳解!
2013-03-23 15:49:06
使用框圖進行更抽象的建模。在該層次上,可以非常方便地將每個元件的物理特性放置在一邊,而僅使用傳遞函數來描述系統。這種MEMS模型將更有利于控制理論技術,這是最高性能設計的一套重要工具。 設計集成 盡管
2018-11-07 11:00:01
NE555中文資料詳解
2012-08-20 13:49:07
NE555中文資料詳解
2012-08-21 09:27:19
NE555中文資料詳解
2012-11-23 22:08:18
;quot;Verdana">集成電路封裝不僅起到集成電路芯片內鍵合點與外部進行電氣連接的作用,也為集成電路芯片提供了一個穩定可靠的工作環境,對集成電路芯片起到機械的作用
2009-11-30 17:16:42
,敘述了它們的基本工作原理,并分析了它們各自的優缺點。采樣控制理論中有一個重要結論:沖量相等而形狀不同的窄脈沖加在具有慣性的環節上時,其效果基本相同。PWM控制技術就是以該結論為理論基礎,對半導體開關
2010-01-10 12:14:06
隨著半導體制造能力允許在單塊芯片上集成數千門邏輯電路,系統級芯片(SoC)開始占據未來IC技術的中心。不過,當今天人們在談論SoC時,他們實際談論的只是部分系統——僅是把數字基帶與數據轉換器、一
2019-07-05 08:04:37
背景知識一、stm32的內存映射參考博文:STM32 IAP 在線升級詳解操作前我們先來說一下內存映射:下圖在stm32f100芯片手冊的29頁,我們只截取關鍵部分注意: 根據啟動方式不同,地址空間
2022-02-21 06:10:13
下載用uCOS-II在STM32上的移植詳解.pdf (1.64 MB )
2020-05-26 02:13:52
《ARM Cortex-M3應用開發實例詳解》作 者:劉波文 編著 內容簡介 劉波文編著的《ARM Cortex-M3應用開發實例詳解》針對市場上新型熱門的ARM芯片SAM3U Cortex-M3
2014-03-13 11:06:45
隨著市場對芯片集成度要求的提高,I/O引腳數急劇增加,功耗也隨之增大,對集成電路封裝更加嚴格。為了滿足發展的需要,BGA封裝開始被應用于生產。BGA也叫球狀引腳柵格陣列封裝技術,它是一種高密度表面
2018-09-18 13:23:59
MEMS陀螺儀;或者生物芯片如DNA芯片。在通訊與信息技術中,當把范圍局限到硅集成電路時,芯片和集成電路的交集就是在“硅晶片上的電路”上。芯片組,則是一系列相互關聯的芯片組合,它們相互依賴,組合在一起能
2018-07-09 16:59:31
集成無源元件技術可以集成多種電子功能,具有小型化和提高系統性能的優勢,以取代體積龐大的分立無源元件。文章主要介紹了什么是集成無源元件?集成無源元件對PCB技術發展產生了什么影響?
2019-08-02 07:04:23
微波集成電路技術是無線系統小型化的關鍵技術.在毫米波集成電路中,高性能且設計緊湊的功率放大器芯片電路是市場迫切需求的產品.
2019-09-11 11:52:04
從技術發展來看,計算機電話集成技術大致經歷了兩個階段:一是單個專用業務的計算技術整合階段——即所有的應用業務都基于PBX接口開發; 二是以標準為基礎,形成一個統一的公共平臺和一系列開發工具的階段
2019-09-10 10:42:17
全球芯片上以光速的協調新興的互聯技術用于G尺度集成ieee電腦設計與測試 2010.9 2020-1-7lpda的通訊媒體為電磁波,其能力畢竟有限,隨著互聯網的發展,和光學理論的應用,取長補短,則優
2021-01-07 10:05:15
就是集成電路的載體,廣義上我們就將芯片等同于了集成電路。所以對于小白來說,只需要記住,當芯片、集成電路、半導體出現的時候,別慌,是同一碼事兒。半導體芯片內部結構半導體芯片雖然個頭很小。但是內部結構
2020-11-17 09:42:00
單芯片集成額溫槍的技術參數是什么?單芯片集成額溫槍有哪些優勢?
2021-06-26 06:00:48
單片集成就是在將集成電路和光電子器件制作在同一材料上,將微電子與光電子技術的優勢相互結合,以期達到最佳性能。單片集成的光電子集成回路具有結構緊湊、器件一體化、集成度較高等特點 ,但由于光子器件
2011-11-15 10:51:27
基于BES2300系列芯片的audio音頻通路詳解引言BES2300X,BES2500X系列博文請點擊這里本文是BES2300X,BES2500X系列博文的audio音頻通路部分目前國內市場,BES
2022-02-17 06:51:17
請教各位高手一個入門問題:想保護一下線路板上的芯片(集成電路)型號規格信息,除了用砂紙砂掉還有更好的辦法嗎?什么樣的芯片值得去這樣保護?多謝多謝。
2019-12-26 15:05:51
沒有讀者認識到發生在3DIC集成中的技術進步,他們認為該技術只是疊層和引線鍵合,是一種后端封裝技術。而我們該如何去拯救3DIC集成技術?
2021-04-07 06:23:51
集成電路芯片已經很小了,然而它需要工作的話還得給它通電,那個很細的金屬絲怎么連到芯片上呢?
2021-03-18 06:12:53
請問各位大俠,有哪些關于485的集成芯片,就一個集成芯片,直接與MCU連,不用自己外加電阻,電容元器件(像MAX485)。我們有個板子上用的是AMD2587,但是老師好像不太滿意其價格,有別的嗎?廉價的?請請問各位大俠多多推薦,最好能順帶提供datasheet,非常感激!
2013-04-01 19:58:28
五個技術指標 1. 集成度(Integration Level)是以一個IC芯片所包含的元件(晶體管或門/數)來衡量,(包括有源和無源元件) 。隨著集成度的提高,使IC及使用IC的電子設備的功能增強
2018-08-24 16:30:28
智能傳感器技術-隨著半導體集成技術的發展,微處理器和存儲器不斷進步,敏感元件與信號處理電路有可能集成在同一芯片上,故智能傳感器將成為現實。智能化傳感器是一種帶微處理器的,兼有信息檢測、信息處理、信息記憶、邏輯思維與判斷功能的傳感器。以下重點探討智能傳感器的應用和發展。
2020-04-20 07:24:17
本文系統地介紹了12種簡化設計技術,這些技術解決了系統集成中的所有常見問題,有助確保在系統芯片中成功集成高性能數據轉換器。
2021-02-23 07:19:13
求一款集成芯片能夠代替下面圖中大量的PNP管(Q201到Q220),最好是8合1集成的。電路上需要40路的可控三極管,占PCB板的空間太大了,想要用集成芯片代替。作用是用來控制可控的上拉電阻的,沒有大電流的要求。
2016-08-17 15:27:38
本帖最后由 eehome 于 2013-1-5 09:46 編輯
片上系統(SOC——System-On-a-Chip)是指在單芯片上集成微電子應用產品所需的全部功能系統,其是以超深亞微米
2011-09-27 11:46:06
1928年,G.B,Crouse激早提出采用集成磁件(Integratea Magnetics,簡稱IM)濾波電路的專利申請,其中,IM是用于濾波電路中的耦合電感,其后的近40年間,磁集成技術的研究一直局限在電感與電感的集成。
2019-09-17 09:01:39
的進步及深亞微米技術和微細化縮小芯片尺寸等技術的使用,人們產生了將多個LSI芯片組裝在一個精密多層布線的外殼內形成MCM產品的想法。進一步又產生另一種想法:把多種芯片的電路集成在一個大圓片上,從而又導致
2018-09-03 09:28:18
制程、15X15mm封裝,和上一代產品比較,BCM5702WKFB芯片顯著降低了千兆以太網連接所需的器件成本、電路板空間及功耗。BroadCom57系列中的bcm5703網卡芯片被廣泛集成到服務器主板上,如聯想
2008-10-19 13:28:29
給大家學習用藍牙技術詳解(中文版).pdf (8.33 MB )
2019-06-09 15:55:39
藍牙芯片技術原理詳解
2021-01-14 07:25:56
藍牙模塊技術指標詳解
2012-08-20 09:49:39
請問ADI的RF芯片里面有沒有集成了AD的收發一體芯片,工作頻率大概在2.4GHz到2.8GHz之間,最近要做一個東西,時間比較急! 以前沒有考慮過這方面的芯片,不知道有沒有這方面的芯片。 希望ADI的技術大N們盡快給我回復!!
2019-03-08 11:23:22
資源分享:藍牙技術詳解(中文版)
2019-03-28 22:50:37
想自己的修音響,發現一個主板上的集成芯片燒壞了,卻不知道那個芯片是什么來的。不知道音響中的集成芯片有什么功能或者有什么型號。
2012-10-24 11:35:32
集成電路封裝技術詳解包括了概述,陶瓷封裝,塑料封裝,金屬封裝,其它封裝等。
2008-05-12 22:41:56 702
702 迪文T5L平臺COB結構智能屏是基于迪文自主研發的高性價比雙核T5L系列芯片,將整個智能屏核心電路放到PCB板子上,集成整合觸摸屏(電阻觸摸和電容觸摸
2022-06-15 13:49:45
北橋芯片詳解
北橋芯片(North Bridge)是主板芯片組中起主導作用的最重要的組成部分,也稱
2009-04-26 17:41:28 3319
3319 南橋芯片詳解 南橋芯片(South Bridge)是主板芯片組的重要組成部分,一般位于主板上離CPU插槽較遠
2009-04-26 17:42:46 3663
3663 555芯片應用詳解,感興趣的小伙伴們可以看看。
2016-08-22 15:16:39 52
52 超級電容技術詳解
2017-01-24 16:29:19 42
42 LED 在照明領域的廣泛應用,集成封裝也將得到快速發展。 目前,實現大功率LED 照明的方法有兩種:一是對單顆大功率LED 芯片進行封裝,二是采用多芯片集成封裝。對于前者來說,隨著芯片技術的發展,尺寸增大,品質提高,可通過大電流驅動實現
2017-10-10 17:07:20 9
9 多芯片混合集成技術是實現瓦級LED的重要途徑之一。由于傳統小芯片工藝成熟,集成技術簡單,側光利用率較高(相對于大尺寸芯片),散熱效果較好(相對于傳統炮彈型LEDs),用鋁基板或金屬陶瓷基板集成的實用型LED產品已經問世。其綜合光學性能可以與Lumileds公司的相應瓦數的LED產品相比。
2019-09-19 16:34:15 779
779 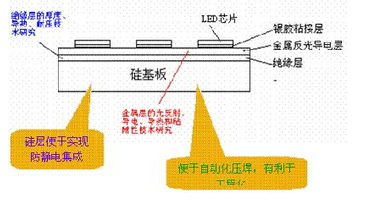
WAT技術詳解
2023-07-17 11:40:44 638
638 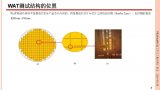
集成芯片的原理圖詳解涉及多個方面,包括芯片的結構、功能模塊、信號傳輸以及內部電路連接等。
2024-03-19 16:36:59 148
148 光電集成芯片技術是一項引領未來科技發展的重要技術,它結合了光學和電子學的優勢,具有高性能、高可靠性和小型化等特點。
2024-03-20 16:02:37 128
128 集成芯片的制造運用了多種技術,這些技術相互關聯、相互支持,共同構成了集成芯片制造的完整過程。
2024-03-21 15:48:33 123
123 集成芯片,也稱為集成電路(Integrated Circuit,簡稱IC),是一種將大量的電子元器件(如晶體管、電阻、電容、二極管等)集成在一個小型的半導體材料片(通常是硅)上的技術。集成電路技術是現代電子工程的基礎,它極大地推動了電子設備的發展,使得電子設備更小、更快、更便宜、更可靠。
2024-03-22 17:01:24 180
180 光子集成芯片和光子集成技術是光子學領域的重要概念,它們代表了光子在集成電路領域的應用和發展。
2024-03-25 14:17:47 125
125 光子集成芯片和光子集成技術雖然緊密相關,但它們在定義和應用上存在一些區別。
2024-03-25 14:45:05 124
124
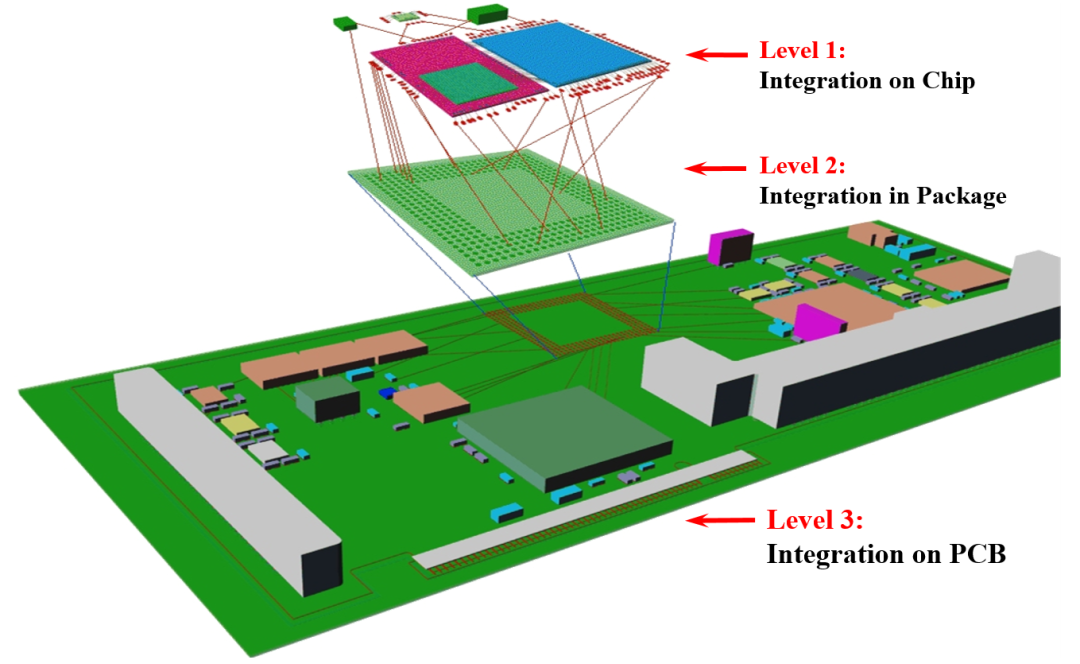

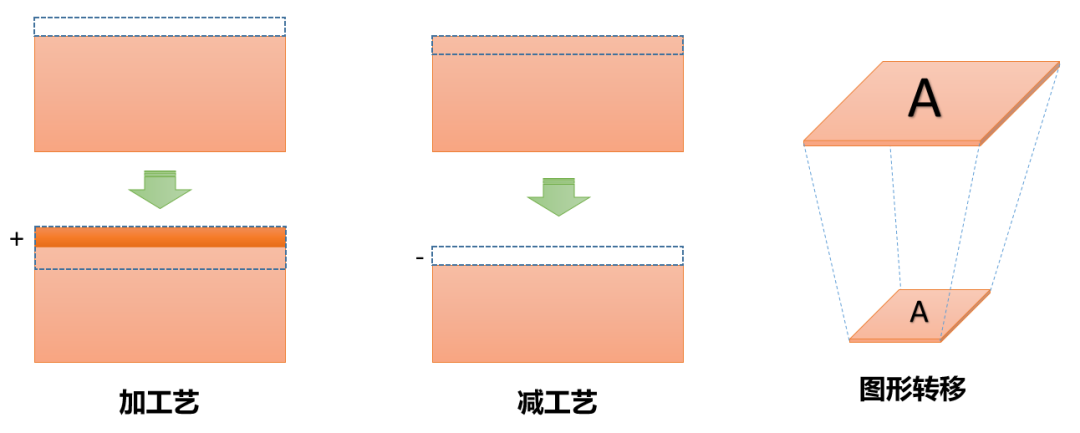
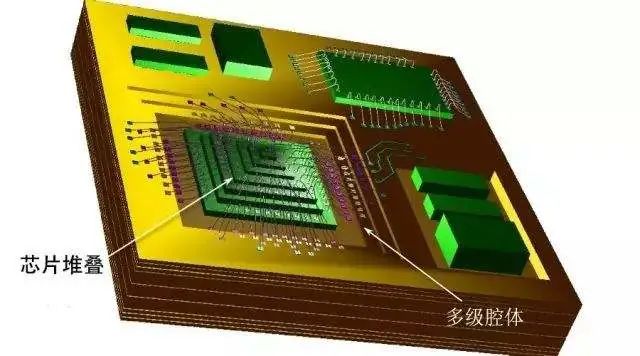


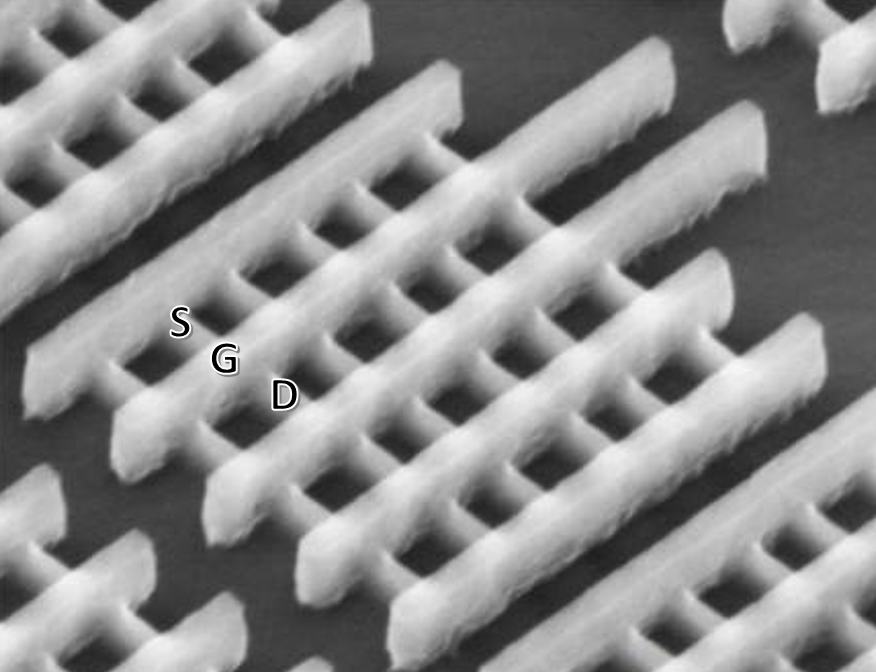
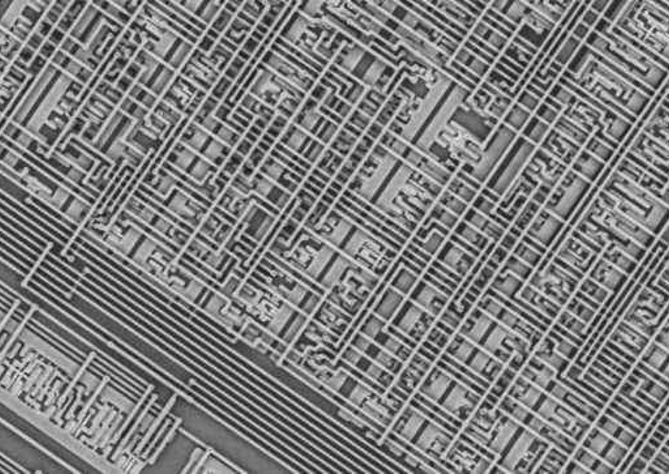
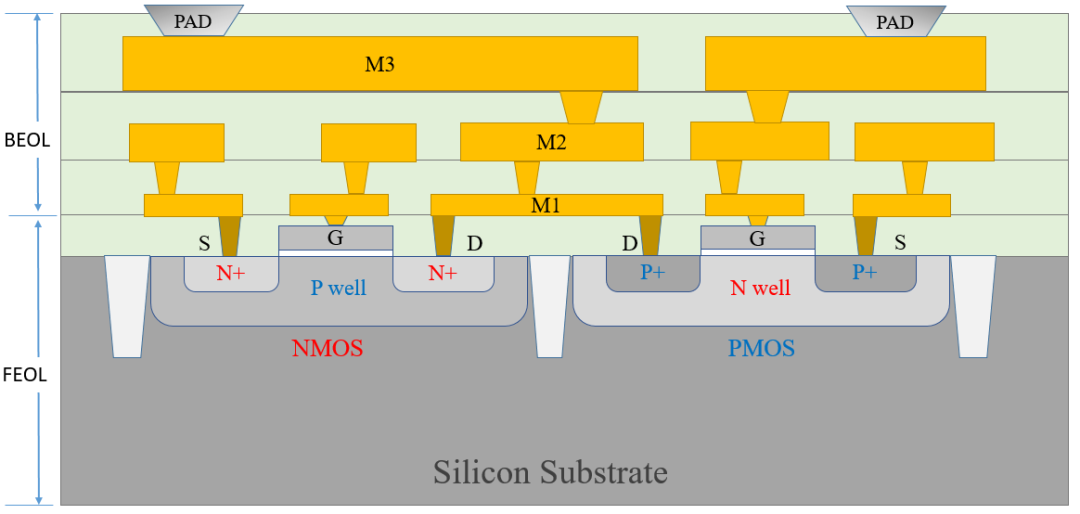
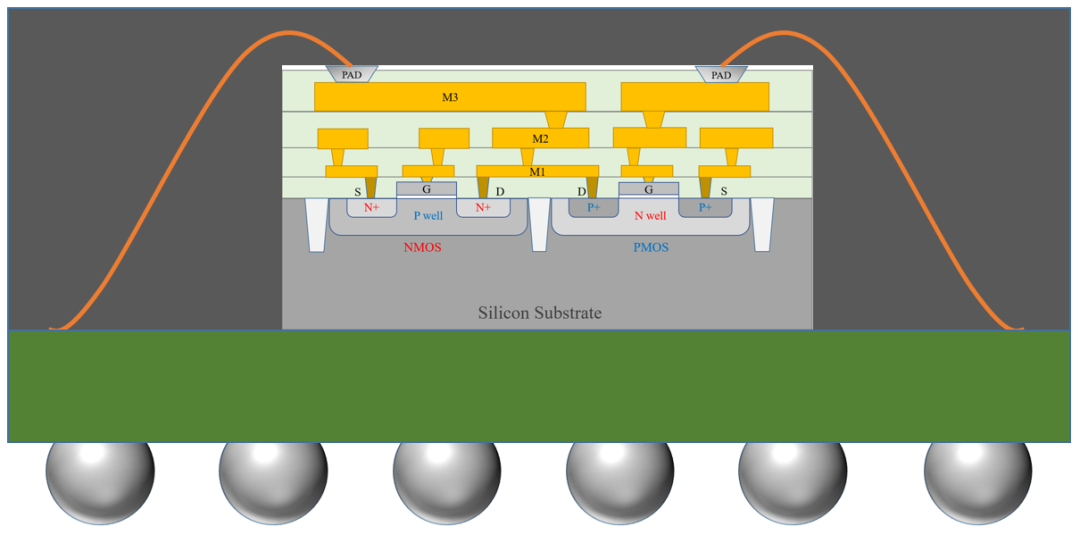
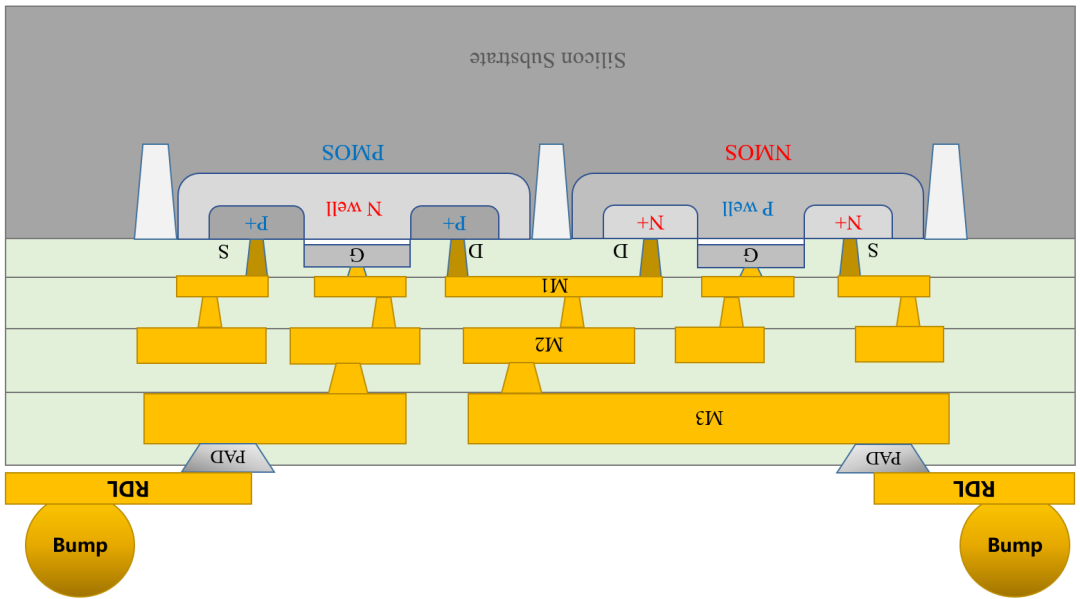
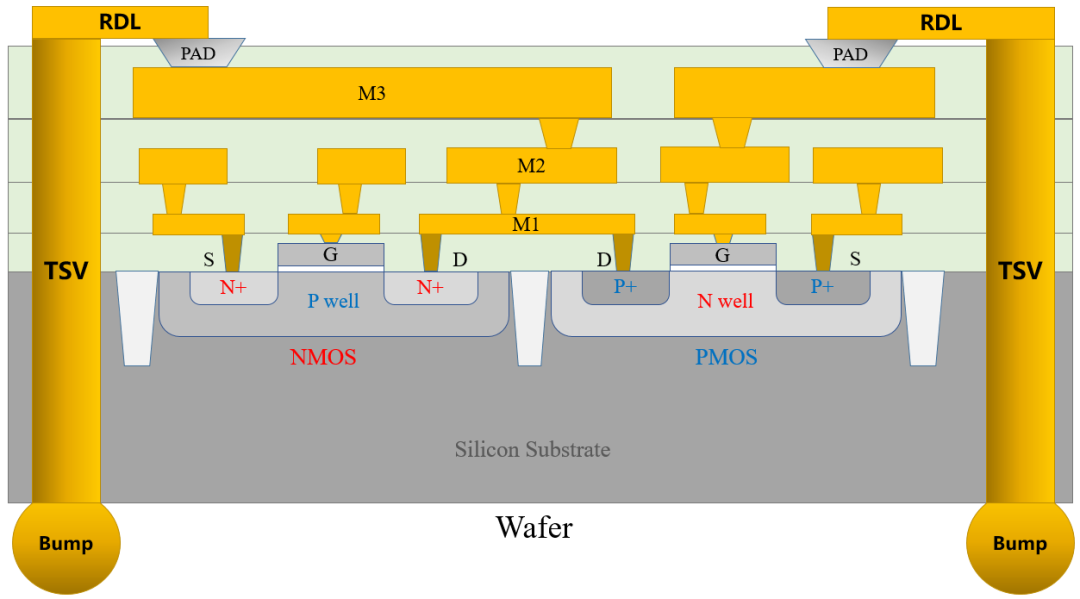
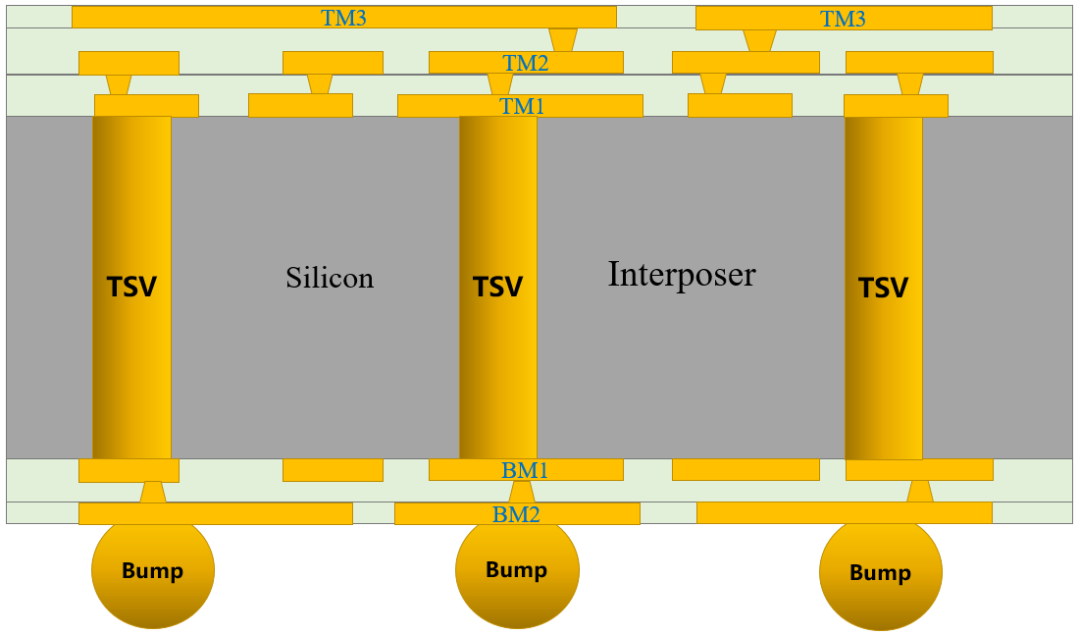
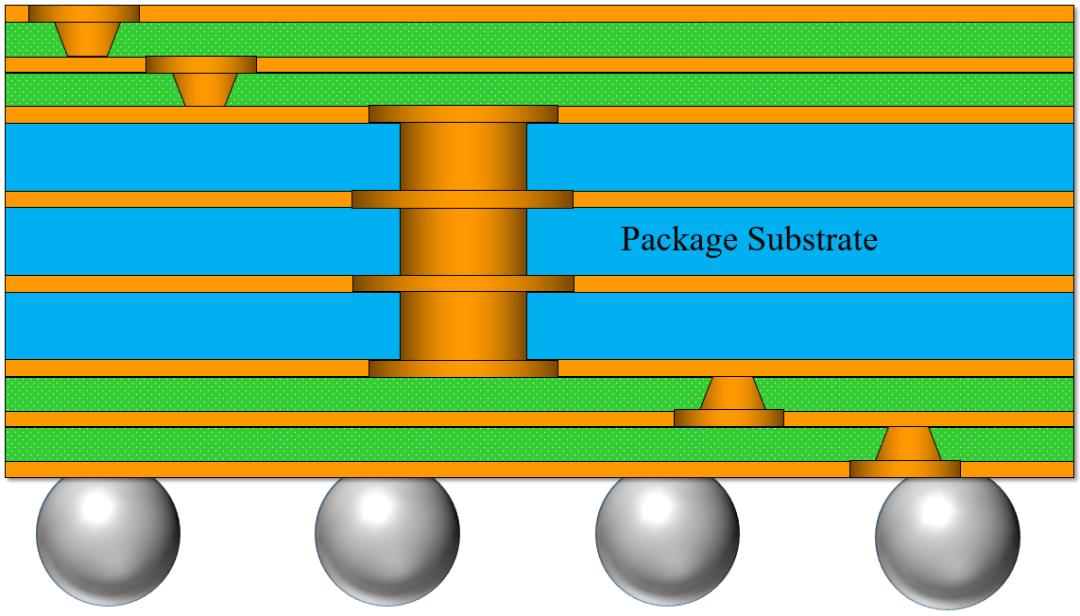
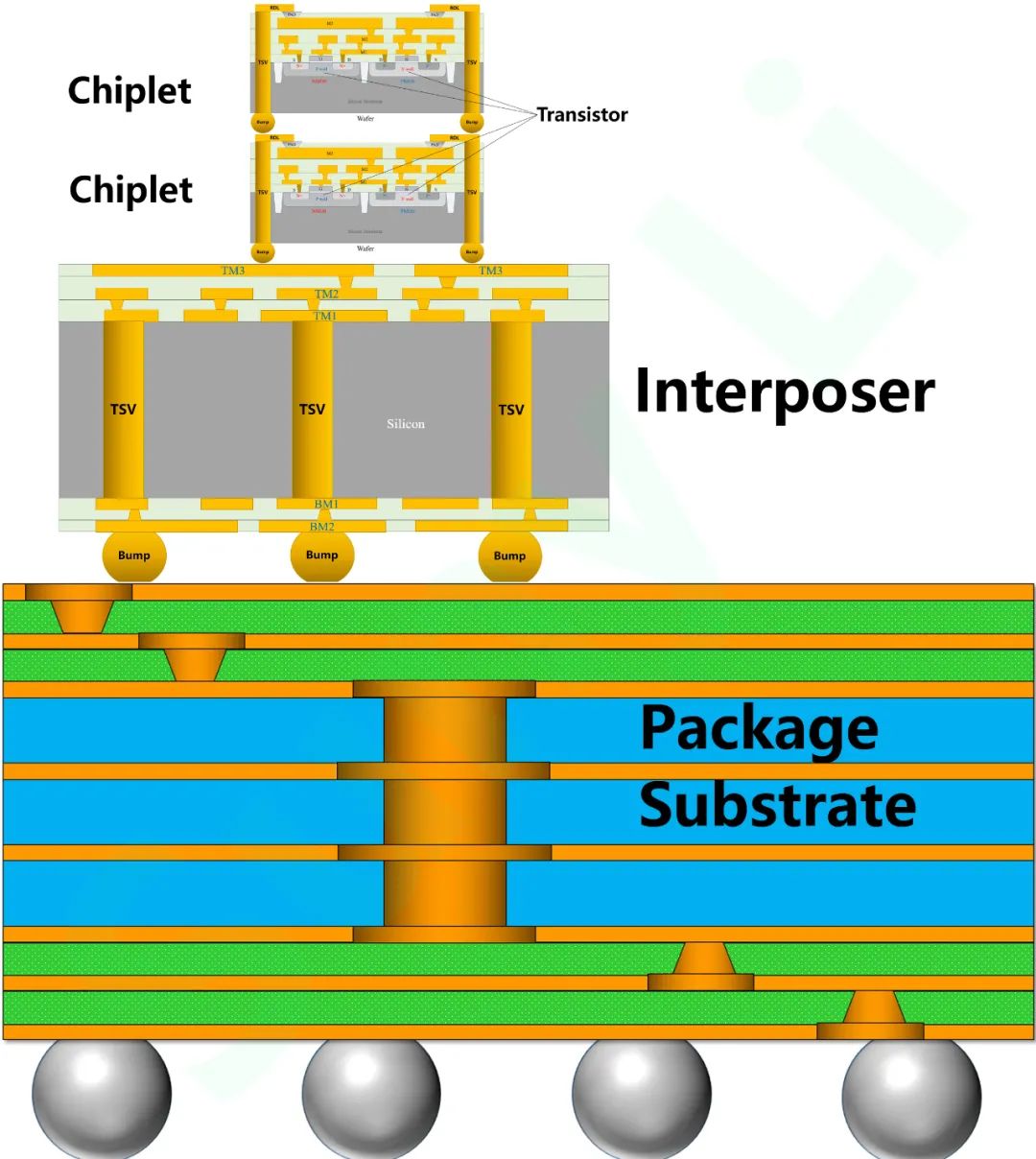
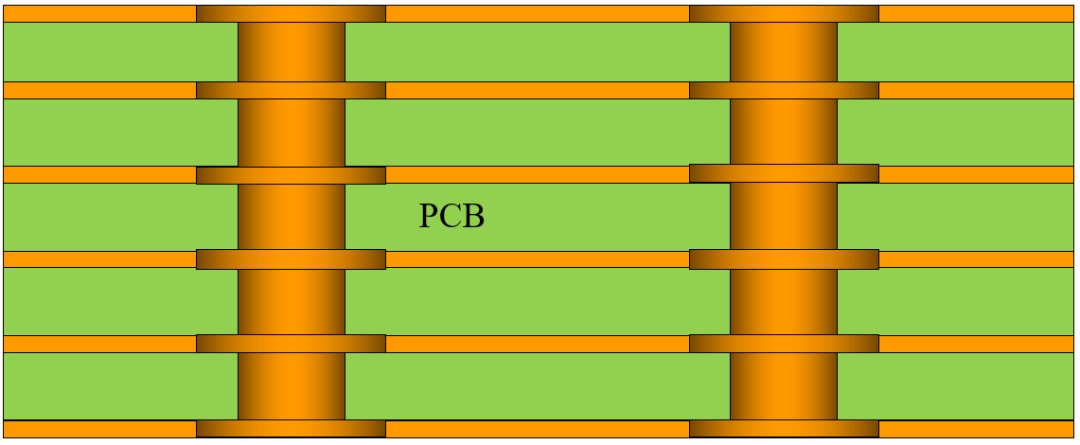
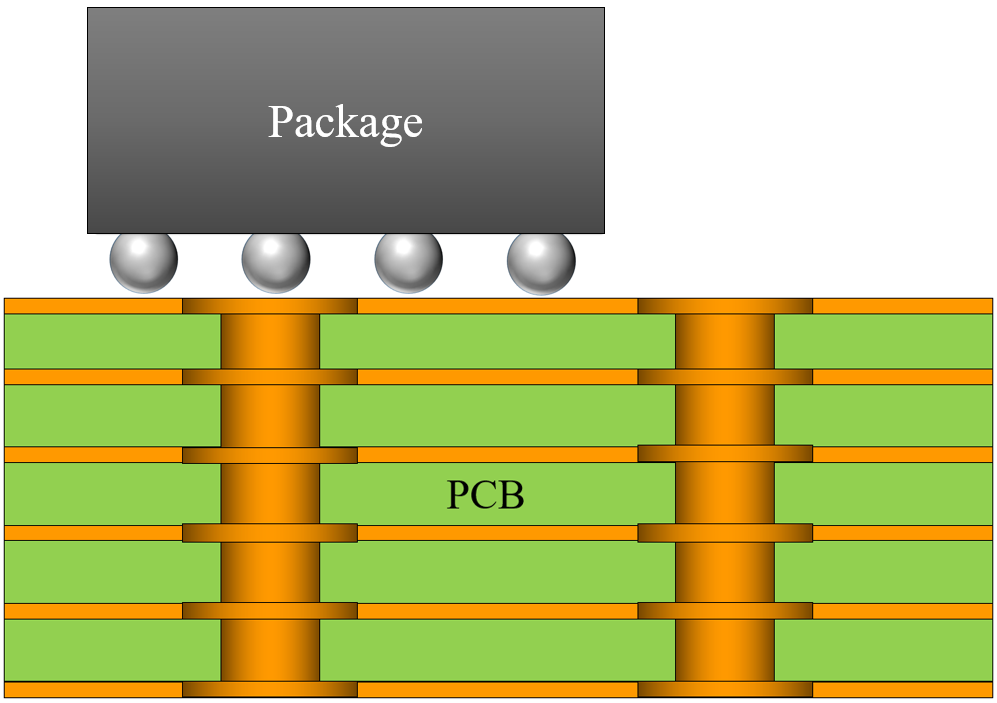
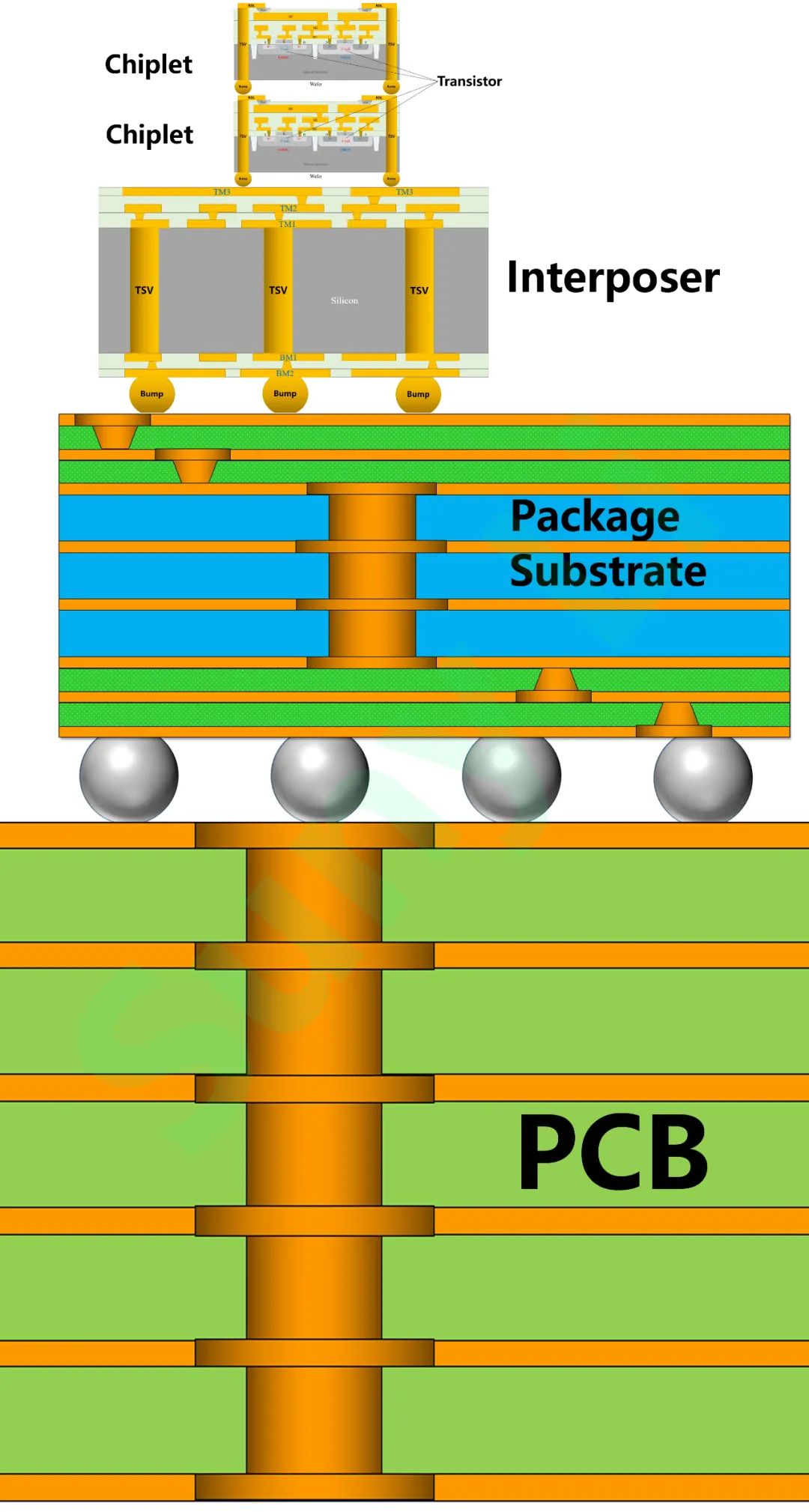
 電子發燒友App
電子發燒友App









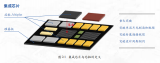



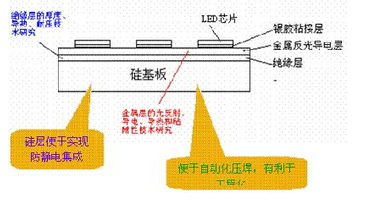
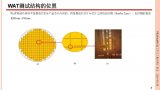










評論