在Intel的六大技術支柱中,封裝技術和制程工藝并列,是基礎中的基礎,這兩年Intel也不斷展示自己的各種先進封裝技術,包括Foveros、Co-EMIB、ODI、MDIO等等。
今天,Intel又宣布了全新的“混合結合”(Hybrid Bonding),可取代當今大多數(shù)封裝技術中使用的“熱壓結合”(thermocompression bonding)。

據(jù)介紹,混合結合技術能夠加速實現(xiàn)10微米及以下的凸點間距(Pitch),提供更高的互連密度、更小更簡單的電路、更大的帶寬、更低的電容、更低的功耗(每比特不到0.05皮焦耳)。
Intel目前的3D Foveros立體封裝技術,可以實現(xiàn)50微米左右的凸點間距,每平方毫米集成大約400個凸點,而應用新的混合結合技術,不但凸點間距能縮小到1/5,每平方毫米的凸點數(shù)量也能超過1萬,增加足足25倍。
采用混合結合封裝技術的測試芯片已在2020年第二季度流片,但是Intel沒有披露未來會在什么產(chǎn)品上商用。
-
芯片
+關注
關注
459文章
52464瀏覽量
440135 -
英特爾
+關注
關注
61文章
10192瀏覽量
174577 -
封裝
+關注
關注
128文章
8651瀏覽量
145364
發(fā)布評論請先 登錄
英特爾宣布工程技術領導層重要任命,加速CEO陳立武轉型布局
英特爾先進封裝,新突破
英特爾持續(xù)推進核心制程和先進封裝技術創(chuàng)新,分享最新進展

英特爾代工:明確重點廣合作,服務客戶鑄信任
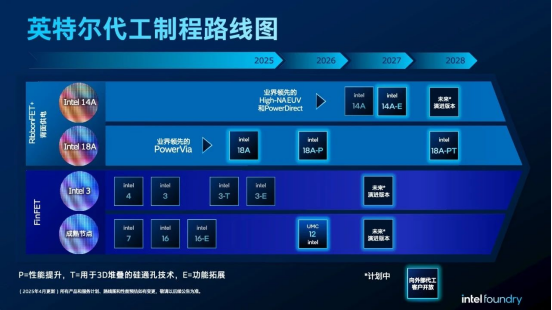
英特爾宣布裁員20% 或2萬人失業(yè)
英特爾發(fā)布全新企業(yè)AI一體化方案
英特爾CEO Gelsinger宣布退休
英特爾宣布擴容成都封裝測試基地
英特爾擴容成都封裝測試基地
英特爾擴容在成都的封裝測試基地
英特爾至強品牌新戰(zhàn)略發(fā)布
淺談英特爾在先進封裝領域的探索
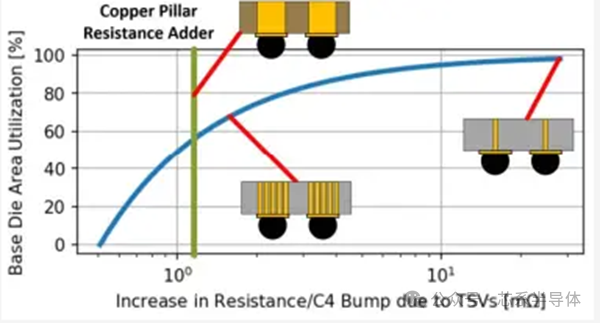





 英特爾宣布混合結合封裝技術,可替代“熱壓結合”
英特爾宣布混合結合封裝技術,可替代“熱壓結合”












評論