在現今的移動電子設備市場中,產品一直朝更薄、更細及更高性能的方向邁進。尤有甚之,這股潮流也逐漸吹向產品內的半導體元件。因此,扇出型晶圓級封裝已逐漸成為最優化的晶圓級封裝技術,務求在更細及更緊湊的封裝元件中,提供更多I/O連接口,同時達至最佳的電熱性能。
在采用扇出型晶圓級封裝技術時,需要采用精準度極高的貼裝平臺,確保能精準貼裝不同形狀的元件,不同類型的芯片及不同尺寸的無源器件,達至最高的生產效益。
傳統的半導體貼裝解決方案,只局限于貼裝一定尺寸的晶圓,未能成為最具成本效益的生產方案。
在環球儀器的先進封裝方案,所采用的FuzionSC半導體貼片機,不受元件尺寸限制,可以在極高速的表面貼裝生產線中,處理面積極大的基板,維持極高的精準度,同時可以貼裝任何類型及形狀的元件。
FuzionSC半導體貼片機,不受晶圓大小所限,能在大至625 X 813毫米的基板上操作
FuzionSC半導體貼片機的優勢
支持最大達625毫米 x813毫米的基板,依然保持極高的精準度(±10μm)
最高精度(±10微米)、最高速度(10K cph)
在同一個平臺上,能精準貼裝不同尺寸的有源芯片及無源芯片
支持由AOI精度返饋進行貼裝位置補償
軟件支持大量芯片的組裝
精準的物料處理及熱度階段選項
可采用SECS-GEM系統追蹤晶片
可以支持任何一種送料器:晶圓級式、盤式、帶式、管式、大批量連續接合式、直接拾取盤式
可以在任何基板上貼裝,包括薄膜、柔板及大板
FuzionSC半導體貼片機因配備以下工具,能在大面積范圍進行扇出型晶圓級封裝。
精準及靈活的FZ7貼裝頭
精準的精度(10微米@ Cpk>1)
0201至150平方毫米(多重視像),最高達25毫米
高速的IC及芯片貼裝,群組拾取最多達7個元件
快速及精準的PEC下視相機
高分辨率(.27MPP)
可編程的燈光、波長照明、交叉極性光源
標準/可調校的基準點及焊盤辨識
高分辨率的Magellan上視相機
支持所有倒裝芯片
高分辨率達1024 x 1024,可確保辨識微細特征
高精度升降平臺和治具
可處理基板、載具/托盤、厚度由0.10毫米至12.0毫米
內置真空發生器
精準記錄基板的x、y及z軸
支持倒裝芯片、裸晶片及表面貼裝的多種送料器
晶圓級送料器、盤式、卷帶盤式、管式及散裝式
最多可安裝4個直接晶圓送料器,晶圓尺寸最大為300毫米
支持固定及自動堆疊矩陣盤式送料器
為微小無源元件設計的標準和雙軌卷帶盤式送料器
可處理任何基板
厚、薄、窄及大型組裝面積
基板、晶圓、引線框架、陶瓷、玻璃、柔板及多層板
最大基板至625毫米x 813毫米
| 貼裝速度(cph) | 30,750 (最高) / 21,750 (1-板IPC 芯片) |
| 精度(um@>1.00 Cpk) | ±10 (陣列元件/倒裝芯片) / ±38 (無源元件/芯片) |
| 電路板最大尺寸 | 625 x 813毫米,可配備更大板特殊功能 |
| 最多送料站位(8毫米) | 120 (2 ULC) |
| 送料器類型 | 晶圓級(最大至300毫米),盤式、卷帶盤式、管式及散裝式 |
| 元件尺寸范圍(毫米) | (0201) .25 x .5 x .15 (最少)至150 平方毫米 (多重視像),最高25毫米 |
| 最少錫球尺寸及錫球間距 (微米) | 錫球尺寸:20,錫球間距:40 |
END
原文標題:能在625 X 813毫米的基板上進行扇出型晶圓級封裝的設備,就是FuzionSC。
文章出處:【微信公眾號:環儀精密設備制造上海】歡迎添加關注!文章轉載請注明出處。
-
半導體
+關注
關注
335文章
28829瀏覽量
236262 -
晶圓
+關注
關注
53文章
5140瀏覽量
129622
原文標題:能在625 X 813毫米的基板上進行扇出型晶圓級封裝的設備,就是FuzionSC。
文章出處:【微信號:UIC_Asia,微信公眾號:環儀精密設備制造上海】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
選購高精度貼片機必看!5大核心關注點與避坑指南

半導體貼裝工藝大揭秘:精度與效率的雙重飛躍

SMT貼片機故障處理:提升生產效率的關鍵
從研發到應用:國產高速高精度貼片機的全面發展之路
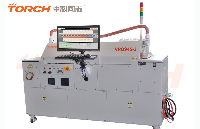
環球儀器FuzionSC半導體貼片機的優勢
環球儀器聯同母公司臺達攜全方位半導體解決方案亮相SEMICON 臺灣 2024展






 FuzionSC半導體貼片機可以貼裝任何類型的元件
FuzionSC半導體貼片機可以貼裝任何類型的元件
















評論