對于非立方晶系的晶體,本身具有各向異性——不同的方向具有不同的性能。
4H-SiC和6H-SiC的空間群都是P63mc,點群是6mm,都屬于六方晶系,具有各向異性。
3C-SiC的空間群是F-43m,點群是-43m,屬于立方晶系,不具有各向異性。
15R-SiC的空間群是R3m,點群是3m,屬于三方晶系,具有各向異性。
更進一步,6mm、3m屬于10個極性點群(1,2,3,4,6;m,3m;mm2,4mm,6mm)中的一個,所以4H-SiC、6H-SiC、15R-SiC是極性晶體。所謂極性晶體,是指一塊晶體中至少有一個方向與其相反方向具有不同的性能,可以是電性能(熱電性能、鐵電性能)、生長性能等。也就是,同一方向的正負面都會有性能的區別。 對于各向異性的表示,會直接體現在不同晶面具有不同的性質。在晶體中,不同晶面是通過晶面指數的差異來表示的。晶面指數也叫做米勒指數,為(hkl)。 具體表示方法為:建立晶體的坐標系,這個晶面與坐標軸的截距會是a、b、c,接著取截距的倒數1/a、1/b、1/c,化簡成最簡單的整數比就是(hkl)。對于三方和六方晶系的晶體,(hkl)=(hkil),i=-h-k。但是,根據晶體的對稱性,會有一系列晶面是相同的。比如說,(100)與(200)這些只是沒有化為最簡整數比。 對于各向異性的應用有很多。 不同方向的籽晶的生長性質有很大的差別。以晶面(0001)為基準,偏轉一定角度(臺階流)的晶片更易于生長碳化硅。 電學性質上也會有很大的差別。比如利用晶面(0-33-8)來制備SiC MOSFET,這是因為由于其較低的界面態密度和較高的自由電子比,使得該面在所有摻雜濃度下的溝道遷移率最高。
如圖所示,當采用10^18/cm3的摻雜濃度時,可實現60cm2V-1s-1的高溝道遷移率,以及高達4V的閾值電壓——該電壓足以抑制高溫下的誤啟動,比(0001)晶面高。
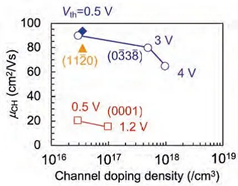
運用該性質,日本住友電氣工業有限公司為SiC MOSFET開發了一種新的結構。它具有V型溝槽,使用(0-33-8)晶面,由此具有更高遷移率的性能。
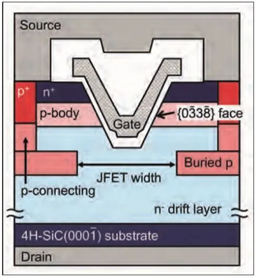
4H-SiC的(0-33-8)晶面與(0001)面成54.7度的偏角。

三方和六方晶系的晶胞參數為a、c。晶面(h1k1l1)(h2k2l2)的計算方法如下:

生產該器件的關鍵是使用化學刻蝕工藝來形成V形溝槽。使用二氧化硅作為刻蝕掩模,并在約900℃的氯氣環境中進行刻蝕。
不刻蝕的表面先氧化為二氧化硅;
氯氣與表面碳化硅產生化學反應,使其轉化為碳,然后再與氧反應生成二氧化碳;
生成的氯化硅和二氧化碳在高溫下揮發,將(0-33-8)晶面暴露出來。
注意,不能使用離子刻蝕,盡管離子刻蝕是形成U形溝槽的常規方法,但是將會導致刻蝕損傷和子溝槽的形成。

通過掃描電子顯微鏡的圖像,可以看到化學刻蝕獲得了高質量的晶面。
原文標題:材料 | 不同碳化硅晶面帶來新的可能!
文章出處:【微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
責任編輯:haq
-
晶硅
+關注
關注
1文章
52瀏覽量
22927
原文標題:材料 | 不同碳化硅晶面帶來新的可能!
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
碳化硅功率器件有哪些特點
碳化硅薄膜沉積技術介紹
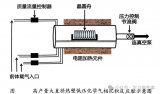
碳化硅的耐高溫性能
碳化硅在半導體中的作用
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
碳化硅在新能源領域的應用 碳化硅在汽車工業中的應用
碳化硅的應用領域 碳化硅材料的特性與優勢
碳化硅襯底,進化到12英寸!


碳化硅功率器件的工作原理和應用

碳化硅功率器件的優點和應用
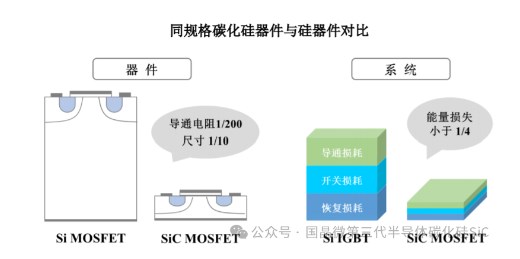
碳化硅功率器件有哪些優勢
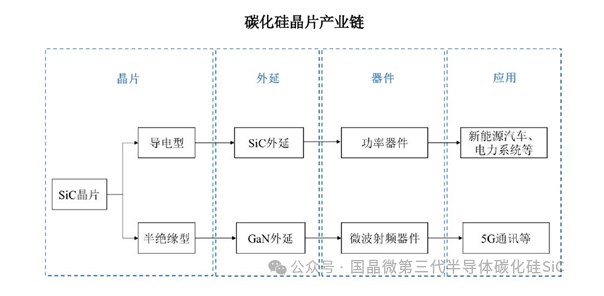
碳化硅晶圓和硅晶圓的區別是什么
碳化硅功率器件的優勢和分類
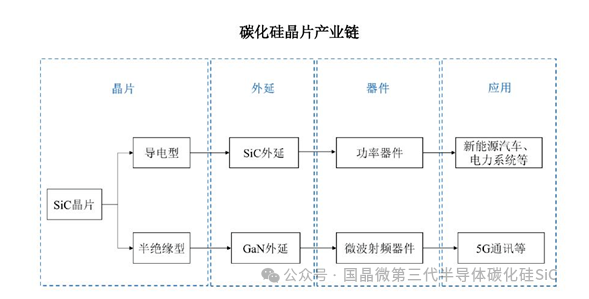





 不同碳化硅晶面帶來新的可能
不同碳化硅晶面帶來新的可能











評論