每一道工序都有它的意義。上次我們說(shuō)過(guò),IC封裝常見(jiàn)的材料有塑料、陶瓷、玻璃、金屬等,雖然它們所使用的材料不同,但它們的目的幾乎都是相同的。
第一,保護(hù):半導(dǎo)體芯片的生產(chǎn)車間都有非常嚴(yán)格的生產(chǎn)條件控制,恒定的溫度(230±3℃)、恒定的濕度(50±10%)、嚴(yán)格的空氣塵埃顆粒度控制(一般介于1K到10K)及嚴(yán)格的靜電保護(hù)措施,裸露的裝芯片只有在這種嚴(yán)格的環(huán)境控制下才不會(huì)失效。但是,我們所生活的周圍環(huán)境完全不可能具備這種條件,低溫可能會(huì)有-40℃、高溫可能會(huì)有60℃、濕度可能達(dá)到100%,如果是汽車產(chǎn)品,其工作溫度可能高達(dá)120℃以上,為了要保護(hù)芯片,所以我們需要封裝。
第二,支撐:支撐有兩個(gè)作用,一是支撐芯片,將芯片固定好便于電路的連接,二是封裝完成以后,形成一定的外形以支撐整個(gè)器件、使得整個(gè)器件不易損壞。
第三,連接:連接的作用是將芯片的電極和外界的電路連通。引腳用于和外界電路連通,金線則將引腳和芯片的電路連接起來(lái)。載片臺(tái)用于承載芯片,環(huán)氧樹脂粘合劑用于將芯片粘貼在載片臺(tái)上,引腳用于支撐整個(gè)器件,而塑封體則起到固定及保護(hù)作用。
第四,穩(wěn)定性:任何封裝都需要形成一定的穩(wěn)定性,這是整個(gè)封裝工藝中最重要的衡量指標(biāo)。原始的芯片離開特定的生存環(huán)境后就會(huì)損毀,需要封裝。芯片的工作壽命,主要決于對(duì)封裝材料和封裝工藝的選擇。
SOP系列封裝發(fā)展歷程
IC封裝的材料有多種可選,它們的封裝形式也分很多種類型,拿常見(jiàn)的SOP系列為例:包括SSOP/TSOP/TSSOP/MSOP/VSOP等。
TSOP封裝技術(shù)出現(xiàn)于上個(gè)世紀(jì)80年代,一出現(xiàn)就得到了業(yè)界的廣泛認(rèn)可,至今仍舊是主流封裝技術(shù)之一。TSOP是“Thin Small Outline Package”的縮寫,意思是薄型小尺寸封裝。其封裝體總高度不得超過(guò)1.27mm、引腳之間的節(jié)距0.5mm。TSOP封裝具有成品率高、價(jià)格便宜等優(yōu)點(diǎn),曾經(jīng)在DRAM存儲(chǔ)器的封裝方面得到了廣泛的應(yīng)用。
從本世紀(jì)初開始,國(guó)外主要的半導(dǎo)體封裝廠商都開始了疊層芯片封裝工藝的研究。
疊層芯片封裝技術(shù):簡(jiǎn)稱3D(是目前用于簡(jiǎn)稱疊層芯片封裝的最常見(jiàn)縮寫),是指在不改變封裝體的尺寸的前提下,在同一個(gè)封裝體內(nèi)于垂直方向疊放兩個(gè)或兩個(gè)以上的芯片的封裝技術(shù),它起源于快閃存儲(chǔ)器(NOR/NAND)及SDRAM的疊層封裝。疊層芯片封裝技術(shù)對(duì)于無(wú)線通訊器件、便攜器件及存儲(chǔ)卡來(lái)講是最理想的系統(tǒng)解決方案。
2005年以后,疊層芯片(3D)封裝技術(shù)開始普及。2007年,我們看到兩種全新的封裝類型,PiP(Package in Package)及PoP(Package on Package),它們就是疊層芯片(3D)封裝技術(shù)廣泛應(yīng)用的結(jié)果。這幾乎涉及到所有流行的封裝類型,如SIP、TSOP、BGA、CSP、QFP,等等。
加上近年來(lái),手機(jī)、PDA、電腦、通訊、數(shù)碼等消費(fèi)產(chǎn)品的技術(shù)發(fā)展非常快,這此行業(yè)的迅猛發(fā)展需要大容量、多功能、小尺寸、低成本的存儲(chǔ)器、DSP、ASIC、RF、MEMS等半導(dǎo)體器件,于是疊層芯片技術(shù)于近幾年得到了蓬勃發(fā)展。
TSOP疊層芯片技術(shù)研究和重要性和意義
TSOP封裝曾經(jīng)廣泛應(yīng)用于早期的動(dòng)態(tài)隨機(jī)存儲(chǔ)器(DRAM)中。由于TSOP封裝的信號(hào)傳輸長(zhǎng)度較長(zhǎng)、不利于速度提升,容積率只有TInyBGA的50%,在DDR/DDRRII內(nèi)存封裝中被TInyBGA所取代。但是,隨著NAND快閃存儲(chǔ)器的興起,它了重新煥發(fā)了生機(jī)。
疊層芯片技術(shù)是一項(xiàng)非常重要的技術(shù),它的興起帶了封裝技術(shù)的一場(chǎng)革命。因此,TSOP疊層芯片封裝技術(shù)的研究有十分深遠(yuǎn)的歷史及現(xiàn)實(shí)意義。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28732瀏覽量
234617 -
IC封裝
+關(guān)注
關(guān)注
4文章
187瀏覽量
27179 -
芯片封裝
+關(guān)注
關(guān)注
11文章
576瀏覽量
31324
發(fā)布評(píng)論請(qǐng)先 登錄
最全最詳盡的半導(dǎo)體制造技術(shù)資料,涵蓋晶圓工藝到后端封測(cè)
模數(shù)轉(zhuǎn)換電路的四個(gè)過(guò)程
半導(dǎo)體封裝的主要類型和制造方法
倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

芯片為什么要進(jìn)行封裝?
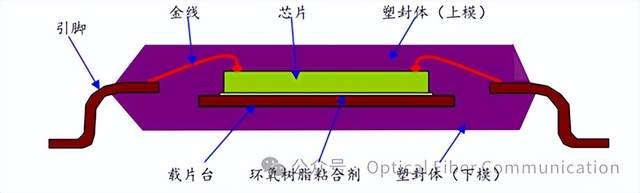
【「大話芯片制造」閱讀體驗(yàn)】+跟著本書”參觀“半導(dǎo)體工廠
想了解半導(dǎo)體芯片的設(shè)計(jì)和生產(chǎn)制造
中國(guó)半導(dǎo)體的鏡鑒之路
半導(dǎo)體封裝技術(shù)的類型和區(qū)別
led封裝和半導(dǎo)體封裝的區(qū)別
PCB與半導(dǎo)體的橋梁:封裝基板的奧秘與應(yīng)用

PCB半導(dǎo)體封裝板:半導(dǎo)體產(chǎn)業(yè)的堅(jiān)實(shí)基石
半導(dǎo)體封裝材料全解析:分類、應(yīng)用與發(fā)展趨勢(shì)!






 淺談半導(dǎo)體芯片封裝的四個(gè)目的
淺談半導(dǎo)體芯片封裝的四個(gè)目的










評(píng)論