由于具有更好的品質因數(shù),寬帶隙 (WBG) 半導體(例如氮化鎵 (GaN))提供比硅更高的功率密度,占用的芯片面積更小,因此需要更小尺寸的封裝。假設器件占用的面積是決定熱性能的主要因素,那么可以合理地假設較小的功率器件會導致較高的熱阻。本文將展示芯片級封裝 (CSP) GaN FET 如何提供至少與硅 MOSFET 相同(如果不優(yōu)于)的熱性能。由于其卓越的電氣性能,GaN FET 的尺寸可以減小,從而在尊重溫度限制的同時提高功率密度。這種行為將通過 PCB 布局的詳細 3D 有限元模擬來展示,同時還提供實驗驗證以支持分析。
功率器件的熱管理
電力電子市場需要越來越小、更高效和更可靠的設備。滿足這些嚴格要求的關鍵因素是高功率密度(能夠減少解決方案的占地面積和成本)和出色的熱管理(能夠控制設備溫度)。功率半導體熱管理系統(tǒng)的三個主要要求如下:
- 熱量應以足夠低的熱阻從器件傳導到周圍環(huán)境,以防止結溫 (T J ) 升高超過規(guī)定限值。由于降額因素,T J通常低于數(shù)據(jù)表中的值。
- 電源電路與周圍環(huán)境之間應提供電氣隔離。
- 由材料熱膨脹系數(shù)不匹配引起的熱致機械應力應被吸收。
功率器件最常見的熱管理系統(tǒng)如圖 1 所示。它包括一個散熱器(將熱量從功率半導體傳遞到周圍環(huán)境)和一個電絕緣體(熱界面材料,或 TIM),用于分隔金屬散熱器從半導體結。由于大多數(shù)介電材料的導熱率較低,因此需要在電隔離和熱阻之間進行權衡。
In real systems, power devices often come in a package composed of multiple metal and dielectric layers and are mounted on PCBs that also comprise multiple layers of metal and dielectrics. The heatsink is attached to this assembly, making it quite complex.
審核編輯:劉清
-
pcb
+關注
關注
4362文章
23467瀏覽量
408946 -
MOSFET
+關注
關注
150文章
8511瀏覽量
219939 -
散熱器
+關注
關注
2文章
1083瀏覽量
38535
發(fā)布評論請先 登錄
適用于先進3D IC封裝完整的裸片到系統(tǒng)熱管理解決方案

鴻蒙原生頁面高性能解決方案上線OpenHarmony社區(qū) 助力打造高性能原生應用
適用于低壓差應用的高性能線性調節(jié)器

Molex莫仕發(fā)布革新熱管理解決方案,賦能高性能數(shù)據(jù)中心應對未來挑戰(zhàn)
適用于600V GaN功率級的QFN12x12封裝的熱性能

適用于K頻帶的 AFE7950 超外差解決方案應用說明

適用于 Microsemi? RTG4? FPGA 的 TI 航天級電源解決方案應用手冊

適用于TI超聲AFE的模擬時間增益控制(ATGC)解決方案

適用于網(wǎng)絡接口卡的BAW振蕩器解決方案

LM98725高性能16位81 MSPS信號處理解決方案






 適用于CSP GaN FET的簡單且高性能的熱管理解決方案?
適用于CSP GaN FET的簡單且高性能的熱管理解決方案?

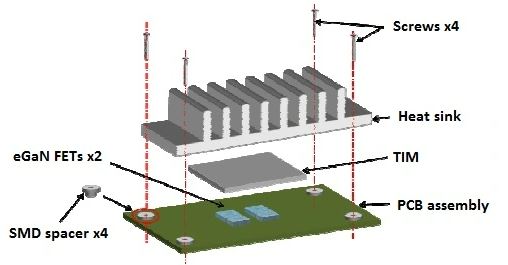










評論