半導(dǎo)體行業(yè)向復(fù)雜的2.5D和3D IC封裝快速發(fā)展,帶來(lái)了極嚴(yán)峻的熱管理挑戰(zhàn),這需要從裸片層級(jí)到系統(tǒng)層級(jí)分析的復(fù)雜解決方案。西門(mén)子通過(guò)一套集成工具和方法來(lái)應(yīng)對(duì)這些多方面的挑戰(zhàn),這些工具和方法結(jié)合了先進(jìn)的熱建模以及包括精確測(cè)量能力在內(nèi)的穩(wěn)健驗(yàn)證方法。這種綜合方法使設(shè)計(jì)團(tuán)隊(duì)能夠在設(shè)計(jì)流程的早期識(shí)別和緩解熱問(wèn)題,同時(shí)優(yōu)化所有集成層級(jí)的熱性能,以確保基于小芯片的復(fù)雜多裸片封裝能夠可靠運(yùn)行。
序言:先進(jìn)封裝中的熱挑戰(zhàn)
半導(dǎo)體行業(yè)向三維集成電路的演進(jìn)代表著熱管理要求的根本轉(zhuǎn)變。傳統(tǒng)的2D單芯片IC熱分析主要通過(guò)簡(jiǎn)單的設(shè)計(jì)規(guī)則和通常簡(jiǎn)單的基于模板的模型構(gòu)建解決方案來(lái)處理,但已不再適合當(dāng)今復(fù)雜的架構(gòu)。一直以來(lái)裸片和封裝是在兩個(gè)不同的開(kāi)發(fā)流程中使用不同的工具集進(jìn)行設(shè)計(jì)的。現(xiàn)代3D配置帶來(lái)了一系列新的熱挑戰(zhàn),這就需要?jiǎng)?chuàng)新的設(shè)計(jì)工作流程,因?yàn)樾⌒酒头庋b設(shè)計(jì)已緊密聯(lián)系在一起。
3D IC中有源裸片的垂直堆疊帶來(lái)了極嚴(yán)峻的功率密度挑戰(zhàn)。使用減薄的裸片(通常遠(yuǎn)小于100微米)會(huì)使情況變得更加復(fù)雜,因?yàn)闇p薄的裸片會(huì)顯著降低裸片自身的橫向散熱能力,從而加劇熱點(diǎn)問(wèn)題。當(dāng)多個(gè)發(fā)熱層緊密相鄰放置時(shí),通過(guò)復(fù)雜材料堆疊的有限散熱路徑會(huì)產(chǎn)生具有挑戰(zhàn)性的熱管理場(chǎng)景,必須仔細(xì)分析和解決。對(duì)于堆疊的HBM,來(lái)自相鄰緊密放置的發(fā)熱邏輯裸片的橫向熱流會(huì)使問(wèn)題更加嚴(yán)重。
現(xiàn)代IC封裝中多樣的連接方式引入了額外的熱考量因素。硅通孔(TSV)充當(dāng)層間的熱橋,會(huì)產(chǎn)生復(fù)雜的熱分布模式,必須精確建模。微凸塊陣列顯著影響局部熱阻,而混合鍵合界面引入了傳統(tǒng)封裝中不存在的新的熱考量因素。基于中介層的設(shè)計(jì)增加了熱路徑的復(fù)雜性,這需要設(shè)計(jì)和分析工具之間的協(xié)作來(lái)管理和了解其熱影響并優(yōu)化性能。
隨著層數(shù)的增加,通常會(huì)出現(xiàn)硅和復(fù)合半導(dǎo)體技術(shù)的異質(zhì)混合(具有不同的物理特性),材料和界面考量在先進(jìn)封裝中變得愈發(fā)關(guān)鍵。對(duì)于某些材料,必須仔細(xì)考慮不同方向上的各向異性、不均勻熱導(dǎo)率,并且必須考慮材料屬性隨溫度變化的特性以對(duì)非線性行為進(jìn)行建模。界面熱阻曾經(jīng)是主要影響封裝邊界,現(xiàn)在已成為封裝結(jié)構(gòu)中決定整體熱性能的關(guān)鍵因素。
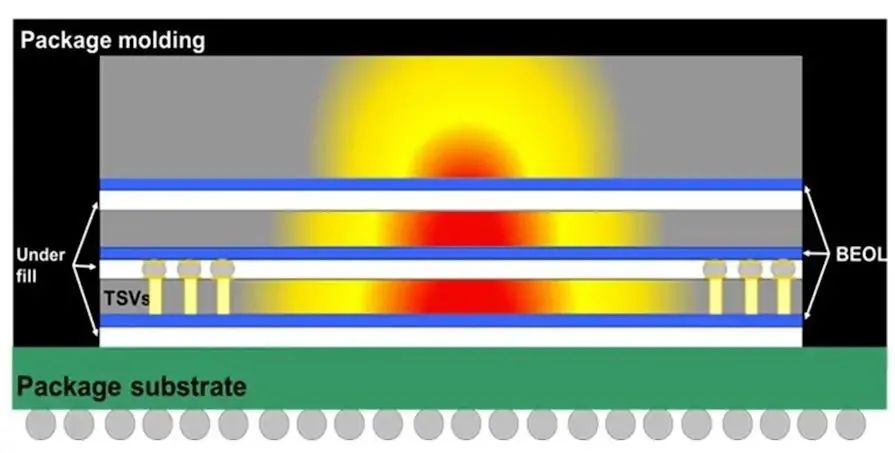
圖1. 3D IC散熱的說(shuō)明性示例。
為了應(yīng)對(duì)這些極嚴(yán)峻的熱管理挑戰(zhàn),西門(mén)子的重點(diǎn)已從設(shè)計(jì)特定的一流工具轉(zhuǎn)向創(chuàng)建集成的工作流程,以滿足各種用戶(hù)角色的需求:
不具備深厚熱學(xué)專(zhuān)業(yè)知識(shí)的封裝架構(gòu)師和設(shè)計(jì)工程師現(xiàn)在需要能夠在架構(gòu)設(shè)計(jì)階段早期快速評(píng)估熱影響并識(shí)別潛在的溫度限制因素。將設(shè)計(jì)數(shù)據(jù)轉(zhuǎn)換為熱模型和多物理場(chǎng)模型的過(guò)程自動(dòng)化至關(guān)重要,這樣才能使這些非熱學(xué)專(zhuān)家無(wú)需依賴(lài)領(lǐng)域?qū)<揖湍苓M(jìn)行可行性研究。此外,這些大型3D設(shè)計(jì)的復(fù)雜性使得即使是經(jīng)驗(yàn)豐富的CFD工程師也很難從頭開(kāi)始構(gòu)建精確的熱模型,這進(jìn)一步提高了自動(dòng)化的價(jià)值。
西門(mén)子的解決方案包括Calibre 3DThermal軟件、Innovator3D IC解決方案和Simcenter Flotherm軟件,通過(guò)提供自動(dòng)化工作流程來(lái)彌合電氣/封裝設(shè)計(jì)與熱分析之間的差距,從而應(yīng)對(duì)這些挑戰(zhàn)。設(shè)計(jì)在Innovator3D IC中以單一數(shù)據(jù)源形式進(jìn)行裝配和管理,并可在設(shè)計(jì)周期(從早期架構(gòu)規(guī)劃到最終sign-off)中導(dǎo)出至Calibre 3DThermal進(jìn)行熱分析。該工具為電氣設(shè)計(jì)師提供預(yù)期半導(dǎo)體結(jié)溫的快速精準(zhǔn)反饋,以幫助其確保設(shè)計(jì)仍具有熱可行性,且無(wú)需脫離其慣用的設(shè)計(jì)環(huán)境。為了滿足熱分析師這一用戶(hù)角色的需求,這些熱模型可以導(dǎo)出到Simcenter Flotherm,在其中可以為封裝級(jí)熱模型添加PCB、散熱器、熱管和風(fēng)扇等系統(tǒng)層級(jí)特性,以實(shí)現(xiàn)全面的系統(tǒng)層級(jí)熱分析和優(yōu)化。這使得封裝架構(gòu)師、設(shè)計(jì)工程師和熱學(xué)專(zhuān)家能夠更有效地協(xié)作,盡早發(fā)現(xiàn)和緩解熱問(wèn)題,并在所有集成層級(jí)優(yōu)化性能和冷卻解決方案成本。其目標(biāo)是將熱學(xué)考量作為設(shè)計(jì)流程的組成部分,而非單獨(dú)的關(guān)注點(diǎn),以確保復(fù)雜的多裸片封裝的可靠運(yùn)行。
Calibre 3DThermal:
先進(jìn)的硅層級(jí)熱建模
西門(mén)子已經(jīng)開(kāi)發(fā)出一套全面的解決方案,通過(guò)多種綜合方法解決這些熱挑戰(zhàn)。在裸片層級(jí),該解決方案始于復(fù)雜的物理數(shù)據(jù)庫(kù)處理。Calibre 3DThermal是一款基于Calibre和Simcenter Flotherm等核心技術(shù)構(gòu)建的新型工具,可以對(duì)LEF/DEF、GDS和OASIS文件進(jìn)行先進(jìn)解析,以提取詳細(xì)的裸片層級(jí)幾何形狀,從而實(shí)現(xiàn)精確的熱屬性映射和詳細(xì)的半導(dǎo)體層級(jí)熱模型創(chuàng)建。該過(guò)程包括智能層堆疊分析和熱點(diǎn)建模,同時(shí)納入對(duì)精確建模至關(guān)重要的特定工藝熱特性。該解決方案包括用于BEOL層建模的先進(jìn)功能,可創(chuàng)建有效的熱導(dǎo)率模型,準(zhǔn)確表示復(fù)雜的局部金屬和電介質(zhì)結(jié)構(gòu)。考慮到金屬密度和分布模式,每個(gè)層的熱屬性都是單獨(dú)計(jì)算的。該系統(tǒng)整合過(guò)孔模式和密度效應(yīng),以創(chuàng)建一個(gè)能反映實(shí)際行為的綜合熱模型,利用諸如材料映射(有效材料屬性提取)等與Simcenter Flotherm等系統(tǒng)層級(jí)工具兼容的技術(shù)。結(jié)合mPower,功率分析和映射功能可以提供有關(guān)熱負(fù)載的詳細(xì)見(jiàn)解。該系統(tǒng)從電路仿真數(shù)據(jù)生成綜合功率圖,納入開(kāi)關(guān)活動(dòng)信息以創(chuàng)建準(zhǔn)確的動(dòng)態(tài)功率分布。此分析包括統(tǒng)計(jì)功率分布考量,使設(shè)計(jì)人員能夠了解平均和峰值熱狀況。與Solido軟件配合使用時(shí),Calibre 3DThermal可提供溫度信息,提高仿真及混合信號(hào)IC設(shè)計(jì)的SPICE仿真預(yù)測(cè)精度。3D IC設(shè)計(jì)具有極高的電流密度(達(dá)數(shù)百安培級(jí)別),因此該解決方案還提供先進(jìn)焦耳熱分析功能。高分辨率電流密度映射與溫度相關(guān)電阻計(jì)算相結(jié)合,提供準(zhǔn)確的自熱效應(yīng)分析。該信息與配電網(wǎng)絡(luò)分析相結(jié)合,以呈現(xiàn)熱負(fù)載的整體情況。該系統(tǒng)的電熱仿真功能對(duì)于仿真電路尤其有價(jià)值,因?yàn)闇囟刃?yīng)會(huì)顯著影響其性能。該解決方案提供的耦合電熱分析結(jié)合了溫度相關(guān)的器件模型,并考慮了熱反饋回路。穩(wěn)態(tài)和瞬態(tài)分析功能可確保對(duì)熱場(chǎng)景進(jìn)行全面覆蓋,方法是導(dǎo)出包括局部器件溫度的反標(biāo)SPICE網(wǎng)表,然后可供像Solido這樣的SPICE仿真器使用。為了支持對(duì)復(fù)雜的2.5D、3D結(jié)構(gòu)及其封裝特征進(jìn)行建模,需要詳細(xì)的設(shè)計(jì)幾何形狀,而不只是簡(jiǎn)單的裸片表示。Calibre 3DThermal通過(guò)將3D堆疊定義與精確的設(shè)計(jì)幾何形狀相結(jié)合來(lái)創(chuàng)建高精確度3D IC模型,以解決整個(gè)結(jié)構(gòu)中不均勻的材料屬性。此功能在分析封裝邊界及外部(如外部冷卻組件的模型)的熱路徑時(shí)尤為關(guān)鍵。


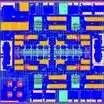
圖2. 使用詳細(xì)設(shè)計(jì)幾何形狀的高精確度芯片模型。
早期熱可行性分析是Calibre 3DThermal解決方案的另一個(gè)重要功能。該系統(tǒng)使設(shè)計(jì)人員能夠從設(shè)計(jì)的最早階段進(jìn)行熱評(píng)估,從而使他們能夠在潛在的熱問(wèn)題變成代價(jià)高昂的問(wèn)題之前發(fā)現(xiàn)并解決它們。這種早期分析能力支持迭代設(shè)計(jì)方法,其中熱考量可以為整個(gè)開(kāi)發(fā)過(guò)程中的設(shè)計(jì)決策以及電路板層級(jí)和系統(tǒng)層級(jí)的冷卻解決方案選擇提供信息和指導(dǎo)。
綜合設(shè)計(jì)流程集成
西門(mén)子熱管理解決方案的集成能力遠(yuǎn)遠(yuǎn)超出了基本的工具兼容性。這種集成的核心是各種設(shè)計(jì)工具之間的無(wú)縫工作流程,特別是Calibre 3DThermal和Innovator3D IC之間用于封裝層級(jí)架構(gòu)和裝配的復(fù)雜交互。這種集成使設(shè)計(jì)師能夠在從初始概念到最終驗(yàn)證的整個(gè)設(shè)計(jì)過(guò)程中保持一致性和精度。
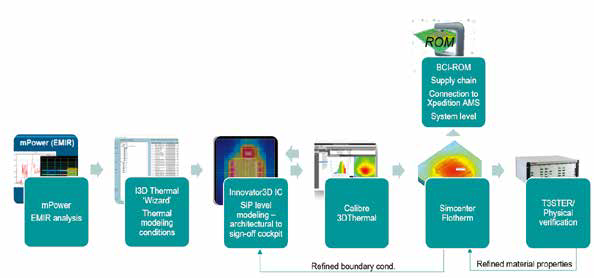
圖3. 西門(mén)子集成的3D IC設(shè)計(jì)和熱分析流程。
這種集成方法的核心是管理封裝堆疊中所有結(jié)構(gòu)組件的數(shù)字孿生。Innovator3D IC不僅是設(shè)計(jì)從裸片到環(huán)境的連接系統(tǒng)的理想工具,還保留了設(shè)計(jì)中每個(gè)物理元素的全面數(shù)字表示,確保熱模型準(zhǔn)確反映正在開(kāi)發(fā)的實(shí)際物理結(jié)構(gòu)。這種數(shù)字孿生方法可以作為封裝結(jié)構(gòu)元素的單一數(shù)據(jù)源,自動(dòng)創(chuàng)建模型并降低熱分析中出現(xiàn)錯(cuò)誤的可能性,從而使非熱學(xué)專(zhuān)家更容易進(jìn)行高精確度分析。

圖4. Innovator3D IC中的先進(jìn)封裝布局和連接關(guān)系。
該解決方案對(duì)不斷提高精確度的多次設(shè)計(jì)迭代的支持在現(xiàn)代IC封裝開(kāi)發(fā)中尤為重要。可以使用簡(jiǎn)化模型進(jìn)行初步分析,以快速評(píng)估早期的布局規(guī)劃想法,而后續(xù)的迭代可以在有可用信息時(shí)不斷納入更詳細(xì)的信息。這種持續(xù)漸進(jìn)的改進(jìn)方法使設(shè)計(jì)人員能夠保持高效的工作流程(與實(shí)際設(shè)計(jì)流程一致),同時(shí)確保最終分析在設(shè)計(jì)最終流片前包含所有必要細(xì)節(jié)以實(shí)現(xiàn)準(zhǔn)確熱預(yù)測(cè)。該系統(tǒng)與標(biāo)準(zhǔn)IC設(shè)計(jì)和布局布線工具的集成確保最終熱模型不僅涵蓋裸片細(xì)節(jié),還能精確表征中介層和基板。此集成支持3DSTACK+格式和3Dblox設(shè)計(jì),可與多種設(shè)計(jì)方法和工具兼容。由此形成一體化設(shè)計(jì)環(huán)境,用戶(hù)可為設(shè)計(jì)添加材料數(shù)據(jù)、功耗及邊界條件等熱屬性。此類(lèi)信息與設(shè)計(jì)的幾何形狀及位置數(shù)據(jù)均可一鍵傳輸至Calibre 30Thermal進(jìn)行自動(dòng)化熱仿真。熱分析借由此方法成為設(shè)計(jì)流程的有機(jī)組成部分,而非單獨(dú)的考慮因素。

圖5. 對(duì)圖4所示設(shè)計(jì)進(jìn)行的熱仿真結(jié)果。

圖6. 前面示例中所示設(shè)計(jì)的Simcenter Flotherm模型。
該工作流程的另一個(gè)重要特點(diǎn)是能夠在Calibre 3DThermal運(yùn)行后導(dǎo)出FloXML或.pack文件,在設(shè)計(jì)的任何階段與Simcenter Flotherm完全兼容。該集成對(duì)處理多裸片或3D堆疊配置等先進(jìn)半導(dǎo)體封裝的熱分析師尤為有利,因?yàn)榭梢愿鶕?jù)實(shí)際設(shè)計(jì)數(shù)據(jù)自動(dòng)建立模型。Simcenter Flotherm提供了全面的工具來(lái)管理這些復(fù)雜封裝的熱仿真,涵蓋封裝規(guī)模現(xiàn)象及其在系統(tǒng)層級(jí)環(huán)境中的相互作用。Simcenter Flotherm的功能包括對(duì)散熱路徑、氣流模式以及緊密排布元器件之間的熱耦合進(jìn)行精確建模,這對(duì)于確保高密度電子組件的可靠性能至關(guān)重要。此外,Simcenter Flotherm可以連接到多物理場(chǎng)工作流程,從而能夠同時(shí)分析先進(jìn)封裝設(shè)計(jì)中至關(guān)重要的熱、電和機(jī)械相互作用。通過(guò)FloXML自動(dòng)生成詳細(xì)的熱模型,分析師可以輕松地將復(fù)雜的封裝幾何形狀和材料屬性導(dǎo)入Flotherm,而無(wú)需從頭開(kāi)始重建模型。該工作流程不僅加速了仿真過(guò)程,而且通過(guò)保持設(shè)計(jì)和仿真模型之間的一致性提高了精度。此外,該解決方案能夠在不同工具和設(shè)計(jì)階段保持?jǐn)?shù)據(jù)一致性,有助于防止因手動(dòng)數(shù)據(jù)傳輸或轉(zhuǎn)換導(dǎo)致的常見(jiàn)錯(cuò)誤。這種自動(dòng)化數(shù)據(jù)處理確保熱分析結(jié)果能夠準(zhǔn)確反映設(shè)計(jì)的當(dāng)前狀態(tài),即使設(shè)計(jì)經(jīng)過(guò)多次迭代也是如此。除了能夠通過(guò)Calibre 3DThermal自動(dòng)生成封裝層級(jí)熱模型以供Simcenter Flotherm使用之外,工作流程集成還可以提高這兩種設(shè)計(jì)環(huán)境的預(yù)測(cè)精度。Calibre 3DThermal和Simcenter Flotherm集成的另一優(yōu)勢(shì)是Flotherm能夠確定Calibre 3DThermal可以使用的局部熱邊界條件。Flotherm可以分析封裝的熱環(huán)境,無(wú)論它是基于JEDEC標(biāo)準(zhǔn)條件還是3D空間中定制的、特定于應(yīng)用的熱環(huán)境。這使得Calibre 3DThermal能夠更準(zhǔn)確地表示封裝周?chē)臒徇吔鐥l件,而非依賴(lài)對(duì)封裝表面?zhèn)鳠嵯禂?shù)的“經(jīng)驗(yàn)猜測(cè)”方法。在熱邊界條件確定方面的精度提升顯著增強(qiáng)了Calibre 3DThermal的溫度預(yù)測(cè)能力,使其能夠?qū)?D IC封裝及其熱環(huán)境進(jìn)行更可靠、更具代表性的熱分析。
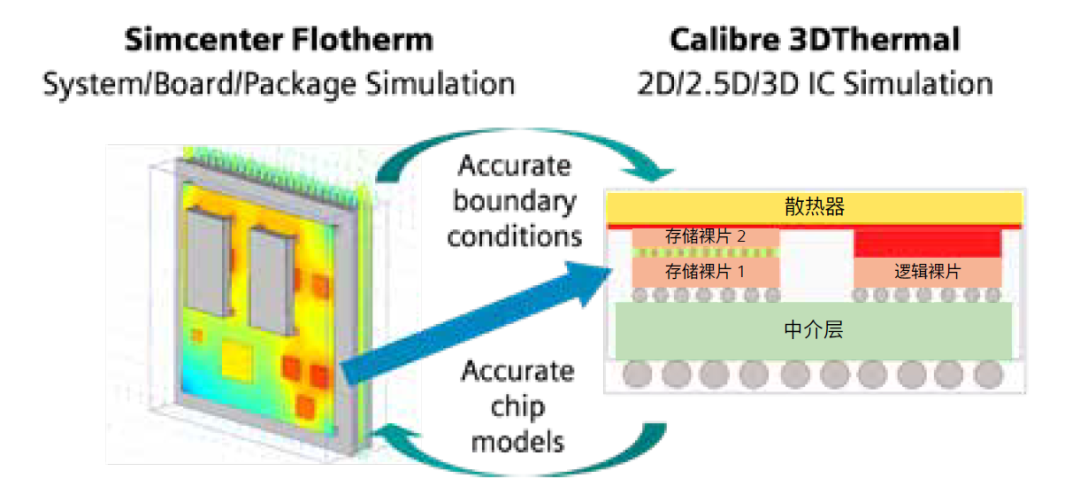
圖7. Simcenter Flotherm和Calibre 3DThermal數(shù)據(jù)路徑。
測(cè)量和驗(yàn)證
熱行為的理論分析必須輔以精確的測(cè)量和驗(yàn)證能力,以確保設(shè)計(jì)成功。西門(mén)子的解決方案融合了以Simcenter Micred T3STER熱瞬態(tài)測(cè)試設(shè)備為中心的測(cè)量工具和方法,該設(shè)備可對(duì)復(fù)雜的半導(dǎo)體封裝和組件進(jìn)行高精度熱特性分析,并已被證明適用于2.5D和3D IC封裝的特性分析。Simcenter Micred T3STER系統(tǒng)能夠精確測(cè)量熱瞬態(tài)響應(yīng),使設(shè)計(jì)人員能夠了解在實(shí)際工作條件下熱量在其設(shè)計(jì)中是如何傳導(dǎo)的。該能力在處理先進(jìn)封裝配置時(shí)尤為重要,因傳統(tǒng)穩(wěn)態(tài)測(cè)量可能無(wú)法揭示關(guān)鍵熱行為。該系統(tǒng)可在單次非破壞性測(cè)量中同時(shí)捕獲裸片層級(jí)微秒級(jí)快速熱事件,以及封裝與系統(tǒng)層級(jí)需數(shù)分鐘或數(shù)小時(shí)才能穩(wěn)定的長(zhǎng)期熱平衡。

圖8. Simcenter Micred T3STER熱測(cè)量工具。
原位材料屬性校準(zhǔn)是測(cè)量和驗(yàn)證過(guò)程的另一個(gè)關(guān)鍵方面。該解決方案能夠根據(jù)實(shí)際測(cè)量對(duì)熱模型進(jìn)行微調(diào),從而可以調(diào)整材料屬性和界面熱阻以匹配觀察到的行為。該校準(zhǔn)過(guò)程對(duì)于實(shí)現(xiàn)準(zhǔn)確的熱預(yù)測(cè)至關(guān)重要,因?yàn)橛捎诠に囎兓徒缑嫘?yīng),理論材料屬性往往與實(shí)際值不同。除硅基器件外,該系統(tǒng)還專(zhuān)門(mén)支持復(fù)合半導(dǎo)體元器件,特別是SiC和GaN器件,這些器件在電力電子應(yīng)用中越來(lái)越重要,但也在被集成到異構(gòu)封裝中。這些材料由于具有高功率密度和更高的工作溫度而帶來(lái)獨(dú)特的熱挑戰(zhàn)。該解決方案的測(cè)量能力經(jīng)過(guò)專(zhuān)門(mén)調(diào)整,可處理這些材料的獨(dú)特特性,確保在各種工作條件下都能進(jìn)行準(zhǔn)確的熱特性分析。對(duì)于生產(chǎn)環(huán)境,該解決方案包括使用短脈沖測(cè)量的非破壞性熱完整性測(cè)試功能。這種方法使制造商能夠快速有效地驗(yàn)證封裝器件的熱性能,而不會(huì)影響可靠性。所得數(shù)據(jù)可用于在器件部署到現(xiàn)場(chǎng)之前識(shí)別潛在的熱問(wèn)題,從而降低與熱相關(guān)的故障風(fēng)險(xiǎn)。
系統(tǒng)層級(jí)集成
從元器件層級(jí)到系統(tǒng)層級(jí)熱分析的過(guò)渡是通過(guò)上述與Simcenter Flotherm的直接集成來(lái)實(shí)現(xiàn)的。此集成構(gòu)建了涵蓋從單裸片特性到完整系統(tǒng)行為的全面熱分析環(huán)境。該組合解決方案使設(shè)計(jì)人員能夠了解他們的元器件在實(shí)際應(yīng)用中的表現(xiàn),同時(shí)考慮系統(tǒng)層級(jí)熱相互作用和冷卻解決方案。
元器件和系統(tǒng)層級(jí)分析工具之間的集成促進(jìn)了IC和封裝設(shè)計(jì)團(tuán)隊(duì)之間的協(xié)作工作流程。可以評(píng)估設(shè)計(jì)決策在多個(gè)集成層級(jí)上的影響,并且設(shè)計(jì)決策對(duì)所有相關(guān)方可見(jiàn),從而確保某一層級(jí)的優(yōu)化不會(huì)在另一層級(jí)引發(fā)問(wèn)題。這種整體的熱管理方法可幫助團(tuán)隊(duì)在滿足所有設(shè)計(jì)約束的同時(shí)實(shí)現(xiàn)較佳的熱性能。
系統(tǒng)層級(jí)集成的一個(gè)關(guān)鍵特征是生成邊界條件無(wú)關(guān)降階模型(BCI-ROM)。此類(lèi)模型在保護(hù)知識(shí)產(chǎn)權(quán)并降低計(jì)算復(fù)雜性的同時(shí),保持了詳細(xì)仿真的熱精度。BCI-ROM能夠在不泄露敏感設(shè)計(jì)細(xì)節(jié)的情況下進(jìn)行高效的系統(tǒng)層級(jí)熱分析,使其成為在供應(yīng)鏈中共享熱模型的理想選擇。半導(dǎo)體廠商無(wú)需擔(dān)憂IP問(wèn)題,可直接將BCI-ROM交付給系統(tǒng)集成商用于其電路板層級(jí)和系統(tǒng)層級(jí)設(shè)計(jì),從而推動(dòng)在AI、機(jī)器學(xué)習(xí)、先進(jìn)駕駛以及航空航天和國(guó)防應(yīng)用中采用先進(jìn)的封裝解決方案。獨(dú)特的是,Simcenter Flotherm不僅能夠創(chuàng)建供整個(gè)價(jià)值鏈?zhǔn)褂玫腂CI-ROM模型,還可在電路板層級(jí)或系統(tǒng)層級(jí)仿真中直接應(yīng)用此類(lèi)模型。
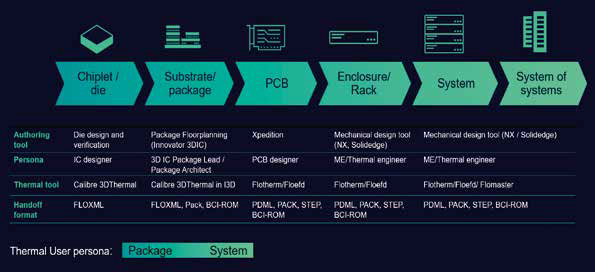
圖 9. 裸片到系統(tǒng)的熱管理。
ECXML
在工具互操作性方面,西門(mén)子致力于維護(hù)一個(gè)開(kāi)放的平臺(tái)。除了BCI-ROM模型的功能之外,您可能還需要共享詳細(xì)的建模數(shù)據(jù)以供非西門(mén)子工具包使用。為此,我們的熱分析工具提供了符合JEDEC JEP181標(biāo)準(zhǔn)的重要導(dǎo)出功能,JEDEC JEP181通常稱(chēng)為ECXML(Electronics Cooling XML,電子冷卻XML),這是電子元器件熱模型交換的行業(yè)標(biāo)準(zhǔn)文件格式。到2018年,ECXML已成為事實(shí)上的標(biāo)準(zhǔn),并于2020年正式發(fā)布為JEDEC標(biāo)準(zhǔn)。
ECXML提供了一種中立的、與廠商無(wú)關(guān)的格式,用于在不同的仿真工具和電子設(shè)計(jì)工作流程之間共享熱分析數(shù)據(jù)。JEP181可表示3D熱模型數(shù)據(jù)(從PCB和元器件到風(fēng)扇和散熱器),實(shí)現(xiàn)仿真軟件互操作性,并為構(gòu)建數(shù)字化電子供應(yīng)鏈奠定基礎(chǔ)。
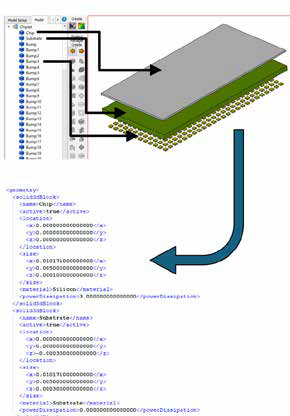
-
IC封裝
+關(guān)注
關(guān)注
4文章
188瀏覽量
27237 -
熱管理
+關(guān)注
關(guān)注
11文章
481瀏覽量
22456
發(fā)布評(píng)論請(qǐng)先 登錄
簡(jiǎn)化選型,優(yōu)化性能!納芯微提供完整的集成式熱管理驅(qū)動(dòng)系統(tǒng)解決方案

CADENAS 解決方案的標(biāo)準(zhǔn)化名稱(chēng):3Dfindit
TPS65735 用于主動(dòng)快門(mén) 3D 眼鏡的電源管理 IC數(shù)據(jù)手冊(cè)

智能倉(cāng)儲(chǔ)管理解決方案NRF5832
3D投影沙盤(pán)技術(shù)方案 四面金字塔結(jié)構(gòu)+無(wú)線遙控 可拆裝運(yùn)輸設(shè)計(jì)+高亮觸控屏+AI中控系統(tǒng)

納芯微集成式熱管理驅(qū)動(dòng)系統(tǒng)解決方案

英倫科技裸眼3D便攜屏有哪些特點(diǎn)?

技術(shù)前沿:半導(dǎo)體先進(jìn)封裝從2D到3D的關(guān)鍵

YES 宣布推出適用于先進(jìn)封裝應(yīng)用的 VertaCure XP G3 系統(tǒng)
一文理解2.5D和3D封裝技術(shù)

中興通訊攜手中國(guó)移動(dòng)推出AI裸眼3D創(chuàng)新產(chǎn)品
適用于電器旋鈕的3D霍爾效應(yīng)傳感器

適用于3D機(jī)器視覺(jué)的高度可擴(kuò)展的TI DLP技術(shù)

VSP2232適用于數(shù)碼相機(jī)的完整混合信號(hào)處理IC數(shù)據(jù)表






 適用于先進(jìn)3D IC封裝完整的裸片到系統(tǒng)熱管理解決方案
適用于先進(jìn)3D IC封裝完整的裸片到系統(tǒng)熱管理解決方案












評(píng)論