電子發(fā)燒友網(wǎng)報道(文/劉靜)9月19日,從事高端電子封裝材料研發(fā)的德邦科技在上交所科創(chuàng)板成功敲鐘上市!發(fā)行價為46.12元/股,上市首日開盤大漲55.25%。截至上午11點30分,股票最新價格為76.35元/股,漲幅突破65%,總市值達108.60億元。

成功登陸科創(chuàng)板資本市場后,德邦科技將募集6.44億元,投向“高端電子專用材料生產(chǎn)項目”、“年產(chǎn)35噸半導體電子封裝材料建設(shè)項目”等。
高端電子封裝材料一直是我國未解決的“卡脖子”難題,而企業(yè)實現(xiàn)國產(chǎn)化成為解決這一難題的關(guān)鍵。現(xiàn)在國家在大力幫扶這些上游的原材料企業(yè)發(fā)展,國內(nèi)的投資機構(gòu)也在積極給予資金上的支持。據(jù)悉,德邦科技已完成三輪融資,獲得大基金、三行資本、元禾璞華、晨道資本、君海創(chuàng)芯等知名機構(gòu)參投。其中大基金既是投資者,也是目前德邦科技的第一大股東,直接持股24.87%。
毛利率逐年下降,集成電路封裝材料業(yè)務(wù)收入翻倍漲
德邦科技在“國家隊”大基金等資本的加持下快速崛起,先后在集成電路封裝、智能終端封裝、動力電池封裝、光伏疊瓦封裝等領(lǐng)域?qū)崿F(xiàn)核心技術(shù)突破,并成功實現(xiàn)產(chǎn)業(yè)化,批量供貨給華天科技、通富微電、歌爾股份、小米科技、寧德時代等國內(nèi)知名企業(yè)。
大客戶持續(xù)涌入,帶動德邦科技業(yè)績實現(xiàn)快速增長。具體來看,2019年-2021年德邦科技實現(xiàn)的營業(yè)收入分別為3.27億元、4.17億元、5.84億元,年均復合增長率為33.64%。同期凈利潤以高超51%的年均復合增長率成長,2021年同比漲幅亦在50%以上,呈現(xiàn)逐年快速的增長趨勢。

不過,德邦科技的綜合毛利率已經(jīng)連續(xù)三年下降了,據(jù)了解這主要跟德邦科技的新能源應(yīng)用材料銷量大幅增加,毛利率大幅減少有關(guān),2021年該業(yè)務(wù)的毛利率已從2019年的25.87%下降至16.73%。此外,毛利率持續(xù)下降,跟高端電子封裝材料制造的關(guān)鍵原材料銀粉和環(huán)氧樹脂單價連年大幅上漲也有關(guān),2021年這兩大原材料單價分別同比上漲11.41%、41.20%。
目前德邦科技營業(yè)收入來源于四大業(yè)務(wù),分別為集成電路封裝材料、智能終端封裝材料、新能源應(yīng)用材料、高端裝備應(yīng)用材料,2021年分別同比增長114.40%、7.34%、63.13%、12.41%。

2019年、2020年收入最主要來源的是智能終端封裝材料,而2021年新能源應(yīng)用材料業(yè)務(wù)收入快速增長,首度超越智能終端封裝材料業(yè)務(wù)收入,成為德邦科技的第一大業(yè)務(wù)。
2021年收入增速最高的是集成電路封裝材料業(yè)務(wù),這是德邦科技唯一實現(xiàn)翻倍增長的業(yè)務(wù),占主營業(yè)務(wù)收入的比例為14.35%。德邦科技主要為集成電路封裝提供晶圓UV膜、芯片固晶材料、芯片級底部填充膠、Lid框粘接材料、板級底部填充膠、板級封裝用導熱墊片。‘’
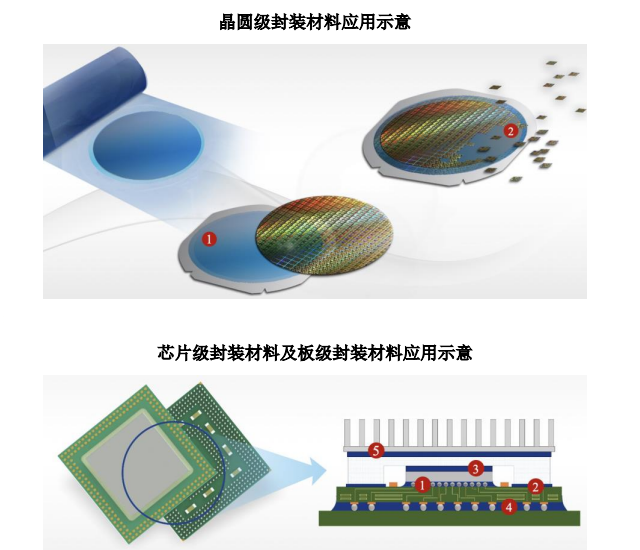
隨著德邦科技拓展的客戶數(shù)量不斷增加,其產(chǎn)銷量規(guī)模不斷擴大,2021年產(chǎn)能已突破3818噸,銷量高達5375噸,產(chǎn)能利用率超181%,現(xiàn)有產(chǎn)能已無法滿足客戶持續(xù)增長的需求。
在客戶方面,德邦科技已與華天科技、通富微電、長電科技、矽德半導體、日月新、鉅研材料、海爾智家、立訊精密、歌爾股份、華勤技術(shù)、小米科技、瑞聲光電、ATL、通威股份、寧德時代、阿特斯、晶科能源、隆基股份、中航鋰電等知名企業(yè)建立長期合作。
發(fā)明專利數(shù)量在國內(nèi)同行企業(yè)之上,研發(fā)團隊81人
在高端電子封裝材料行業(yè),國際一流大廠主要包括德國漢高、富樂、美國3M、陶氏杜邦、日東電工、日本琳得科、日本信越、日立化成。在全球集成電路、智能終端等產(chǎn)業(yè)產(chǎn)能加速向國內(nèi)轉(zhuǎn)移的背景下,高端電子材料國產(chǎn)化需求強勁,一批以世華科技、晶瑞電材、中石科技、回天新材、賽伍技術(shù)為代表的優(yōu)秀國產(chǎn)企業(yè)快速崛起。
2021年德邦科技在營業(yè)收入和毛利率方面與國內(nèi)同行企業(yè)的比較如下所示:

德邦科技的營收規(guī)模略高于世華科技,總體處于中小規(guī)模,與賽伍技術(shù)和回天新材相比,需要追趕的差距仍較大。盈利能力上,聚焦精密制程應(yīng)用材料、電子復合功能材料和光電顯示模組材料研發(fā)的世華科技表現(xiàn)突出,毛利率高達61.27%,其大客戶主要是蘋果和三星。
在技術(shù)實力上,德邦科技與國內(nèi)同行企業(yè)的比較情況如下:

截至2021年底,德邦科技擁有國家級海外高層次專家人才2人,研發(fā)人員81人,研發(fā)人員占總?cè)藬?shù)的比例為14.24%。雖然從研發(fā)人員數(shù)量上,德邦科技比不上賽伍技術(shù)、中石科技、回天新材這些100人以上的團隊規(guī)模,但是其在發(fā)明專利數(shù)量上卻領(lǐng)跑國內(nèi)同行企業(yè)。由此可見,德邦科技研發(fā)團隊的自主研發(fā)創(chuàng)新實力還是不錯的,掌握的核心技術(shù)不遜色國內(nèi)頭部企業(yè)。
2019年-2021年德邦科技的研發(fā)費用分別為1973.42萬元、2415.04萬元、3066.42萬元,三年累計研發(fā)投入金額高達7454.88萬元。在研發(fā)投入上,總體保持逐年加大的趨勢,2021年同比增長26.97%。營收規(guī)模相對較小的德邦科技,始終保持高于行業(yè)平均研發(fā)費用率水平,且2021年研發(fā)費用率高于晶瑞電材、賽伍技術(shù)、回天新材。
2021年度研發(fā)投入金額超200萬元的有6大項目,“高導熱聚合物熱界面材料開發(fā)及產(chǎn)業(yè)化和原材料國產(chǎn)化”、“電子丙烯酸材料研發(fā)”、“半導體用精密涂布模材料”、“集成電路封裝關(guān)鍵材料開發(fā)及產(chǎn)業(yè)化技術(shù)”、“電芯粘接耐電解液材料研發(fā)”、“窄間距大尺寸芯片封裝用底部填充材料應(yīng)用研發(fā)”,具體研發(fā)投入金額分別為666.75萬元、342.19萬元、298.23萬元、294.85萬元、221.41萬元、207.20萬元。從研發(fā)項目的投入情況看,近三年德邦科技著重發(fā)力集成電路封裝材料和新能源應(yīng)用材料領(lǐng)域的研發(fā)。
產(chǎn)能利用率超181%,募資 6.44億擴充高端電子封裝材料產(chǎn)能
此次IPO,德邦科技擬募集6.44億元資金,投入以下三大募投項目:

德邦科技的訂單量在快速增加,2021年產(chǎn)能利用率已超181.16%,很明顯其現(xiàn)有產(chǎn)能已無法滿足未來持續(xù)增長的客戶需求。德邦科技所聚焦的集成電路封裝、智能終端封裝、新能源動力電池、光伏制造等應(yīng)用領(lǐng)域需求都在逐年快速增長。
為了擴充公司現(xiàn)有產(chǎn)能,德邦科技分別將3.87億元、1.12億元募資投入“高端電子專用材料生產(chǎn)項目”、“年產(chǎn)35噸半導體電子封裝材料建設(shè)項目”。這兩大募投項目完成后,可新增年產(chǎn)封裝材料8800噸動力電池封裝材料、200噸智能終端封裝材料、350萬平方米集成電路封裝材料、2000卷導熱材料、15噸半導體芯片與系統(tǒng)封裝用電子封裝材料和20噸光伏疊晶材料的產(chǎn)能。
投入1.45億元的“新建研發(fā)中心建設(shè)項目”,研發(fā)的主要方向是高密度半導體芯片封裝 用高性能熱界面材料、底部填充材料、芯片框架粘接材料、芯片固晶材料、晶圓UV膜及電子系統(tǒng)組裝材料等。
德邦科技表示,未來將繼續(xù)鎖定集成電路封裝材料、智能終端封裝材料、新能源應(yīng)用材料、高端裝備應(yīng)用材料四個發(fā)展方向,實施“1+6+N(New)”的市場發(fā)展戰(zhàn)略,拓展新領(lǐng)域,開發(fā)新產(chǎn)品,實現(xiàn)快速發(fā)展。

成功登陸科創(chuàng)板資本市場后,德邦科技將募集6.44億元,投向“高端電子專用材料生產(chǎn)項目”、“年產(chǎn)35噸半導體電子封裝材料建設(shè)項目”等。
高端電子封裝材料一直是我國未解決的“卡脖子”難題,而企業(yè)實現(xiàn)國產(chǎn)化成為解決這一難題的關(guān)鍵。現(xiàn)在國家在大力幫扶這些上游的原材料企業(yè)發(fā)展,國內(nèi)的投資機構(gòu)也在積極給予資金上的支持。據(jù)悉,德邦科技已完成三輪融資,獲得大基金、三行資本、元禾璞華、晨道資本、君海創(chuàng)芯等知名機構(gòu)參投。其中大基金既是投資者,也是目前德邦科技的第一大股東,直接持股24.87%。
毛利率逐年下降,集成電路封裝材料業(yè)務(wù)收入翻倍漲
德邦科技在“國家隊”大基金等資本的加持下快速崛起,先后在集成電路封裝、智能終端封裝、動力電池封裝、光伏疊瓦封裝等領(lǐng)域?qū)崿F(xiàn)核心技術(shù)突破,并成功實現(xiàn)產(chǎn)業(yè)化,批量供貨給華天科技、通富微電、歌爾股份、小米科技、寧德時代等國內(nèi)知名企業(yè)。
大客戶持續(xù)涌入,帶動德邦科技業(yè)績實現(xiàn)快速增長。具體來看,2019年-2021年德邦科技實現(xiàn)的營業(yè)收入分別為3.27億元、4.17億元、5.84億元,年均復合增長率為33.64%。同期凈利潤以高超51%的年均復合增長率成長,2021年同比漲幅亦在50%以上,呈現(xiàn)逐年快速的增長趨勢。

不過,德邦科技的綜合毛利率已經(jīng)連續(xù)三年下降了,據(jù)了解這主要跟德邦科技的新能源應(yīng)用材料銷量大幅增加,毛利率大幅減少有關(guān),2021年該業(yè)務(wù)的毛利率已從2019年的25.87%下降至16.73%。此外,毛利率持續(xù)下降,跟高端電子封裝材料制造的關(guān)鍵原材料銀粉和環(huán)氧樹脂單價連年大幅上漲也有關(guān),2021年這兩大原材料單價分別同比上漲11.41%、41.20%。
目前德邦科技營業(yè)收入來源于四大業(yè)務(wù),分別為集成電路封裝材料、智能終端封裝材料、新能源應(yīng)用材料、高端裝備應(yīng)用材料,2021年分別同比增長114.40%、7.34%、63.13%、12.41%。

2019年、2020年收入最主要來源的是智能終端封裝材料,而2021年新能源應(yīng)用材料業(yè)務(wù)收入快速增長,首度超越智能終端封裝材料業(yè)務(wù)收入,成為德邦科技的第一大業(yè)務(wù)。
2021年收入增速最高的是集成電路封裝材料業(yè)務(wù),這是德邦科技唯一實現(xiàn)翻倍增長的業(yè)務(wù),占主營業(yè)務(wù)收入的比例為14.35%。德邦科技主要為集成電路封裝提供晶圓UV膜、芯片固晶材料、芯片級底部填充膠、Lid框粘接材料、板級底部填充膠、板級封裝用導熱墊片。‘’
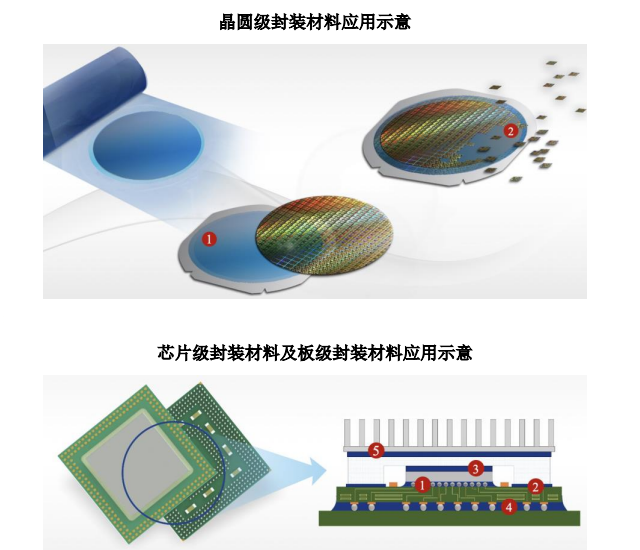
隨著德邦科技拓展的客戶數(shù)量不斷增加,其產(chǎn)銷量規(guī)模不斷擴大,2021年產(chǎn)能已突破3818噸,銷量高達5375噸,產(chǎn)能利用率超181%,現(xiàn)有產(chǎn)能已無法滿足客戶持續(xù)增長的需求。
在客戶方面,德邦科技已與華天科技、通富微電、長電科技、矽德半導體、日月新、鉅研材料、海爾智家、立訊精密、歌爾股份、華勤技術(shù)、小米科技、瑞聲光電、ATL、通威股份、寧德時代、阿特斯、晶科能源、隆基股份、中航鋰電等知名企業(yè)建立長期合作。
發(fā)明專利數(shù)量在國內(nèi)同行企業(yè)之上,研發(fā)團隊81人
在高端電子封裝材料行業(yè),國際一流大廠主要包括德國漢高、富樂、美國3M、陶氏杜邦、日東電工、日本琳得科、日本信越、日立化成。在全球集成電路、智能終端等產(chǎn)業(yè)產(chǎn)能加速向國內(nèi)轉(zhuǎn)移的背景下,高端電子材料國產(chǎn)化需求強勁,一批以世華科技、晶瑞電材、中石科技、回天新材、賽伍技術(shù)為代表的優(yōu)秀國產(chǎn)企業(yè)快速崛起。
2021年德邦科技在營業(yè)收入和毛利率方面與國內(nèi)同行企業(yè)的比較如下所示:

德邦科技的營收規(guī)模略高于世華科技,總體處于中小規(guī)模,與賽伍技術(shù)和回天新材相比,需要追趕的差距仍較大。盈利能力上,聚焦精密制程應(yīng)用材料、電子復合功能材料和光電顯示模組材料研發(fā)的世華科技表現(xiàn)突出,毛利率高達61.27%,其大客戶主要是蘋果和三星。
在技術(shù)實力上,德邦科技與國內(nèi)同行企業(yè)的比較情況如下:

截至2021年底,德邦科技擁有國家級海外高層次專家人才2人,研發(fā)人員81人,研發(fā)人員占總?cè)藬?shù)的比例為14.24%。雖然從研發(fā)人員數(shù)量上,德邦科技比不上賽伍技術(shù)、中石科技、回天新材這些100人以上的團隊規(guī)模,但是其在發(fā)明專利數(shù)量上卻領(lǐng)跑國內(nèi)同行企業(yè)。由此可見,德邦科技研發(fā)團隊的自主研發(fā)創(chuàng)新實力還是不錯的,掌握的核心技術(shù)不遜色國內(nèi)頭部企業(yè)。
2019年-2021年德邦科技的研發(fā)費用分別為1973.42萬元、2415.04萬元、3066.42萬元,三年累計研發(fā)投入金額高達7454.88萬元。在研發(fā)投入上,總體保持逐年加大的趨勢,2021年同比增長26.97%。營收規(guī)模相對較小的德邦科技,始終保持高于行業(yè)平均研發(fā)費用率水平,且2021年研發(fā)費用率高于晶瑞電材、賽伍技術(shù)、回天新材。
2021年度研發(fā)投入金額超200萬元的有6大項目,“高導熱聚合物熱界面材料開發(fā)及產(chǎn)業(yè)化和原材料國產(chǎn)化”、“電子丙烯酸材料研發(fā)”、“半導體用精密涂布模材料”、“集成電路封裝關(guān)鍵材料開發(fā)及產(chǎn)業(yè)化技術(shù)”、“電芯粘接耐電解液材料研發(fā)”、“窄間距大尺寸芯片封裝用底部填充材料應(yīng)用研發(fā)”,具體研發(fā)投入金額分別為666.75萬元、342.19萬元、298.23萬元、294.85萬元、221.41萬元、207.20萬元。從研發(fā)項目的投入情況看,近三年德邦科技著重發(fā)力集成電路封裝材料和新能源應(yīng)用材料領(lǐng)域的研發(fā)。
產(chǎn)能利用率超181%,募資 6.44億擴充高端電子封裝材料產(chǎn)能
此次IPO,德邦科技擬募集6.44億元資金,投入以下三大募投項目:

德邦科技的訂單量在快速增加,2021年產(chǎn)能利用率已超181.16%,很明顯其現(xiàn)有產(chǎn)能已無法滿足未來持續(xù)增長的客戶需求。德邦科技所聚焦的集成電路封裝、智能終端封裝、新能源動力電池、光伏制造等應(yīng)用領(lǐng)域需求都在逐年快速增長。
為了擴充公司現(xiàn)有產(chǎn)能,德邦科技分別將3.87億元、1.12億元募資投入“高端電子專用材料生產(chǎn)項目”、“年產(chǎn)35噸半導體電子封裝材料建設(shè)項目”。這兩大募投項目完成后,可新增年產(chǎn)封裝材料8800噸動力電池封裝材料、200噸智能終端封裝材料、350萬平方米集成電路封裝材料、2000卷導熱材料、15噸半導體芯片與系統(tǒng)封裝用電子封裝材料和20噸光伏疊晶材料的產(chǎn)能。
投入1.45億元的“新建研發(fā)中心建設(shè)項目”,研發(fā)的主要方向是高密度半導體芯片封裝 用高性能熱界面材料、底部填充材料、芯片框架粘接材料、芯片固晶材料、晶圓UV膜及電子系統(tǒng)組裝材料等。
德邦科技表示,未來將繼續(xù)鎖定集成電路封裝材料、智能終端封裝材料、新能源應(yīng)用材料、高端裝備應(yīng)用材料四個發(fā)展方向,實施“1+6+N(New)”的市場發(fā)展戰(zhàn)略,拓展新領(lǐng)域,開發(fā)新產(chǎn)品,實現(xiàn)快速發(fā)展。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學習之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
科創(chuàng)板
+關(guān)注
關(guān)注
4文章
902瀏覽量
28041
發(fā)布評論請先 登錄
相關(guān)推薦
熱點推薦
花20億收購一家上市公司,“稚暉君”速通科創(chuàng)板
電子發(fā)燒友網(wǎng)報道(文/梁浩斌)科創(chuàng)板人形機器人第一股就這么誕生了?智元機器人“借殼”科創(chuàng)板

小米股價開盤大漲 小米YU7 3分鐘大定突破200000臺 小米發(fā)布會亮點頻頻
,創(chuàng)歷史新高,小米總市值接近1.6萬億港元。截止發(fā)稿,小米股價報收59.4;上漲4.39%。 小米YU7 3分鐘大定突破200000臺? 在小米發(fā)布會上小米YU7的售價正式公布,25.

京東方精電2024年營收破百億
近日,在香港聯(lián)交所上市的BOE(京東方)旗下全球車載業(yè)務(wù)平臺京東方精電(股份代號:00710.HK)發(fā)布2024年度業(yè)績公告,以134.49億港元(約合125.72億人民幣)的營業(yè)收入成功突破百億級人民幣大關(guān),實現(xiàn)同比增長25%
中國領(lǐng)先的電化學儲能系統(tǒng)解決方案與技術(shù)服務(wù)提供商海博思創(chuàng)成功登陸科創(chuàng)板
上海2025年1月27日?/美通社/ -- 北京時間1月27日,啟明創(chuàng)投投資企業(yè)、中國領(lǐng)先的電化學儲能系統(tǒng)解決方案與技術(shù)服務(wù)提供商海博思創(chuàng)成功登陸科
聯(lián)蕓科技成功登陸上交所科創(chuàng)板
近日,全球SSD獨立主控芯片出貨量排名第二的聯(lián)蕓科技(杭州)股份有限公司(簡稱“聯(lián)蕓科技”)成功在上海證券交易所科創(chuàng)板掛牌上市,其證券代碼為
勝科納米即將科創(chuàng)板IPO上會
近日,上交所官網(wǎng)發(fā)布重要公告,勝科納米(蘇州)股份有限公司(簡稱“勝科納米”)將于2024年11月22日迎來科創(chuàng)板首發(fā)上會。此舉標志著勝
國科天成成功登陸創(chuàng)業(yè)板
國科天成(證券代碼:301571)近日在深圳證券交易所創(chuàng)業(yè)板成功上市,開盤即迎來強勁表現(xiàn)。發(fā)行價格為11.14元/股的國
中控技術(shù)榮獲“2024最具價值科創(chuàng)板上市公司”
與表彰。在萬眾矚目的“科創(chuàng)板開市五周年評選”中,中控技術(shù)憑借其在工業(yè)自動化、數(shù)字化、智能化領(lǐng)域的卓越表現(xiàn),榮獲“2024最具價值科創(chuàng)
思瑞浦榮膺 “2024年最具創(chuàng)新力科創(chuàng)板上市公司”
聚焦高性能模擬芯片和嵌入式處理器2024年7月26日,由上海市投資促進服務(wù)中心及《科創(chuàng)板日報》主辦的“科創(chuàng)

科創(chuàng)板開市五周年|芯海科技榮獲“年度最具創(chuàng)新力科創(chuàng)板上市企業(yè)”
評選”榜單。芯海科技(股票代碼:688595)榮登該榜單,喜獲“2024年度最具創(chuàng)新力科創(chuàng)板上市企業(yè)”殊榮。上海市經(jīng)濟和信息化委員會副主任葛東波致辭表示,新“國九

思瑞浦榮膺“2024年最具創(chuàng)新力科創(chuàng)板上市公司”
2024年7月26日,由上海市投資促進服務(wù)中心及《科創(chuàng)板日報》主辦的“科創(chuàng)板開市五周年峰會”在上
喜訊!佰維存儲榮獲“2024最具價值科創(chuàng)板上市企業(yè)”,成長實力再創(chuàng)新高
7月26日,由上海市投資促進服務(wù)中心與《科創(chuàng)板日報》聯(lián)合主辦的“科創(chuàng)板開市五周年峰會”峰會在上海
發(fā)表于 07-29 13:39
?493次閱讀

佰維存儲榮獲“2024最具價值科創(chuàng)板上市企業(yè)”
近日,由上海市投資促進服務(wù)中心與《科創(chuàng)板日報》聯(lián)合主辦的“科創(chuàng)板開市五周年峰會”峰會在上海
喜報 | 芯聯(lián)集成榮獲“2024最具創(chuàng)新力科創(chuàng)板上市公司”獎
2024年7月26日,芯聯(lián)集成榮獲“2024最具創(chuàng)新力科創(chuàng)板上市公司”獎。該獎項由上海報業(yè)集團專注新興產(chǎn)業(yè)與一級市場資本的新型媒體平臺 《科
發(fā)表于 07-29 09:24
?346次閱讀

中微公司迎來科創(chuàng)板上市五周年
在科創(chuàng)板開市五周年之際,中微半導體設(shè)備(上海)股份有限公司(以下簡稱“中微公司”,上交所股票代碼:688012)也迎來了上市五周年。作為科





 德邦科技科創(chuàng)板成功上市!開盤大漲55.25%,總市值突破百億
德邦科技科創(chuàng)板成功上市!開盤大漲55.25%,總市值突破百億











評論