在電子制造中,[集成電路封裝]制造的最后階段,其中半導體材料塊被封裝在支撐外殼中,以防止物理損壞和腐蝕。這種稱為“封裝”的外殼支撐著將設備連接到電路板的電觸點。在集成電路工業(yè)中,該過程通常被稱為封裝。其他名稱包括半導體器件組裝、組裝、封裝或密封。封裝階段之后是集成電路的測試。下面小編就來講訴一下半導體集成電路封裝技術的作用,以及體集成電路芯片封裝的意義。
集成電路封裝技術
“封裝”一詞伴隨集成電路制造技術的產(chǎn)生而出現(xiàn),這一概念用于電子工程的歷史并不是很久。早在真空電子管時代,將電子管等器件安裝在基座上構成電路設備的方法稱為“電子組裝或電子裝配”,當時還沒有“封裝”的概念。
20世紀50年代晶體管的問世和后來集成電路芯片的出現(xiàn),改寫了電子工程的歷史。一方面,這些半導體元器件細小柔弱另一方面,其性能高,且多功能、多規(guī)格。為了充分發(fā)揮其功能,需要補強、密封、擴大,以便實現(xiàn)與外電路可靠的電氣連接并得到有效的機械、絕緣等方面的保護,以防止外力或環(huán)境因素導致的破壞。在此基礎上,“封裝”才有了具體的概念。
集成電路封裝在電子學金字塔中的位置既是金字塔的尖頂又是金字塔的基座。說它同時處在這兩種位置都有很充分的根據(jù)。從電子元器件(如晶體管)的密度這個角度上來說,IC(集成電路)代表了電子學的尖端。但是IC又是一個起始點,是一種基本結構單元,是組成人們生活中大多數(shù)電子系統(tǒng)的基礎。同樣,IC不僅是單塊芯片或者基本電子結構,IC 的種類千差萬別(模擬電路、數(shù)字電路、射頻電路、傳感器等),因而對于封裝的需求和要求也各不相同。
芯片封裝意義
集成電路芯片封裝(Packaging,PKG)是指利用膜技術及微細加工技術,將芯片及其他要素在框架或基板上布置、粘貼固定及連接,引出接線端子并通過可塑性絕緣介質(zhì)灌封固定構成整體立體結構的工藝。此概念稱為狹義的封裝。
在更廣的意義上的封裝是指封裝工程,即將封裝體與基板連接固定,裝配成完整的系統(tǒng)或電子設備,并確保整個系統(tǒng)綜合性能的工程。
以上兩個層次封裝的含義連接在一起,就構成了廣義上的封裝的概念。
將基板技術、芯片封裝體、分立器件等全部要素,按電子設備整機要求進行連接和裝配,實現(xiàn)電子的、物理的功能,使之轉(zhuǎn)變?yōu)檫m用于機械或系統(tǒng)的形式,成為整機裝置或設備的工程稱為電子封裝工程。圖1-1表示了封裝前的芯片和封裝幾種不同芯片的外觀圖。
集成電路封裝的目的,在于保護芯片不受或少受外界環(huán)境的影響,并為之提供一個良好的工作條件,以使集成電路具有穩(wěn)定、正常的功能。封裝為芯片提供一種保護,人們平時看見的電子設備,比如計算機、家用電器、通信設備等,都是封裝好的,沒有封裝的集成電路芯片一般是不能直接使用的。
上圖所示是集成電路制造的工藝流程。從中可以看出,制造一塊集成電路需要經(jīng)歷集成電路設計、掩膜版制造、原材料制造、芯片制造、封裝、測試幾道工序。封裝工藝屬于集成電路制造工藝的后道工序,緊接著在芯片制造工藝完成后進行,此時的芯片已經(jīng)通過電測試。
集成電路封裝的技術領域
芯片封裝技術涵蓋的技術面極廣,屬于復雜的系統(tǒng)工程。它應用了物理、化學、化工、材料、機械、電氣與自動化等各門學科,也使用金屬、陶瓷、玻璃、高分子等各種各樣的材料,因此電子封裝是一門跨學科知識整合的科學,也是整合產(chǎn)品電氣特性、熱傳導特性、可靠度、材料與工藝技術的應用以及成本價格等因素,以達到最佳化目的的工程技術。在微電子產(chǎn)品功能與層次提升的追求中,開發(fā)封裝技術的重要性不亞于集成電路芯片工藝技術和其他相關工藝技術,世界各國的電子工業(yè)都在全力研究開發(fā)這一技術,以期得到在該領域的技術領先地位。
綜上所訴就是關于半導體集成電路封裝技術作用及芯片封裝意義、技術領域的詳細介紹了,希望能給大家?guī)韼椭?茰蕼y控專注于推拉力測試機研發(fā)、生產(chǎn)、銷售。廣泛用于與LED封裝測試、IC半導體封裝測試、TO封裝測試、IGBT功率模塊封裝測試、光電子元器件封裝測試、大尺寸PCB測試、MINI面板測試、大尺寸樣品測試、汽車領域、航天航空領域、軍工產(chǎn)品測試、研究機構的測試及各類院校的測試研究等應用。如果您有遇到任何有關半導體集成電路等問題,歡迎給我們私信或留言,科準的技術團隊也會為您免費解答!
審核編輯 黃昊宇
-
芯片
+關注
關注
459文章
51925瀏覽量
433602 -
集成電路
+關注
關注
5415文章
11865瀏覽量
366251
發(fā)布評論請先 登錄
相關推薦
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
全面剖析倒裝芯片封裝技術的內(nèi)在機制、特性優(yōu)勢、面臨的挑戰(zhàn)及未來走向
芯和半導體將參加2024集成電路特色工藝與先進封裝測試產(chǎn)業(yè)技術論壇
2.5D封裝與異構集成技術解析
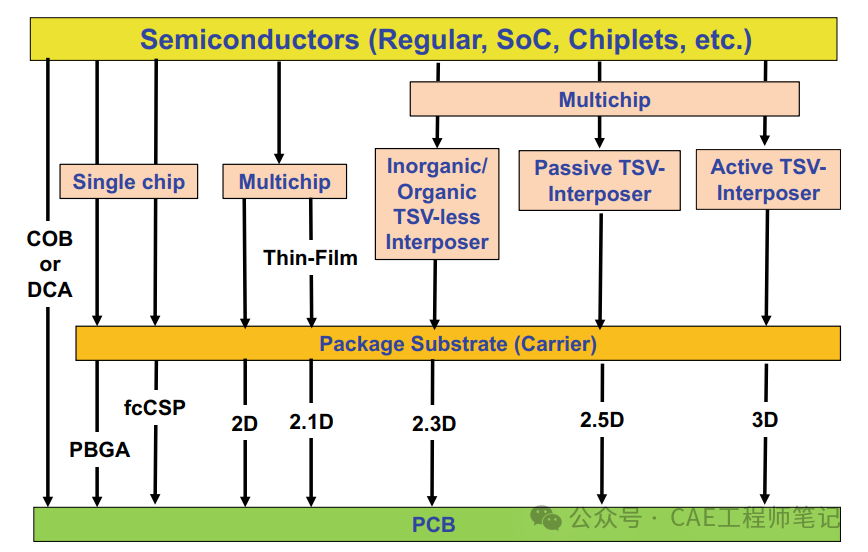
led封裝和半導體封裝的區(qū)別
容泰半導體集成電路芯片級封裝項目竣工投產(chǎn)
半導體封裝技術的可靠性挑戰(zhàn)與解決方案






 半導體集成電路封裝技術及芯片封裝意義、技術領域分享!
半導體集成電路封裝技術及芯片封裝意義、技術領域分享!















評論