芯片供電網(wǎng)絡(luò)(Power Delivery Network, PDN)的設(shè)計目標是以最高效率為芯片上的主動元件提供所需的電源(VDD)與參考電壓(VSS)。一直以來,業(yè)界都是利用后段制程(BEOL),在晶圓正面布線,透過這些低電阻的導線來供應(yīng)電力給芯片(圖1)。但也因為如此,芯片內(nèi)的供電網(wǎng)絡(luò)與信號網(wǎng)絡(luò)(即芯片內(nèi)的信號線)必須共用相同的元件空間。

圖1.傳統(tǒng)的芯片正面供電網(wǎng)絡(luò)
但隨著制程節(jié)點往前推進,把電源網(wǎng)絡(luò)實作在芯片正面,遇到越來越多挑戰(zhàn),使得業(yè)界開始探索把供電網(wǎng)絡(luò)轉(zhuǎn)移到背面的可能性,從而讓晶背供電(Backside PDN)成為熱門的技術(shù)議題。本文將先從傳統(tǒng)PDN所遇到的挑戰(zhàn)談起,進一步探討晶背供電技術(shù)的優(yōu)勢,以及這項技術(shù)未來的發(fā)展重點。
傳統(tǒng)PDN布線面臨諸多挑戰(zhàn)
為了將電力從封裝傳輸至芯片中的電晶體,電子必須經(jīng)由金屬導線和通孔,穿越15~20層BEOL堆疊。然而,越接近電晶體,線寬和通孔就越窄,電阻值也因而上升,這使得電子在向下傳輸?shù)倪^程中,會出現(xiàn)IR壓降現(xiàn)象,導致電力損失產(chǎn)生。
除了電力損失之外,PDN占用的空間也是一個問題。當電子快到達電晶體,例如抵達標準元件層時,電子會進入由BEOL制程所制造Mint金屬層,進而分配給負責提供工作電壓與接地電壓的電源軌。然后,這些電源軌會透過互連網(wǎng)絡(luò),連接到每一個電晶體的源極與汲極,完成供電任務(wù)。但這些電源軌會占用元件周圍及標準單元(Standard Cell)之間的空間。
然而,隨著制程技術(shù)世代交替,傳統(tǒng)后段制程的元件架構(gòu)難以跟上電晶體的微縮速度。如今,芯片內(nèi)部的電源線路,在布線復雜的后段制程上,往往占據(jù)了至少20%的繞線資源,如何解決信號網(wǎng)絡(luò)跟供電網(wǎng)絡(luò)之間的資源排擠問題,變成芯片設(shè)計者所面臨的主要挑戰(zhàn)之一。此外,電源線和接地線在標準單元設(shè)計上占了很大空間,使得元件很難進一步微縮。就系統(tǒng)設(shè)計而言,因為功率密度和IR壓降急劇增加,從穩(wěn)壓器到電晶體的功率損失就很難控制在10%以下,帶給工程師嚴峻挑戰(zhàn)。
晶背供電網(wǎng)絡(luò)具有雄厚潛力
把芯片內(nèi)的PDN從正面移到背面,也就是所謂的晶背PDN(圖2),可以解決上述問題。若能將供電網(wǎng)絡(luò)與信號網(wǎng)絡(luò)分離,把電源線路全部移至晶圓背面,就能對標準單元進行直接供電,不僅導線更寬、電阻更低,而且電子還不需層層穿越后段制程的元件堆疊。如以一來,不僅緩解了IR壓降問題,讓PDN的效能獲得改善,同時也避免了后段制程的布線壅塞問題。如果設(shè)計得當,晶背PDN甚至還能進一步減少標準單元的高度。

圖2 把供電網(wǎng)絡(luò)從正面轉(zhuǎn)移到背面,讓供電網(wǎng)絡(luò)跟信號網(wǎng)絡(luò)分離,可帶來諸多效益
要把PDN從芯片正面轉(zhuǎn)移到背面,需要兩項關(guān)鍵技術(shù),分別是埋入式電源軌(BPR)與納米硅穿孔(nTSV),其結(jié)構(gòu)示意如圖3。

圖3 晶背供電網(wǎng)絡(luò)結(jié)構(gòu)的示意圖,最頂端的Nanosheet電晶體藉由埋入式電源軌跟納米硅穿孔,連接到位于芯片背部的互聯(lián)線路
埋入式電源軌是一種微縮化技術(shù),可以進一步降低標準單元的高度,并減緩IR壓降問題。這些電源軌是埋在電晶體下方的導線,一部份藏在硅基板內(nèi),另一部份則在淺溝槽隔離氧化層內(nèi)。它們?nèi)〈藗鹘y(tǒng)后段制程在標準單元布下的電源線與接地線。
將供電網(wǎng)絡(luò)的實作從后段制程移到前段制程,是劃時代之舉。這種作法能有效減少Mint層的元件堆疊數(shù)量,進而微縮標準單元尺寸。還有一點,如果電源軌設(shè)計在標準單元的垂直向,還能放寬導線,進而減緩IR壓降。
在2019年的IEEE國際電子研究會議(IEDM)上,imec攜手硅智財公司Arm,預測晶背供電技術(shù)所能帶來的效能升級。Arm在其開發(fā)與采用先進設(shè)計規(guī)則的中央處理器(CPU)上進行模擬,并比較「傳統(tǒng)供電」、「晶圓正面供電結(jié)合埋入式電源軌」、「晶背供電搭配納米硅穿孔與埋入式電源軌」這三種供電網(wǎng)絡(luò)實作方法的優(yōu)劣。
模擬結(jié)果顯示,就供電效率來看,第三種明顯勝過其它實作方法。芯片上的動態(tài)IR壓降熱力圖(圖4)顯示,與傳統(tǒng)的正面供電網(wǎng)絡(luò)相比,導入埋入式電源軌后,IR壓降最多可以減至1.7倍。但埋入式電軌結(jié)合晶背供電網(wǎng)絡(luò)的性能表現(xiàn)更佳,電壓損耗大幅下降7倍。

圖4 三種不同供電方法的動態(tài)IR壓降模擬熱力圖
晶背PDN制程解析
接下來,我們會說明晶背供電網(wǎng)絡(luò)的其中一項應(yīng)用案例:納米硅穿孔在超薄膜晶圓的背面進行制造,并與埋入式電源軌連接。我們以在晶圓正面制造的FinFET為例,這些元件透過埋入式電源軌與納米硅穿孔,連接到晶圓背面。其制程步驟如圖5。
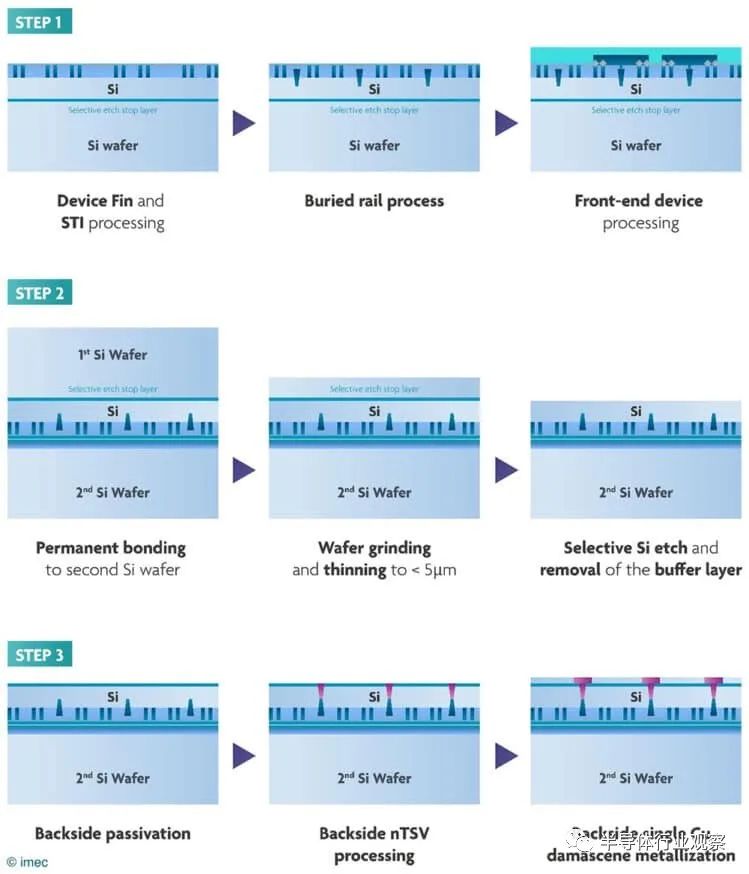
圖5 晶背供電網(wǎng)絡(luò)制程包含與納米硅穿孔相連的埋入式電源軌。為了方便說明,步驟2和步驟3的部分細節(jié)與步驟1雷同,故省略,包含連接埋入式電源軌與元件
步驟1:在晶圓正面制程導入埋入式電軌
首先,在12吋硅晶圓上成長一層硅鍺(SiGe)層。這層硅鍺材料在接下來進行晶圓研磨(步驟2)時可以當作蝕刻停止層。接下來,在硅鍺層上方成長一層薄膜硅覆蓋層,這時才算開始制造元件與埋入式電源軌。埋入式電源軌在進行淺溝槽隔離后才確定圖形。這些溝槽在硅覆蓋層內(nèi)蝕刻成形,并以氧化物(襯墊層)與金屬材料(例如鎢或釕)填充。通常,這些電源軌的最大線寬為30nm,最大間距為100nm。接著在金屬材料挖洞,并覆蓋一層介電材料。元件(本文指的是FinFET)的制造是在布下埋入式電源軌之后,而這些電源軌透過連接到BPR的通孔(via-to-BPR, VBPR)與M0A層的導線,與電晶體的源極和汲極連接。最后進行銅金屬化。
步驟2:晶圓接合與研磨
載有元件與埋入式電源軌的晶圓接著翻到另一面,讓用來制造主動元件的晶圓正面與未圖形化的載板接合。先在室溫下采用SiCN熔接制程(Fusion Bonding),然后在250℃下進行退火,第一片晶圓的背面就能研磨到硅鍺層,也就是蝕刻停止層。晶圓研磨步驟結(jié)合了化學機械研磨(CMP)與濕式、干式蝕刻技術(shù),依序進行晶背薄化處理。接著,移除硅鍺層,晶圓處理就緒,準備進入納米硅穿孔制程。
步驟3:制造納米硅穿孔并連接到埋入式電源軌
先在晶背長出一層鈍化層,隨后采用一種能從晶背穿透硅材進行對準的微影制程,進行納米硅穿孔的圖形化。這里所用的蝕刻技術(shù)可以穿透硅材(深度達到數(shù)百納米)來制造納米硅穿孔,這些通孔最后落在埋入式電源軌上,并以氧化物與金屬鎢填充。
在這個特殊案例中,納米硅穿孔的間距為200nm,完全沒占用到標準單元的空間。最終是制造單層或多層的金屬層,這些位于晶背的元件層會透過納米硅穿孔,與晶圓正面的埋入式電源軌實現(xiàn)通電。
鎖定三大關(guān)鍵步驟進一步改良
導入晶背供電網(wǎng)絡(luò)意味著增加制程步驟。這幾年來,imec展示了不少關(guān)鍵技術(shù),逐步處理這些新增制程步驟所帶來的挑戰(zhàn)。
為埋入式電源軌引進新金屬材料
就先前提議的制程,埋入式電源軌會在制成元件前,于前段制程制造。也就是說,這些金屬導線必須在后續(xù)進行元件制造的步驟時承受高溫。對芯片制造商來說,這就跟數(shù)十年前在后段制程導入銅材料一樣,極具顛覆性。
因此,埋入式電源軌的材料選擇至關(guān)重要。imec可以整合以不同耐火金屬制成的埋入式電源軌,包含釕(Ru)和鎢(W)等高度耐熱的金屬元素。為了避免前段制程的材料受到污染,imec研究團隊還額外增加了覆蓋層來包覆這些金屬導線。
imec相信,就性能升級與微縮化而言,結(jié)合埋入式電源軌與納米硅穿孔的發(fā)展?jié)摿κ挚捎^。晶背供電網(wǎng)絡(luò)還有其它做法,但是有的會犧牲供電效能、標準單元面積,或是增加前段制程的復雜度。
提高晶圓研磨精準度
為了將納米硅穿孔連接至后續(xù)制造的銅導線,并降低其電阻,進而減緩IR壓降,我們必須更精準地控制晶圓薄化的厚度,研磨至數(shù)百納米。這就限制了晶圓厚度的容許差異,但在進行不同道研磨步驟時就可能出現(xiàn)變異性。imec攜手合作伙伴,致力于改良蝕刻制程的化學溶液。例如,最后一道濕式蝕刻能夠展現(xiàn)高度選擇性,干凈去除硅鍺層。在晶圓研磨的最后一步,硅鍺層被移除,這時需要一種對硅材具備高度選擇性的專用化學物質(zhì)。這樣才能確保硅覆蓋層能夠平滑露出,厚度差異小于40nm。
不過,在硅基板高度薄化的情況下,元件本身的溫度變化所造成的熱沖擊(Thermal Impact)會變得更加明顯。這是需要審慎評估的一點。初步模擬結(jié)果顯示,晶背的導線可協(xié)助從橫向散逸熱能,因此對整體散熱效果能帶來許多助益,從而緩解了熱沖擊的疑慮。其它與散熱有關(guān)的模擬工作仍在進行,以獲取更多這方面的資訊。
提高晶圓接合對位精度
晶圓接合步驟會讓主動式元件所在的第一層晶圓產(chǎn)生形變,進而在微影方面帶來技術(shù)挑戰(zhàn)。因為要在晶圓研磨后,從晶背進行納米硅穿孔的圖形化,故微影技術(shù)需要更高精確度,才能讓納米硅穿孔與下層的埋入式電源軌對準。因為這些元件特征都算是標準單元設(shè)計,對準精度應(yīng)該優(yōu)于10nm。但是傳統(tǒng)的微影對準技術(shù)不足以準確校正晶圓接合的形變。
值得慶幸的是,晶圓接合技術(shù)已有多項進展,對準誤差和失真都已大幅下降。此外,透過先進的微影校正技術(shù),納米硅穿孔對準埋入式電源軌的誤差可以降至10nm以下。
新增制程不影響元件電性
在前段制程添加埋入式電源軌、晶圓研磨跟納米硅穿孔這些新步驟,會影響前段制程所制造出的元件的電性嗎?這點想必是很多半導體制程工程師都會有的疑問。
為了找出解答,imec近期開發(fā)了測試元件,采用上述制程與經(jīng)過改良的做法。該元件是微型FinFET(圖6),利用精確的對準能力,將納米硅穿孔從晶背連接至320nm深的埋入式電源軌。電源軌透過MOA層與VO通孔連接到晶圓正面的導線。借此,研究人員就能比較測試元件在進行后段制程前后的電性差異。結(jié)果顯示,只要在制程最后進行退火,就能取得FinFET的最佳性能,不受埋入式電源軌與后段制程影響。
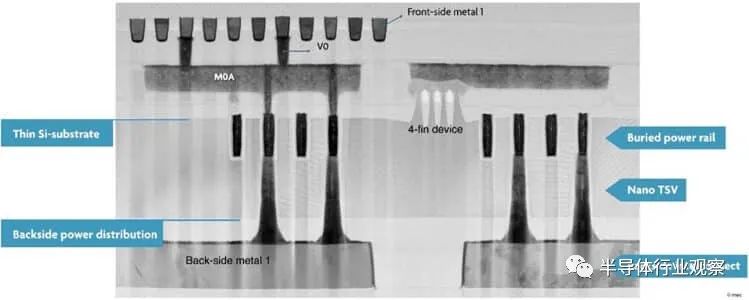
圖6 微型FinFET測試元件的穿透式電子顯微鏡(TEM)圖,可見其與晶圓正面和背面相連
先進邏輯與3D SoC率先獲益
有些芯片廠商已經(jīng)宣布將在2nm及未來技術(shù)節(jié)點的邏輯芯片制程,也就是Nanosheet電晶體世代導入晶背供電技術(shù)。不過,這項新興的布線技術(shù)其實可以應(yīng)用在更廣泛的電晶體架構(gòu)上。imec認為,未來業(yè)界將發(fā)展出具備6T的Nanosheet電晶體,若結(jié)合埋入式電源軌設(shè)計,標準單元高度可望降至6T以下。
其實,晶背供電技術(shù)的應(yīng)用不僅限于2D芯片,未來還有可能用來提升3D系統(tǒng)單芯片(SoC)的性能。想像未來的3D SoC能將部分甚至所有的記憶體元件移到芯片上層,邏輯元件則在下層,如圖7。

圖7 導入晶背供電網(wǎng)絡(luò)的3D SoC示意圖
技術(shù)上,這是可以透過晶圓接合技術(shù)實現(xiàn)的。把邏輯元件與記憶體分別置于不同晶圓的正面,再將兩片晶圓正面接合。這時,兩片晶圓的背面變成3D SoC的外側(cè)。接著就是思考如何善用邏輯元件那片晶圓的背面,才能把電源連接到核心邏輯電路。其實,透過2D SoC技術(shù)就能做到這點,但主要差別是前面提到的載板晶圓,本來是為了晶圓研磨而設(shè)計,但現(xiàn)在則是以記憶體那片晶圓來取代。
雖然目前還未進入實驗,初步評估這套做法在IR壓降方面的發(fā)展可期。透過先進制程研究用的設(shè)計流程套件(PDK),上述解決方案在邏輯與記憶體堆疊(Memory-on-logic)的芯片分區(qū)設(shè)計上進行驗證。結(jié)果顯示,結(jié)合晶背供電網(wǎng)絡(luò)、納米硅穿孔與埋入式電源軌的元件性能頗富前景:與傳統(tǒng)從晶圓正面供電的做法相比,底層元件的平均IR壓降減少81%,峰值減少77%。因此,晶背供電技術(shù)特別適合用于先進CMOS的3D IC設(shè)計。
不論是2D或3D芯片設(shè)計,晶背空間還能有其它的延伸應(yīng)用,像是增設(shè)I/O或靜電保護(ESD)等元件。舉例來說,imec結(jié)合了晶背供電技術(shù)與2.5D元件:一顆柱狀且由金屬—絕緣體—金屬(MIM)組成的去耦電容。該元件將電容密度提升了4~5倍,利于進一步控制IR壓降。這些研究成果皆源自經(jīng)過實驗數(shù)據(jù)校正的IR壓降模型。
晶背供電帶來諸多優(yōu)勢發(fā)展?jié)摿χ档闷诖?/p>
新一代芯片很可能打破傳統(tǒng),從晶圓背面供電。晶背供電網(wǎng)絡(luò)的設(shè)計包含在晶圓背面制造金屬導線、埋入式電源軌與納米硅穿孔,具備多項發(fā)展優(yōu)勢,不僅能減少IR壓降、紓解后段制程的布線壓力,還能幫助微縮標準單元。關(guān)鍵的制程技術(shù)包含整合埋入式電源軌、晶圓接合、晶圓研磨與納米硅穿孔制程,全都在進行研發(fā)改良,為將來應(yīng)用在先進邏輯元件與3D SOC做準備。
審核編輯 :李倩
-
芯片
+關(guān)注
關(guān)注
459文章
52253瀏覽量
436921 -
電阻
+關(guān)注
關(guān)注
87文章
5610瀏覽量
174410 -
電力
+關(guān)注
關(guān)注
7文章
2225瀏覽量
51072
原文標題:芯片要靠這個供電革命了!
文章出處:【微信號:光刻人的世界,微信公眾號:光刻人的世界】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
通過AD芯片的哪些參數(shù)可以推算出對AD芯片供電的電源的紋波和噪聲的要求啊?
Matter 1.4推動智能家居節(jié)能革命
使用SN65LBC184D設(shè)計板子的時候,供電電壓腳飛線了,為什么?
tvp7002這個器件數(shù)據(jù)手冊標注的供電電壓是1.9V,使用1.8V的話有影響嗎?
AI算力芯片供電電源測試利器:費思低壓大電流系列電子負載

單對以太網(wǎng)供電開辟了新的應(yīng)用前景
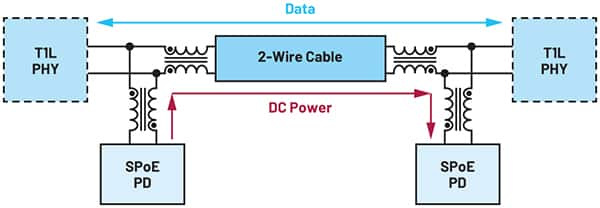





 芯片要靠這個供電革命了!
芯片要靠這個供電革命了!










評論