引線(xiàn)鍵合是指在半導(dǎo)體器件封裝過(guò)程中,實(shí)現(xiàn)芯片(或其他器件)與基板或框架互連的一種方法。作為最早的芯片封裝技術(shù),引線(xiàn)鍵合因其靈活和易于使用的特點(diǎn)得到了大規(guī)模應(yīng)用。引線(xiàn)鍵合工藝是先將直徑較小的金屬線(xiàn)(一般是直徑為25μm 的金線(xiàn))連接到芯片的金屬焊盤(pán)(一般是鋁焊盤(pán))上,再將金屬線(xiàn)的另一端連接到基板或框架上從而形成互連。該工藝?yán)谜{(diào)節(jié)溫度、壓力、超聲波能量和時(shí)間參數(shù),實(shí)現(xiàn)芯片與基板或框架間的電氣互連、芯片散熱和芯片間的信息互通。引線(xiàn)鍵合屬于固相鍵合中的一種,其鍵合 原理是引線(xiàn)與芯片焊盤(pán)間發(fā)生電子的跨區(qū)遷移、共享及不同原子的相互擴(kuò)散,使金屬實(shí)現(xiàn)原子量級(jí)上的鍵合,從而實(shí)現(xiàn)穩(wěn)定可靠的連接。
按外加能量的不同,引線(xiàn)鍵合可分為超聲鍵合、熱壓鍵合和熱超聲鍵合;按劈刀類(lèi)型的不同,引線(xiàn)鍵合可分為楔形鍵合和球形鍵合。目前,電子封裝行業(yè)使用較多的是超聲球形鍵合技術(shù),配合使用的線(xiàn)材多為金線(xiàn)、銅線(xiàn),因?yàn)榻鹁€(xiàn)具有高抗拉強(qiáng)度、高導(dǎo)電性、高可靠性和強(qiáng)抗氧化性。此外,鋁線(xiàn)因?yàn)樘厥獾难趸阅軐?dǎo)致不易成球,因此鋁線(xiàn)和鋁帶多用于楔形鍵合。電子封裝行業(yè)中應(yīng)用引線(xiàn)鍵合的封裝形式有 TSSOP、 QFN 、DFN、 BGA 以及3D封裝等。
引線(xiàn)鍵合工藝流程如下圖

線(xiàn)拉力試驗(yàn)(Pull Test)和球剪切試驗(yàn)(Shear Test)通常被用于測(cè)量、評(píng)估鍵合強(qiáng)度.試驗(yàn)可分為破壞性試驗(yàn)和非破壞性試驗(yàn)兩種,其試驗(yàn)方法和標(biāo)準(zhǔn)一般采用的是美國(guó)軍工標(biāo)準(zhǔn)(MIL-STD-883 Method 2011.9)。高溫存儲(chǔ)試驗(yàn)(HTST)、熱沖擊和熱循環(huán)試驗(yàn)(TS&TCT)、濕氣相關(guān)的可靠性試驗(yàn) (PCTHAST)和電遷移試驗(yàn)(ET) 主要用于評(píng)價(jià)引線(xiàn)鍵合封裝的可靠性,其試驗(yàn)條件和方法一般采用JEDEC 的相關(guān)標(biāo)準(zhǔn)。
早期引線(xiàn)鍵合使用的主要線(xiàn)材為金線(xiàn),金線(xiàn)材成本較高,且金線(xiàn)鍵合界面金屬間化合物 (Intermetallic Corapound, IMC)生長(zhǎng)速率快,易于生成白斑。影響鍵合的可靠性。為順應(yīng)封裝技術(shù)逐漸向高密度和細(xì)間距的發(fā)展趨勢(shì),其他高導(dǎo)熱和高導(dǎo)電性能的金屬線(xiàn)材(主要為銅線(xiàn)和銀線(xiàn))被逐漸使用在引線(xiàn)鍵合中。金、銅、銀的熱導(dǎo)率分別為 320W/(m ?K)、400W/(m ?K)、430W/(m ?K),其電阻率分別為 2.20Ω ?m、1.72Ω ?m、1.63Ω ?m。由于銅的易氧化性和銀的易電遷移性,使得鍍鈀銅線(xiàn)和銀合金線(xiàn)成為封裝行業(yè)中使用較多的鍵合線(xiàn)材。與線(xiàn)材相對(duì)應(yīng)的芯片焊盤(pán)材料有鋁焊盤(pán)、金焊盤(pán),以及更適合銅線(xiàn)鍵合的鎳鈀金焊盤(pán)等。
金線(xiàn)一般采用99.99%的純金,直徑為 15~50μm,具有優(yōu)良的 HAST 可靠性能,多用于有高可靠性要求的軍工和航空航天電子器件。
銅線(xiàn)采用 99.99%的純銅,直徑一般為 18~50μm。鍍鈿銅線(xiàn)直徑一般為 18~30μm,內(nèi)部芯材采用99. 99%的純銅,外部為鍍鈀層(厚度為 50~100nm)。因鍍鈀銅線(xiàn)的 HAST 可靠性?xún)?yōu)于銅線(xiàn),銅線(xiàn)多用于框架類(lèi)封裝,而鍍鈀銅線(xiàn)則多用于基板類(lèi)封裝。
銀合金線(xiàn)的直徑一般為 16~75μm,分為低銀合金線(xiàn)(銀含量為 88%)、中銀合金線(xiàn)(銀含量為 95%)和高銀合金線(xiàn)(銀含量為 98%),多應(yīng)用于 LED 封裝和基板類(lèi)封裝,但其基板類(lèi)封裝的 HAST 可靠性低于鍍鈀銅線(xiàn),且高銀線(xiàn)材的可靠性低于中銀線(xiàn)材。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28283瀏覽量
229349 -
封裝
+關(guān)注
關(guān)注
128文章
8339瀏覽量
144363 -
工藝
+關(guān)注
關(guān)注
4文章
651瀏覽量
29135 -
銅線(xiàn)
+關(guān)注
關(guān)注
2文章
56瀏覽量
17063 -
引線(xiàn)鍵合
+關(guān)注
關(guān)注
2文章
24瀏覽量
8305
原文標(biāo)題:引線(xiàn)鍵合工藝,焊綫製程, Wire Bonding, Process
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
有償求助本科畢業(yè)設(shè)計(jì)指導(dǎo)|引線(xiàn)鍵合|封裝工藝
半導(dǎo)體引線(xiàn)鍵合清洗工藝方案
集成電路封裝中的引線(xiàn)鍵合技術(shù)

引線(xiàn)鍵合工藝參數(shù)對(duì)封裝質(zhì)量的影響因素分析
LED引線(xiàn)鍵合的檢測(cè)內(nèi)容與工藝評(píng)價(jià)
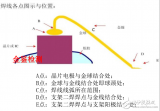
LED引線(xiàn)鍵合工藝評(píng)價(jià)
引線(xiàn)鍵合是什么?引線(xiàn)鍵合的具體方法

什么是引線(xiàn)鍵合?引線(xiàn)鍵合的演變

IGBT模塊銀燒結(jié)工藝引線(xiàn)鍵合工藝研究
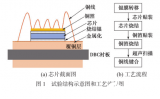
優(yōu)化關(guān)鍵工藝參數(shù)提升功率器件引線(xiàn)鍵合的可靠性
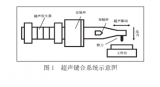
金絲引線(xiàn)鍵合的影響因素探究

引線(xiàn)鍵合之DOE試驗(yàn)
帶你一文了解什么是引線(xiàn)鍵合(WireBonding)技術(shù)?

引線(xiàn)鍵合的基礎(chǔ)知識(shí)






 引線(xiàn)鍵合工藝流程講解
引線(xiàn)鍵合工藝流程講解
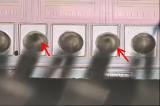










評(píng)論